Selbst gesätes MOCVD-Wachstum und dramatisch verstärkte Photolumineszenz von InGaAs/InP-Kern-Schale-Nanodrähten
Zusammenfassung
Wir berichten über das Wachstum und die Charakterisierung von InGaAs/InP-Kern-Schale-Nanodrähten auf Si-(111)-Substraten durch metallorganische chemische Gasphasenabscheidung (MOCVD). Die durch die große Gitterfehlanpassung zwischen dem InGaAs-Kern und den InP-Schalenmaterialien induzierte Spannung an der Kern-Schale-Grenzfläche hat einen starken Einfluss auf das Wachstumsverhalten der InP-Schale, was zu einem asymmetrischen Wachstum der InP-Schale um den InGaAs-Kern und sogar zum Biegen der Nanodrähte. Transmissionselektronenmikroskopie (TEM)-Messungen zeigen, dass die InP-Schale mit dem InGaAs-Kern ohne Fehlanpassungsversetzungen kohärent ist. Darüber hinaus zeigen Photolumineszenz(PL)-Messungen bei 77 K, dass die PL-Peakintensität der InGaAs/InP-Kern-Schale-Nanodrähte aufgrund der Passivierung der Oberflächenzustände und der effektiven Trägereinschluss aufgrund der InP-Hüllenschicht. Die hier erzielten Ergebnisse erweitern unser Verständnis des Wachstumsverhaltens von verspannten Kern-Schale-Heterostruktur-Nanodrähten und können neue Möglichkeiten für Anwendungen in InGaAs/InP-Heterostruktur-Nanodraht-basierten optoelektronischen Bauelementen auf einer Si-Plattform eröffnen.
Hintergrund
III-V-Halbleiter-Nanodrähte gelten aufgrund ihrer einzigartigen elektronischen, optischen und geometrischen Eigenschaften als vielversprechende Kandidaten für nanoskalige Bauelemente der nächsten Generation [1,2,3,4]. Unter den III–V-Halbleitermaterialien ist der ternäre InGaAs-Nanodraht aufgrund seiner hervorragenden physikalischen Eigenschaften, wie z. Darüber hinaus wurde die Integration von III–V-Materialien mit einer Si-Plattform, die die Kombination der Vorteile der einzigartigen physikalischen Eigenschaften von III–V-Materialien mit ausgereifter Komplementärmetalloxid-Halbleitertechnologie (CMOS) ermöglicht, intensiv untersucht. Aufgrund des geringen Footprints bieten Nanodrähte eine Möglichkeit für die Integration von III-V-Materialien mit Si, wobei der große Unterschied in den Gitterparametern zwischen den Materialien ignoriert wird [5, 6]. Bisher wurden verschiedene Bauelemente auf Basis von ternären InGaAs-Nanodrähten auf Si-Substraten hergestellt, darunter stromsparende Hochgeschwindigkeitstransistoren [7, 8], Tunnel-basierte Bauelemente [9, 10], Leuchtdioden (LEDs) [11 ], photonische Geräte [12, 13] und Solarzellen [14, 15].
Aufgrund des hohen Oberfläche-zu-Volumen-Verhältnisses des eindimensionalen Nanodrahts sind die zahlreichen Oberflächenzustände jedoch zu einer Haupteinschränkung bei der Erzielung hochleistungsfähiger optoelektronischer Bauelemente auf Nanodrahtbasis geworden. Einerseits können diese Oberflächenzustände durch Streuung und einen strahlungslosen Rekombinationsprozess sowohl die elektronischen als auch die optischen Eigenschaften der III–V-Materialien stark verschlechtern [16,17,18,19,20]. Andererseits kann bei Nanodrähten aus einigen Materialien mit schmaler Bandlücke (wie InAs, In-rich InGaAs) die hohe Dichte der Oberflächenzustände zu einer Krümmung der elektronischen Bandstruktur nahe der Nanodrahtoberfläche führen (Oberflächen-Fermi-Niveau-Pinned-Effekt ). Eine solche nicht-flache Bandstruktur führt außerdem zu einer Umverteilung der Ladungsträger, die die Leistung von optischen Nanodraht-basierten Geräten stark beeinträchtigen kann [21]. Daher ist es dringend erforderlich, diese Oberflächenzustände zu eliminieren. Für ternäre InGaAs-Nanodrähte mit höherer In-Zusammensetzung ist InP eine wünschenswerte Oberflächenpassivierungsschicht, da das Materialsystem eine Typ-I-Bandlückenausrichtung bildet, die Ladungsträger in InGaAs effektiv einschließen kann. Darüber hinaus ist die Emissionswellenlänge des InGaAs/InP-Materialsystems, das in planaren Strukturen umfassend untersucht wurde, im Bereich von 1,31–1,55 μm abstimmbar, was vielversprechende Aussichten für die Glasfaserkommunikation bietet.
In dieser Arbeit haben wir das Wachstum und die Charakterisierung von InGaAs/InP-Kern-Schale-Nanodrähten auf Si-(111)-Substraten mittels metallorganischer chemischer Gasphasenabscheidung (MOCVD) durchgeführt. Es zeigt sich, dass die Dehnung an der Kern-Schale-Grenzfläche, die aus einer großen Gitterfehlanpassung zwischen den Kern- und Schalenmaterialien resultiert, einen starken Einfluss auf das Wachstumsverhalten der InP-Schale hat. Die große Gitterfehlanpassung zwischen den Kern- und Schalenmaterialien kann zu einer ungleichmäßigen Keimbildung der InP-Überzugsschicht um die InGaAs-Kern-Nanodrähte und sogar zum Biegen der Nanodrähte führen. Durch Optimierung der Wachstumsbedingungen können InGaAs/InP-Kern-Schale-Nanodrähte mit guter Morphologie erreicht werden. Darüber hinaus zeigen Photolumineszenz(PL)-Messungen bei 77 K, dass die PL-Peakintensität der InGaAs/InP-Kern-Schale-Nanodrähte aufgrund der Passivierung der Oberflächenzustände und der effektiven Ladungsträgerbegrenzung durch die InP-Beschichtung eine etwa 100-fache Verbesserung im Vergleich zu den blanken InGaAs-Nanodrähten zeigt Schicht.
Methoden/Experimental
Nanodrahtwachstum
Die InGaAs/InP-Kern-Schale-Nanodrähte wurden mit einem motornahen Duschkopf-MOCVD-System (AIXTRON Ltd., Deutschland) bei 133 mbar gezüchtet. Als Vorstufen der Gruppe III wurden Trimethylindium (TMIn) und Trimethylgallium (TMGa) verwendet, und Arsin (AsH3 ) und Phosphin (PH3 ) wurden als Vorstufen der Gruppe V verwendet. Ultrahochreiner Wasserstoff (H2 .) ) als Trägergas verwendet wurde und die Gesamtflussrate von H2 war 12 slm. Vor dem Wachstum wurden die Si-(111)-Substrate zum Tempern auf 635 °C erhitzt und dann unter AsH3 . auf 400 °C abgekühlt Flussmittel, um (111)B-ähnliche Oberflächen zu bilden [22]. Die Nanodrähte des InGaAs-Kerns wurden bei 565 °C für 15 Minuten gezüchtet. Während des Wachstumsprozesses werden TMIn und AsH3 Durchflussraten von 0.8 × 10 − 6 mol/min und 1.0 × 10 − 4 mol/min, während die TMGa-Strömungsrate variiert wird. Die TMGa-Dampfphasenzusammensetzung Xv, die als das Verhältnis der Fließgeschwindigkeiten TMGa/(TMGa + TMIn) definiert wurde, wurde von 30 bis 40% variiert. Die InP-Schale wurde bei 565 °C für 10 min mit TMIn und PH3 . gezüchtet Durchflussraten von 2 × 10 − 6 mol/min und 8.0 × 10 − 4 mol/min bzw. Nach dem Wachstum wurden die Proben mit PH3 . auf Raumtemperatur abgekühlt als Schutzmittel.
Charakterisierungsmethoden
Die Morphologie der Nanodrähte wurde durch Rasterelektronenmikroskopie (REM) (Nova Nano SEM 650) und Transmissionselektronenmikroskopie (TEM) (JEM2010F TEM; 200 kV) in Verbindung mit energiedispersiver Röntgenspektroskopie (EDS) charakterisiert untersuchen die Kristallstruktur bzw. -zusammensetzung. Für TEM-Beobachtungen wurden die Nanodrähte mechanisch von den Proben auf mit einem Kohlenstofffilm beschichtete Kupfergitter übertragen. Um die optischen Eigenschaften der gewachsenen Nanodrähte zu untersuchen, wurden Photolumineszenz(PL)-Messungen mit einem Laser mit 532 nm Wellenlänge als Anregungsquelle durchgeführt. Die Proben wurden mit einer Laserleistung von ~ 100 mW über eine Spotgröße mit einem Durchmesser von ca. 150 µm angeregt. Das PL-Signal wurde direkt in ein Fourier-Transform-Infrarot-(FTIR)-Spektrometer eingespeist und von einem mit flüssigem Stickstoff gekühlten InSb-Detektor aufgezeichnet. Der bewegliche Spiegel im FTIR-Spektrometer lief in einem Rapid-Scan-Modus [23], im Unterschied zu den Step-Scan-modulierten PL-Messungen an InAs-Nanodrähten im mittleren Infrarotbereich [24].
Ergebnisse und Diskussion
Abbildung 1 zeigt eine schematische Darstellung des Wachstums von InGaAs/InP-Kern-Schale-Nanodrähten auf einem Si-(111)-Substrat und die Source-Supply-Sequenzen für das Wachstum der Nanodrähte. InGaAs-Nanodrähte wachsen durch einen selbstkatalysierten Mechanismus [25]. Bitte beachten Sie, dass In-Tröpfchen unter einem AsH3 . verbraucht werden Atmosphäre (gezeigt in Region 3 in Abb. 1). Das Überwachsen der InP-Shell wurde durch den Wechsel des AsH3 . eingeleitet zu PH3 Flussmittel und Öffnen des TMIn-Flussmittels gleichzeitig.
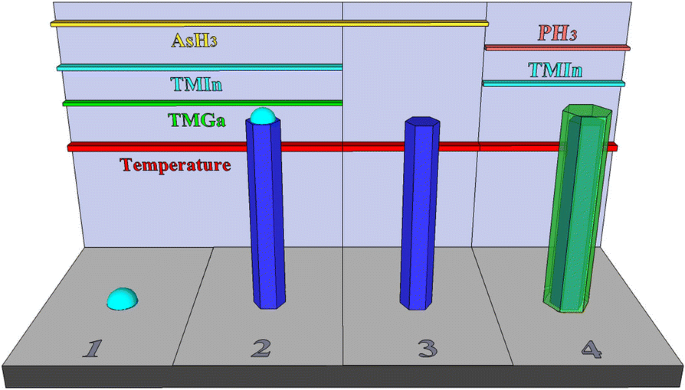
Schematische Darstellung des Wachstums von InGaAs/InP-Kern-Schale-Nanodrähten und der Source-Supply-Sequenzen für das Nanodrahtwachstum
Abbildung 2a, b zeigen typische SEM-Bilder von blanken InGaAs- bzw. InGaAs/InP-Kern-Schale-Nanodrähten mit Xv = 30%. Alle InGaAs-Nanodrähte sind auf dem Si-Substrat mit einheitlichem Durchmesser über die gesamte Länge vertikal ausgerichtet. Nach dem anschließenden Wachstum der InP-Schale weisen die Nanodrähte immer noch glatte Seitenfacetten auf, was auf die Optimierung der Wachstumsparameter hinweist. Aus den statistischen Durchmesserverteilungen der blanken InGaAs- und InGaAs/InP-Kern-Schale-Nanodrähte nimmt der durchschnittliche Durchmesser der Nanodrähte nach dem Wachstum der InP-Schale von 65 auf ∼ 95 nm zu, was auf eine durchschnittliche InP-Schalendicke von etwa 15 hinweist nm. Die InGaAs/InP-Kern-Schale-Nanodrähte in Abb. 2b sind jedoch sichtbar verbogen, was durch die Belastung des InGaAs-Kern-Nanodrahts durch die InP-Schale aufgrund der großen Gitterfehlanpassung zwischen den Kern- und Schalenmaterialien induziert wird. Abbildung 2c, d zeigt REM-Aufnahmen der InGaAs/InP-Kern-Schale-Nanodrähte mit einem Xv von 35 % bzw. 40 %. Im Vergleich zu den Nanodrähten in Abb. 2b verringerte sich die Biegung von InGaAs/InP-Kern-Schale-Nanodrähten mit einem Xv von 35% stark (Abb. 2c). Durch eine weitere Erhöhung von Xv auf 40% sind die Nanodrähte gerade ohne sichtbare Biegung (Abb. 2d). Dieses Phänomen kann der Verringerung der Gitterfehlanpassung zwischen dem InGaAs-Kern und den InP-Hüllenmaterialien mit der Zunahme der Ga-Zusammensetzung zugeschrieben werden. Aus den statistischen Verteilungen der Durchmesser von InGaAs/InP-Kern-Schale-Nanodrähten geht außerdem hervor, dass mit zunehmender Ga-Zusammensetzung gleichzeitig der Durchmesser der Nanodrähte zunimmt, was auch verhindern kann, dass sich die InGaAs-Kern-Nanodrähte nach der InP-Beschichtung biegen.

a 30°-gekippte REM-Aufnahmen der InGaAs-Nanodrähte und der InGaAs/InP-Kern-Schale-Nanodrähte mit Xv von b 30 %, c 35 % und d 40%
Um die Kristallstruktur der gewachsenen Nanodrähte zu untersuchen und die Existenz der Kern-Schale-Struktur nach dem Aufwachsen der InP-Schale zu bestätigen, wurden detaillierte TEM-Messungen durchgeführt. Wie in Abb. 3a gezeigt, besteht die Kristallstruktur des InGaAs-Nanodrahts mit einem Xv von 35% aus einem Polytyp von Wurtzit (WZ) und Zinkblende (ZB)-Strukturen mit einer großen Anzahl von Stapelfehlern (SFs) entlang seines Wachstums Richtung, und aufgrund der Koexistenz von WZ- und ZB-Strukturen zusammen mit Strukturdefekten teilen sich die entsprechenden Selected Area Electron Diffraktion (SAED)-Spots auf und sind entlang der Wachstumsrichtung leicht verlängert (Einschub in Abb. 3a). Diese planaren Defekte werden häufig beim Wachstum von InAs- oder InGaAs-Nanodrähten ohne Fremdkatalysator durch MOCVD beobachtet [26, 27, 28]. Abbildung 3b zeigt eine Hellfeld(BF)-TEM-Aufnahme mit niedriger Auflösung eines typischen InGaAs/InP-Kern-Schale-Nanodrahts mit einem Xv von 35% (wie in Abbildung 2c gezeigt). Nach der InP-Beschichtung ist der Nanodraht immer noch ziemlich gerade, ohne sich zu verjüngen. Ein entsprechendes hochauflösendes (HR) TEM-Bild ist in Abb. 3c gezeigt. Es ist eine klare Grenzfläche zwischen InGaAs-Kern und InP-Hülle zu beobachten. Außerdem wurden keine Fehlanpassungsversetzungen gefunden, indem man den {111}-Ebenen an der Kern-Schale-Grenzfläche folgte. Daher ist die gewachsene InP-Schale kohärent mit dem InGaAs-Kern. Darüber hinaus erbt aufgrund des kohärent epitaktischen Wachstums der InP-Beschichtung die Kristallstruktur der InP-Schale vollständig die des InGaAs-Kern-Nanodrahts, wie durch die gemischte WZ/ZB-Struktur des InGaAs/InP-Kern-Schale-Nanodrahts in Abb. . bestätigt wird 3c. Dieses Phänomen wurde bei Kern-Schale-Nanodrähten anderer Materialsysteme beobachtet [29,30,31] und das Verhalten unterstreicht die Notwendigkeit, die Kristallqualität der selbstkatalysierten InGaAs-Nanodrähte zu verbessern.
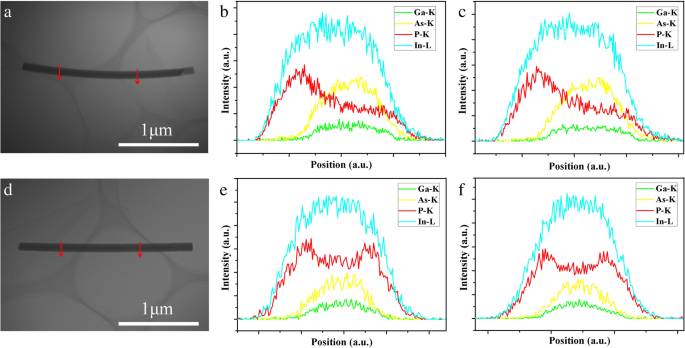
a HRTEM-Bild des blanken InGaAs-Nanodrahts (Xv = 35%), aufgenommen von der < 110>-Zonenachse. Der Einschub ist das entsprechende Selected Area Electron Diffraktion (SAED)-Muster. b TEM-Aufnahme mit geringer Vergrößerung eines InGaAs/InP-Kern-Schale-Nanodrahts (Xv = 35%). c HRTEM-Bild des Nanodrahts, betrachtet von der < 110>-Zonenachse. Die rote gestrichelte Linie zeigt die Schnittstelle zwischen dem Kern und der Hülle an
Abbildung 4a–c zeigt ein TEM-Bild mit geringer Vergrößerung und EDS-Analysen eines typischen InGaAs/InP-Kern-Schale-Nanodrahts aus Abbildung 2b. Gemäß den EDS-Linienscans über den Nanodraht kann das P-Signal offensichtlich in den Spektren identifiziert werden, was auf die Existenz einer InP-Schale um den InGaAs-Kern hinweist. Dagegen ist das EDS-Spektrum des P-Signals asymmetrisch, was bedeutet, dass das Überwachsen der InP-Schale um den InGaAs-Kern-Nanodraht ungleichmäßig ist. Wir vermuten, dass dieses Phänomen hauptsächlich durch die relativ große Gitterfehlanpassung zwischen Kern- und Schalenmaterialien induziert wird, und eine solche ungleichmäßige Nukleation der InP-Schale wird weiter zu einer Biegung der Nanodrähte führen. Im Gegensatz dazu zeigen für den geraden InGaAs/InP (Xv = 35%) Kern-Schale-Nanodraht in Abb. 2c die EDS-Analysen in Abb. 4e–f symmetrische Verteilungen des P-Signals über den Nanodraht, was auf die verbesserte Gleichmäßigkeit der InP-Schale um . hinweist der InGaAs-Kern mit der Erhöhung des Ga-Gehalts hier.
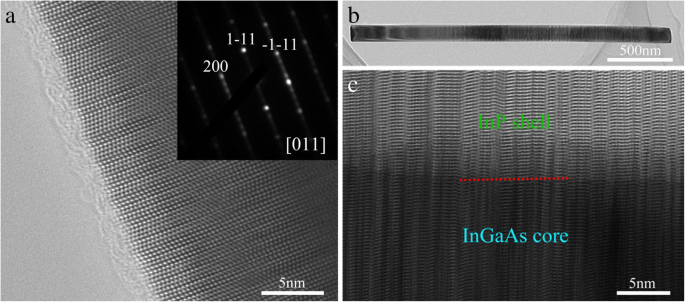
a Ein TEM-Bild mit geringer Vergrößerung eines InGaAs/InP (Xv = 30%) Kern-Schale-Nanodrahts. b , c EDS-Zeilenscans entlang der beiden roten Linien, die in a markiert sind . d Ein TEM-Bild mit geringer Vergrößerung eines InGaAs/InP (Xv = 35%) Kern-Schale-Nanodrahts. e , f EDS-Zeilenscans entlang der beiden roten Linien, die in (d . markiert sind) )
Um die optischen Eigenschaften der gewachsenen Nanodrähte zu untersuchen, wurden Photolumineszenz(PL)-Messungen durchgeführt. Abbildung 5 vergleicht typische PL-Spektren der blanken InGaAs- und InGaAs/InP (Xv = 30%) Kern-Schale-Nanodrähte bei 77 K. Das PL-Spektrum der blanken InGaAs-Nanodrähte zeigt eine viel schwächere Emission mit einem Spitzenwert bei ∼ 0.73 eV (blaue Linie in Abb. 5), während das PL-Spektrum der InGaAs/InP-Kern-Schale-Nanodrähte eine sehr starke Emission mit einem Spitzenwert von ∼ 0.78 eV (rote Linie in Abb. 5) zeigt und die PL-Peakintensität eine ∼ 100-fache Verstärkung im Vergleich zeigt zu den blanken InGaAs-Nanodrähten. Da die Nanodrahtdichten verschiedener Proben vergleichbar sind, gehen wir davon aus, dass eine solch dramatische PL-Emissionsverbesserung von InGaAs/InP-Kern-Schale-Nanodrähten durch die effektive Unterdrückung von Oberflächenzuständen und Trägereinschluss durch die InP-Beschichtung verursacht wird.
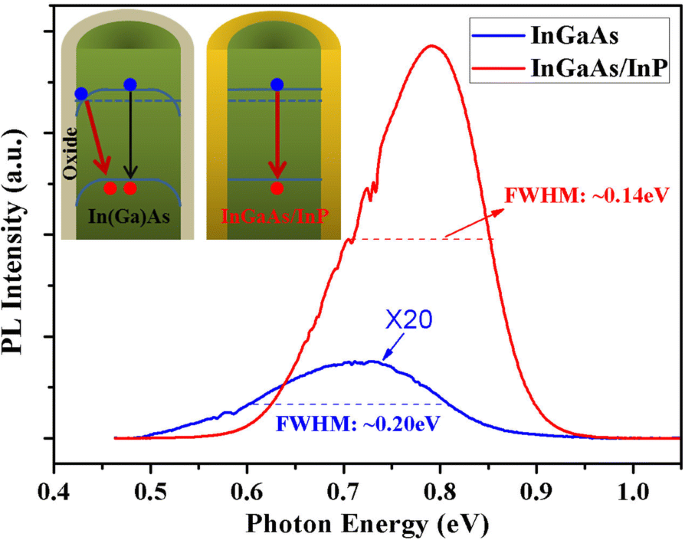
PL-Spektren von blanken InGaAs und InGaAs/InP (Xv = 30%) Kern-Schale-Nanodrähten bei 77 K. Einschub ist eine schematische Darstellung der Bandstrukturen von blanken In-reichen InGaAs und InGaAs/InP Kern-Schale-Nanodrähten
Ein weiteres interessantes Merkmal ist die leichte Blauverschiebung des InGaAs/InP PL-Peaks (∼ 50 meV) im Vergleich zu den blanken InGaAs-Nanodrähten. Zunächst führen wir dieses unterschiedliche Verhalten auf eine Änderung des Rekombinationspfads der dominanten Ladungsträger zurück, wenn der InGaAs-Kern mit einer InP-Schale beschichtet wird. Typischerweise ist bei blanken InAs oder In-reichen InGaAs-Nanodrähten mit nativen Oxid-bedeckten Oberflächen das Oberflächen-Fermi-Niveau in dem durch die zahlreichen Oberflächenzustände induzierten Leitungsband fixiert, was eine nach unten gerichtete Bandbiegung in der Nähe der Nanodraht-Oberfläche verursacht. Dann führt diese nicht-flache Bandstruktur zu einer Ladungsträgerumverteilung, bei der sich Elektronen in der Nähe der Nanodrahtoberfläche ansammeln, während Löcher eher in der Mitte des Nanodrahts verbleiben. Unter Beleuchtung wird ein räumlich indirekter Elektron-Loch-Paar-Übergang mit niedrigerer Energie bevorzugt, wie im Einschub in Abb. 5 gezeigt. Für blanke InAs-Nanodrähte wurde berichtet, dass die Energiedifferenz zwischen der Emission nahe der Bandkante und Die Emission beträgt ungefähr ~ 35–45 meV [21]. Da jedoch bei InGaAs-Nanodrähten die Oberflächenbandbiegung mit zunehmender Ga-Zusammensetzung signifikant verringert wird, würde diese Energiedifferenz gleichzeitig abnehmen, und dann werden Elektronen weniger nahe der Nanodrahtoberfläche eingeschlossen und Löcher werden weniger in der Nanodrahtmitte lokalisiert. Daher gehen wir davon aus, dass das PL-Spektrum der blanken InGaAs-Nanodrähte eine Mischung aus oberflächenbezogener Emission und Emission nahe der Bandkante ist. Aufgrund der räumlichen Trennung ist die oberflächenvermittelte Übergangswahrscheinlichkeit sehr gering. Darüber hinaus können die zahlreichen Oberflächenzustände durch den strahlungslosen Rekombinationsprozess zusätzliche Elektron-Loch-Paare verbrauchen. Somit ist die PL-Intensität der blanken InGaAs-Nanodrähte extrem schwach.
Die Situation würde sich jedoch ändern, wenn InGaAs-Kern-Nanodrähte mit einer InP-Hülle beschichtet werden. Da Oberflächenzustände von Kernnanodrähten effektiv entfernt werden und die InP−Schale als Energiebarriere wirkt, die die Ladungsträger effektiv auf die InGaAs−Nanodrähte begrenzt, wird ein direkter Übergang nahe der Bandkante mit höherer Übergangswahrscheinlichkeit dominant, was durch die signifikante Verbesserung der PL−Emission bestätigt wird. Darüber hinaus zeigt das PL-Spektrum von InGaAs/InP-Kern-Schale-Nanodrähten aufgrund der Eliminierung der oberflächenbezogenen Emission eine schmalere Halbwertsbreite (FWHM) im Vergleich zu den blanken InGaAs-Nanodrähten. Wie bereits erwähnt, sollte wegen der hier erhaltenen verringerten Oberflächenbandverbiegung für InGaAs-Nanodrähte die Energiedifferenz zwischen der Emission nahe der Bandkante und der oberflächenbezogenen Emission weit niedriger sein als die hier erhaltenen ~50 meV. Abgesehen von diesem Effekt vermuten wir daher, dass die Dehnung der Hauptgrund für die beobachtete Blauverschiebung ist. Da die InP-Schale kohärent auf dem InGaAs-Kern ohne Fehlanpassungsversetzungen an der Grenzfläche gewachsen ist, steht der InGaAs-Kern unter Druckspannung, die eine Bandlückenverbreiterung des InGaAs-Kern-Nanodrahts induzieren und die Blauverschiebung der PL-Peak-Emission erklären kann [ 32, 33]. Daher sollte durch Aufwachsen der InP-Beschichtungsschicht die PL-Spitzenenergie von InGaAs-Nanodrähten eine Blauverschiebung aufweisen und ihre PL-Emissionsintensität kann stark verbessert werden.
Abbildung 6a zeigt normalisierte PL-Spektren von InGaAs/InP-Kern-Schale-Nanodrähten mit unterschiedlichem Xv bei 77 K. Die PL-Peakenergie zeigt eine kontinuierliche Blauverschiebung (von ~ 0.78 eV bis ~ 0.86 eV) mit einer Zunahme von Xv im Bereich von 30 bis 40 %. Darüber hinaus weist die Emission der InGaAs/InP-Kern-Schale-Nanodrähte aus den PL-Messungen bei Raumtemperatur ihren Höhepunkt im Wellenlängenbereich von 1.49–1.68 μm auf, was eine minimale Leistungsdämpfung in der Glasfaserkommunikation (~ 1.55 μm-Bereich) aufweist. Abbildung 6b zeigt temperaturabhängige PL-Spektren für die InGaAs/InP-Kern-Schale-Nanodrahtprobe mit Xv = 40%, und der Einschub zeigt die entsprechende temperaturabhängige Verschiebung der PL-Peakenergie. Üblicherweise zeigt die Temperaturabhängigkeit der Lumineszenz in einkristallinem Schüttgut eine kontinuierliche Rotverschiebung mit steigender Temperatur gemäß der Varshni-Gleichung. Interessanterweise kann die Rotverschiebung aus dem Einschub in Abb. 6b nur im Temperaturbereich von 60–290 K beobachtet werden. Wenn die Temperatur unter 60 K liegt, bleibt die PL-Spitzenenergie fast unverändert. In Anbetracht der hohen Dichte an Strukturdefekten in den gewachsenen Nanodrähten vermuten wir, dass dieses Phänomen höchstwahrscheinlich durch lokalisierte Fallenzustände nahe der Bandkante verursacht wird [34]. Bei niedriger Temperatur wird die Emission von der Fallenunterstützung dominiert. Mit steigender Temperatur werden die eingefangenen Ladungsträger aus den Fallenzuständen niedrigerer Energie zur Bandkante angeregt. Daher folgt die PL-Spitzenenergie im Niedertemperaturbereich nicht der üblicherweise beobachteten kontinuierlichen Rotverschiebung mit der Temperatur und wird im Vergleich zur genauen Bandkante tendenziell unterschätzt.
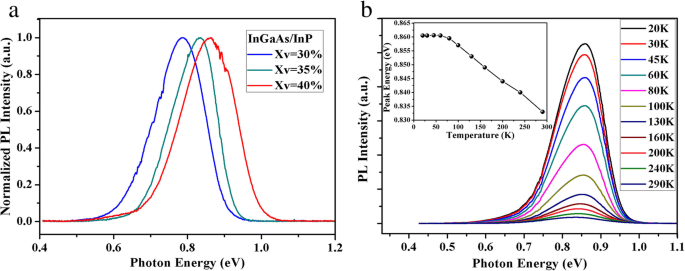
a Normalisierte PL-Spektren von InGaAs/InP-Kern-Schale-Nanodrähten mit unterschiedlichem Xv (Xv = 30%, 35% und 40%) bei 77 K. b Temperaturabhängige PL-Spektren von InGaAs/InP-Kern-Schale-Nanodrähten mit Xv = 40%. Eingefügt in b zeigt eine entsprechende temperaturabhängige Verschiebung der PL-Spitzenenergie
Schlussfolgerungen
Zusammenfassend haben wir das Wachstum und die Charakterisierung von InGaAs/InP-Kern-Schale-Nanodrähten auf Si-(111)-Substraten mittels MOCVD vorgestellt. Die Spannung an der Kern-Schale-Grenzfläche, die durch die große Gitterfehlanpassung zwischen den Kern- und Schalenmaterialien verursacht wird, hat einen starken Einfluss auf das Wachstumsverhalten der InP-Schale, was zu einem asymmetrischen Wachstum der InP-Schale um den InGaAs-Kern und sogar zu einer Verbiegung von die Nanodrähte. TEM-Messungen zeigten, dass die InP-Schale kohärent auf dem InGaAs-Kern ohne Fehlanpassungsversetzungen wuchs. Aus den PL-Messungen bei 77 K zeigt die PL-Peakintensität von InGaAs/InP-Kern-Schale-Nanodrähten eine 100-fache Verbesserung im Vergleich zu den blanken InGaAs-Nanodrähten aufgrund der Passivierung der Oberflächenzustände und der effektiven Ladungsträgerbegrenzung durch die InP-Beschichtung. Eine solche signifikante Emissionssteigerung der InP-beschichteten Nanodrähte ermöglicht es uns, die Emission sogar bei Raumtemperatur zu beobachten. Insgesamt erweitern die hier erzielten Ergebnisse unser Verständnis des Wachstumsverhaltens von verspannten Kern-Schale-Nanodrähten mit Heterostruktur und können die Grundlage für die Herstellung optoelektronischer Bauelemente auf Basis von InGaAs-Nanodrähten ebnen.
Abkürzungen
- BF:
-
Hellfeld
- CMOS:
-
Komplementärer Metalloxid-Halbleiter
- EDS:
-
Energiedispersive Spektroskopie
- FTIR:
-
Fourier-Transformations-Infrarot
- FWHM:
-
Volle Breite auf halbem Maximum
- LED:
-
Leuchtdiode
- MOCVD:
-
Metall-organische chemische Gasphasenabscheidung
- PL:
-
Photolumineszenz
- SAED:
-
Ausgewählte Bereichselektronenbeugung
- SEM:
-
Rasterelektronenmikroskopie
- TEM:
-
Transmissionselektronenmikroskopie
- TMGa:
-
Trimethylgallium
- TMIn:
-
Trimethylindium
- ZB:
-
Zinkblende
Nanomaterialien
- Materialwissenschaftler bringen Nanodrähten das Tanzen bei
- Nanofasern und Filamente für eine verbesserte Wirkstoffabgabe
- Herstellung und verbesserte katalytische Hydrierungsaktivität von Sb/Palygorskit (PAL)-Nanopartikeln
- Selbstkatalysiertes Wachstum von vertikalen GaSb-Nanodrähten auf InAs-Stämmen durch metallorganische chemische Gasphasenabscheidung
- Optische und elektrische Eigenschaften von Silizium-Nanodrähten, die durch stromloses Ätzen hergestellt wurden
- Synthese und Lumineszenzeigenschaften wasserlöslicher α-NaGdF4/β-NaYF4:Yb,Er Kern-Schale-Nanopartikel
- Effizientes und effektives Design von InP-Nanodrähten für maximale Sonnenenergiegewinnung
- Einfluss der erhöhten thermischen Stabilität der Trägerschicht aus Aluminiumoxid auf das Wachstum vertikal ausgerichteter einwandiger Kohlenstoffnanoröhren und ihre Anwendung in Nanofiltrationsmem…
- Bildungsmechanismen von InGaAs-Nanodrähten, die durch eine zweistufige chemische Gasphasenabscheidung auf einer festen Quelle hergestellt werden
- 5G und die Herausforderung des exponentiellen Datenwachstums



