Negativer differentieller Widerstandseffekt in Ru-basierten RRAM-Bauelementen, die durch Atomlagenabscheidung hergestellt wurden
Zusammenfassung
In dieser Arbeit werden Ru-basierte RRAM-Bausteine mit atomarer Schicht aus AlOy /HfOx Funktionsschicht hergestellt und untersucht. Während des Spannungseinstellungsprozesses wurde ein negatives differentielles Widerstandsverhalten (NDR) beobachtet, und sein physikalischer Ursprung wurde untersucht. Basierend auf dem physikalischen Verständnis des resistiven Schaltens wird angenommen, dass das gemessene NDR-Verhalten mit dem teilweise unipolaren Reset-Effekt in Verbindung steht, der auf die Rekombination zwischen Sauerstoffleerstellen und den thermisch freigesetzten Sauerstoffionen aus dem RuO2 Schnittstellenschicht. Die gemessenen elektrischen Eigenschaften und die Ergebnisse der Röntgenphotoelektronenspektroskopie (XPS) bestätigten die physikalische Interpretation.
Einführung
Als einer der vielversprechendsten aufkommenden nichtflüchtigen Speicher wurde der resistive Direktzugriffsspeicher (RRAM) ausführlich in Bezug auf Materialoptimierung, Leistungsverbesserung und Geräteintegration untersucht [1,2,3,4]. Aufgrund der signifikanten Vorteile wie einfacher Zellstruktur, schneller Betriebsgeschwindigkeit, geringer Leistungsaufnahme und unvergleichlichem Miniaturisierungspotenzial [5] wurde RRAM weit verbreitet in hirninspirierten neuromorphen Computern und rekonfigurierbarer Boolescher Logik eingesetzt [6,7,8,9 ,10] und weist auch ein großes Potenzial für Storage Class Memory (SCM)-Anwendungen auf [11]. Wie jedoch aus der International Roadmap for Devices and Systems 2017 (https://irds.ieee.org/images/files/pdf/2017/2017IRDS_ES.pdf) hervorgeht, sind Herausforderungen wie Skalierbarkeit, Gerätezuverlässigkeit und Prozesskompatibilität immer noch hinderlich Entwicklungen von RRAM. Daher ist die Konstruktion von CMOS-kompatiblen RRAM-Bauelementen mit überlegener Leistung von großer Bedeutung für Anwendungen, die auf der 1T1R-Struktur einer RRAM-Zelle basieren [12,13,14]. Laut einer früheren Studie [15] zeigt ein Ru-basiertes RRAM-Bauelement ein großes Potenzial im Vergleich zu Pt-basierten, während während eines Spannungseinstellungsprozesses ein negativer differentieller Widerstand (NDR) nachgewiesen wurde. Die mit resistivem Schalten einhergehenden NDR-Phänomene wurden in anderen RRAM-Strukturen untersucht, die hauptsächlich auf das Einfangen/Entfallen von elektronischen Ladungsträgern zwischen tief lokalisierten Zuständen, das durch implantierte Metallnanopartikel induziert wird [16, 17], oder die Akkumulation von Defekten, die die Neuinstallation des Übergangs verursachte, waren [18]. Während das Auftreten von NDR in einer Ru-basierten RRAM-Zelle unter großem Strom noch offen ist, wurde in dieser Arbeit die elektrische Leistung eines Ru-basierten RRAM-Bauelements bewertet, das durch Atomlagenabscheidung (ALD) hergestellt wurde. Basierend auf der Röntgen-Photoelektronenspektroskopie (XPS)-Charakterisierung und elektrischen Messungen mit unterschiedlichen Stimuli kann das NDR-Phänomen im Ru-basierten RRAM im Rahmen des leitfähigen Filamentmodells für Sauerstoffleerstellen erklärt werden.
Methoden
Das schematische Diagramm der Gerätestruktur und des hergestellten RRAM-Arrays sind in Fig. 1a bzw. b gezeigt. Das Ru/AlOy /HfOx /TiN RRAM-Bauelement wurde auf einem thermisch oxidierten 300-nm-SiO2 . hergestellt Substrat. Ein 80-nm-Ru-Dünnfilm wurde auf einer 20-nm-Ti-Adhäsionsschicht als untere Elektrode durch DC-Magnetron-Sputtern (Angstrom Engineering NEXDEP) unter Verwendung eines Ru-Metall-Targets abgeschieden. SiO2 durch plasmaunterstützte chemische Gasphasenabscheidung (PECVD) aufgewachsen, dient als Dielektrikum zum Isolieren von Elektroden und bildet die Durchkontaktierungen. Dann die Widerstandsschicht aus 2 nm AlOy und 3 nm HfOx wurde durch ein Atomlagenabscheidungssystem (PICOSUN R200) bei 300 °C mit Trimethylaluminium (TMA)- und Tetrakis[ethylmethylamino]hafnium (TEMAH)-Vorstufen abgeschieden. Danach wurde 80 nm TiN unter Verwendung eines Ti-Targets reaktiv gesputtert und geätzt, um die oberen Elektrodenmuster zu bilden. Ein weiteres Trockenätzen wurde ebenfalls durchgeführt, um die untere Elektrode für den elektrischen Kontakt freizulegen.
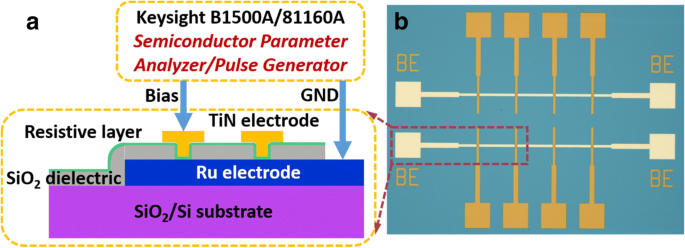
a Schematische Darstellung eines Ru-basierten Geräts. b Hergestelltes RRAM-Array
Die Elementanalyse wurde durch ein Röntgen-Photoelektronenspektroskopie-(XPS)-System (Thermo Scientific ESCALAB 250Xi) unter Verwendung der frischen Probe ohne eine obere Elektrode durchgeführt. Vor der Messung wurde eine Oberflächenreinigung mit Ar-Plasma vor der Messung durchgeführt, um den Einfluss von C zu eliminieren. Die Peakposition von Al 2p wurde zur Kalibrierung verwendet. Die elektrischen Messungen wurden bei Raumtemperatur mit einem Halbleiter-Analysegerät (Agilent B1500A) und einem Impulsfunktions-Arbiträrgenerator (Agilent 81160A) durchgeführt.
Ergebnisse und Diskussion
Die typischen IV-Eigenschaften von Ru-basierten RRAM-Bauelementen sind in Fig. 2a gezeigt. Nach dem Galvanisieren wurde eine positive Spannung (2,5 V) für den Setzprozess angelegt, um die Zelle mit einem Compliance-Strom von 1 mA vom hochohmigen Zustand (HRS) in den niederohmigen Zustand (LRS) zu schalten, um den dauerhaften Durchbruch während des Leitens zu verhindern Filament (CF)-Bildung. Nach dem eingestellten Übergang wurde eine negative Spannung (− 2,3 V) verwendet, um das Gerät mit einem allmählich abnehmenden Strom von LRS auf HRS umzuschalten. Um die Widerstandsvariabilität von Gerät zu Gerät zu bewerten, wurden 10 Ru-basierte RRAM-Zellen willkürlich ausgewählt. Wie in Abb. 2b dargestellt, zeigen die statistischen Ergebnisse die ausgezeichnete Gleichmäßigkeit von HRS und LRS mit einem Widerstandsfenster von mehr als 10 3 . , das ein vielversprechender Kandidat für NVM-basierte Logikanwendungen sein könnte. Im Vergleich zu den zuvor berichteten Pt-basierten Geräten [2] ist es erwähnenswert, dass während des Setzprozesses ein NDR-Phänomen beobachtet wurde, bei dem der Strom mit steigender Spannung (Set-Phase 1) in einer begrenzten Spannungsskala abnimmt, gefolgt von einem Anstieg zum Compliance-Strom (Set-Phase 2).

a DC-Eigenschaften. b Statistische HRS/LRS-Verteilungen von 10 Ru-basierten RRAM-Bausteinen
Die Zyklus-zu-Zyklus-Variabilität von Ru-basierten RRAM-Bauelementen wurde auch im Pulsmodus untersucht, um die Zyklengleichmäßigkeit zu untersuchen. Die Impulse für Set (2,4 V, 15 ns) und Impuls (− 3 V, 100 ns) werden verwendet, um das Gerät zwischen LRS und HRS mit einer Lesespannung von 0,1 V nach jedem Impuls umzuschalten. Wie in Abb. 3a gezeigt, weist das Gerät mit 1000 Zyklen eine gleichmäßige Verteilung mit Standardabweichungen von 379 Ω und 3 × 10 5 . auf Ω für LRS und HRS, was zu einem stabilen Speicherfenster von mehr als 100 führt. Auch nach 10 6 . tritt keine Verschlechterung der Ausdauer auf Schaltzyklen wie zuvor in Ref. beschrieben. [fünfzehn]. Darüber hinaus zeigt das Gerät auch eine ausgezeichnete Retentionseigenschaft, wie in Abb. 3b gezeigt. Sowohl der LRS- als auch der HRS-Widerstand halten einen konstanten Wert über 10 5 s bei 120 °C ohne Fehler.

a 1000 Ausdauerzyklen. b Hochtemperatur-Retentionsverhalten eines Ru/AlOy /HfOx /TiN RRAM-Gerät
Um das NDR-Phänomen zu erforschen, hat das I–V Kurven wurden sowohl im Spannungs-Sweep-Modus als auch im Strom-Sweep-Modus gemessen. Abbildung 4a zeigt den Bildungsprozess von fünf zufällig ausgewählten frischen RRAM-Zellen. Der Strom steigt allmählich an, gefolgt von einem Abbruch, der die Bildung von CF anzeigt, während kein NDR beobachtet wurde. Nach dem Galvanisieren werden Set-Operationen in verschiedenen Sweep-Modi in derselben Zelle durchgeführt, um die Stromänderung zu beobachten, wie in Abb. 4b gezeigt. Beim stromgesteuerten Gerät steigt der Strom langsam mit einem plötzlichen Spannungsabfall an, was den Widerstandsübergang von HRS zu LRS demonstriert. Dieses Verhalten unterscheidet sich von der spannungsgesteuerten Charakteristik, die auf die unterschiedliche stimuliinduzierte Joulesche Erwärmung über den CF zurückzuführen sein könnte. Darüber hinaus wurden aufeinanderfolgende Set/Reset-Operationen unter unterschiedlichen Vorspannungen durchgeführt, um den Zwischenwiderstandszustand im NDR-Bereich zu untersuchen. Während des Setzvorgangs wurde eine geeignete Stoppspannung von 1 V angelegt, wie in Abb. 4c gezeigt, um den Sweep am Talgrund zu beenden. Nach Wegnahme der Spannung wurde ein nichtflüchtiger Widerstandszustand erhalten, der ein unipolares Widerstandsschaltverhalten zeigte. Daher wird dieses NDR-Phänomen vorläufig einem zweiten Zurücksetzen des CF während des Setzvorgangs zugeschrieben.
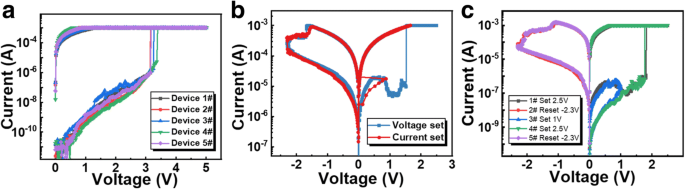
a Spannungsformung von fünf Ru-basierten RRAM-Bauelementen. b Spannungsgesteuerte und stromgesteuerte Set-Prozesse in derselben RRAM-Zelle. c Unvollständiger Setzvorgang mit der Stoppspannung am unteren Ende des Stromtals
Kombiniert mit den Messungen in verschiedenen Modi und Herstellungsprozessen von Bauelementen sowie den Eigenschaften von RuO2 , wurde der physikalische Ursprung des NDR-Phänomens vorgeschlagen, wie in Abb. 5 dargestellt. Eine frühere Studie [19, 20] legte nahe, dass die Erzeugung und Rekombination von elektronenverarmten Sauerstoffleerstellen (V o ) und Sauerstoffion (O 2− ) unter verschiedenen elektrischen Polaritäten sind für das konventionelle HfOx . verantwortlich -basierte bipolare RRAM-Bauelemente, die den Set-Phase-2- und Reset-Prozessen ähnlich sind. Im Gegensatz zum konventionellen Setzprozess findet jedoch ein zweiter Bruch des CF statt, der die Ru-Elektrode und den CF trennt und zum NDR führt. Im Allgemeinen dissoziieren die Sauerstoffatome in V o und O 2− im elektrischen Feld mit dem Driften des O 2− zur oberen Elektrode, wobei das V o um den CF zu bilden, der für den Elektronentransport verwendet wird. Aber aufgrund der Jouleschen Erwärmung durch das elektrische Feld wird das gebildete RuO2 Die Grenzschicht würde sich bei ~ 600 °C langsam zersetzen und O 2− . freisetzen die mit dem elektronenverarmten V . rekombinieren könnte o (V o 2+ ) in der Nähe der Ru-Elektrode (Set-Phase 1) [21], was zu einer Stromabnahme führt. Dieser Vorgang kann auch als partieller unipolarer Reset-Vorgang angesehen werden. Mit weiter steigender Spannung wird die CF zwischen TE und BE durch eine Akkumulation von V . rekonstruiert o wie in Setzphase 2 gezeigt, und RRAM-Zelle schaltet auf LRS um. Beim Reset laufen zwei Prozesse gleichzeitig ab:(1) die O 2− von der TiN-Elektrode freigesetzt, rekombinieren schnell mit dem positiv geladenen V o aufgrund des verbesserten Erfassungsabschnitts (2) die O 2- Driften in Richtung BE reagiert mit Ru und bildet das RuO2 . zurück Grenzschicht aufgrund der lokalen Jouleschen Erwärmung [22]. In diesem Zustand schaltet die RRAM-Zelle auf HRS.

Physikalische Prozesse des resistiven Schaltens in Ru-basierten RRAM. a NDR-Effekt (Set-Phase 1). b Gemeinsame SET-Prozesse (Set-Phase 2). c RESET-Vorgang des Gerätes
XPS-Analyse des RuO2 Grenzschicht, die während des Herstellungsprozesses des Bauelements gebildet wurde, unterstützt auch die vorgeschlagene Erklärung des NDR-Effekts. Abbildung 6a zeigt das vollständige XPS-Spektrum der Probe, das die Kernniveaus O 1s, Ru 3d, Al 2p und Hf 4f umfasst. Die anderen nicht markierten Peaks entsprechen alle diesen Elementen mit unterschiedlichen Elektronenbahnen. Die Anpassungskurve in Abb. 6b passt perfekt zu den experimentellen Daten und ist in vier Peaks unterteilt, die dem Ru 3d5/2 . entsprechen (280,01 eV für Ru und 280,75 eV für RuO2 ) und Ru 3d3/2 (284,3 eV für Ru und 285,26 eV für RuO2 ) Kernebenen, die die Koexistenz von Ru und RuO2 . demonstrieren im dünnen Film [23]. Die geringe Intensität von Ru 3d5/2 Peak zeigt an, dass das gebildete RuO2 Interface Layer ist wie erwartet sehr dünn.

XPS-Spektren von a Ru/AlOy /HfOx dünner Film und b Ru 3D-Kernebene. Das RuO2 dünner Film zwischen Ru und AlOy bildet sich während des ALD-Prozesses [18]
Schlussfolgerung
In dieser Studie wurde das CMOS-kompatible Ru/AlOy /HfOx /TiN RRAM-Gerät wurde hergestellt. Die hervorragende Schaltleistung wurde mit einem einheitlichen Widerstand von Gerät zu Gerät und einem großen Widerstandsfenster sowie einer guten Hochtemperatur-Halteeigenschaft erreicht. Basierend auf den elektrischen Messungen und der XPS-Analyse kann das NDR-Phänomen im Set-Prozess durch die Rekombination von Sauerstoffleerstellen und aus dem RuO2 . freigesetzten Sauerstoffionen erklärt werden Grenzschicht aufgrund der elektrisch induzierten Joule-Erwärmung.
Abkürzungen
- ALD:
-
Atomlagenabscheidung
- CF:
-
Leitfähiges Filament
- HRS:
-
Hochohmiger Zustand
- LRS:
-
Niederohmiger Zustand
- NDR:
-
Negativer Differenzwiderstand
- PECVD:
-
Plasmaverstärkte chemische Gasphasenabscheidung
- RRAM:
-
Resistiver Direktzugriffsspeicher
- SCM:
-
Speicherklasse Speicher
- XPS:
-
Röntgenphotoelektronenspektroskopie
Nanomaterialien
- Was ist der Hauteffekt?
- Advanced Atomic Layer Deposition Technologies für Mikro-LEDs und VCSELs
- Bipolar-resistive Schalteigenschaften von HfO2/TiO2/HfO2-RRAM-Bauelementen mit dreischichtiger Struktur auf Pt- und TiN-beschichteten Substraten, die durch Atomlagenabscheidung hergestellt wurden
- Grenzflächen-, elektrische und Bandausrichtungseigenschaften von HfO2/Ge-Stapeln mit in situ gebildeter SiO2-Zwischenschicht durch plasmaunterstützte Atomlagenabscheidung
- Die Wirkung von Sulfat-Anionen auf die ultrafeine Titandioxid-Keimbildung
- Die antibakteriellen hierarchischen Polyamid-6-ZnO-Nanofasern, hergestellt durch Atomlagenabscheidung und hydrothermales Wachstum
- Photokatalytische Eigenschaften von Co3O4-beschichteten TiO2-Pulvern, hergestellt durch plasmaunterstützte Atomlagenabscheidung
- Fermi-Level-Tuning von ZnO-Filmen durch Supercycling-Atomschichtabscheidung
- Auswirkungen von Ätzvariationen auf die Ge/Si-Kanalbildung und die Geräteleistung
- Temperatureinfluss auf die mechanischen Eigenschaften von elektrogesponnenen PU-Nanofasern



