Untersuchung der Nitrierung der Bandausrichtung an MoS2/HfO2-Grenzflächen
Zusammenfassung
Die Wirkung der Nitridierungsbehandlung auf die Bandausrichtung zwischen wenigen MoS2 .-Schichten und HfO2 wurde durch Röntgenphotoelektronenspektroskopie untersucht. Die Valenz-(Leitungs-)Band-Offsets von MoS2 /HfO2 mit und ohne Nitrierbehandlung wurden mit 2,09 ± 0,1 (2,41 ± 0,1) bzw. 2,34 ± 0,1 (2,16 ± 0,1) eV bestimmt. Die abstimmbare Bandausrichtung könnte der Mo-N-Bindungsbildung und der Oberflächenbandverbiegung für HfO2 . zugeschrieben werden ausgelöst durch Nitrierung. Diese Studie zum Energieband-Engineering von MoS2 /HfO2 Heteroübergänge können auch auf andere High-k-Dielektrika erweitert werden, um sie mit zweidimensionalen Materialien zu integrieren, um ihre elektronischen Geräte zu entwerfen und zu optimieren.
Hintergrund
Derzeit stoßen geschichtete Übergangsmetalldichalkogenide (TMDCs) aufgrund ihrer faszinierenden Eigenschaften für potenzielle Anwendungen in der modernen Elektronik und Optoelektronik auf großes Interesse [1, 2]. Insbesondere Molybdändisulfid (MoS2 ) hat als vielversprechendes Kanalmaterial für die weitere Skalierung über den 7-nm-Technologieknoten hinaus große Aufmerksamkeit auf sich gezogen [3, 4]. Strukturell ist das MoS2 Kristall besteht aus einer hexagonal angeordneten Mo-Ebene, die von zwei hexagonal angeordneten S-Ebenen eingeschlossen ist. Über die kovalent gebundenen S-Mo-S -Einheiten wurde eine dreieckige prismatische Anordnung gebildet [5, 6]. MoS2 besitzt eine schichtabhängige Bandlücke, die von einer direkten Bandlücke (1,8 eV) für einlagiges (SL) MoS2 . variiert auf eine indirekte Bandlücke (1.2 eV) für Bulk-MoS2 [7]. Im Gegensatz zu Graphen mit einer Bandlücke von Null motivierte die dickeabhängige Modulation der Bandlücken die Erforschung von MoS2 in optischen und elektrischen Geräten [3, 8]. Basierend auf der Physik von MoS2 , die Zustandsdichte von mehrlagigem MoS2 ist dreimal so hoch wie bei einlagigem MoS2 , was in der ballistischen Grenze zu hohen Antriebsströmen führt [8]. In diesem Zusammenhang ist MoS2 . mit mehreren Schichten kann erhebliche Vorteile für Transistoranwendungen bieten als SL MoS2 [3].
Auf der anderen Seite stoßen die elektronischen Bauelemente auf Basis traditioneller Siliziumdioxid-Dielektrika aufgrund ihrer niedrigen Dielektrizitätskonstante an die physikalische Grenze [9]. Um eine dünne äquivalente Oxiddicke (EOT) zu erhalten, ist es von entscheidender Bedeutung, High-k-Dielektrika mit MoS2 . zu integrieren . Bis heute wurden viele High-k-Dielektrika mit MoS2 . untersucht , einschließlich Al2 O3 , ZrO2 , HfO2 , und h-BN [10,11,12,13,14]. DiStefanoet al. die entsprechenden Leitungs- und Valenzband-Offsets von 3,3 ± 0,2 und 1,4 ± 0,2 eV für MoS2 . mit wenigen Schichten erhalten durch Oxiddampfabscheidung auf amorphem BN gezüchtet [13]. Taoet al. berichteten, dass der Leitungsband-Offset (CBO) für die Monoschicht MoS2 /Al2 O3 (ZrO2 ) wurde abgeleitet, dass der Heteroübergang 3,56 eV (1,22 eV) beträgt, während der Valenzband-Offset (VBO) 3,31 eV (2,76 eV) betrug [15]. Und ein CBO von 2,09 ± 0,35 eV und VBO von 2,67 ± 0,11 eV bei MoS2 /HfO2 Schnittstelle wurden von McDonnell et al. [12]. Unter diesen Gatedielektrika ist HfO2 wurde aufgrund seiner hohen Dielektrizitätskonstanten (k ∼ 20), seiner Kompatibilität mit Poly-SiGe-, TaN-Gates und polykristallinem Silizium-Gate als einer der vielversprechendsten Kandidaten angesehen [16]. HfO2 . jedoch hat eine schlechte thermische Stabilität, einen großen Leckstrom, eine hohe Oxidfallendichte, Grenzflächenfallendichte usw. [17]. Diese Einschränkungen haben zu umfangreichen Untersuchungen von Passivierungstechniken geführt, wie z. B. Grenzflächennitridierungs- oder Fluorierungsbehandlungstechnologien [18, 19]. In dieser Arbeit haben wir die Ausrichtung der Energiebänder von MoS2 . mit wenigen Schichten untersucht auf HfO2 Dielektrika mit und ohne Plasmanitrierung, bei denen der Effekt der Oberflächennitrierung durch Röntgenphotoelektronenspektroskopie (XPS) charakterisiert wurde.
Methoden
Das SiO2 (280 nm)/Si-Wafer wurde abwechselnd mit Aceton und Isopropanol durch Ultraschallreinigung alle 10 min gereinigt, gefolgt von einer Spülung mit entionisiertem Wasser und N2 trocken. Das mehrschichtige MoS2 Filme wurden auf SiO2 . abgeschieden /Si-Substrat durch chemische Gasphasenabscheidung (CVD) unter Verwendung von Vorläufern von MoO3 (0,08 mg, 99%, Alfa Aesar) und S-Pulver (1 mg, 99%) [20, 21]. Nach dem Wachstumsvorgang wird das MoS2 Film würde auf HfO2 übertragen /Si-Substrat nach dem Poly(methylmethacrylat)(PMMA)-Verfahren [22], wie in Abb. 1a dargestellt. Dabei wurde zunächst PMMA auf MoS2 . schleuderbeschichtet /SiO2 /Si-Proben als Stützschicht. Dann wurden die Proben in KOH-Lösung eingetaucht, um das SiO2 . wegzuätzen , wonach das MoS2 Schicht mit PMMA würde an der Spitze der Lösung schwimmen. Am Ende würde die PMMA-Schicht in Aceton aufgelöst, nachdem die Probe auf HfO2 . übertragen wurde /Si-Substrat. Das HfO2 Filme wurden auf dem Siliziumwafer durch Atomlagenabscheidung (ALD) bei einer Temperatur von 200 °C unter Verwendung von Hf [N (CH3 )(C2 H5 )]4 [tetrakis (ethylmethylamido) hafnium, TEMAH] und H2 O-Dampf als Vorstufen [23, 24]. Bei der Optimierung der Plasmabehandlungszeit wurde festgestellt, dass der Stickstoff nach 70 s Nitrierbehandlung durch SIMS-Messungen stark in das Oxid diffundieren würde, was die Oxidqualität stark verschlechtern würde. Während die Plasmabehandlungszeit 30 s beträgt, wurde aus den SIMS-Ergebnissen kein offensichtlicher N-Peak an der Oxidoberfläche beobachtet. Für die Kontrollprobe 50 s N2 Plasmabehandlung wurde auf HfO2 . implementiert /Si-Substrat bei einem Druck von 3 Pa vor dem MoS2 Transfer. Unter Plasmabedingungen beträgt die resultierende N-Dosis etwa 8,4 × 10 14 Atome/cm 2 geschätzt aus den Ergebnissen der Sekundärionen-Massenspektrometrie (SIMS). Und die Stickstoffkonzentration wurde basierend auf den XPS-Daten zu ungefähr 1,5% nach der Nitrierung berechnet. Vier Proben 1–4# wurden für XPS-Messungen vorbereitet:1# MoS mit wenigen Schichten2 Film auf SiO2 /Si-Substrat (wenige Schichten MoS2 ), 2# dickes HfO2 Film auf Si-Substrat (Bulk HfO2 ), 3# übertragenes MoS2 Film über gewachsenes HfO2 /Si-Substrat (wie gezüchtetes MoS2 /HfO2 Heteroübergang) und 4# übertragenes MoS2 Film auf N2 plasmabehandeltes HfO2 /Si-Substrat (nitriertes MoS2 /HfO2 Heteroübergang).
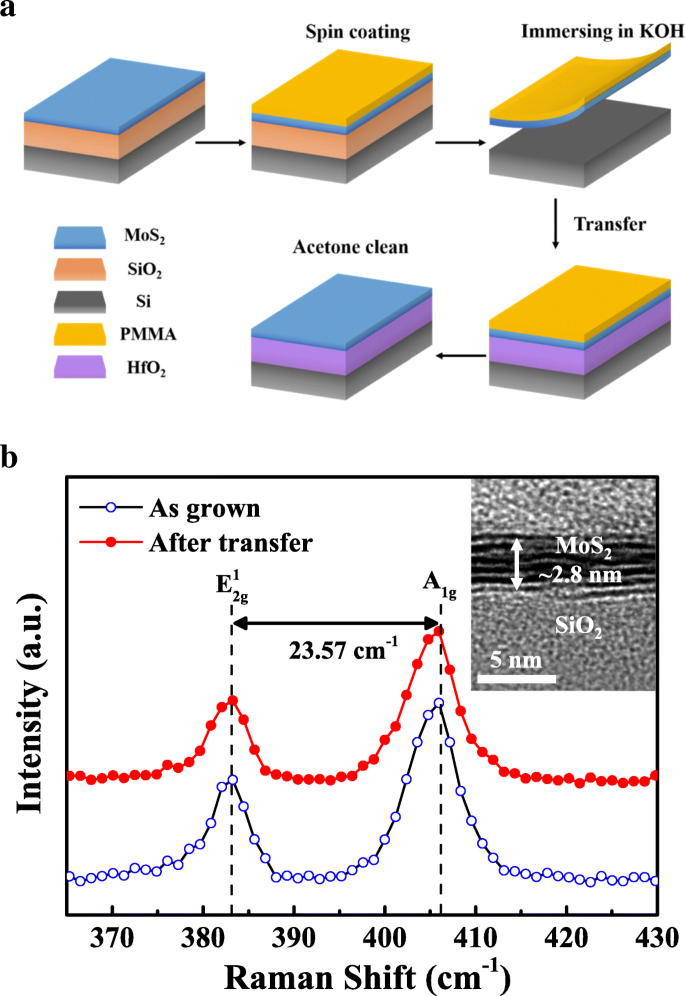
a Prozessablauf des PMMA-unterstützten Nasstransferverfahrens für das MoS2 /ALD-HfO2 Heterojunction-Bildung. b Entsprechende Raman-Spektren von gewachsenem und übertragenem MoS2 Film. Der Einschub ist die Querschnitts-Transmissionselektronenmikroskopie von MoS2 . im gewachsenen Zustand auf SiO2 /Si-Substrat
Ergebnisse und Diskussionen
RENISHAW inVia Raman-Spektroskopie wurde verwendet, um die Raman-Spektren von mehrschichtigem MoS2 . zu charakterisieren Film vor und nach dem Transfervorgang, wie in Abb. 1b dargestellt. Zwei Raman-Peaks sind bei etwa 382,86 cm −1 . zu sehen und 406,43 cm −1 , entsprechend der In-Plane (\( {E}_{2g}^1 \)) und Out-of-plane (A 1g ) Modi bzw. [25, 26]. Es wurde festgestellt, dass es in \( {E}_{2g}^1 \) und A . fast keine Raman-Verschiebung gibt 1g Modenfrequenzen nach dem Übertragungsprozess, was auf eine minimale Strukturänderung hinweist. Die Frequenzdifferenz (∆k ) zwischen \( {E}_{2g}^1 \) und A 1g Der Modus wurde auf etwa 23,57 cm −1 . geschätzt , bezeichnet etwa vier bis fünf Schichten von MoS2 Film [27]. Wie im Einschub von Fig. 1b gezeigt, ist die Dicke von MoS2 Der Film wurde mit einem hochauflösenden Transmissionselektronenmikroskop (HRTEM) auf ungefähr 2,8 nm verifiziert, was mit den oben erwähnten Raman-Spektren übereinstimmt. Darüber hinaus präsentierten wir SIMS-Tiefenprofile von übertragenem MoS2 Film auf nitriertem HfO2 /Si-Substrat. Die SIMS-Messung wurde auf einem ADEPT 1010 SIMS-Instrument von Physical Electronics mit einem Cs-Primärionenstrahl bei einer Energie von 1 keV durchgeführt, in dem positive Ionen gesammelt und eine Ladungskompensation durchgeführt wurde. Bei dieser SIMS-Messung wurde das Stickstoffelement quantifiziert, während die anderen Elemente (Mo, Hf und Si) nur als Schichtmarker gedacht und nicht quantifiziert wurden. Wie in Abb. 2a dargestellt, sind die Tiefenprofile für übertragenes MoS2 Film auf nitriertem HfO2 /Si-Substrat wurden durch SIMS bestimmt, wobei Signale der Hauptkomponenten, die durch Mo, N, Hf und Si repräsentiert werden, gegen die Tiefe aufgetragen sind. Die Ausbreitung von N in das HfO2 Schicht beobachtet, die durch die N-Injektion in die darunterliegende Schicht während Primärstrahlbombardierungen oder Plasmabehandlungen fasziniert sein könnte. Es ist auch erwähnenswert, dass Tiefenprofile in der Nähe der Oberflächenschicht aufgrund der Oberflächenverschmutzung und Oberflächeneffekte, z. B. der anormalen Intensität des N-Elements in der Nähe der Oberfläche, normalerweise kompliziert und bedeutungslos sind [28]. Das höhere Signal des N-Profils in der Nähe des HfO2 /Si-Grenzfläche könnte darauf zurückgeführt werden, dass der Stickstoff dazu neigt, zum HfO2 . zu diffundieren /Si-Grenzfläche, was zur Ansammlung von N in der Nähe der Grenzfläche führt [29]. Der Schweif von Mo in HfO2 Film könnte hauptsächlich durch Primärstrahlbeschuss in SIMS-Messungen verursacht werden [30]. 2b veranschaulicht die jeweiligen N 1s XPS-Spektren für Probe 3# und 4#; die hochintensiven Peaks für beide Heteroübergänge waren Mo 3p3/2 während für den nitrierten Heteroübergang ein Peak niedriger Intensität bei ~ 395.80 eV nachgewiesen wurde, was auf die Bildung einer Mo-N-Bindung hinweist [31].
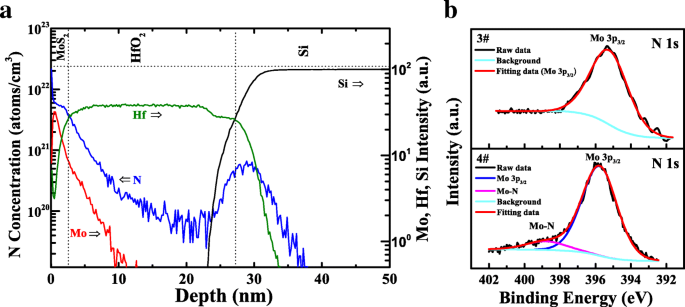
a SIMS-Tiefenprofile von übertragenem MoS2 Film auf nitriertem HfO2 /Si-Substrat. b N 1s XPS-Spektren für MoS2 /HfO2 Heteroübergänge mit bzw. ohne Nitrierbehandlung
Um die Bandausrichtungen zwischen MoS2 . mit wenigen Schichten zu erhalten und HfO2 mit und ohne Nitrierbehandlung wurden XPS-Messungen mit einer Stufe von 0,05 eV auf einem VG ESCALAB 220i-XL-System unter Verwendung einer monochromatischen Al Kα-Röntgenquelle (hν = 1486.6 eV) durchgeführt. Die konstante Durchgangsenergie wurde auf 20 eV eingestellt. Zusätzlich wurde der Standard C 1s (284,8 eV) zur Kalibrierung der Bindungsenergie (BE) verwendet [32]. Um VBO-Werte für MoS2 . auszuwerten /HfO2 Heteroübergänge, Mo 3d- und Hf 4f-Kernniveaus (CLs) wurden jeweils für die Proben 1–4# ausgewählt. Abbildung 3a zeigt den XPS-Schmalscan von Mo 3d- und Valenzbandspektren aus Probe 1# [33]. Somit ist die Bindungsenergiedifferenz (BED) zwischen Mo 3d5/2 Kernniveau und Valenzbandmaximum (VBM) für Probe 1# wurden mit 228,49 ± 0,1 eV berechnet. Abbildung 3b veranschaulicht die CLs von Hf 4f7/2 und VBM für Probe 2#; die entsprechende BED wurde mit 14,10 ± 0,1 eV bestimmt. Abbildung 3c zeigt die gemessenen XPS-Spektren von Mo 3d und Hf 4f CLs für MoS2 /HfO2 Heteroübergänge mit/ohne Nitrierbehandlung. Es wird darauf hingewiesen, dass die Mo 3d5/2 CL verschob sich von 229,45 ± 0,05 eV für Probe 3# auf 229,90 ± 0,05 eV für Probe 4#. Dies könnte darauf zurückgeführt werden, dass am MoS2 . eine Nitridierungsgrenzschicht eingebracht wurde /HfO2 Grenzfläche nach der Plasmabehandlung, was zu der oben erwähnten Mo-N-Bindung führt. Bei Vorhandensein von Mo-N-Bindungen trug der resultierende Ladungstransfer zwischen Mo- und N-Elementen zum gemessenen Mo 3d5/2 . bei CL-Verschiebung. Außerdem die Hf 4f7/2 CL von 17,40 ± 0,05 eV für Probe 3# wurde zu einer höheren Bindungsenergie von 17,60 ± 0,05 eV für Probe 4# verschoben, während O 1s ebenfalls eine Verschiebung von 0,20 eV zu einer höheren BED zeigte, wie in 3d gezeigt. Diese Peakverschiebungen implizierten die Abwärtsbiegung des Bandes am HfO2 Oberfläche, was so interpretiert werden könnte, dass das Stickstoffplasma Donor-ähnliche Defekte für HfO2 . induzierte [34]. Basierend auf der Kraut-Methode [35] ist die VBO (∆E V ) Werte können aus der folgenden Gleichung berechnet werden:
$$ \Updelta {E}_V=\left({E}_{\mathrm{Mo}\ 3{\mathrm{d}}_{5/2}}^{\mathrm{Mo}{\mathrm{S }}_2}-{E}_{\textrm{VBM}}^{\textrm{Mo}{\textrm{S}}_2}\right)-\left({E}_{\textrm{Hf}\ 4{\mathrm{f}}_{7/2}}^{{\mathrm{Hf}\mathrm{O}}_2}-{E}_{\mathrm{VBM}}^{{\mathrm{Hf }\mathrm{O}}_2}\right)-{\Delta E}_{\mathrm{CL}} $$ (1)wobei \( {E}_{\mathrm{Mo}\ 3{\mathrm{d}}_{5/2}}^{\mathrm{Mo}{\mathrm{S}}_2} \) und \( {E}_{\mathrm{VBM}}^{\mathrm{Mo}{\mathrm{S}}_2}\) sind Bindungsenergien von Mo 3d5/2 CL und VBM für MoS2 , \( {E}_{\mathrm{Hf}\ 4{\mathrm{f}}_{7/2}}^{{\mathrm{Hf}\mathrm{O}}_2} \) und \( {E}_{\mathrm{VBM}}^{{\mathrm{HfO}}_2} \) sind Bindungsenergien von Hf 4f7/2 CL und VBM für ALD-HfO2 , ∆E CL =\( {E}_{\mathrm{Mo}\ 3{\mathrm{d}}_{5/2}}^{\mathrm{Mo}{\mathrm{S}}_2}-{E}_ {\mathrm{Hf}\ 4{\mathrm{f}}_{7/2}}^{{\mathrm{Hf}\mathrm{O}}_2} \) bezieht sich auf die BED zwischen Mo 3d 5/2 und Hf 4f7/2 CLs für ALD-HfO2 /MoS2 Heterojunctions. Daher ist das ∆E V von MoS2 auf ALD-HfO2 mit und ohne Nitrierbehandlung wurden mit 2,09 ± 0,1 bzw. 2,34 ± 0,1 eV berechnet.

a XPS-Spektren von Mo 3d CL und Valenzband für das wenige Schichten MoS2 . b XPS-Spektren von Hf 4f CL und Valenzband für Bulk-HfO2 . XPS-Spektren von c Mo 3d, Hf 4f und d O 1s CLs für übertragene MoS2 Film auf Bulk-HfO2 mit/ohne Nitrierbehandlung
Um den Einfluss von N2 . zu beurteilen Plasmabehandlung am Leitungsband-Offset (CBO, ∆E C ) zwischen ALD-HfO2 und mehrschichtiges MoS2 , die Bandlücken von 5,9 ± 0,1 eV für HfO2 und 1,4 ± 0,1 eV für MoS2 wurden hier jeweils verwendet [7, 36]. Somit kann der CBO durch die folgende Gleichung erreicht werden:
$$ {\Updelta E}_C={E}_g^{{\mathrm{HfO}}_2}-{E}_g^{\mathrm{Mo}{\mathrm{S}}_2}-{\Updelta E }_V $$ (2)wobei \( {E}_g^{{\mathrm{HfO}}_2} \) und \( {E}_g^{\mathrm{Mo}{\mathrm{S}}_2} \) die Bandlücken von HfO . sind 2 und MoS2 , bzw. Nach Gl. (2), das ∆E C zwischen MoS2 und ALD-HfO2 mit und ohne Nitridierungsbehandlung wurden mit 2,41 ± 0,1 bzw. 2,16 ± 0,1 eV berechnet. Die entsprechenden Banddiagramme sind in Abb. 4 dargestellt. Bemerkenswerterweise liefern sowohl die VBO- als auch die CBO-Werte dieser beiden Heteroübergänge ausgezeichnete Elektronen- und Locheinschlüsse, was ihre Eignung für MoS2 . sicherstellt -basierte FETs [37]. Darüber hinaus hat der nitrierte Heteroübergang einen höheren CBO als der nicht nitrierte Heteroübergang, was für n-Kanal-FETs-Anwendungen besser ist.
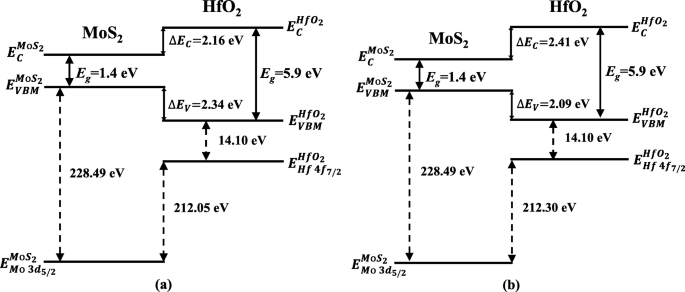
Banddiagramme von MoS2 /HfO2 Heteroübergang a ohne Nitrierbehandlung und b mit Nitrierbehandlung
Schlussfolgerungen
Zusammenfassend ergaben die XPS-Messungen, dass die Bandausrichtung am MoS2 /HfO2 Grenzfläche könnte durch Einführung von Nitrierung zu HfO2 . modifiziert werden Oberfläche vor dem Stapeln von MoS2 Film. CBO und VBO wurden mit 2,16 ± 0,1 und 2,34 ± 0,1 eV für das nicht nitrierte MoS2 . bestimmt /HfO2 Heteroübergang, während der CBO auf 2,41 ± 0,1 eV und der VBO auf 2,09 ± 0,1 eV für das nitrierte MoS2 . verändert wurde /HfO2 Heteroübergang bzw. An der Grenzfläche wurde eine Nitridierungsgrenzflächenschicht eingeführt, die zur Bildung der Mo-N-Bindung führte. Darüber hinaus könnte das Stickstoffplasma Donor-ähnliche Defekte induzieren, die zu einer Verbiegung der Oberflächenbande für HfO2 . führen . Auf diese Weise würde die Grenzflächen-Bandausrichtungstechnik vielversprechende Wege zur flexiblen Gestaltung und Optimierung moderner Elektronik bieten.
Verfügbarkeit von Daten und Materialien
Die Datensätze, die die Schlussfolgerungen dieses Manuskripts unterstützen, sind im Manuskript enthalten.
Abkürzungen
- ALD:
-
Atomlagenabscheidung
- BE:
-
Bindungsenergie
- BETT:
-
Bindungsenergiedifferenz
- CBO:
-
Leitungsband-Offset
- CL:
-
Kernstufe
- Lebenslauf:
-
Chemische Gasphasenabscheidung
- FET:
-
Feldeffekttransistor
- HfO2:
-
Hafniumoxid
- HRTEM:
-
Hochauflösendes Transmissionselektronenmikroskop
- MoS2 :
-
Molybdändisulfid
- PMMA:
-
Poly(methylmethacrylat)
- SIMS:
-
Sekundärionen-Massenspektrometrie
- SL:
-
Einschichtig
- TEMAH:
-
Tetrakis (ethylmethylamido) hafnium
- TMDC:
-
Übergangsmetalldichalkogenid
- VBM:
-
Valenzband-Maximum
- VBO:
-
Valenzband-Offset
- XPS:
-
Röntgenphotoelektronenspektroskopie
Nanomaterialien
- Einführung in die Terahertz-Band
- MoS2 mit kontrollierter Dicke für die elektrokatalytische Wasserstoffentwicklung
- Grenzflächen-, elektrische und Bandausrichtungseigenschaften von HfO2/Ge-Stapeln mit in situ gebildeter SiO2-Zwischenschicht durch plasmaunterstützte Atomlagenabscheidung
- Temperaturabhängige Kristallisation von MoS2-Nanoflocken auf Graphen-Nanoblättern für die Elektrokatalyse
- Großer seitlicher photovoltaischer Effekt bei MoS2/GaAs-Heterojunction
- Vorspannungsabhängige Photoempfindlichkeit von mehrschichtigen MoS2-Phototransistoren
- Die Hauptkomponenten der Bandsägemaschinen
- Wie wähle ich die Sägegeschwindigkeit?
- Die leistungsstarke Metallbandsäge
- Einführung des vertikalen Bandsägewerks



