Untersuchungen zu den optischen Eigenschaften von InGaN/GaN-Mehrfachquantenquellen mit unterschiedlicher Dicke der GaN-Deckschicht
Zusammenfassung
Drei InGaN/GaN-MQWs-Proben mit unterschiedlicher Dicke der GaN-Deckschicht wurden durch metallorganische chemische Gasphasenabscheidung (MOCVD) gezüchtet, um die optischen Eigenschaften zu untersuchen. Wir haben festgestellt, dass eine dickere Deckschicht die Verdampfung der In-Zusammensetzung in der InGaN-Quantentopfschicht wirksamer verhindert. Darüber hinaus wird der quantenbegrenzte Stark-Effekt (QCSE) mit zunehmender Dicke der GaN-Deckschicht verstärkt. Darüber hinaus konzentrieren wir uns im Vergleich zu den Elektrolumineszenz-Messergebnissen auf den Unterschied von Lokalisierungszuständen und Defekten in drei Proben, die durch unterschiedliche Kappendicken induziert werden, um die Anomalien bei Raumtemperatur-Photolumineszenzmessungen zu erklären. Wir haben festgestellt, dass eine zu dünne GaN-Deckschicht die Inhomogenität der Lokalisierungszustände in der InGaN-QW-Schicht verschlimmert und eine zu dicke GaN-Deckschicht mehr Defekte in der GaN-Deckschicht erzeugt.
Einführung
Die InGaN/GaN-Mehrfachquantentopfstruktur (MQWs) wird häufig in sichtbaren Licht emittierenden Dioden (LEDs) und Laserdioden (LDs) als aktiver Bereich verwendet und hat großen Erfolg erzielt [1,2,3,4]. Die Verbesserung der Qualität von InGaN/GaN-MQWs ist technologisch wichtig, um Hochleistungs-LEDs und LDs auf GaN-Basis zu realisieren. In früheren Forschungen wurde festgestellt, dass hochtemperaturgewachsene GaN (HT-GaN)-Quantenbarrieren (QBs) vorteilhaft sind, um die Kristallqualität und Lichtstärke von InGaN/GaN-Quantentöpfen zu verbessern [5, 6]. Aufgrund der schwachen In-N-Bindungsstärke ist die Wachstumstemperatur der InGaN-Quantentrog-(QWs)-Schicht im Allgemeinen niedriger als die der GaN-QBs, um einen hohen In-Gehalt zu erhalten. Dies kann dazu führen, dass die Indiumatome während des Wachstums von GaN QB bei höherer Temperatur aus InGaN QW verdampfen. Das Einfügen einer bei niedriger Temperatur gewachsenen GaN-Kappenschicht (LT-GaN-Kappenschicht) zwischen InGaN QW und GaN QB reduziert nachweislich die Desorption der In-Zusammensetzung, was die Gleichmäßigkeit der Dicke der InGaN-QW-Schicht und die Verteilung der In-Zusammensetzung verbessern kann [7,8,9]. Wenn jedoch die Wachstumstemperatur der GaN-Deckschicht abnimmt, wird die Migrationsfähigkeit der Adatome schwächer, was zu einer Verschlechterung der GaN-Materialien führt. Darüber hinaus wird berichtet, dass die Anzahl der Defekte mit zunehmender Dicke der bei niedriger Temperatur gewachsenen GaN-Deckschicht zunimmt, was einer Verbesserung der Gleichmäßigkeit der Indiumatomverteilung und der Lichtintensität von InGaN-Quantentöpfen nicht zuträglich ist [10]. Viele frühere Berichte konzentrierten sich nicht auf die Wirkung von Lokalisierungszuständen auf die Lumineszenzeigenschaften im aktiven Bereich mit verschiedenen Dicken der GaN-Kappen. In dieser Arbeit verwenden wir Röntgenbeugung (XRD), Elektrolumineszenz (EL) und Photolumineszenz (PL), um den Einfluss der bei niedriger Temperatur gewachsenen GaN-Deckschichtdicke auf die Struktur und die Lumineszenzeigenschaften von InGaN/GaN . zu beschreiben MQWs und beschreiben detailliert die Rolle von Lokalisierungszuständen in Lumineszenzeigenschaften durch temperaturabhängige PL-Experimente.
Methoden
Drei InGaN/GaN-MQWs-Proben wurden auf dem Saphirsubstrat der c-Ebene durch metallorganische chemische Gasphasenabscheidung (MOCVD) aufgewachsen. Alle Proben enthalten die gleichen Strukturen, bestehend aus einer undotierten GaN-Pufferschicht (1,2 µm), einer Si-dotierten n-GaN-Schicht (1 µm), einem aktiven Zweiperioden-InGaN/GaN-MQW-Bereich und einem Mg-dotierten p-GaN Schicht (40 nm). Beim Wachsen des aktiven InGaN/GaN-Bereichs waren die Wachstumsbedingungen der InGaN-QWs untereinander identisch; eine dünne LT-GaN-Deckschicht wurde bei der gleichen Temperatur wie InGaN QW (710 °C) aufgewachsen, um das Verdampfen von Indium zu verhindern, und die Wachstumszeit der LT-GaN-Deckschicht betrug 150 s, 300 s und 500 s für Probe A, B bzw. C; und dann wurde die Wachstumstemperatur von GaN QB auf 810 °C erhöht, um die Materialqualität von GaN QB zu verbessern, und die Wachstumszeit von HT-GaN QB war für diese Proben identisch. Röntgenbeugung (XRD) wurde verwendet, um die strukturellen Parameter dieser drei Proben zu bestimmen. Elektrolumineszenz (EL) und Raumtemperatur-Photolumineszenz (PL) wurden durchgeführt, um die optischen Eigenschaften der aktiven Regionen zu charakterisieren.
Die EL-Spektren wurden mit dem hochauflösenden Spektrometer Ocean Optics HR2000 bei Gleichstrom (DC) gemessen, wobei die Ausgangsleistung unter Verwendung einer Si-Photodiode erfasst wird und die spektrale EL-Spitzenenergie und FWHM durch einen Monochromator und eine Photomultiplier-Röhre erfasst werden. Für die PL-Messung ist ein λ =325 nm Dauerstrich-He-Cd-Laser wurde als Anregungsquelle mit einer einfallenden optischen Leistung von 3 mW und einer Punktgröße von 0,5 mm 2 . verwendet . Temperaturabhängige PL-Messungen von 30 K bis 300 K wurden aufgezeichnet, um die Wirkung von Lokalisierungszuständen auf die Lumineszenzeigenschaften zu analysieren, indem ein 405 nm GaN-Halbleiterlaser mit 5 mW Emissionsleistung als Anregungsquelle verwendet wurde. Die Probe wurde mit frei fließendem flüssigem Helium gekühlt und für die temperaturabhängigen Messungen wurde ein geschlossener Kühlkreislauf von CTI Cryogenics verwendet.
Ergebnisse und Diskussionen
1a zeigt die Beugungsmuster der (0002)-Ebene, die durch einen ω-2θ-Scan für diese Proben aufgenommen wurden. Die Satellitenpeaks dieser Proben sind deutlich zu sehen, was darauf hindeutet, dass in diesen MQWs eine feine periodische Struktur und eine scharfe Grenzfläche vorhanden sind. Wir verwenden SmartLab Studio II und das Global Fit-Programm (das eine fortschrittliche parallele Temperungsbasis-Anpassungsmethode bietet, um die vom SmartLab-Diffraktometer erzeugten Daten zu analysieren), um die durchschnittliche In-Zusammensetzung und die QB- und QW-Dicke zu erhalten, wie in Tabelle 1 gezeigt gesehen, dass die In-Zusammensetzung in der QW mit zunehmender Dicke der LT-GaN-Deckschicht zunimmt, was darauf hinweist, dass eine dickere Deckschicht die Verdampfung der In-Zusammensetzung wirksamer verhindert. Abbildung 1b zeigt die reziproke Raumabbildung (RSM) von Probe C. Der GaN-Hauptpeak und die Satellitenpeaks liegen auf einer Linie, was darauf hindeutet, dass die QW-Schichten mit dem höchsten In-Gehalt in allen Proben vollständig belastet sind. Daher sollte der Einfluss des piezoelektrischen Felds auf die Leuchteigenschaften berücksichtigt werden.
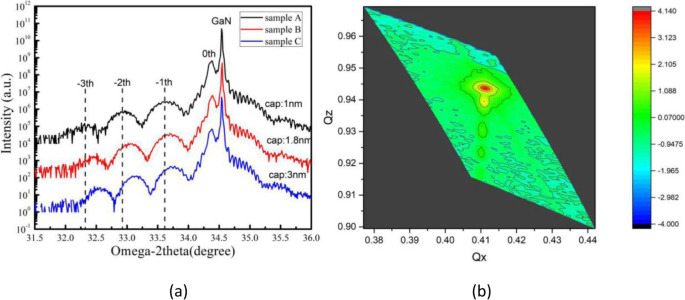
a XRD ω-2θ Scankurven auf GaN (0002) Plan für die Proben A, B und C. b Reziproke Raumabbildung der Probe C
Abbildung 2 zeigt die EL-Spektren der Proben A, B und C bei einem Strom von 5 mA. Die Spitzenwellenlänge beträgt 453,6 nm, 456,3 nm und 466,7 nm für die Proben A, B bzw. C. Aus den Ergebnissen von XRD-Messungen geht hervor, dass mit zunehmender Dicke der LT-GaN-Deckschicht die erhöhte In-Zusammensetzung in QWs die Rotverschiebung der EL-Spitzenenergie induziert. Wir fanden auch, dass die EL-Intensität mit zunehmender Dicke der LT-GaN-Deckschicht abnimmt. Es ist bekannt, dass eine dickere GaN-Barriereschicht (die Gesamtdicke von LT-GaN-Deckschicht und HT-GaN-QB) den Abstand der Löcher von p-GaN zum aktiven Bereich erhöht, was zu einer Verringerung der Lochinjektionseffizienz führt, was zu zu einer Abnahme der EL-Intensität [11, 12]. Darüber hinaus verstärkt die Zunahme der In-Zusammensetzung das piezoelektrische Feld in der InGaN-QW-Schicht, so dass die Neigung des Energiebandes verstärkt wird, was zu einer Rotverschiebung der Spitzenemission und einer verringerten Lichtausbeute führt, die als quantenbegrenztes Stark . bekannt ist Wirkung (QCSE) [13,14,15]. Um den Einfluss von QCSE auf EL zu verifizieren, sind die Spitzenenergie und die FWHM der EL-Änderung bei unterschiedlicher Injektion in Abb. 3 gezeigt. Wenn der Injektionsstrom zunimmt, kann die Blauverschiebung der Emissionsspitzenenergie dem Bandfülleffekt und QCSE . zugeschrieben werden durch den Elektronen-Screening-Effekt kompensiert [16,17,18]. Da Probe C mit der meisten In-Zusammensetzung den tiefsten Potentialtopf und das stärkste piezoelektrische Feld aufweist, sind der Bandfülleffekt und der Ladungsabschirmungseffekt am signifikantesten, sodass die Blauverschiebung der EL-Spitzenenergie für Probe C am größten ist (166 meV .). ). Der Bandfülleffekt und Ladungsabschirmungseffekt in Probe A ist am schwächsten, so dass die Bandlückenschrumpfung aufgrund des thermischen Effekts bei hohem Injektionsstrom (50 mA) allmählich dominant wird, was zu einer Rotverschiebung der Spitzenenergie führt. Für Probe A nimmt die FWHM mit zunehmendem Injektionsstrom zu, wie in Fig. 3b gezeigt, was darauf hinweist, dass die durch den Bandfülleffekt induzierte EL-Spektrumverbreiterung immer dominant ist. Es wurde berichtet, dass die Ladungsabschirmung des polarisierten elektrischen Felds in den InGaN-QWs eine Verengung der spektralen EL-Bandbreite mit zunehmendem Injektionsstrom verursacht [19]. Daher ist für die Proben B und C der Bandfülleffekt bei niedrigeren Injektionsströmen signifikant und das EL-Spektrum wird verbreitert. Wenn der Injektionsstrom weiter ansteigt, übernimmt allmählich die Ladungsträgerabschirmung des Prozesses des polarisierten elektrischen Felds, so dass die FWHM abnimmt. Darüber hinaus haben wir auch festgestellt, dass der Strom, der dem Wendepunkt der FWHM vom Ansteigen zum Abfallen für die Proben B und C entspricht, etwa 10 mA bzw. 20 mA beträgt, was auch bedeutet, dass das piezoelektrische Feld in Probe C am stärksten ist.
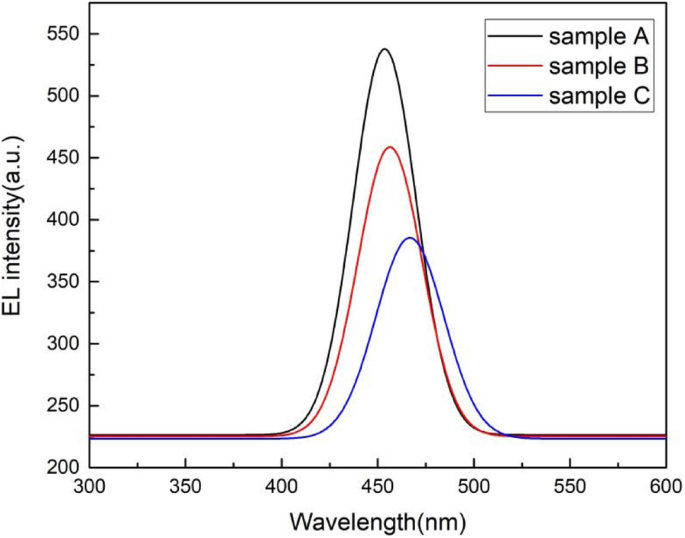
EL-Spektren der Proben A, B und C unter 5 mA Strom
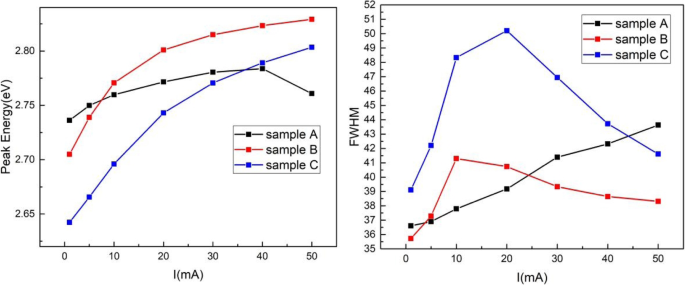
(a ) EL-Spitzenenergie und (b ) EL volle Breite beim halben Maximum (FWHM) als Funktion des Injektionsstroms für die Proben A, B und C
Abbildung 4a zeigt die PL-Spektren bei Raumtemperatur für die Proben A, B und C bei 5 mW 405 nm GaN-Halbleiterlaser-Anregungsleistung. Die Spitzenwellenlänge beträgt 473,1 nm, 472,9 nm und 478,2 nm für die Proben A, B bzw. C. Da die PL-Intensität der Proben B und C in Fig. 4a relativ schwach ist, verwenden wir auch einen 325-nm-He-Cd-Laser als Anregungsquelle, um das Photolumineszenz-Experiment durchzuführen. Die experimentellen PL-Ergebnisse in Fig. 4a und b stimmen miteinander überein, wodurch die Unsicherheit der experimentellen Ergebnisse aus Fig. 4a eliminiert wird. Verglichen mit den EL-Messergebnissen aus Fig. 2 fanden wir in Fig. 4a einige Anomalien:(1) Probe A enthält weniger In-Zusammensetzung als Probe B, aber die Spitzenwellenlänge von Probe A ist etwas länger als Probe B; (2) die PL-Intensität von Probe B und C ist einander ähnlich, und die Lichtstärke von Probe A ist viel höher als die von Probe B und C. Um die relevanten Gründe für die Erklärung dieser Anomalien herauszufinden, wird der temperaturabhängige PL (TDPL ) wurde für drei Proben durchgeführt, und die PL-Spitzenenergie als Funktion der Temperatur ist in Fig. 5 gezeigt. Bei Probe B nimmt die Emissions-Spitzenenergie monoton mit steigender Temperatur ab. Im Allgemeinen führt eine zunehmende temperaturinduzierte Bandlückenschrumpfung zu einer Rotverschiebung der Emissionsenergie. Es gibt jedoch eine bemerkenswerte Blauverschiebung in Probe A, wenn die Temperatur von 70 K auf 190 K ansteigt. Die thermische Umverteilung lokalisierter Exzitonen wurde eingeführt, um die abnormale Emissionsblauverschiebung in TDPL zu erklären:Mit steigender Temperatur wurden lokalisierte Exzitonen thermisch aktiviert und thermischen Transfer von potentiellen Minima von Lokalisierungszuständen in einen höheren Energiezustand [5, 20, 21]. Für Probe C ist die PL-Spitzenenergie im Bereich von 50 K bis 175 K fast unverändert, was darauf hindeutet, dass sich der Bandlückenschrumpfungseffekt und der Exzitonen-Lokalisierungseffekt gegenseitig aufheben.
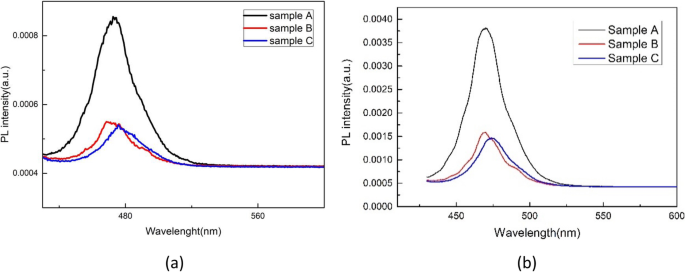
PL-Spektren bei Raumtemperatur für die Proben A, B und C unter Verwendung eines 405-nm-GaN-Halbleiterlasers (a ) und 325 nm He-Cd-Laser (b ). Die Spitzenwellenlänge beträgt 473,1 nm, 472,9 nm und 478,2 nm, erhalten aus (a ) und 470,5 nm, 470,1 nm und 475,2 nm erhalten aus (b ) für die Proben A, B bzw. C
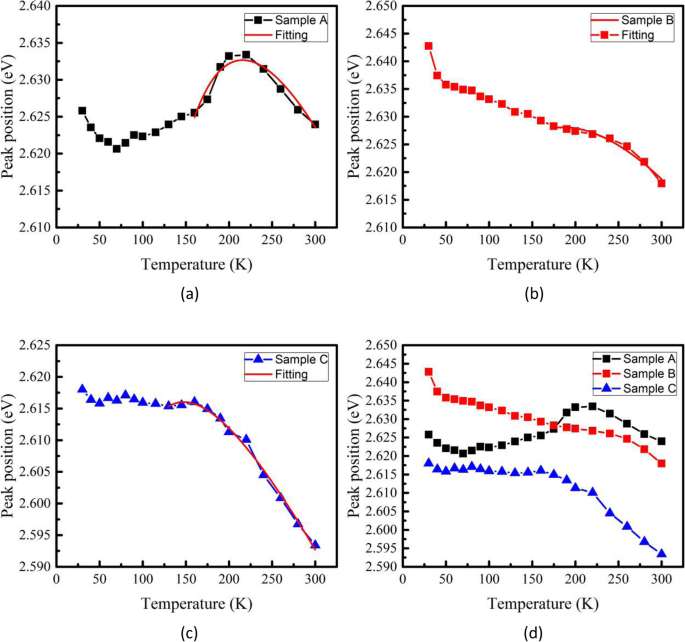
Die roten Linien in (a ), (b ) und (c ) sind Anpassungskurven basierend auf Gl. (1) und der Anpassungsparameter σ 36,96 meV, 18,89 meV und 23,77 meV für die Proben A, B bzw. C beträgt. (d ) Zeigt die experimentellen Daten der PL-Spitzenenergie als Funktion der Temperatur
Unter Berücksichtigung des Exzitonen-Lokalisierungseffekts kann das Bandschwanzmodell auf den folgenden Ausdruck revidiert werden, um die temperaturabhängige Emissionsspitzenenergie zu beschreiben [22, 23]:
$$ {E}_0(T)={E}_0(0)\hbox{-} \frac{\alpha {T}^2}{T+\beta}\hbox{-} \frac{\sigma^2 }{{\textrm{k}}_BT} $$ (1)wo E 0 (0) ist die Bandlücke bei T =0, α und β sind Varshinis Parameter, k B ist die Boltzmann-Konstante. Der dritte Begriff σ ist die Standardabweichung der lokalisierten Verteilung und beschreibt den Grad des Lokalisierungseffekts, d. h. ein größerer Wert von σ bedeutet eine stärkere Inhomogenität der Lokalisierungszustände. Die Fluktuation der In-Zusammensetzung in InGaN kann der Hauptgrund für die Bildung von Bandschweifen sein. Die Zustände in den Bandenden werden bei der minimalen lokalen potentiellen Energie gebildet, ähnlich wie bei Quantenpunkten. Die Rekombination von Elektron-Loch-Paaren in diesen selbstgebildeten Quantenpunkten kann als lokalisierte Exzitonen-Rekombination angesehen werden [24, 25]. Bei tiefen Temperaturen ist das Modell wegen starker Entartung und möglicher Abweichung vom Quasi-Gleichgewicht nicht anwendbar [20]. Der Anpassungsparameter σ 36,96 meV, 18,89 meV und 23,77 meV für die Proben A, B bzw. C beträgt, was impliziert, dass die Lokalisierungszustände von Probe A mit der dünnsten Deckschicht am inhomogensten sind. Im Allgemeinen stammen Lokalisierungszustände von In-reichen Clustern mit unterschiedlichen Größen und der Fluktuation der QW-Dicke in InGaN-Legierungen. Daher gehen wir vernünftigerweise davon aus, dass eine dünnere LT-GaN-Deckschicht das Verdampfen von Indium nicht wirksam verhindern kann, wenn die Temperatur einer aufgewachsenen GaN-QB-Schicht erhöht wird. Der Prozess der zufälligen Verdampfung der Indiumzusammensetzung führt zu Schwankungen des In-Gehalts und der InGaN-QW-Dicke. Für Probe B ist die 1,8 nm dicke GaN-Deckschicht dick genug, um In vor Desorption zu schützen, um eine gleichförmigere InGaN-QW-Schicht zu bilden. Inhomogene Lokalisierungszustände behalten normalerweise einen tieferen Potentialzustand bei und führen zu einer Rotverschiebung der Emissionspeakenergie. Aus diesem Grund ist die Spitzenwellenlänge von Probe A länger als die in Abbildung 4 beobachtete Probe B. Außerdem fördert eine Zunahme der In-Zusammensetzung in der InGaN-QW-Schicht auch die Bildung von großen In-Clustern, was erklärt, warum der Exzitonenlokalisierungseffekt in Probe C mit dem höchsten Indiumgehalt ist etwas stärker als Probe B.
Abbildung 6 zeigt die integrierte PL-Intensität als Funktion der Temperatur für Probe A und C, die durch den folgenden Ausdruck [5, 26] gut angepasst werden kann:
$$ I(T)=\frac{1}{1+{\sum}_{\mathrm{i}}{C}_i\exp \left(-\frac{E_i}{k_BT}\right)} $ $ (2)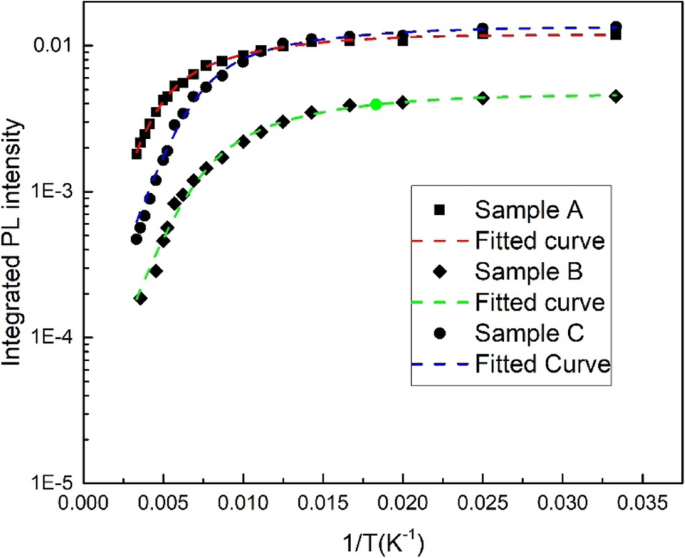
Integrierte PL-Intensität als Funktion der Umkehrtemperatur für die Proben A, B und C
wobei C ich eine Konstante ist, die der Dichte der nichtstrahlenden Rekombinationszentren entspricht, und E ich repräsentiert die Aktivierungsenergie von nichtstrahlenden Rekombinationszentren. Der Anpassungsparameter C ich und E ich wurden in Tabelle 2 gezeigt. Es ist bemerkenswert, dass die Photomultiplierspannung im Gitterspektrometer für Probe B während temperaturabhängiger PL-Messungen niedriger eingestellt wurde als die Proben A und C; daher ist die integrierte PL-Intensität von Probe B die niedrigste, aber sie beeinflusst die Anpassungsergebnisse nicht.
C 2 für Proben B und C sind größer als Probe A, was anzeigt, dass mehr Defekte in einer dickeren LT-GaN-Deckschicht gebildet werden. Es wurde beobachtet, dass die Defekte in der LT-Cap-Schicht mit zunehmender Dicke der LT-Cap-Schicht zunehmen [6, 10]. Der Einfluss von Defekten in der LT-GaN-Deckschicht neben dem Quantentopf auf die PL-Intensität ist signifikant, da die Elektronen- und Lochwellenfunktionen in die Barrieren eindringen. Die aktive Energie von 79,67 meV (E a2 für Probe A) bezieht sich auf die Emission von Löchern aus QWs, gefolgt von Einfangen durch Barrieredefekte und strahlungsloser Rekombination, die mit den Berichten von Olaizola [6] übereinstimmen. Wir haben auch die Mikro-PL-Bilder der Proben A, B und C verglichen, wie in Abb. 7 gezeigt. Die dunklen Flecken in Mikro-PL-Bildern können der strahlungslosen Rekombination in der aktiven InGaN/GaN-Region zugeschrieben werden. Im Vergleich zu Probe A können in den Proben B und C offensichtlich mehr große dunkle Flecken beobachtet werden, was darauf hinweist, dass in einer dickeren LT-GaN-Deckschicht mehr Defekte vorhanden sind. Im Allgemeinen wird nach der LT-Deckschicht ein thermisches Ausheilen durchgeführt, um die Indiumcluster in der InGaN-Schicht zu reduzieren und die Kristallqualität zu verbessern. Wenn die Deckschicht zu dick ist, wird der Effekt des thermischen Glühens abgeschwächt und die Bildung von mehr metallischen Indium-Ausscheidungen wird die Adatome der GaN-Deckschichtdiffusion behindern und mehr Defekte in die LT-Deckschicht einbringen. Das Auftreten von mehr Defekten und stärkerer QCSE in InGaN/GaN-MQWs mit einer dickeren LT-GaN-Deckschicht ist für die Verbesserung der Lumineszenzintensität nachteilig. Warum also ist die PL-Intensität von C mit B vergleichbar? Tatsächlich spielen auch Lokalisierungszustände eine wichtige Rolle bei der Verbesserung der Lichtausbeute. Träger können in lokalisierten Zuständen eingefangen und strahlend rekombiniert werden. Je stärker der lokalisierte Effekt von Exzitonen ist, desto mehr Ladungsträger werden nicht in Defekten eingefangen, was zu erklären scheint, dass die PL-Intensität der Proben B und C einander ähnlich ist, und die Lichtintensität von Probe A ist viel höher als die der Proben B und C.
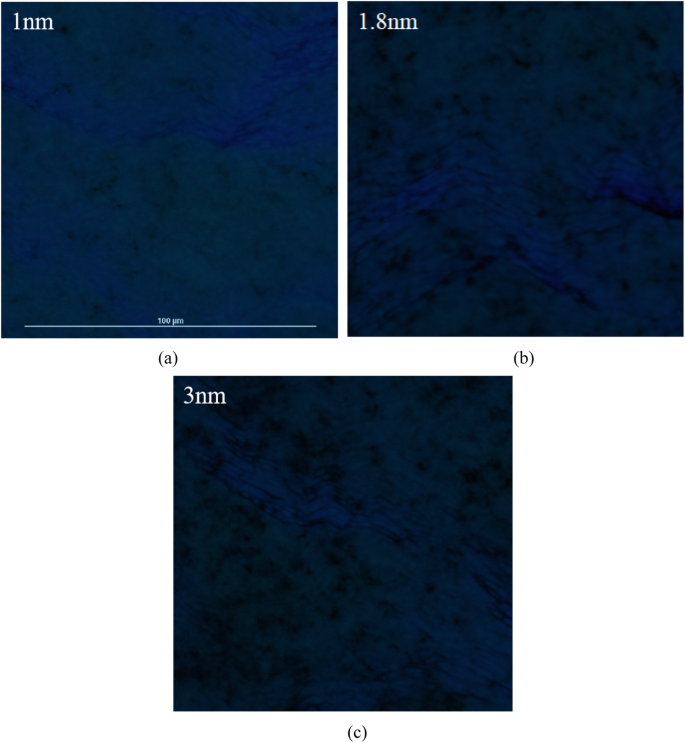
Mikro-PL-Bilder der Proben A, B und C mit verschiedenen LT-GaN-Deckschichtdicken (a ) 1 nm, (b ) 1,8 nm und (c ) 3.0 nm
Schlussfolgerungen
Zusammenfassend wurde der Einfluss der Dicke der GaN-Deckschicht auf die optischen Eigenschaften untersucht. Die aus XRD-Messungen erhaltenen Ergebnisse zeigen, dass eine dickere Deckschicht wirksamer ist, um die In-Zusammensetzung vor Desorption zu schützen. Mit zunehmender Dicke der GaN-Deckschicht wird QCSE verbessert und die Effizienz der Löcherinjektion verringert. Die verschiedenen Grade des Exzitonen-Lokalisierungseffekts, die durch unterschiedliche Dicken der GaN-Deckschicht induziert werden, erklären die Anomalien der PL-Peakwellenlänge und -intensität für drei Proben. Eine zu dünne LT-Deckschicht verschlimmert die Inhomogenität der Lokalisierungszustände in der InGaN-QW-Schicht, und eine zu dicke LT-Deckschicht erzeugt mehr Defekte in der GaN-Deckschicht. Daher ist die Optimierung der Dicke der LT-GaN-Deckschicht ein Schlüsselthema, um die Gleichmäßigkeit und Emissionsintensität der aktiven InGaN-Schicht zu fördern.
Verfügbarkeit von Daten und Materialien
Die in der aktuellen Studie verwendeten und/oder analysierten Datensätze sind auf begründete Anfrage beim entsprechenden Autor erhältlich.
Abkürzungen
- MOCVD:
-
Metallorganische chemische Gasphasenabscheidung
- QCSE:
-
Quantenbegrenzter Stark-Effekt
- MQWs:
-
Mehrere Quantentöpfe
- QB:
-
Quantenbarriere
- LEDs:
-
Leuchtdioden
- LDs:
-
Laserdioden
- HT:
-
Hohe Temperatur
- LT:
-
Niedrige Temperatur
- EL:
-
Elektrolumineszenz
- TDPL:
-
Temperaturabhängige Photolumineszenz
- XRD:
-
Röntgenbeugung
- FWHM:
-
Volle Breite auf halbem Maximum
Nanomaterialien
- Die atomare Umlagerung von GaN-basierten mehreren Quantenquellen in H2/NH3-Mischgas zur Verbesserung der strukturellen und optischen Eigenschaften
- Mehrfarbige Emission von ultravioletter GaN-basierter photonischer Quasikristall-Nanopyramidenstruktur mit semipolaren InxGa1−xN/GaN-Mehrfachquantenquellen
- Die elektrischen Eigenschaften von Hybridverbundwerkstoffen basierend auf mehrwandigen Kohlenstoffnanoröhren mit Graphit-Nanoplättchen
- Untersuchung der Oberflächenpolarisation einer Al2O3-beschichteten GaN/AlGaN/GaN-Heterostruktur durch winkelaufgelöste Röntgenphotoelektronenspektroskopie
- Auswirkungen der Doppelschichtdicke auf die morphologischen, optischen und elektrischen Eigenschaften von Al2O3/ZnO-Nanolaminaten
- Abstimmung der Oberflächenmorphologien und -eigenschaften von ZnO-Filmen durch das Design der Grenzflächenschicht
- Optimale Silizium-Dotierungsschichten von Quantenbarrieren in der Wachstumssequenz, die ein weiches Einschlusspotential von In0,2Ga0,8N/GaN-Quantenquellen von Blau mit acht Perioden bilden LEDs
- Untersuchung einer kristallinen Silizium-Solarzelle mit schwarzer Siliziumschicht auf der Rückseite
- Morphologie, Struktur und optische Eigenschaften von Halbleiterfilmen mit GeSiSn-Nanoinseln und gespannten Schichten
- Optische Eigenschaften von Al-dotierten ZnO-Filmen im Infrarotbereich und ihre Absorptionsanwendungen



