Tunneling atomarer Schichtabgeschiedenes Aluminiumoxid:eine korrelierte strukturelle/elektrische Leistungsstudie für die Oberflächenpassivierung von Siliziumverbindungen
Zusammenfassung
Die Passivierung ist ein Schlüsselprozess zur Optimierung von Silizium-p-n-Übergängen. Unter den verschiedenen Technologien, die zum Passivieren der Oberflächen- und Kontaktgrenzflächen verwendet werden, wird Aluminiumoxid häufig verwendet. Ein Schlüsselparameter ist die Dicke der Passivierungsschicht, die üblicherweise unter Verwendung der Atomlagenabscheidungstechnik (ALD) abgeschieden wird. Dieses Papier zielt darauf ab, korrelierte strukturelle/elektrische Studien für den Passivierungseffekt von Aluminiumoxid an Si-Übergängen vorzustellen, um eine optimale Dicke der Aluminiumoxid-Passivierungsschicht zu erhalten. Beobachtungen mit einem hochauflösenden Transmissionselektronenmikroskop (HRTEM) in Verbindung mit energiedispersiven Röntgenmessungen (EDX) werden verwendet, um die Dicke von Aluminiumoxid auf atomarer Ebene zu bestimmen. Die korrelierten elektrischen Parameter werden sowohl mit dem Sonnensimulator als auch mit Sintons Suns-Voc . gemessen Messungen. Schließlich wird somit eine optimale Aluminiumoxiddicke von 1,2 nm nachgewiesen.
Einführung
Die Reduzierung der Oberflächenrekombinationsverluste in Silizium-p-n-Übergängen ist von größter Bedeutung, um die Effizienz der Lichtabsorption und deren Umwandlung in Photostrom zu verbessern, wobei Solarzellen eine Hauptanwendung sind [1, 2]. Unter den Schlüsselprozessen, die die Defektrekombination in Silizium-Übergängen verbessern können, war und ist die Passivierung der Oberfläche und der Kontakte von größter Bedeutung. Sowohl für die beleuchteten nichtmetallisierten Bereiche als auch für die metallischen Siliziumkontakte wurden Vorder- und Rückseitenpassivierungen entwickelt [3, 4]. Die Metall-Silizium-Grenzfläche zeichnet sich durch eine große Rekombination aus, daher wurden zwei Optionen entwickelt, um die Verluste an der Kontaktfläche zu minimieren:eine kleine Kontaktfläche in Verbindung mit einem geringen lokalen Dotierungsniveau oder eine lokale Passivierung der Metall-Silizium-Grenzfläche durch die Einführung einer dünnen Tunnelung dielektrische Schicht. Kürzlich wurde eine neue Route mit vielversprechendem Potenzial vorgeschlagen, die eine trägerselektive Passivierungsschicht verwendet [5]. In diesem Fall wird eine Polarität der Ladungsträger zum Metall durchgelassen, während die andere Polarität blockiert wird.
Unter allen Passivierungsschichten ist Aluminiumoxid (Al2 O3 ), die durch Atomlagenabscheidung (ALD) abgeschieden wird, ist eine der am häufigsten verwendeten Methoden, auch wenn auch plasmaunterstützte chemische Gasphasenabscheidung (PECVD) angewendet werden kann [6, 7]. ALD ermöglicht eine gute Kontrolle der Dicke bis in den atomaren Maßstab, während die Verwendung von Aluminiumoxid zu einer guten chemischen Passivierung von Grenzflächenzuständen sowie zu einer effizienten Feldeffektpassivierung durch lokalisierte Ladungen in der Oxidschicht führt [8]. Elmi et al. zeigten, dass die Einführung von eingebetteten Ag-Nanopartikeln in eine dünne Aluminiumoxidschicht die Feldeffektpassivierung effektiv verbessern kann [9]. Es ist bekannt, dass das Vorzeichen und die Dichte der lokalisierten Ladungen sowie die Dicke der Aluminiumoxidschicht wichtige Parameter für die Oberflächenpassivierung sind. Es wurden viele Arbeiten veröffentlicht, um den Einfluss der Aluminiumoxiddicke auf die Geräteleistung zu untersuchen; Es besteht jedoch kein Konsens über die optimale Aluminiumoxiddicke, da sie in der Literatur von 0,24 bis 30 nm variiert, wie in Tabelle 1 zusammengefasst. Tabelle 1 veranschaulicht die Streuung der optimierten Aluminiumoxiddicke. Tatsächlich betreffen viele Daten die Oberflächenrekombinationsgeschwindigkeit (Se), die nicht den Messungen an den hergestellten Solarvorrichtungen entspricht. Der allgemeine Trend ist eine Abnahme von Se für größere Dickenwerte aufgrund einer besseren chemischen Passivierung durch das Vorhandensein von Wasserstoff in der Aluminiumoxidschicht, der die Grenzflächenzustände während des thermischen Glühens nach dem Wachstum passiviert.
Richteret al. berichteten, dass der Sättigungsstrom des Emitters bis auf 30 fA/cm 2 . sinkt konnte für dünne Schichten (0,5 bis 3 nm) erhalten werden, jedoch mit einer Stapelstruktur aus Aluminiumoxid und 70 nm SiNx [17]. Der beste passivierte Metall-Silizium-Kontakt wird mit einem 0,24 nm dicken Al2 . beobachtet O3 [18]. Schließlich ist die Passivierung in Bezug auf die Dotierungs- und Typniveaus bei n + . effizienter aber ein SiO2 /Aluminiumoxid-Stapelstruktur bietet die Möglichkeit, die Dichte lokalisierter Ladungen einzustellen und kann sowohl auf n- als auch auf p-Typ verwendet werden [23]. Dennoch zeigten nur wenige Arbeiten die Korrelation zwischen der Qualität der Substrat/Aluminiumoxid-Grenzfläche und der elektrischen Leistung von Geräten. Es ist daher notwendig, eine systematische Beobachtung im atomaren Maßstab auf der Aluminiumoxid-Passivierungsschicht durchzuführen und einen optimalen Wert der Aluminiumoxid-Dicke zu erhalten, der mit der elektrischen Leistung korreliert ist.
In dieser Arbeit wurden Aluminiumoxidschichten verwendet, die unter Verwendung der ALD-Technik mit unterschiedlichen Dicken von 0,24 bis 1,9 nm abgeschieden wurden, um implantiertes Si n + . zu passivieren -p-Übergänge. Die Grenzfläche der Aluminiumoxidschicht auf der Vorderseite des Si-Übergangs wurde unter Verwendung eines hochauflösenden Transmissionselektronenmikroskops (HRTEM) untersucht, während die Dicke der Aluminiumoxidschicht mit den zugehörigen elektrischen Parametern wie Serienwiderstand, Idealitätsfaktor, Lebensdauer, externe korreliert wurde Quanteneffizienz (EQE) und Leistungsumwandlungseffizienz (PCE). Sintons Suns-Voc Es wurden Messungen durchgeführt, um den Einfluss des Serienwiderstands aufzulösen. Schließlich wurde eine optimierte Aluminiumoxiddicke von 1,2 nm erhalten. Es sei darauf hingewiesen, dass wir uns hier nur auf die Frontkontaktpassivierung von Silizium-p-n-Übergängen konzentrieren; die Geräteeffizienz ist nicht vollständig optimiert, was den Zweck dieser Arbeit verfehlt.
Methoden
Geräteherstellung
Abbildung 1a zeigt den Herstellungsprozess von implantiertem Si n + -p-Übergänge mit Oberflächenpassivierung von Al2 O3 /SiNx :H-Stapel. Als Substrate wurden 4 Zoll bordotierte p-Silizium-(100)-Wafer mit einem spezifischen Widerstand von 5–10 Ω·cm verwendet. Die Proben wurden vor der Realisierung von n + . mit Piranha-Lösung und destilliertem Wasser gereinigt oberste Schicht. Die Phosphorionenimplantation wurde mit einer Dosis von 10 14 . durchgeführt at/cm 2 bei 180 keV, gefolgt von einem Tempern bei 900°C während 5 min, um die Dotierstoffe zu aktivieren. Detaillierte Beschreibungen des technologischen Verfahrens finden Sie in unseren bisherigen Arbeiten [24, 25].

a Schema des Herstellungsprozesses von implantiertem Si n + -p Übergang passiviert durch Al2 O3 /SiNx Stapel. b HRTEM-Bild, aufgenommen entlang der [011]-Richtung des Siliziumsubstrats. Intensitätsprofil entsprechend dem weißen Rechteck (ein Aluminiumoxidfilm mit einer Dicke von etwa 0,9 nm ist auf der Oberseite der Siliziumdioxidschicht sichtbar). c , d STEM-HAADF-Bilder der beiden durch ALD gewachsenen Aluminiumoxidschichten mit den entsprechenden STEM-EDX-Karten von Al, O und Si. Die helleren Kontraste in den HAADF-Bildern auf der Oberseite der Siliziumdioxidschicht sind auf die höhere Dichte zurückzuführen (höherer Durchschnitt Z Wert) im Vergleich zu Siliziumdioxid oder Siliziumnitrid. Intensitätsprofile geben die Dicke der Aluminiumoxidschichten von ~ 1.2 nm bzw. 1.9 nm an
Ein ultradünnes Al2 O3 Tunnelschicht mit einer erwarteten Dicke von d im Bereich von 0,24 bis 1,9 nm wurde unter Verwendung der ALD-Technik abgeschieden. Beachten Sie, dass diese Dicke aus der durchschnittlichen Dicke abgeleitet wurde, die durch Ellipsometrie-Spektroskopie bestimmt wurde, die für Aluminiumoxid-Dünnfilme erhalten wurde, die mit unterschiedlicher Anzahl von Zyklen aufgewachsen wurden. Ein ALD-Zyklus hat eine Monoschicht abgeschieden, die 0,12 nm entspricht. Kreuzungen ohne Aluminiumoxid (d = 0), d. h. mit unpassivierten Metall-Silizium-Kontakten, wurden realisiert, aber der PCE ist mit nur 0,4% sehr gering [9]. Die Aluminiumoxidabscheidung wurde in einem PICOSUN R200 System durch einen thermischen Prozess durchgeführt. Als Reaktanten wurden Trimethylaluminium (TMA) und H2 . verwendet O, während die Wachstumstemperatur 290 °C betrug. Während des ALD-Prozesses wurden Wasserkreisläufe verwendet, um den TMA-Precursor zu oxidieren. Als Ergebnis wird ein dünnes SiO2 Aufgrund der natürlichen Oxidation der Siliziumoberfläche wurde zwischen der Siliziumoberfläche und der Aluminiumoxidschicht eine Oxidschicht abgeschieden. Die durch TEM beobachtete Dicke einer solchen nativen Oxidschicht lag nahe bei 1,5 nm. Zweitens, ein 80 nm dickes SiNx :H-Schicht, die dem üblicherweise in der Si-Solarzellenindustrie verwendeten Wert entspricht, wurde auf der Probe unter Verwendung des PECVD-Ansatzes mit einer Mischung aus SiH4 . abgeschieden und NH3 . Die Abscheidungstemperatur betrug 340 °C, der Druck 1 Torr und die Leistung 10 W. Die Probe wurde dann 10 Minuten lang bei 650 °C geglüht, damit H in Si diffundiert
Fingerelektroden aus Ti/Au (20/800 nm) wurden auf der Vorderseite durch Sputtern mit einer Lochmaske nach dem Öffnen des SiNx . abgeschieden :H-Beschichtung durch reaktives Ionenätzen (RIE). Der Rückkontakt wurde dann durch Aufdampfen eines 400 nm dicken Ti/Au-Films abgeschieden. Schließlich wurden die Proben bei 400°C für 10 min getempert, um einen ohmschen Kontakt zu bilden.
Charakterisierung
Die TEM-Analyse wurde von dünnen Querschnittsfolien durchgeführt, die durch fokussierten Ionenstrahl (FIB) auf einem FEI Helios Dual-Beam Nanolab 600i hergestellt wurden. Vor der Ionenverdünnung wurden ein Kohlenstofffilm und eine Platinschicht abgeschieden, um die Oberfläche der Probe zu schützen. Die Beobachtungen mit TEM, STEM High Angle Annular Dark Field (HAADF) und STEM Energy Dispersion X-ray (EDX) wurden mit einem doppelt korrigierten JEOL ARM200F Kalt-FEG-Mikroskop durchgeführt, das bei 200 kV betrieben und mit einem EDX-Spektrometer (CENTURION von JEOL) ausgestattet war ). Die Bildbearbeitung erfolgte mit DIGITALMICROGRAPH (GATAN). Die Bilder wurden mit dem Elektronenstrahl parallel zur [011]-Richtung des Si (100)-orientierten Substrats aufgenommen. In dieser Ausrichtung verläuft der Elektronenstrahl parallel zur Grenzfläche Aluminiumoxid/Substrat.
Die elektrischen Parameter unter Beleuchtung wurden mit einem Sonnensimulator (Oriel®Sol3ATM) unter AM 1,5G-Beleuchtung gemessen, während die externen Quanteneffizienz (EQE)-Spektren unter Standardmessbedingungen auf einem 7-SCSpec-System, hergestellt von 7-STAR Co., gemessen wurden. Um den Einfluss des Serienwiderstands zu überwinden, verwendet Sintons Suns-Voc Es wurden Messungen durchgeführt [26,27,28]. Sintons Suns-Voc Die Technik ist eine Methode im offenen Stromkreis, um die Leistung eines p-n-Übergangs oder einer Solarzelle anzuzeigen, die es ermöglicht, die vom Sonnensimulator angegebenen elektrischen Parameter mit den ohne den Einfluss des Serienwiderstands abgeleiteten zu vergleichen. Das Setup umfasst eine Xenon-Blitzlampe mit einem vollständigen Satz Neutralfilter und einen auf 25 °C geregelten Wafertisch. Ein Standard-IV-Kurvenformat mit einem geschätzten Jsc kann durchgeführt werden, indem entweder die p+- und n+-Bereiche direkt untersucht werden oder die Metallisierungsschicht untersucht wird. Die Daten können direkt verwendet werden, um die Material- und Passivierungsqualität von Solarzellen anzuzeigen.
Ergebnisse und Diskussion
1(b) ist ein typisches HRTEM-Bild, das entlang der [011]-Richtung des Siliziumsubstrats aufgenommen wurde. In dieser Richtung verläuft der Elektronenstrahl notwendigerweise parallel zur Grenzfläche des Filmsubstrats. Beachten Sie, dass die Oberseite des Substrats nicht ganz eben ist. Diese Beobachtung impliziert, dass die Grenzflächen zwischen den verschiedenen oben genannten amorphen Schichten (Siliziumdioxid, Aluminiumoxid und Siliziumnitrid) ebenfalls rau sind, was ihre Charakterisierung zu einer sehr schwierigen Aufgabe macht. Allerdings wird die Dickenmessung aufgrund dieser Rauheit immer überschätzt. Der Einschub von Fig. 1(b) ist ein Intensitätsprofil senkrecht zum Substrat und über einen 10 nm breiten Bereich, wie durch das weiße Rechteck des HRTEM-Bildes angezeigt. Dieses Profil zeigt den Kontrastunterschied zwischen den drei amorphen Schichten auf der Oberseite des Si-Substrats. Tatsächlich kann aufgrund des Z-Kontrasts eine dunklere, 0,9 nm dicke Schicht über der Siliziumdioxidschicht beobachtet werden, bei der es sich höchstwahrscheinlich um die durch ALD gewachsene Aluminiumoxidschicht handelt. Um dieses Ergebnis zu bestätigen, wurde eine ringförmige Dunkelfeldabbildung mit großem Winkel auf zwei verschiedenen Aluminiumoxidschichten durchgeführt, kombiniert mit einer chemischen Kartierung, die durch Rastertransmissionselektronenmikroskopie, gekoppelt mit einem energiedispersiven Röntgenspektrometer, erhalten wurde. Abbildung 1(c) und (d) sind zwei Datensätze, die zwei unterschiedliche Schichtdicken von Aluminiumoxid veranschaulichen.
Beide Sätze bestehen aus einem HAADF-Bild, das die obere Oberfläche des Si-Substrats (entlang der [011]-Richtung) und die drei amorphen Schichten, nämlich Siliziumdioxid (dunkler Bereich), Aluminiumoxid (weißerer Bereich) und schließlich Siliziumnitrid (mittlerer Kontrast), darstellt. Beachten Sie, dass insbesondere in 1(d) einige helle Punkte sichtbar sind. Diese Eigenschaften sind auf Platinstäube zurückzuführen, die während der FIB-Präparation der dünnen Folie aus der Schutzschicht austreten. Für beide Strukturen sind chemische STEM-EDX-Karten von Aluminium, Sauerstoff und Silizium oben in den Abbildungen 1(c) und (d) angegeben. Die Aluminiumkarten zeigen schön das Vorhandensein von Aluminium entsprechend den weißeren Regionen der HAADF-Bilder. Es zeigt sich, dass in den angrenzenden Bereichen einige helle Punkte vorhanden sind, die jedoch während der Aufnahme einem gewissen „Rauschen“ im Hintergrund entsprechen. Breitere Regionen sind in den Sauerstoffkarten sichtbar, da sie die Aluminiumoxid- und Siliziumdioxidschichten abbilden. Schließlich zeigen die Siliziumkarten eine dunkle Linie, die den Aluminiumoxidschichten entspricht, der einzigen Schicht ohne Silizium. Aufgrund von Diffusionsstreuungsphänomenen sind die chemischen Karten nicht die besten Daten, um die Dickenwerte richtig abzuschätzen.
Um den durch das Vorhandensein der Aluminiumoxidschicht induzierten unterschiedlichen Kontrast deutlicher zu zeigen, haben wir die Intensitätsprofile für beide Bilder aufgetragen, wie in Fig. 1(c) und (d) gezeigt. Wie diese Profile deutlich zeigen, zeigt ein breites Band die helleren Bereiche an, die der Aluminiumoxidschicht entsprechen. Da das Aluminiumoxid eine gewisse Rauheit aufweist, ist es sinnvoll, die Schichtdicke durch Messen des Abstands zwischen zwei vertikalen Linien, die sich in der Mitte der Schrägen auf jeder Seite der Schicht befinden, abzuschätzen. Die Ergebnisse sind ungefähr 1,2 nm bzw. 1,9 nm.
Entwicklung des Serienwiderstands R s
Wie in Abb. 2a gezeigt, R s ist fast konstant (R s = 1.1 ± 0.15 Ω) von d = 0,24 bis 1,2 nm und steigt abrupt auf 3,1 ± 0,2 Ω für d = 1,9 nm. Der gemessene Widerstand R s ist die Addition der Emitter- und Basiszone, der metallischen Finger und des mit dem dünnen SiO2 . verbundenen Widerstands Oxidschicht, insgesamt mit R bezeichnet ich , plus Widerstand R do der Aluminiumoxidschicht zugeordnet. Für alle Proben gilt im Rahmen der Reproduzierbarkeit des Technologieverfahrens, das durch die Fehlerbalken (± 0,15 Ω) in Abb. 4 gegeben ist, R ich wird als konstant angesehen, da derselbe technologische Prozess angewendet wird. d ist der einzige geänderte Parameter. Also, als R s ist konstant bis d = 1.2 nm und als Tunnelwiderstand R do variiert offensichtlich mit d , schließen wir, dass bis zu d = 1.2 nm, R do variiert, aber seine Variation ist geringer als die Streuung der Messungen, d. h. 0,15 . R do ist direkt an den Kehrwert des Transferkoeffizienten γ für das Tunneln gebunden, d. h. die Tunnelwahrscheinlichkeit von Trägern durch eine rechteckige Barriere, gegeben durch [29]:
$$ \gamma \approx \kern0.5em \exp \left(-\frac{2d\sqrt{2q{m}^{\ast }{\upphi}_{\mathrm{B}}}}{\overline{ h}}\rechts) $$ (1)wo m * ist die effektive Masse in der Aluminiumoxidbarriere (m * = 0,75 m 0 [30], mit m 0 als Elektronenmasse), h ist die Planck-Konstante, q die Elektronenladung ist und ϕ B ist die effektive Barrierenhöhe, gleich dem Leitungsband-Offset ΔEC zwischen Dielektrikum und n + Silikonkontakt. Der Tunnelwiderstand ist gegeben durch:
$$ {R}_{\mathrm{thu}}=Ax{\gamma}^{-1} $$ (2)wo A ist eine Konstante. Für d = 1.9 nm, R do entspricht der auf R measured gemessenen Stufe s , und daher leiten wir R . ab do (1,9 nm) = 2 Ω. Von diesem Wert A berechnet werden kann. Dafür müssen wir ϕ . wissen B was gleich dem Leitungsbandversatz zwischen Si und der dielektrischen Schicht ist, da das Fermi-Niveau innerhalb des Minimums des Leitungsbandes im stark dotierten n + . liegt Silikonkontakt. Tatsächlich besteht die dielektrische Schicht aus einigen Nanometern SiO2 /Al2 O3 Stapel, sodass der Bandversatz von diesen beiden dielektrischen Schichten abhängt. Der Leitungsband-Offset liegt im Bereich von 3,13–3,5 eV und 2,08–2,8 eV für SiO2 und Al2 O3 [31] bzw. Tabelle 2 enthält die Werte des A Vorfaktor abgeleitet aus dem Wert von R s gemessen bei d = 1.9 nm, für die beiden Extremwerte von ϕ B.
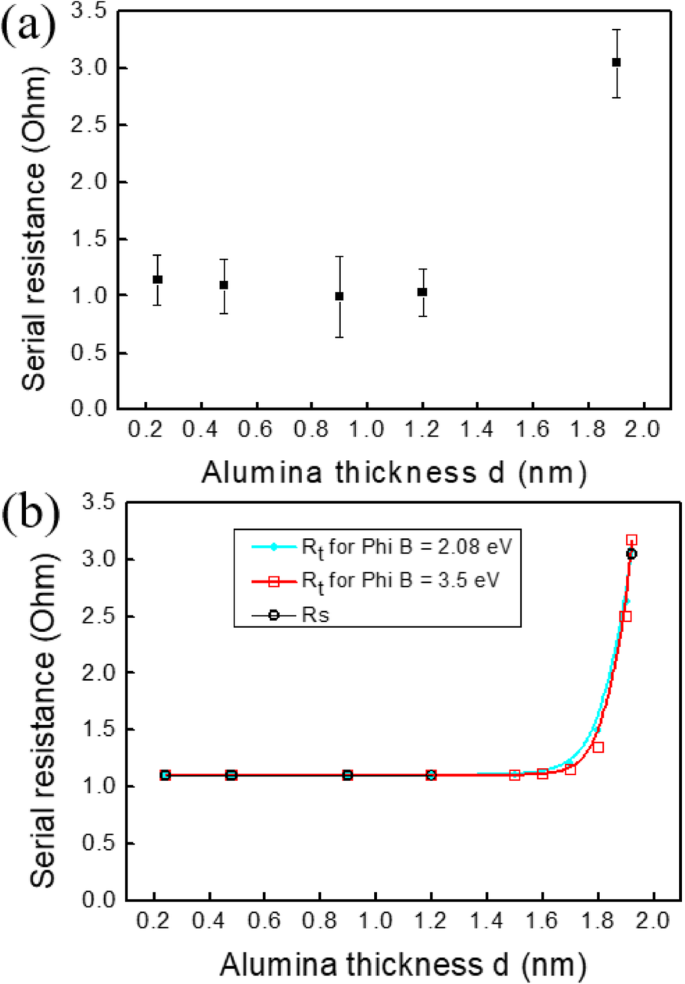
a Entwicklung des Serienwiderstands R s gegenüber der Aluminiumoxiddicke. b Experimentelle Werte von R s und simulierte R Simu berechnet für ϕ B = 2,08 und 3,5 eV gegen die Aluminiumoxiddicke d (nm)
In Abb. 2b haben wir R . aufgetragen s und der simulierte Gesamtwiderstand R Simu = R ich + R do für die beiden ϕ B Werte im Vergleich zu d (R s wurde zwischen d . auf seinen Durchschnittswert von 1,1 Ω gebracht = 0,24 und 1,2 nm). Was auch immer ϕ B , für d ≤ 1.2 nm, R do Ist vernachlässigbar. Es bestätigt unsere Ausgangshypothese:der bei 1,9 nm beobachtete Schritt in der Evolution von R s ist mit der Entwicklung der Tunnelbarriere verbunden. Für d weniger als 1,2 nm, die Hauptwirkung der Aluminiumoxidschicht besteht darin, das n + . zu passivieren Kontakte und der p-Oberfläche, mittels Feldeffektpassivierung, die mit den im Oxid lokalisierten festen Ladungen verbunden ist. Für größere d Werten führt die Aluminiumoxidschicht zu einem parasitären Reihenkontaktwiderstand, der die elektrische Leistung der Zellen verringert.
Schließlich können wir den spezifischen Widerstand ρ . abschätzen der Aluminiumoxidschicht. Dazu betrachten wir den gemessenen Widerstand R für einen Dickenwert von 1,9 nm. Der Tunneleffekt lässt nach und die Schicht beginnt ein „bulk-like“-Verhalten (eine grobe Näherung) zu haben. Bei einer solchen Aluminiumoxiddicke (d = 1.9 nm) und unter Berücksichtigung der Oberfläche S des Kontakts (10,54 mm 2 ), folgern wir ρ unter Verwendung der folgenden Gleichung:
$$ R=\rho\ \frac{d}{S} $$ (3)Das führt zu ρ = 1.1 × 10 6 ·cm. Bei Schüttgütern auf den Märkten variiert der spezifische Widerstandswert in Abhängigkeit von der Wachstumstemperatur und den Verunreinigungen im Aluminiumoxid von 10 5 bis 10 14 Ω·cm (von Kyocera™). Unser geschätzter Wert zeigt also, dass wir ein „Pseudo-Bulk“-Material haben, an der Grenze zwischen einer dünnen Schicht und einer Bulk-Schicht.
Entwicklung des Idealitätsfaktors n
Bei Vorhandensein eines Serienwiderstandes ist die I-V-Kurve einer Solarzelle:
$$ I={I}_{\textrm{L}}-{I}_0\ \exp \left(\frac{q\left(V+I\ {R}_{\textrm{s}}\right )}{n\k\T}\right) $$ (4)wo ich ist der Zellenausgangsstrom, I L ist der durch Licht erzeugte Strom, V ist die Spannung an der Zelle, T ist die Temperatur, k ist die Boltzmann-Konstante, n ist der Idealitätsfaktor und R S ist der Serienwiderstand der Zelle. Für einen niedrigen Injektionspegel mit nur Band-zu-Band- oder Schottky-Read-Hall-Rekombinationen beträgt der Idealitätsfaktor n kleiner als 2 ist. Er erreicht den Wert 1, wenn die Rekombination durch Minoritätsträger begrenzt wird [31]. Ein Anstieg von n weist darauf hin, dass ein ungewöhnlicher Rekombinationsmechanismus stattfindet, an dem sowohl Minoritäts- als auch Majoritätsträger beteiligt sind [32]. Also, n ist eine Signatur der Rekombination (oder der Passivierung) des Geräts. Außerdem n ist auch an R . gebunden s das erhöht den Idealitätsfaktor [33]. Die Entwicklung von n gegen die Aluminiumoxiddicke ist in Abb. 3a dargestellt.

a Entwicklung des Idealitätsfaktors n gegenüber der Aluminiumoxiddicke d . b Entwicklung der Lebensdauer τ gegenüber der Aluminiumoxiddicke d
Für einen geringen Dickenwert (0,24 nm), n größer als 2 ist, was die Signatur einer nicht passivierten Oberfläche ist. Mit zunehmender Aluminiumoxiddicke n nimmt ab und stabilisiert sich bei etwa 1,5, was einen wirksamen Passivierungseffekt durch das Aluminiumoxid belegt. Für einen Aluminiumoxiddickenwert von 1,9 nm, n steigt abrupt auf 4 an, entsprechend dem abrupten Anstieg von R s . Also, beide R s und n zeigen, dass die Aluminiumoxidschicht den Si-Übergang gut passiviert, was mit einer niedrigen Tunnelbarriere verbunden ist. Für d = 1,9 nm, die Tunnelbarriere steigt mit einer nachfolgenden Verschlechterung von R s und damit des Idealitätsfaktors.
Lebensdauer
Ein weiterer wichtiger Parameter, der den Passivierungseffekt veranschaulicht, ist die Lebensdauer der Phototräger, τ . Tatsächlich hängt die Lebensdauer direkt mit der Rekombinationsrate der Ladungsträger zusammen, die an die Konzentration von Oberflächendefekten (Rekombinationszentren) gebunden ist. Sie wurde aus der gemessenen Leerlaufspannung, ihrer zeitlichen Ableitung und der tatsächlichen Beleuchtungsstärke abgeleitet. Seine Entwicklung gegenüber der Aluminiumoxiddicke ist in Abb. 3b angegeben. Die Entwicklung der Lebensdauer stimmt mit den bisherigen Ergebnissen überein. Der Durchschnittswert ist niedrig, hauptsächlich aufgrund des nicht passivierten Rückkontakts. Es zeigt jedoch deutlich eine Zunahme mit der Aluminiumoxiddicke, entsprechend einer besseren Passivierung des Frontkontakts und mit einem optimalen Dickenwert von 1,2 nm. Für d = 1,9 nm, die Lebensdauer nimmt ab. Es ist möglich, dass mit zunehmender Aluminiumoxiddicke weniger Wasserstoff aus dem SiNx . diffundiert Schicht zum Kontakt während des thermischen Glühens, und daher nimmt der chemische Passivierungseffekt ab.
Abbildung 4 zeigt den gemessenen EQE gegenüber der Aluminiumoxiddicke. Die beste EQE wird für d . beobachtet = 1,2 nm. Die Hauptverbesserung wird für die Wellenlänge beobachtet, die von 600 bis 900 nm variiert. In allen Fällen ist die EQE weit von einer idealen rechteckigen Form im IR entfernt, was ein Zeichen der Rekombination am nicht passivierten Rückkontakt ist.
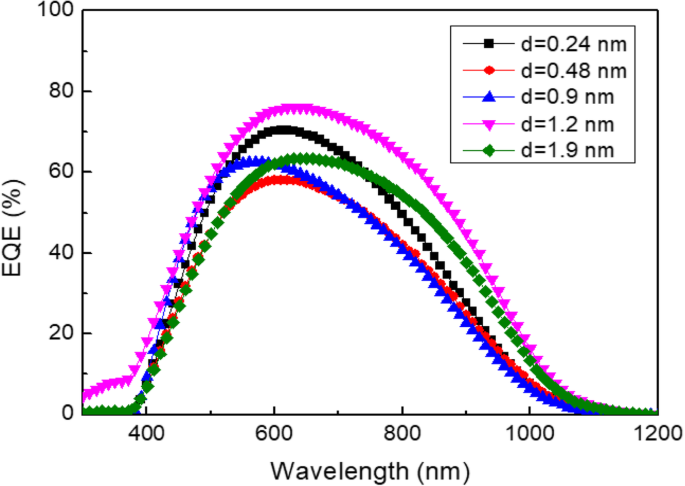
Gemessener EQE gegenüber der Wellenlänge für verschiedene Aluminiumoxiddicken
Um die Analyse zu vervollständigen, haben wir die elektrischen Parameter unter Beleuchtung untersucht, die sowohl unter einem Sonnensimulator als auch mit der Sinton-Methode gemessen wurden. Abbildung 5 zeigt die Energieeffizienz der Solarzellen in Abhängigkeit von der Dicke des Aluminiumoxids:die gemessene mit dem Sonnensimulator und die optimierte ohne R s . Mit zunehmender Aluminiumoxiddicke steigt der gemessene PCE aufgrund eines besseren Passivierungseffekts und erreicht einen Maximalwert von 5 % für d = 1.2 nm, bevor d . abnimmt = 1,9 nm. Der korrigierte PCE für R s = 0 hat einen recht konstanten Wert um 11%. Dieser Wert ist sinnvoll, wenn man nur die Passivierung des Rückkontakts berücksichtigt. Für d = 1,9 nm, die korrigierte Ausbeute sinkt auf 6% aufgrund des parasitären Shunt-Widerstands.
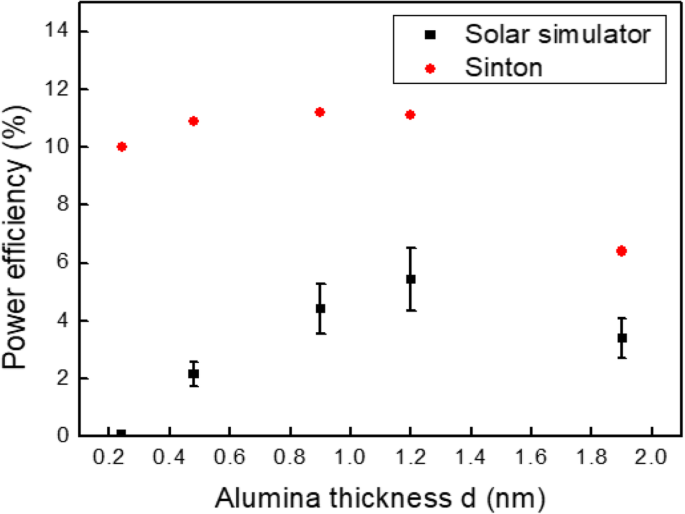
Gemessene und extrapolierte Leistungseffizienz gegenüber der Aluminiumoxiddicke d
Schlussfolgerungen
Durch ALD abgeschiedenes Aluminiumoxid ist eine effiziente Methode zur Passivierung elektrischer Kontakte, einem Schlüsselparameter für Silizium-p-n-Übergänge. In dieser Arbeit wurde eine Tunnel-Atomschicht-abgeschiedene Aluminiumoxidschicht mit verschiedenen Dicken von 0,24 bis 1,9 nm verwendet, um das implantierte Si n + . zu passivieren -p-Übergänge. Wir haben systematische HRTEM-, STEM HAADF- und STEM EDX-Strukturanalysen durchgeführt, die mit einem vollständigen Satz elektrischer Messungen korreliert sind, wobei sowohl der Sonnensimulator als auch die Sinton-Analysen verwendet wurden. Dieser ursprüngliche Ansatz erlaubt die Behauptung, dass die optimale Aluminiumoxiddicke zum Erzielen eines wirksamen Passivierungseffekts 1,2 nm beträgt. Obwohl der Gerätewirkungsgrad in dieser Arbeit nicht vollständig optimiert wurde, könnte die optimale Aluminiumoxid-Passivierung für die Entwicklung der hocheffizienten siliziumbasierten Solarzellen von Vorteil sein.
Abkürzungen
- ALD:
-
Atomlagenabscheidung
- EDX:
-
Energiedispersive Röntgenstrahlung
- EQE:
-
Externe Quanteneffizienz
- FIB:
-
Fokussierter Ionenstrahl
- HAADF:
-
Ringförmiges Dunkelfeld mit großem Winkel
- HRTEM:
-
Hochauflösendes Transmissionselektronenmikroskop
- PCE:
-
Leistungsumwandlungseffizienz
- PECVD:
-
Plasmaunterstützte chemische Gasphasenabscheidung
- RIE:
-
Reaktives Ionenätzen
- TEM:
-
Transmissionselektronenmikroskop
- TMA:
-
Trimethylaluminium
Nanomaterialien
- Bewertung der Vorteile von DevOps für IoT-Leistungstests
- Die atomare Umlagerung von GaN-basierten mehreren Quantenquellen in H2/NH3-Mischgas zur Verbesserung der strukturellen und optischen Eigenschaften
- Synthese von elektrisch leitfähigem Siliziumdioxid-Nanofaser/Gold-Nanopartikel-Verbundmaterial durch Laserpulse und Sputtertechnik
- Bildung und Lumineszenzeigenschaften von Al2O3:SiOC-Nanokompositen auf der Basis von durch Phenyltrimethoxysilan modifizierten Aluminiumoxid-Nanopartikeln
- Entwicklung der Kontaktfläche bei Normallast für raue Oberflächen:von atomaren zu makroskopischen Skalen
- Auswirkung verschiedener Bindemittel auf die elektrochemische Leistung einer Metalloxidanode für Lithium-Ionen-Batterien
- Studie über den mehrstufigen Widerstandsschaltspeicher und die speicherzustandsabhängige Photospannung in Pt/Nd:SrTiO3-Übergängen
- Die Optimierung des Spacer-Engineerings für einen kondensatorlosen DRAM basierend auf dem Dual-Gate-Tunneling-Transistor
- Das anionische Tensid/ionische Flüssigkeiten mit interkaliertem reduziertem Graphenoxid für Hochleistungs-Superkondensatoren
- Effektive Lichtabsorption mit doppelseitigen Pyramidengittern für Dünnschicht-Silizium-Solarzellen



