Bipolar-resistive Schalteigenschaften von HfO2/TiO2/HfO2-RRAM-Bauelementen mit dreischichtiger Struktur auf Pt- und TiN-beschichteten Substraten, die durch Atomlagenabscheidung hergestellt wurden
Zusammenfassung
Das HfO2 /TiO2 /HfO2 Resistive Direktzugriffsspeicher (RRAM) mit Dreischichtstruktur wurden auf Pt- und TiN-beschichteten Si-Substraten mit Pt-Oberseitenelektroden durch Atomlagenabscheidung (ALD) hergestellt. Der Einfluss der unteren Elektroden aus Pt und TiN auf die Widerstandsschalteigenschaften von Dreischicht-Struktureinheiten wurde untersucht. Sowohl Pt/HfO2 /TiO2 /HfO2 /Pt und Pt/HfO2 /TiO2 /HfO2 /TiN zeigen ein typisches bipolares resistives Schaltverhalten. Die vorherrschenden Leitungsmechanismen in niederohmigen und hochohmigen Zuständen (LRS und HRS) beider Speicherzellen sind ohmsches Verhalten bzw. raumladungsbegrenzter Strom. Es hat sich herausgestellt, dass die unteren Elektroden aus Pt und TiN einen großen Einfluss auf die Polaritätspräferenz der Elektroformung, das Verhältnis von hohem und niedrigem Widerstand und die Streuung der Betriebsspannungen von Speicherzellen mit dreischichtiger Struktur haben. Im Vergleich zur Verwendung von symmetrischen oberen/unteren Pt-Elektroden zeigen die RRAM-Zellen, die asymmetrische obere/unten TiN-Elektroden verwenden, eine kleinere negative Formungsspannung von –3,7 V, eine relativ enge Verteilung der Setz-/Rücksetzspannungen und ein niedrigeres Verhältnis von hohen und niedrigen Widerständen von 10 2 . Die elektrodenabhängige Polarität der Galvanoformung kann interpretiert werden, indem die chemische Aktivität der Elektroden mit Sauerstoff, die damit verbundenen Reaktionen an der Anode und die ungleichmäßige Verteilung der Sauerstoffleerstellenkonzentration in der Dreischichtstruktur von HfO2 . berücksichtigt werden /TiO2 /HfO2 auf Pt- und TiN-beschichtetem Si. Für Pt/HfO2 /TiO2 /HfO2 /TiN-Geräte spielt die TiN-Elektrode als Sauerstoffreservoir eine wichtige Rolle bei der Reduzierung der Formierspannung und der Verbesserung der Gleichmäßigkeit der Widerstandsschaltparameter.
Hintergrund
Resistive Random Access Memory (RRAM) hat aufgrund seines Potenzials, Flash-Speicher in nichtflüchtigen Speichern der nächsten Generation zu ersetzen [1, 2, 3], große Aufmerksamkeit auf sich gezogen. Das Phänomen des ohmschen Schaltens (RS) wurde in Übergangsmetalloxiden, Festelektrolyten und organischen Polymeren weithin entdeckt [4,5,6,7]. RRAM-Vorrichtungen auf der Basis von Übergangsmetalloxiden wurden aufgrund ihrer einfachen Zusammensetzung und ihrer kompatiblen Verarbeitung mit konventioneller komplementärer Metalloxid-Halbleiter (CMOS)-Fertigung ausgiebig erforscht [8,9,10]. Zur Aufklärung des Schaltverhaltens wird das Filamentmodell der Sauerstoffleerstellenmigration verwendet [1, 11]. Es wird ein einheitliches mikroskopisches Prinzip vorgeschlagen, um sowohl unipolare als auch bipolare Schalteigenschaften von RRAMs auf Übergangsmetalloxidbasis zu quantifizieren, die mit der Verteilung lokalisierter Sauerstoffleerstellen in der Oxidschaltschicht korreliert sind [12, 13].
Jedoch leiden Speicherzellen, die Übergangsmetalloxide verwenden, unter einer Ungleichmäßigkeit der Widerstandsschaltparameter, wie beispielsweise instabilen Widerstandswerten von Zuständen mit niedrigem und hohem Widerstand (LRS und HRS), verstreuten Setz- und Rücksetzspannungen, was kommerzielle Anwendungen behindert. Kürzlich wurde gezeigt, dass RRAM-Bauelemente mit Dreischichtstruktur auf Oxidbasis die Streuung von Widerstandsschaltparametern verbessern. Die Zellen mit einer Struktur aus Al2 O3 /HfO2 /Al2 O3 zeigte eine fantastische Gleichförmigkeit der Setz- und Rücksetzspannungen und eine ausgezeichnete Dauerhaftigkeit beim Umschalten zwischen LRS und HRS [14]. Die Verbindung oder der Bruch der leitfähigen Filamente trat leichter in zwei Grenzflächenschichten zwischen Al2 . auf O3 /IL/HfO2 /IL/Al2 O3 . Inzwischen ist die Einheit der Dreischichtstruktur von TaOx /TiO2 /TaOx zeigte eine gute Leistung in einem Selektor-Eins-Widerstands-Array, was darauf zurückzuführen ist, dass das Energieband des TiO2 Film war oben und unten symmetrisch gebogen TaO x /TiO2 Grenzflächen und modifiziert als eine Kammoxidbarriere aufgrund der Diffusion einiger Ta-Atome in TiO2 Film [15].
Darüber hinaus kann das RS-Verhalten eines gegebenen Oxidspeichermediums durch die Elektrodenmaterialien signifikant beeinflusst werden [1, 16, 17]. Die bestehenden Modelle, die auf der freien Energie der Grenzflächenoxidbildung und den Metallaustrittsarbeiten basieren, reichen jedoch nicht aus, um die Ergebnisse vollständig zu erklären. Unterdessen fehlen derzeit auch die Arbeiten zum elektrodenabhängigen RS-Phänomen des RRAM mit dreischichtiger Struktur.
Atomic Layer Deposition (ALD) ist eine neue Art von Dünnschicht-Abscheidungstechnologie, die auf sequentiellen selbstlimitierten und komplementären Oberflächen-Chemisorptionsreaktionen unter Verwendung von Vorläuferdampf mit einfacher und präziser Dickensteuerung, großer Flächengleichmäßigkeit und ausgezeichneter dreidimensionaler Konformität, insbesondere für die Abscheidung, basiert mit nanolaminierter Struktur [18, 19].
In dieser Arbeit wird das HfO2 /TiO2 /HfO2 RRAM-Bausteine mit dreischichtiger Struktur wurden auf Si/SiO2 . hergestellt /Ti/Pt- und Si/TiN-Substrate mit Pt-Top-Elektroden von ALD. Der Einfluss der unteren Elektroden von Pt und TiN auf das RS-Verhalten von HfO2 /TiO2 /HfO2 Geräte wurden sorgfältig untersucht. Die entsprechende Erklärung wurde vorgeschlagen.
Methoden
In diesem Experiment haben wir zwei verschiedene untere Elektroden verwendet, darunter kommerzielles Si/SiO2 /Ti/Pt und hausgemachtes Si/SiO2 /Zinn. Leitfähiges TiN wurde in unserem Labor durch plasmaunterstützte Atomlagenabscheidung (PEALD) abgeschieden.
ALD wurde in einer kommerziellen Picosun SUNALE TM . durchgeführt R-200 Advanced Reaktor (Picosun, Finnland). P Als Ausgangssubstrate wurden Si(100)-Wafer mit einem spezifischen Widerstand von 1~10 Ω cm verwendet. Nach der herkömmlichen RCA-Reinigung der Si-Wafer ohne Entfernen des nativen Oxids wurde 30 nm dickes TiN auf Si als untere Elektrode bei 400 °C durch PEALD unter Verwendung von TiCl4 . bei Raumtemperatur abgeschieden und NH3 Plasmagas als Ti- bzw. N-Vorläufer. Flüssiges NH3 wurde als NH3 . ausgewählt Plasmaquelle bei Raumtemperatur. Die Plasmaleistung und NH3 der Gasdurchfluss betrug 2500 W bzw. 150 sccm.
Anschließend 5 nm HfO2 /10 nm TiO2 /5 nm HfO2 Stapelstrukturen wurden wiederum auf Pt- und TiN-beschichteten Si-Substraten bei 250 °C durch thermische ALD unter Verwendung von Hf[N(C2 .) abgeschieden H5 )CH3 ]4 (TEMAH), TiCl4 , und H2 O als Hf-, Ti- bzw. O-Vorstufen, wobei ein Oxidzyklus aus 0,1s . bestand Injektion einer Metallquelle, 4s N2 Spülen, 0,1s H2 O Injektion und 4s N2 Reinigung. TEMAH wurde bei 150 °C verdampft. Reines N2 (99,999 %) wurde als Trägergas und Spülgas verwendet. Dann wurden 100 nm dicke Pt-Oberseitenelektroden mit dem Q150T-System durch eine Lochmaske mit einem Durchmesser von 150 μm DC gesputtert.
Das Wachstum pro Zyklus (GPC) von reinem HfO2 oder TiO2 auf Si wurde mit einem spektroskopischen Ellipsometer (GES-5, Sopra) bestimmt. Die Topographie und Oberflächenrauhigkeit der Filme und unteren Elektroden wurden durch Rasterkraftmikroskopie (AFM, Cypher, Asylum Research) analysiert. Die Rauhigkeitswerte des quadratischen Mittelwerts (RMS) wurden aus Bereichen von 1 μm × 1 μm aufgezeichnet. Die Zusammensetzung und der chemische Zustand der Stapelstrukturen wurden durch Röntgenphotoelektronenspektroskopie (XPS, Thermo Fisher K-Alpha) mit einem monochromatischen Al Kα . untersucht Quelle (hν = 1486.6 eV) zur Anregung von Photoelektronen. Der Ladungseffekt wurde durch Einstellen der C 1s . kalibriert Photoemission bei 284,6 eV. Das XPS-Tiefenprofil von HfO2 /TiO2 /HfO2 auf Pt- und TiN-beschichtetem Si wurde durch Ar-Ionenätzen erhalten. Die elektrischen Eigenschaften von HfO2 /TiO2 /HfO2 RRAM-Bauelemente mit dreischichtiger Struktur wurden mit einem Keithely 4200-Halbleiter-Charakterisierungssystem auf einer Sondenstation (CasCade Summit 12000 B-M) gemessen. Eine Stromkonformität von 10 mA wurde vorgeschrieben, um die hergestellten Geräteeinheiten vor Beschädigungen durch hohe Ströme während der Setzprozesse zu schützen. Die Vorspannung wurde an die obere Pt-Elektrode angelegt, wobei die geerdeten unteren Elektroden aus Pt oder TiN bestanden.
Ergebnisse und Diskussion
Das Schema des RRAM-Bausteins von HfO2 /TiO2 /HfO2 Die Dreischichtstruktur von ALD ist in Abb. 1 dargestellt. Die Oberflächenmorphologie und -rauheit der unteren Elektroden und die Dreischichtstruktur von HfO2 /TiO2 /HfO2 auf Pt- und TiN-beschichtetem Si wurden untersucht. Die untere Pt-Elektrode hat einen kleineren RMS-Wert von 0,39 nm als von PEALD abgeleitetes TiN von 0,87 nm. Daher die Probe von HfO2 /TiO2 /HfO2 auf Pt-beschichtetem Si weist mit einem RMS von 0,68 nm auch eine relativ glattere Oberfläche auf als auf TiN-beschichtetem Si mit 1,3 nm.
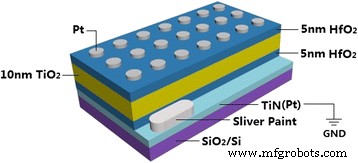
Das Schema des RRAM-Bausteins von HfO2 /TiO2 /HfO2 Dreischicht-Struktur von ALD
Die DC I-V-Kurven von Pt/HfO2 /TiO2 /HfO2 /Pt und Pt/HfO2 /TiO2 /HfO2 /TiN-Vorrichtungen, die den anfänglichen Elektroformungsprozess enthalten, sind in Fig. 2a bzw. b aufgetragen, was eine typische bipolare Widerstandsschaltcharakteristik anzeigt. Bei fast allen Proben wird eine größere Formierspannung benötigt, um vor dem Schalttest leitfähige Filamente zu bilden. Beim Anlegen einer positiven Vorspannung an die obere Pt-Elektrode wird das Pt/HfO2 /TiO2 /HfO2 /Pt-Geräteeinheit zeigt in Fig. 2a eine Formierspannung von +7 V. Bei fortgesetztem Spannungs-Sweep wird eine Rücksetzspannung von –0,8 V für die Elementarzelle von LRS zu HRS und eine eingestellte Spannung von 2,0 V von HRS zu LRS gemessen. Das entsprechende Verhältnis von hohen und niedrigen Widerständen beträgt etwa 10 5 . Der Galvanoformungs- und Ruheprozess kann auch durch Anlegen einer negativen Spannung von -11 V bzw. einer positiven von +4 V abgeschlossen werden, die viel größer sind als die positive Formungsspannung und die negative Rücksetzspannung. Darüber hinaus schaltet die Gerätezelle nach dem Negativformprozess nur für mehrere Zyklen von LRS auf HRS um und kann dann aufgrund des irreversiblen Ausfalls (hier nicht gezeigt) nicht auf HRS zurückgesetzt werden. In Fig. 2b zeigen die RRAM-Bauelemente mit dreischichtiger Struktur mit asymmetrischer unterer TiN-Elektrode und oberer Pt-Elektrode im Vergleich zu denen mit symmetrischen oberen und unteren Elektroden aus Pt eine entgegengesetzte niedrigere Formierspannung von etwa –3,7 V, eine eingestellte Spannung von –1,5 V , Rücksetzspannung von +1,5 V und ein relativ kleineres Verhältnis von hohem und niedrigem Widerstand von 10 2 . Beim Anlegen der positiven Galvanoformungsspannung kann das RS-Phänomen im Pt/HfO2 . nicht beobachtet werden /TiO2 /HfO2 /TiN-Zelle und das Gerät wird bei +14 V ohne den folgenden effizienten Reset von LRS auf HRS bei negativer Spannung dauerhaft zerstört (hier nicht gezeigt).
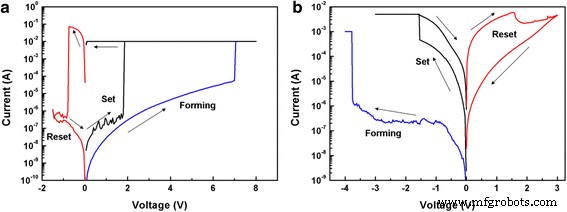
Die typischen bipolaren resistiven Schalteigenschaften der RRAM-Bauelemente. a Pt/HfO2 /TiO2 /HfO2 /Pkt. b Pt/HfO2 /TiO2 /HfO2 /TiN
Die RRAM-Bauelemente mit dreischichtiger Struktur mit symmetrischen oberen/unteren Elektroden aus Pt und asymmetrischer unterer TiN-Elektrode/oberen Pt-Elektroden zeigen eine solche unterschiedliche Polaritätspräferenz für die Elektroformung. Die untere Elektrode aus chemisch inertem Pt oder relativ aktivem TiN scheint eine Schlüsselrolle zu spielen. Der damit verbundene Grund für die elektrodenabhängige Galvanoformungspolarität wird später diskutiert, nachdem die XPS-Tiefenprofile von Dreischichtstrukturen von HfO2 . betrachtet wurden /TiO2 /HfO2 auf Pt- und TiN-beschichtetem Si.
Für eine Speicheranwendung mit hoher Dichte ist die Einheitlichkeit der RS-Parameter sehr wichtig. In Abbildung 3a, b sind die statistischen Ergebnisse der Verteilung der Setz- und Rücksetzspannungen aufgetragen, die von einer einzelnen Geräteeinheit des Pt/HfO2 . gemessen wurden /TiO2 /HfO2 /Pt und Pt/HfO2 /TiO2 /HfO2 /TiN für 200-fache Tests bzw. Abbildung 3c, d zeichnet die I-V-Kurven von 10 zufällig ausgewählten Geräteeinheiten des Pt/HfO2 auf /TiO2 /HfO2 /Pt und Pt/HfO2 /TiO2 /HfO2 /TiN bzw. Die dreischichtigen RRAM-Bauelemente mit symmetrischen oberen und unteren Elektroden aus Pt zeigen eine breite Verteilung für die Setzspannung von 1,2 bis 2,8 V und die Resetspannung von -0,5 bis -1 V (Abb. 3a) und dispersive I-V-Kurven (Abb. 3c). Dagegen zeigen die Geräteeinheiten mit asymmetrischen unteren TiN- und oberen Pt-Elektroden ein besseres RS-Verhalten, wie z (Abb. 3b, d). Gleichzeitig verhalten sich unterschiedliche Bauelemente auf TiN-beschichtetem Si im Vergleich zu denen auf Pt-beschichtetem Si auch verbesserte Monodispersionen bei den RS-Parametern, was für praktische RRAM-Anwendungen von Vorteil ist.

Die statistischen Ergebnisse der Verteilung der Setz- und Rücksetzspannungen gemessen von einer einzigen Geräteeinheit für 200-malige Tests. a Pt/HfO2 /TiO2 /HfO2 /Pkt. b Pt/HfO2 /TiO2 /HfO2 /Zinn. Die I-V-Kurven von 10 zufällig ausgewählten Geräteeinheiten. c Pt/HfO2 /TiO2 /HfO2 /Pkt. d Pt/HfO2 /TiO2 /HfO2 /TiN
Die Beständigkeits- und Retentionseigenschaften der Geräteeinheiten von Pt/HfO2 /TiO2 /HfO2 /Pt und Pt/HfO2 /TiO2 /HfO2 /TiN wurden untersucht, wie in Abb. 4a–d jeweils zu sehen ist. In Pt/HfO2 /TiO2 /HfO2 /Pt wurde die Wobbelspannung von 0 bis 3 V für das Setzen und von 0 bis -1,5 V für das Zurücksetzen angelegt. In Pt/HfO2 /TiO2 /HfO2 /TiN wurde die Wobbelspannung von 0 bis -2 V für das Setzen und 0 bis 2 V für das Zurücksetzen angelegt. Die ON- und OFF-Widerstandswerte wurden mit 0,2 V bei Raumtemperatur abgelesen. Die Retentionstests wurden bei Raumtemperatur mit einer Lesespannung von 0,2 V gemessen. Nach 200 Programmier-/Löschzyklen Pt/HfO2 /TiO2 /HfO2 /Pt-Geräteeinheiten zeigen ein relativ stabiles Widerstandsverhältnis von AUS/EIN-Zuständen über 10 5 (Abb. 4a); jedoch die Beständigkeitscharakteristik von Pt/HfO2 /TiO2 /HfO2 /TiN-Speicherzellen scheinen nicht so gut zu sein wie die von Pt/HfO2 /TiO2 /HfO2 /Pt (Abb. 4b). Die EIN- und AUS-Zustände in Geräten mit Pt-TiN-Elektroden sind bei einem kleineren Widerstandsverhältnis von AUS/EIN-Zuständen von etwa 10 2 . nicht sehr konstant während des Schaltzyklustests, insbesondere signifikante HRS-Schwankung als die von LRS. Basierend auf dem physikalischen Modell in Ref. [12] wird die Ausdauer durch Erhöhung der Bildungsenergie der Sauerstoffleerstelle und der Grenzfläche O 2− . verbessert Höhe. Wir spekulieren über eine plausible Erklärung. In unserer früheren Arbeit [14] wurden ausgezeichnete bipolare resistive Schalteigenschaften von ALD-abgeleitetem Al2 O3 /HfO2 /Al2 O3 Trilayer-Strukturen mit asymmetrischen TiN-Boden- und Pt-Top-Elektroden wurden demonstriert, einschließlich einer besseren Schaltdauer von bis zu 10 3 Zyklen mit stabilem ON/OFF-Widerstandsverhältnis. Hier haben wir HfO2 . übernommen /TiO2 /HfO2 konfigurieren statt Al2 O3 /HfO2 /Al2 O3 . Die Metallionen in HfO2 und TiO2 haben die gleiche identische chemische Wertigkeit von +4, was zu weniger grenzflächengeladenen Defekten wie Sauerstoffleerstellen zwischen zwei Grenzflächenschichten (ILs) aus dreischichtigem HfO2 . führt /TiO2 /HfO2 . Während die Metallionen in Al2 O3 und HfO2 haben unterschiedliche chemische Wertigkeit von Al 3+ und Hf 4+ , wodurch mehr grenzflächengeladene Defekte von Sauerstoffleerstellen zwischen zwei ILs von Al2 . erzeugt werden O3 /HfO2 /Al2 O3 . Daraus lässt sich ableiten, dass die Schnittstelle O 2− Betrag durch Hinzufügen von zwei ILs zwischen Al2 O3 /HfO2 /Al2 O3 sollte höher sein als zwischen HfO2 /TiO2 /HfO2 . Darüber hinaus ist die Bildungsenergie der Sauerstoffleerstelle in der Speicherschicht von Al2 O3 /HfO2 /Al2 O3 ist auch höher als die von HfO2 /TiO2 /HfO2 (Bildungsenergie der Sauerstoffleerstelle 7,08 eV (Al2 O3 ), 6,53 eV (HfO2 ) und 4,35 eV (TiO2 .) ) [20, 21]). Nach Berücksichtigung dieser Faktoren ist die Speicherzelle von Pt/HfO2 /TiO2 /HfO2 /TiN weist im Vergleich zu Pt/Al2 . eine Ausdauerdegeneration auf O3 /HfO2 /Al2 O3 /TiN.

Die Ausdauer- und Retentionseigenschaften der Geräteeinheiten. a , c Pt/HfO2 /TiO2 /HfO2 /Pkt. b , d Pt/HfO2 /TiO2 /HfO2 /TiN.
Für Pt/HfO2 /TiO2 /HfO2 /Pt und Pt/HfO2 /TiO2 /HfO2 /TiN, das Widerstandsniveau der EIN- und AUS-Zustände ändert sich nach einer kumulativen Wartezeit von 10 4 . nicht s bei Raumtemperatur in Abb. 4c–d, was auf eine bessere Retentionseigenschaft beider Speicherzellen über 10 Jahre basierend auf der Extrapolationsmethode hinweist.
Pt/HfO2 /TiO2 /HfO2 /TiN-Geräte haben ein viel niedrigeres Widerstandsverhältnis von AUS/EIN-Zuständen als Pt/HfO2 /TiO2 /HfO2 /Pt, was auf den Unterschied der unteren Elektroden in Austrittsarbeit und Leitfähigkeit zurückgeführt werden kann. Die Austrittsarbeit der unteren Pt- und TiN-Elektroden beträgt 5,65 bzw. 4,5 eV; daher die Grenzflächenbarriere zwischen TiN und dem zugrunde liegenden HfO2 ist relativ niedriger im Pt/HfO2 /TiO2 /HfO2 /TiN-Gerät. Während eines Reset-Prozesses ist die benötigte Energie für das Elektron, um die Barriere zu überwinden, ebenfalls geringer. Also Pt/HfO2 /TiO2 /HfO2 /TiN zeigt im AUS-Zustand einen niedrigeren Widerstandswert als Pt/HfO2 /TiO2 /HfO2 /Pt entsprechend. Während eines Setzvorgangs wechselt das RRAM-Bauelement aufgrund der Bildung der leitenden Kanäle von HRS in LRS. Die untere Pt-Elektrode hat eine höhere Leitfähigkeit als die untere TiN-Elektrode; entsprechend der Widerstandswert im EIN-Zustand für Pt/HfO2 /TiO2 /HfO2 /TiN ist höher als bei Pt/HfO2 /TiO2 /HfO2 /Pkt. Als Ergebnis Pt/HfO2 /TiO2 /HfO2 /TiN-Geräte zeigen ein kleineres Widerstandsverhältnis von AUS/EIN-Zuständen von 10 2 . Das Widerstandsverhältnis von 10 2 hat bereits die Anforderungen von RRAM-Anwendungen erfüllt.
Um den Leitungsmechanismus beim ohmschen Schalten zu verdeutlichen, sind die typischen I-V-Kurven in doppeltlogarithmischer Skala aufgetragen. Abbildung 5a, b zeigen die lineare Anpassung der I-V-Kurven für die Spannungs-Sweep-Bereiche von Pt/HfO2 /TiO2 /HfO2 /Pt und Pt/HfO2 /TiO2 /HfO2 /TiN-Geräte. Beide Speicherzellen verhalten sich ähnlich leitend. Wenn das Gerät auf LRS umgeschaltet wird, sind die Kurven von log (I)-log (V) linear mit einer Steigung nahe 1 (0,94 in Abb. 5a, 0,98 in Abb. 5b), was darauf hindeutet, dass die I–V am LRS wird vom Ohmschen Gesetz dominiert. Das Filamentmodell der Sauerstoffleerstellenmigration kann verwendet werden, um das Schaltverhalten zu erklären. Für die HRS wird im Niederspannungsbereich (Absolutwert <0,11 V) die I–V vom Ohmschen Gesetz mit der linearen Beziehung von Strom und Spannung dominiert (Steigung 1,05 in Abb. 5a, 1,09 in Abb. 5b). Im höheren Spannungsbereich (6,8 V > Absolutwert>0,11 V in Abb. 5a, 1,85 V > Absolutwert>0,11 V in Abb. 5b) beträgt die Steigung der log (I)-log (V)-Linien etwa 2 und der Strom ist abhängig vom ungefähren Quadrat der angelegten Spannung (I/V 2 ). Bei kritischer Spannung (Absolutwert 6,8 V in Abb. 5a, 1,85 V in Abb. 5b) tritt plötzlich ein steiler Stromanstieg mit sehr großer Steigung auf. Dieses Ergebnis besteht aus drei Regionen in HRS, die im Wesentlichen der typischen Fallen-kontrollierten Raumladungs-begrenzten Leitungsinjektion (SCLC) gehorchen [11].
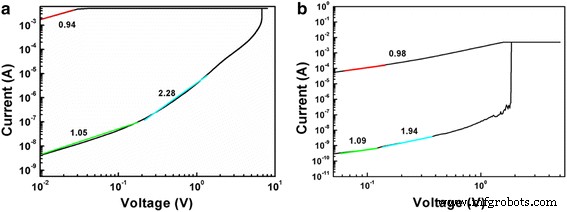
Die typischen I-V-Kurven in doppelt-logarithmischer Skala von a Pt/HfO2 /TiO2 /HfO2 /Pt und b Pt/HfO2 /TiO2 /HfO2 /TiN
Um den zugrunde liegenden resistiven Schaltmechanismus von HfO2 . besser zu verstehen /TiO2 /HfO2 an Pt-beschichtetem und TiN-beschichtetem Si führten wir die XPS-Narrow-Scans und Tiefenanalysen an Dreischichtstrukturen mit symmetrischen und asymmetrischen Bottom/Top-Elektroden durch. XPS-Spektren wurden mit Gauß-Lorentz-Funktionen (G-L) nach intelligenter Hintergrundsubtraktion ausgestattet.
Abbildung 6a–d zeigen die Narrow-Scan-XPS-Spektren von Hf 4f , Ti 2p , und O 1s Peaks in HfO2 und TiO2 Schichten auf TiN-beschichtetem Si. Die Hf 4f und Ti 2p-Spektren von HfO2 und TiO2 Schichten können in zwei Gruppenpeaks entfaltet werden. Das stärkere Hf 4f 5/2 und Hf 4f 2.07 Peaks bei 18,4 und 16,7 eV mit einer Spin-Bahn-Aufspaltung von 1,7 eV werden der Hf-O-Bindung (Hf 4+ ) von HfO2 (Abb. 6a). Die schwächeren Spin-Bahn-Dublett-Peaks bei niedrigeren Bindungsenergien von 17,6 und 14,8 eV resultieren möglicherweise aus dem niederchemischen Valenzzustand von Hf n + –O (n < 4), was auf das Vorhandensein von Sauerstoffleerstellen in HfO2 . hinweist Schicht. Die berechnete prozentuale Konzentration von Hf n + (n < 4) beträgt etwa 3,7% in Hf-Ionen. In Fig. 6b entspricht ein stärkeres Dublett Ti 2p . 3/2 und 2p 1/2 Merkmale bei 458,8 und 464,5 eV, die zur Ti-O-Bindung gehören (Ti 4+ ) aus TiO2 . Ein schwächeres Dublett wird bei 456,1 und 462,0 eV lokalisiert und dem Ti 3+ . zugeordnet –O Bindung. Die berechnete prozentuale Konzentration von Ti 3+ beträgt etwa 21% in Ti-Ionen. Dies impliziert die Existenz von Sauerstoff-Leerstellen in TiO2 Schicht.
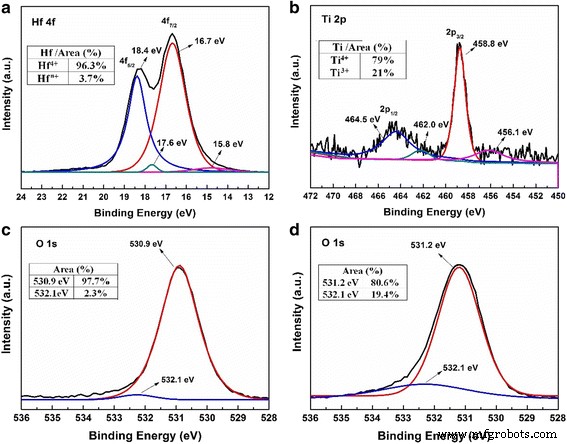
Narrow-Scan XPS-Spektren der Dreischichtstruktur von HfO2 /TiO2 /HfO2 auf TiN-beschichtetem Si. a Hf 4f, b Ti 2p Peaks von HfO2 /TiO2 /HfO2. O 1s Spitzen von c HfO2 und d TiO2 Schichten
Die O 1s Spektren von HfO2 und TiO2 Schichten können auch in zwei Peaks entfaltet werden, wie in Abb. 6c, d zu sehen. Die relativ niedrigeren Bindungsenergien der O 1s Peak bei ~530,9 und 531,2 eV werden der Ti-O- und Hf-O-Bindung in TiO2 . zugeordnet und HfO2 Schichten, die zum Gittersauerstoff ohne Sauerstoffleerstellen gehören. Während die etwas höhere Energie von 532,1 eV im O 1s Spektren von Abb. 6c, d werden den Sauerstoffatomen in der Nähe von Sauerstoffleerstellen in HfO2 . zugeschrieben und TiO2 Schichten basierend auf den Literaturberichten [22,23,24,25]. Die relative Sauerstoffleerstellenkonzentration in der Oxidschicht kann grob durch Berechnung des Flächenanteils jedes Peaks bewertet werden [22, 23]. Die berechnete prozentuale Konzentration der Sauerstoffleerstelle in HfO2 und TiO2 Schichten beträgt etwa 2,3 bzw. 19,4 %, entsprechend den Ergebnissen von Hf n + und Ti 3+ .
Abbildung 7a, b zeigt die XPS-Tiefenprofile von HfO2 /TiO2 /HfO2 Proben auf Pt- bzw. TiN-beschichtetem Si durch Ar-Ionenätzen. Die Dreischichtstruktur von HfO2 /TiO2 /HfO2 auf Pt- und TiN-beschichtetem Si ist leicht zu erkennen, obwohl die signifikante Grenzflächendiffusion zwischen HfO2 /TiO2 und HfO2 /TiN wurde beobachtet. Normalerweise dominiert das Filamentmodell der Sauerstoffleerstellenmigration das RS-Verhalten in RRAM-Bauelementen auf der Basis von Übergangsmetalloxiden [11]. Eine einfache Erhöhung des Sauerstoffleerstellengehalts ist jedoch nicht vollständig wirksam. Wie die Verteilung von Sauerstoffleerstellen-Filamenten effektiv kontrolliert werden kann, ist ein Schlüsselproblem, um die RS-Gleichmäßigkeit endgültig zu verbessern [20]. Viele Arbeiten haben gezeigt, dass normalerweise eine ungleichmäßige Verteilung von Sauerstoffleerstellen für das RS-Verhalten von Vorteil ist, einschließlich einer Verringerung der Formierspannung, einer Verbesserung der Schaltstabilität und der Ausdauerfähigkeit [1, 14, 20, 26, 27, 28, 29]. Eine anfänglich ungleichmäßige Verteilung von Sauerstoffleerstellen in einer Speicheroxidschicht wird häufig durch die Verwendung einer chemisch aktiven Elektrode mit einer relativ hohen Sauerstoffaffinität (z. B. Ta, Ti, Al oder TiN) oder durch bewusstes Einführen einer sauerstoffleerstellenreichen Grenzflächenschicht durch Interface Engineering [1, 17, 30].
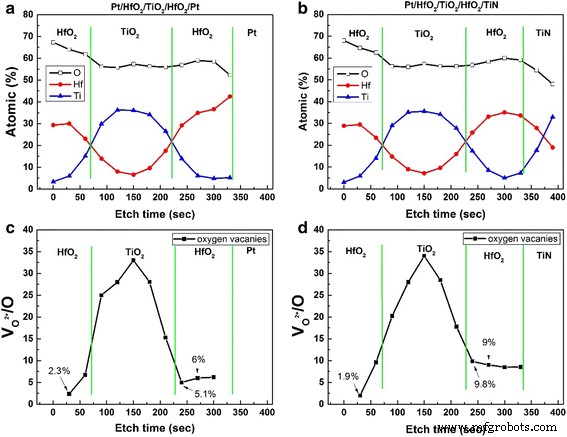
XPS-Tiefenprofile von HfO2 /TiO2 /HfO2 auf Pt- und TiN-beschichtetem Si durch Ar-Ionenätzen. a HfO2 /TiO2 /HfO2 auf Pt-beschichtetem Si. b HfO2 /TiO2 /HfO2 auf TiN-beschichtetem Si. Die Tiefenverteilung der Sauerstoffleerstellenkonzentration (V O 2+ /O) bestimmt aus XPS-Spektren für HfO2 /TiO2 /HfO2 auf Pt- und TiN-beschichtetem Si. c HfO2 /TiO2 /HfO2 auf Pt-beschichtetem Si. d HfO2 /TiO2 /HfO2 auf TiN-beschichtetem Si
Abbildung 7c, d zeigt die Verteilungskurven der Sauerstoffleerstellenkonzentration von HfO2 /TiO2 /HfO2 auf Pt- und TiN-beschichtetem Si basierend auf den obigen XPS-Tiefenprofilen. Die Sauerstoffleerstellenkonzentration wurde unter Verwendung des oben erwähnten Verfahrens bewertet. Es kann festgestellt werden, dass die höchste Sauerstoffleerstellenkonzentration (~34 %) in TiO2 . auftritt Zwischenschicht. Ein weiteres bemerkenswertes Merkmal ist, dass das zugrunde liegende HfO2 Schicht in der Nähe der unteren Pt- oder TiN-Elektroden hat eine höhere Sauerstoffleerstellenkonzentration als das obere HfO2 Schicht (~2%). Außerdem die Sauerstoffleerstellenkonzentration (~9%) des zugrunde liegenden HfO2 Schicht auf TiN-beschichtetem Si ist offensichtlich höher als die (~6%) auf Pt-beschichtetem Si.
Abbildung 8 zeigt die schematische Darstellung des Galvanisierens und Zurücksetzens von Pt/HfO2 /TiO2 /HfO2 /Pt bei positiven und negativen Vorspannungen. Bei chemisch inerten Pt-Ober- und -Unterelektroden hängen die von der Polarität abhängigen Galvanoformungsphänomene mit dem O2 . zusammen Gas, das aus der Oxidschicht an der Anode als Produkt der Elektroreduktion freigesetzt wird. Wie bekannt, werden während des Elektroformungsprozesses Sauerstoffleerstellen durch ein hohes elektrisches Feld erzeugt und wandern zur Kathode, wodurch lokalisierte leitende Filamente in der Oxidschicht gebildet werden, d. h. O O →V O 2+ + O 2− , V O 2+ + 2e − →V O [12] (Abb. 8b, e). Gleichzeitig O 2− Ionen driften zur Anode, geben ihre Ladung ab und entwickeln O2 Gas, d. h. O 2− →1/2O 2 + 2e − (Abb. 8b, e), die möglicherweise eine physikalische Verformung der Zelle bis hin zur Bildung von Rissen oder Löchern verursachen können [31]. Beim Anlegen einer positiven Formierspannung an die obere Pt-Elektrode postulieren wir den O2 über dem oberen HfO2 freigesetztes Gas Film entweicht leicht am Rand der oberen Elektrode oder durch kleine Nanoporen in der oberen Pt-Elektrode (Abb. 8b), was eine schwache physikalische Verformung verursacht. In Anbetracht der relativ höheren Sauerstoffleerstellenkonzentration im zugrunde liegenden HfO2 (~6%) in der Nähe der unteren Pt-Elektrode als die obere HfO2 Schicht (~2,3 %) (Abb. 7c) bildet sich der leitfähige Faden leicht, was zu einer kleineren positiven Formierungsspannung von +7 V führt. Bei einer Sperrspannung von -0,8 V führt die Rückreaktion zu einem Fadenbruch, und das Gerät ist einfach in den HRS-Zustand zurückschalten (Abb. 8d).

Schematische Darstellung der Galvanoformung und Rücksetzung der Dreischichtstruktur von HfO2 /TiO2 /HfO2 mit symmetrischen Pt-Ober- und -Unterelektroden. a –d Galvanisieren bei positiver Spannung und Reset bei negativer Spannung. e –g Galvanisieren bei negativer Spannung und Reset bei positiver Spannung
Umgekehrt bildet sich bei einer negativen Formierspannung an der oberen Elektrode Sauerstoffgas unter dem darunter liegenden HfO2 Schicht und über Pt die untere Elektrode (Abb. 8e). Die O2 das Lösen wird schwieriger, was die Bildung von leitfähigen Filamenten behindert. Da die Sauerstoffleerstellenkonzentration des oberen HfO2 Schicht (~2,3%) ist niedriger als die des darunter liegenden HfO2 (~6%) (Abb. 7c) wird die höhere negative Formierspannung von -11 V benötigt, um Filamente zu formen. Wenn mehr O2 akkumuliert sich zu einem gewissen Druck unter dem zugrunde liegenden HfO2 , it possibly erupts from the mechanically weakest part of the thin films, leading to the hole in oxide films or separation between oxide films and the bottom electrode induced by bubble cracking. Although the device can be reset to HRS at applied +4 V bias (Fig. 8g), the memory cell is degraded after several switching cycles. In our samples, a part of top electrode was blown off after the forming process. Similar electroforming polarity preference scenario has also been observed in Pt/TiO2−x /Pt bipolar RRAM cells with various physical deformation evidences of the junctions [31, 32].
Pt/HfO2 /TiO2 /HfO2 /TiN devices exhibit quite different electroforming polarity from Pt/HfO2 /TiO2 /HfO2 /Pt. The LRS caused by electroforming can be observed at both negative and positive bias voltage; however, the effective reset from LRS to HRS can be achieved only at positive bias voltage in Pt/HfO2 /TiO2 /HfO2 /TiN device. Similar electroforming preference with asymmetric Pt and TiN electrodes has been observed in some literatures with various storage oxide layers such as HfO2 [33, 34], TiO2 [35], ZrO x /HfO y bilayer [22], and Al2 O3 /HfO2 /Al2 O3 trilayer [14]. However, the related explanations are divergent or lacking.
After considering the TiN electrode’s chemical activity with oxygen [1, 30, 36] and the nondistribution of oxygen vacancy concentration in trilayer-structure of HfO2 /TiO2 /HfO2 based on the XPS depth profiles (Fig. 7), a possible mechanism on electroforming polarity preference of Pt/HfO2 /TiO2 /HfO2 /TiN cells is proposed. Figure 9 shows the schematic diagrams of electroforming and reset of Pt/HfO2 /TiO2 /HfO2 /TiN at negative and positive bias voltages. The TiN bottom electrode plays a key role in the electroforming polarity. Kwak et al. reported that the relatively active TiN electrode would easily absorb oxygen ions from oxide films to form TiO x N1−x (TiON) interfacial layer [36]. The severe oxygen diffusion of underlying HfO2 layer into TiN bottom electrode has been confirmed in our sample by the XPS depth profile (Fig. 7b). For Pt/HfO2 /TiO2 /HfO2 /TiN device, the TiN electrode with high oxygen affinity [34, 36] produces a lot of oxygen vacancies in the underlying HfO2 layer near the TiN bottom electrode. The oxygen vacancies concentration of ~9% of underlying HfO2 layer is much higher than that of ~6% in the Pt/HfO2 /TiO2 /HfO2 /Pt device.
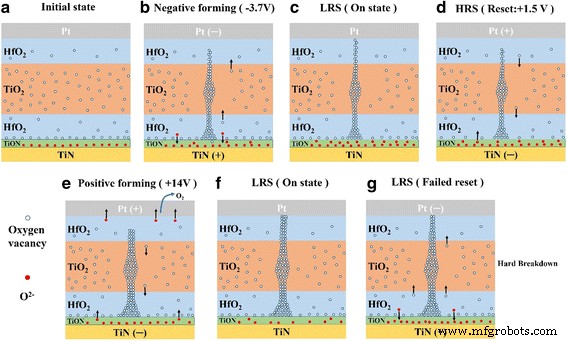
Schematic diagrams of electroforming and reset of trilayer-structure of HfO2 /TiO2 /HfO2 with asymmetric Pt top electrode and TiN bottom electrode. a –d Electroforming at negative voltage and reset at positive voltage. e –g Electroforming at positive voltage and reset at negative voltage
For chemically inert Pt top electrode and relatively active TiN bottom electrode, when applying negative forming voltage, O 2− ions drift towards the TiN anode and are absorbed to form TiO x N1−x layer (Fig. 9b), i.e., TiN + x O 2− →TiO x N 1−x + x 2e , avoiding the O2 release and possible damage to cells. The TiN electrode might act as a reservoir for oxygen ions drifting under an applied voltage [1, 36]. Simultaneously, due to the higher oxygen vacancy in the underlying HfO2 layer (~9%) and intermediate TiO2 layer (~10–34%) than the upper HfO2 layer (~1.9%), the migration of the rich oxygen vacancies from the underlying HfO2 layer through TiO2 layer towards the the upper HfO2 layer, directly producing conductive oxygen vacancy filaments with a smaller forming voltage of −3.7 V (Fig. 9b). When performing reverse reset process at +1.5 V, the bottom electrode of TiN layer acting as oxygen reservoir supplies oxygen ions to react with oxygen vacancy, i.e., O 2− + V O 2+ →O O (lattice oxygen), which is beneficial to the reset operation from LRS to HRS with rupture of conductive filament (Fig. 9d). Above all, the oxygen reservoir effect of TiN bottom electrode contributes the forming voltage reduction as well as better set/reset voltage variation [1, 29, 36].
On the other hand, when imposing the positive forming voltage on top electrode Pt, the oxygen vacancies migrate from the upper HfO2 into the underlying HfO2 on TiN, accumulate in its vicinity, and develop into filaments. Owing to the lower oxygen concentration in the upper HfO2 (~1.9%) than the underlying HfO2 layer (~9%) and intermediate TiO2 layer (~10–34%), this leads to further increase of the oxygen vacancy concentration in underlying HfO2 and intermediate TiO2 Schicht. In the same time, due to slight oxygen existence in PEALD-derived TiN films (about 10%), some oxygen ions in TiN drift into underlying HfO2 layer to form insulate lattice oxygen with nearby oxygen vacancy, preventing from the growth of conductive filaments (Fig. 9e). Finally, when the bias voltage attains +14 V, the coarsening conductive filaments in oxides is formed. However, when a negative voltage is applied on the device, the conductive filament in trilayer structure is too large to be ruptured (Fig. 9g). Therefore, the device cannot switch to HRS by applying a negative voltage, indicating that an irreversible hard breakdown occurs in Pt/HfO2 /TiO2 /HfO2 /TiN device.
Finally, on account of the fact that the inserted TiO2 layer stores more oxygen vacancies than HfO2 layer, the distribution of oxygen vacancies in trilayer structure is not uniform, especially in the two interfacial layers between HfO2 /IL/TiO2 /IL/HfO2 , which might affect the growth position, direction, and overlapping of conductive filaments. The linkage or rupture of the conductive filaments corresponds to the set process from HRS to LRS or the reset process from LRS to HRS, respectively, which more easily happens in two interfacial layers. Further, the shape and position of the conductive filaments in HfO2 and TiO2 layers change less in the set and reset processes.
Schlussfolgerungen
In summary, RRAM devices based on trilayer-structure of Pt/HfO2 /TiO2 /HfO2 /Pt and Pt/HfO2 /TiO2 /HfO2 /TiN have been prepared by ALD. Both memory cells show typical bipolar resistive switching characteristics, and Ohmic and SCLC dominant conduction mechanisms in LRS and HRS, respectively. It is found that the bottom electrodes of Pt and TiN have great influence on the electroforming polarity preference, the ratio of high and low resistances and dispersion of the operating voltage of trilayer-structure memory cells. Compared to with symmetric Pt top/bottom electrodes, the RRAM cells with asymmetric Pt top/TiN bottom electrodes show smaller negative forming voltage of −3.7 V, relatively narrow distribution of the set/reset operation voltages and lower ratio of high and low resistances of 10 2 . The electrode-dependent electroforming polarity can be explained by considering electrodes’ chemical activity with oxygen, the related reactions at anode, and the nonuniform distribution of oxygen vacancy concentration in trilayer-structure of HfO2 /TiO2 /HfO2 on Pt- and TiN-coated Si. Furthermore, the TiN electrode as oxygen reservoir plays an important role in forming voltage reduction and better dispersion of RS parameters for Pt/HfO2 /TiO2 /HfO2 /TiN devices. Considering the modulation effect of electrode and trilayer-structure on resistive switching performance, this work provides a new device design route for future RRAM applications.
Nanomaterialien
- Advanced Atomic Layer Deposition Technologies für Mikro-LEDs und VCSELs
- Retentionsmodell von TaO/HfO x und TaO/AlO x RRAM mit selbstrichtenden Schaltereigenschaften
- Grenzflächen-, elektrische und Bandausrichtungseigenschaften von HfO2/Ge-Stapeln mit in situ gebildeter SiO2-Zwischenschicht durch plasmaunterstützte Atomlagenabscheidung
- Die antibakteriellen hierarchischen Polyamid-6-ZnO-Nanofasern, hergestellt durch Atomlagenabscheidung und hydrothermales Wachstum
- Ein RRAM-integrierter 4T SRAM mit selbsthemmender ohmscher Schaltlast durch reinen CMOS-Logikprozess
- Auswirkung der Verteilung von Goldnanopartikeln in TiO2 auf die optischen und elektrischen Eigenschaften von farbstoffsensibilisierten Solarzellen
- Photokatalytische Eigenschaften von Co3O4-beschichteten TiO2-Pulvern, hergestellt durch plasmaunterstützte Atomlagenabscheidung
- Fermi-Level-Tuning von ZnO-Filmen durch Supercycling-Atomschichtabscheidung
- Eine gemeinsame Studie zur Modellierung und Simulation von resistivem Direktzugriffsspeicher
- Dickenabhängigkeit von Grenzflächen- und elektrischen Eigenschaften in Atomlagen-abgeschiedenem AlN auf c-Ebenen-GaN



