Selbstkatalysiertes Wachstum von vertikalen GaSb-Nanodrähten auf InAs-Stämmen durch metallorganische chemische Gasphasenabscheidung
Zusammenfassung
Wir berichten über das erste selbstkatalysierte Wachstum hochwertiger GaSb-Nanodrähte auf InAs-Stämmen mittels metallorganischer chemischer Gasphasenabscheidung (MOCVD) auf Si(111)-Substraten. Um das Wachstum vertikaler InAs/GaSb-Heterostruktur-Nanodrähte zu erreichen, werden die zweistufigen Flussraten von Trimethylgallium (TMGa) und Trimethylantimon (TMSb) verwendet. Wir verwenden zunächst relativ niedrige TMGa- und TMSb-Flussraten, um die Ga-Tröpfchen auf den dünnen InAs-Stielen zu erhalten. Dann werden die Flussraten von TMGa und TMSb erhöht, um die axiale Wachstumsrate zu erhöhen. Aufgrund der langsameren radialen Wachstumsrate von GaSb bei höherer Wachstumstemperatur weisen bei 500 °C gewachsene GaSb-Nanodrähte größere Durchmesser auf als bei 520 °C gewachsene. In Bezug auf das axiale Wachstum sind jedoch aufgrund des Gibbs-Thomson-Effekts und der Verringerung der Tröpfchenübersättigung mit steigender Wachstumstemperatur bei 500°C gewachsene GaSb-Nanodrähte länger als bei 520 °C gewachsene. Detaillierte Transmissionselektronenmikroskopie (TEM)-Analysen zeigen, dass die GaSb-Nanodrähte eine perfekte Zinkblende (ZB)-Kristallstruktur aufweisen. Die hier vorgestellte Wachstumsmethode könnte für das Wachstum anderer Antimonid-Nanodrähte geeignet sein, und die axialen InAs/GaSb-Heterostruktur-Nanodrähte könnten ein großes Potenzial für den Einsatz bei der Herstellung neuartiger Nanodraht-basierter Bauelemente und beim Studium der grundlegenden Quantenphysik haben.
Hintergrund
III-V-Halbleiter-Nanodrähte gelten aufgrund ihrer einzigartigen elektronischen, optischen und geometrischen Eigenschaften als vielversprechende Kandidaten für elektronische, optische und Quantenbauelemente im Nanomaßstab der nächsten Generation [1,2,3]. Unter den III-V-Halbleitermaterialien haben III-Antimonide aufgrund ihrer einzigartigen Vorteile, wie z Photodetektoren [4], Low-Power-High-Speed-Transistoren [5,6,7] und im Studium der fundamentalen Quantenphysik [8,9,10]. Aufgrund ihrer hohen Atommasse, der geringen Flüchtigkeit von elementarem Sb und der niedrigen Schmelztemperatur von III-Antimonid-Verbindungen ist das Wachstum von Nanodrähten auf Antimonidbasis jedoch äußerst schwierig [11].
Insbesondere GaSb-Nanodrähte, die als äußerst wichtige p-Typ-Antimonid-Nanodrähte gelten, wurden hauptsächlich mit Hilfe von Au-Katalysatoren gezüchtet [12,13,14,15,16]. Die Einführung von Au kann jedoch unerwünschte Rekombinationszentren auf tiefer Ebene in der Si-Bandlücke bilden und die elektronischen und optischen Eigenschaften von III-V-Nanodrähten verschlechtern [17, 18]. Daher ist es sehr wünschenswert, GaSb-Nanodrähte ohne Fremdkatalysatoren zu züchten. Außerdem ist für das vertikale Wachstum von Antimonid-Nanodrähten eine direkte Keimbildung auf dem Substrat sehr schwierig. Um das Problem der Keimbildung zu vermeiden, wird immer zuerst ein kurzer Stamm eines anderen Materials gezüchtet, um das Wachstum von vertikalen GaSb-Nanodrähten zu unterstützen. Kürzlich wurde das selbstkatalysierte Wachstum von GaSb-Nanodrähten auf GaAs-Stämmen durch Molekularstrahlepitaxie (MBE) realisiert [19], aber unseres Wissens gibt es keine Berichte über das Wachstum hochwertiger GaSb-Nanodrähte ohne die Verwendung von Fremdkatalysatoren auf Basis einer metallorganischen chemischen Gasphasenabscheidung (MOCVD). Hier präsentieren wir das selbstkatalysierte Wachstum von GaSb-Nanodrähten mit Hilfe von InAs-Stämmen unter Verwendung von MOCVD auf Si (111)-Substraten. Einerseits ist das Wachstum von GaSb-Nanodrähten auf InAs-Nanodrahtstämmen durch einen selbstkatalysierten Mechanismus aufgrund des Wechsels sowohl der Anionen als auch der Kationen vom InAs-Stamm zum oberen GaSb schwierig. Andererseits ermöglicht das Wachstum von GaSb-Nanodrähten auf InAs-Stämmen aufgrund der geringen Gitterfehlanpassung von 0,6 % und der einzigartigen Typ-II-gebrochenen Bandausrichtung zwischen InAs und GaSb eine neue Plattform für viele Anwendungen, einschließlich Tunnel-basierter Bauelemente [7, 14, 20, 21], Hochgeschwindigkeits-Komplementär-Metall-Oxid-Halbleiter-(CMOS)-Transistoren [22, 23], Forschung zur Elektron-Loch-Hybridisierung [9] und Exziton- und Spinphysikstudien [24].
In diesem Artikel wurden durch sorgfältige Kontrolle der Wachstumsbedingungen hochwertige GaSb-Nanodrähte mit glatten Seitenwänden hergestellt. Um das Wachstum vertikaler InAs/GaSb-Heterostruktur-Nanodrähte zu erreichen, wurden zunächst relativ niedrige Flussraten von Trimethylgallium (TMGa) und Trimethylantimon (TMSb) verwendet, um die Ga-Tröpfchen auf den InAs-Stielen zu erhalten. Dann wurden die Flussraten von TMGa und TMSb erhöht, um das axiale Wachstum der GaSb-Nanodrähte zu verbessern. Aufgrund der langsameren radialen Wachstumsrate von GaSb bei höherer Wachstumstemperatur haben bei 500 °C gewachsene GaSb-Nanodrähte größere Durchmesser als solche, die bei 520 °C gewachsen sind. Aufgrund des Gibbs-Thomson-Effekts und der Verringerung der Tröpfchenübersättigung mit steigender Wachstumstemperatur sind außerdem bei 500 °C gewachsene GaSb-Nanodrähte sowohl im Durchmesser als auch in der Länge größer als die bei 520 °C gewachsenen. Detaillierte Transmissionselektronenmikroskopie (TEM)-Analysen zeigen, dass die Kristallstruktur der InAs-Stämme aus einem Polytyp von Wurtzit (WZ) und Zinkblende (ZB)-Strukturen besteht, während die axial gewachsenen GaSb-Nanodrähte eine reine ZB-Kristallstruktur völlig frei haben von planaren Defekten.
Methoden
Nanodrahtwachstum
Die InAs/GaSb-Heterostruktur-Nanodrähte wurden mit einem motornahen Duschkopf-MOCVD-System (AIXTRON Ltd, Deutschland) bei einem Kammerdruck von 133 mbar gezüchtet. Trimethylindium (TMIn) und TMGa wurden als Vorstufen der Gruppe III verwendet, und Arsin (AsH3 ) und TMSb wurden als Vorstufen der Gruppe V verwendet. Ultrahochreiner Wasserstoff (H2 .) ) als Trägergas verwendet wurde und die Gesamtflussrate von H2 war 12 slm. Die Nanodrähte wurden auf Si(111)-Substraten gezüchtet. Vor dem Wachstum wurden die Substrate zum Tempern auf 635 °C erhitzt und dann unter AsH3 . auf 400 °C abgekühlt Flussmittel, um (111)B-ähnliche Oberflächen zu bilden [25]. Die InAs-Stängel wurden bei 545 °C für 45 s mit TMIn und AsH3 . gezüchtet Durchflussraten von 1.0 × 10 −6 mol/min und 2,0 × 10 −4 mol/min bzw. Anschließend wurden die Quellflüsse von TMIn und AsH3 . umgestellt auf TMGa und TMSb, und die Substrate wurden auf die spezifische Temperatur für das axiale Wachstum von GaSb-Nanodrähten abgekühlt. Schließlich wurden die Proben unter Verwendung von TMSb als Schutzmittel auf Raumtemperatur abgekühlt.
Charakterisierungsmethoden
Die Morphologie der Nanodrähte wurde durch Rasterelektronenmikroskopie (REM) (Nova Nano SEM 650) charakterisiert und TEM (JEM2010F TEM; 200 kV) in Verbindung mit energiedispersiver Röntgenspektroskopie (EDS) wurde verwendet, um die Kristallstruktur zu untersuchen und die Verteilung der elementaren Zusammensetzung. Für TEM-Beobachtungen wurden die gewachsenen Nanodrähte mechanisch von den Proben auf mit einem Kohlenstofffilm beschichtete Kupfergitter übertragen. Raman-Messungen wurden in Rückstreugeometrie bei Raumtemperatur unter Verwendung eines 532-nm-Wellenlängen-Lasers als Anregungsquelle (Jobin-Yvon HR Evolution Raman System) durchgeführt. Die Proben wurden mit einer Laserleistung von 0,36 mW über eine Spotgröße von ca. 1 µm angeregt.
Ergebnisse und Diskussion
Abbildung 1 zeigt eine schematische Darstellung des axialen Wachstums von GaSb-Nanodrähten auf InAs-Stämmen und die Source-Supply-Sequenzen für das Wachstum der Nanodrähte. Die Nanodrähte wachsen über einen selbstkatalysierten Mechanismus, und katalytische Tröpfchen ändern sich allmählich von In zu Ga, nachdem die Flüsse von TMIn und AsH3 . umgeschaltet wurden zu TMGa und TMSb. Im Vergleich zu den Stamm-Nanodrähten haben GaSb-Nanodrähte immer einen viel dickeren Durchmesser, was bedeutet, dass die Größe der katalytischen Ga-Tröpfchen viel größer ist als die der In-Tröpfchen. Dann kann eine zu schnelle Ansammlung von Ga-Adatomen durch die Tröpfchen auf den dünnen InAs-Stielen zu einem Herunterrutschen der Tröpfchen führen (wie in Zusatzdatei 1:Abbildung S1 gezeigt). Um sicherzustellen, dass die katalytischen Tröpfchen genügend Zeit haben, Ga-Adatome während der Übergangsphase von InAs zu GaSb zu sammeln, verwendeten wir zunächst relativ niedrige Flussraten von TMGa und TMSb, um die Ga-Tröpfchen auf den InAs-Stielen zu schützen, wie in Abb. 1 gezeigt. Im ersten Schritt betrugen die Flussraten von TMGa und TMSb 0,35 × 10 –6 . mol/min und 2,0 × 10 −6 mol/min, was einem V/III-Verhältnis von ~5,7 entspricht, und der Wachstumsprozess blieb 15 min (Bereich 2 in Abb. 1). Danach wurden die Flussraten von TMGa und TMSb auf 0,7 × 10 –6 . erhöht, um die axiale Wachstumsrate zu erhöhen mol/min und 4.0 × 10 −6 mol/min für das anschließende Wachstum von GaSb-Nanodrähten (bei konstantem V/III-Verhältnis). Durch die Verwendung der zweistufigen TMGa- und TMSb-Flussraten haben wir erfolgreich das vertikale Wachstum von GaSb-Nanodrähten auf InAs-Stämmen realisiert. Unter Berücksichtigung der unveränderten Wachstumszeit der GaSb-Nanodrähte mit den niedrigen Flussraten sind die in den folgenden Abschnitten erwähnten Wachstumszeiten für GaSb-Nanodrähte, sofern nicht speziell angegeben, identisch mit denen des GaSb-Wachstums mit den hohen Flussraten (Bereich 3 in Abb. 1) .
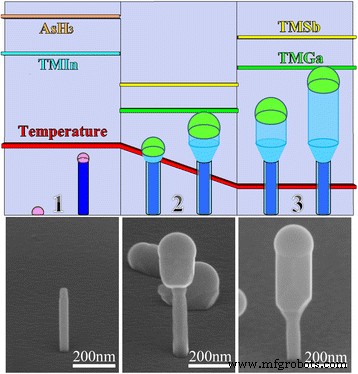
Die Darstellung des axialen Wachstums von GaSb-Nanodrähten auf InAs-Stämmen und die Source-Supply-Sequenzen für das Wachstum der Nanodrähte. Die hier vorgestellten GaSb-Nanodrähte wurden bei 520 °C gezüchtet
Typische SEM-Bilder der auf InAs-Stämmen gewachsenen GaSb-Nanodrähte bei unterschiedlichen Temperaturen von 480, 500, 520 und 545 °C sind in Abb. 2a–d bzw. gezeigt (die InAs-Stämme vor dem GaSb-Wachstum sind in Zusatzdatei 1 gezeigt:Abbildung S2). Die Wachstumszeit von GaSb beträgt 10 min. Es wird beobachtet, dass das Wachstumsverhalten von GaSb sehr empfindlich gegenüber der Wachstumstemperatur ist. Bei 480 °C neigt das GaSb offensichtlich dazu, anstelle eines axialen Wachstums radial um die InAs-Stämme herum oder entlang der planaren Richtung zu wachsen (Abb. 2a). Details über das radiale Wachstum von GaSb-Schalen auf InAs-Kernen und das planare Wachstum von Antimonid-Nanodrähten wurden an anderer Stelle berichtet [26,27,28]. Die Situation ändert sich jedoch mit steigender GaSb-Wachstumstemperatur auf 500 oder 520 °C, wo axiales Wachstum von GaSb-Nanodrähten auf den freistehenden InAs-Stämmen realisiert wird (Abb. 2b, c). Die Ga-Tröpfchen an den Nanodrahtspitzen weisen auf einen selbstkatalysierten Dampf-Flüssig-Feststoff(VLS)-Wachstumsmechanismus der GaSb-Nanodrähte hin. Der Durchmesser der oberen GaSb-Segmente ist im Allgemeinen dicker als der der InAs-Segmente, und die zunehmende Breite der GaSb-Segmente an der InAs/GaSb-Grenzfläche zeigt an, dass die Größe der katalytischen Ga-Tröpfchen im anfänglichen Wachstumsstadium von GaSb allmählich zunimmt. Darüber hinaus können die viel dünneren Stammsegmente in Fig. 2c darauf hindeuten, dass das radiale Wachstum von GaSb mit steigender Wachstumstemperatur von 500 auf 520 °C allmählich abnimmt. Wenn die Temperatur jedoch weiter auf 545 °C erhöht wird, scheinen GaSb-Nanodrähte entlang der planaren oder geneigten Richtung zu wachsen. Darüber hinaus sind die meisten InAs-Schafts verschwunden und der Durchmesser der restlichen InAs-Schafts ist sehr dünn (in Abb. 2d durch die roten Kreise markiert, und weitere REM-Bilder werden in Zusatzdatei 1:Abbildung S3 gezeigt). Wir vermuten, dass die InAs-Stämme bei der hohen Wachstumstemperatur von 545 °C ernsthaft zersetzt werden, was zum Herunterfallen der GaSb-Nanodrähte während des Wachstumsprozesses führt. Um das vertikale Wachstum von GaSb-Nanodrähten auf InAs-Nanodrahtschäften zu erhalten, muss daher die Wachstumstemperatur des GaSb-Nanodrahts sorgfältig kontrolliert werden.

Die 80°-gekippten SEM-Bilder der auf InAs-Stämmen gewachsenen GaSb-Nanodrähte bei a 480 °C, b 500 °C, c 520 °C und d 545 °C für 20 min. Die Wachstumsbedingungen der InAs-Nanodrahtschäfte wurden konstant gehalten. Einsätze in b und c zeigen REM-Bilder mit höherer Vergrößerung. Die roten Kreise in d markieren Sie die restlichen InAs-Stämme
Abbildung 3 zeigt die statistischen Verteilungen von Durchmesser und Länge der in Abbildung 2b, c gezeigten GaSb-Segmente, wobei die Wachstumstemperaturen von GaSb 500 bzw. 520 °C betragen. Die Größenverteilung von bei der gleichen Temperatur gewachsenen GaSb-Nanodrähten (rote oder blaue Punkte in Fig. 3) zeigt eindeutig, dass die dickeren Nanodrähte dazu neigen, länger zu sein. Dieses Phänomen wurde auch für das Ga-katalysierte Wachstum von GaAsP-Nanodrähten durch MBE [29] und für das Au-katalysierte Wachstum von InAs/InSb-Heterostruktur-Nanodrähten durch chemische Strahlepitaxie (CBE) [30] und InGaSb-Nanodrähten durch MOCVD [31 ]. Der Grund wird hauptsächlich auf die geringere effektive Übersättigung (Δμ ) in den kleineren katalytischen Tröpfchen. Für den VLS-Wachstumsmechanismus ist die Übersättigung Δμ , d. h. die Änderung des chemischen Potentials pro III-V-Paar im katalytischen Tröpfchen und dem Nanodraht, ist die Hauptantriebskraft für das Nanodrahtwachstum. Während des selbstkatalysierten Wachstumsprozesses werden Nanodrähte in einer Gruppe-III-reichen Umgebung gezüchtet und die Konzentration der im katalytischen Tröpfchen eingebauten Gruppe-V-Atome dominiert die effektive Übersättigung. Für das selbstkatalysierte Wachstum von GaSb-Nanodrähten ist die effektive Übersättigung Δμ wird von der Konzentration der Sb-Atome dominiert, die in die katalytischen Ga-Tröpfchen eingebaut sind. Daher ist die effektive Übersättigung Δμ kann dargestellt werden als [32, 33]
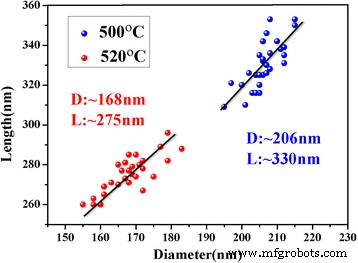
Statistische Daten zu Durchmesser und Länge der bei 500 und 520 °C gewachsenen GaSb-Nanodrähte
.
$$ \varDelta \mu ={k}_{\mathrm{B}} T \ln \left({x}_{\mathrm{Sb}}/{x}_{\mathrm{Sb},\mathrm{ eq}}\right) $$ (1)wo k B ist die Boltzmann-Konstante, T ist die absolute Temperatur. x Sb und x Sb,eq sind der Atomanteil von Sb in den katalytischen Ga-Tröpfchen während des Nanodraht-Wachstumsprozesses bzw. im Gleichgewicht mit dem GaSb-Nanodraht-Kristall. Darüber hinaus wird basierend auf der klassischen Theorie des Kristallwachstums die axiale Wachstumsrate des Nanodrahts (v ) kann ausgedrückt werden als [34].
$$ v\sim {\left(\varDelta\mu /{k}_{\textrm{B}} T\right)}^2 $$ (2)Die Wachstumsrate von Nanodrähten hängt eindeutig stark von der Sb-Konzentration x . ab Sb in den Ga-Tröpfchen. Aufgrund des Gibbs-Thomson-Effekts kann der Dampfdruck von Sb in den katalytischen Tröpfchen mit abnehmendem Durchmesser deutlich ansteigen [35, 36]. Dann können die kleineren Tröpfchen Sb-Atome leichter von den Ga-Katalysatorpartikeln desorbieren, was zu einer niedrigeren Sb-Konzentration führt (x Sb ) in den kleineren katalytischen Ga-Tröpfchen. Infolgedessen ist die effektive Übersättigung in den kleineren Tröpfchen geringer als in den größeren, wodurch die axiale Wachstumsrate der GaSb-Nanodrähte durch den selbstkatalysierten Wachstumsmechanismus verringert wird.
Beim Vergleich der Größenverteilungen von bei 500 und 520 °C gewachsenen GaSb-Nanodrähten wird außerdem beobachtet, dass die bei 500 °C gewachsenen GaSb-Nanodrähte (blaue Punkte in Abb. 3; durchschnittlicher Durchmesser und Länge ∼206 und ~330 nm) sowohl einen größeren Durchmesser als auch eine größere Länge als die bei 520 °C gewachsenen GaSb-Nanodrähte (rote Punkte in Abb. 3; durchschnittlicher Durchmesser und Länge ∼168 und ~275 nm). Die bei 520 °C gewachsenen dünneren Nanodrähte können auf die langsamere radiale Wachstumsrate von GaSb bei höherer Wachstumstemperatur zurückgeführt werden. Für das axiale Wachstum kann jedoch neben dem Gibbs-Thomson-Effekt die Erhöhung der Wachstumstemperatur auch die Tröpfchenübersättigung reduzieren und die axiale Wachstumsrate der GaSb-Nanodrähte weiter reduzieren [29, 37]. Somit sind die bei 500 °C gewachsenen GaSb-Nanodrähte sowohl im Durchmesser als auch in der Länge größer als die bei 520 °C gewachsenen GaSb-Nanodrähte.
Um die Vorteile, die sich aus der Unterstützung der Stiel-Nanodrähte ergeben, weiter zu bestimmen, haben wir dann die direkt auf Si-Substraten und auf kurzen InAs-Stielen aufgewachsenen GaSb-Nanodrähte verglichen, wie in Abb. 4 gezeigt. Die in Abb. 4a, b gezeigten GaSb-Nanodrähte wurden aufgewachsen bei 500 °C, während die in Abb. 4c dargestellten GaSb-Nanodrähte bei 520 °C gezüchtet wurden. Offensichtlich spielen die InAs-Nanodrahtschäfte eine entscheidende Rolle beim erfolgreichen Wachstum von vertikalen GaSb-Nanodrähten. Wie in Abb. 4a gezeigt, wachsen die direkt auf Si(111)-Substraten aufgewachsenen GaSb-Nanodrähte bevorzugt entlang der planaren Richtung (weitere REM-Bilder sind in Zusatzdatei 1:Abbildung S4 verfügbar), und wir spekulieren, dass dieses Problem der Antimonid-Nanodrähte direkt auf Substraten nukleiert wird mit der Tensidwirkung von Sb-Adatomen in Verbindung gebracht, die den Kontaktwinkel zwischen den vorher abgeschiedenen Ga-Tröpfchen und der Si-Substratoberfläche verringern kann [38, 39]. Dagegen werden, wie in Abb. 4b, c gezeigt, vertikale GaSb-Nanodrähte mit Hilfe der kurzen InAs-Stämme hergestellt. Wir stellen fest, dass in Abb. 4b, c die Wachstumszeit der InAs-Nanodrahtschäfte auf 20 s verringert wird (was dazu führt, dass die Länge der InAs-Nanodrähte im Allgemeinen unter 120 nm liegt), während die Wachstumszeit der GaSb-Nanodrähte auf . erhöht wird 30 Minuten. Alle GaSb-Nanodrähte haben über ihre gesamte Länge extrem glatte Seitenwände ohne sichtbare Verjüngung. Bemerkenswerterweise haben die InAs-Stielsegmente fast den gleichen Durchmesser wie die oberen GaSb-Nanodrähte (wie im Einschub von Abb. 4b, c gezeigt), was darauf hindeutet, dass die radiale Wachstumsrate von GaSb um InAs-Stiele herum schneller ist als um obere GaSb-Nanodrähte . Dieser Unterschied könnte mit der Tatsache zusammenhängen, dass die von der Substratoberfläche diffundierten Reaktanten-Adatome dazu neigen, sich um die Seitenwände der dünnen und kurzen InAs-Nanodrähte zu sammeln, was zu einer lokalen Erhöhung der radialen Wachstumsrate von GaSb um die InAs-Stämme herum führt. Schließlich haben die gewachsenen Nanodrähte bei ausreichender Wachstumszeit einen nahezu gleichförmigen Durchmesser entlang der Wachstumsrichtung; das gleiche Verhalten wurde auch beim Wachstum von InSb-Nanodrähten auf Basis kurzer InAs-Stämme durch MOCVD beobachtet [40].

Die um 80° geneigten REM-Bilder der ohne InAs-Stämme gewachsenen GaSb-Nanodrähte (a ) und auf den kurzen InAs-Stämmen (b , c ). Die in a gezeigten GaSb-Nanodrähte und b wurden bei 500 °C gezüchtet, während die GaSb-Nanodrähte in c wurden bei 520 °C gezüchtet. Einsätze in b und c REM-Bilder mit höherer Vergrößerung anzeigen
Um die strukturellen Eigenschaften der erhaltenen Nanodrähte zu untersuchen, wurden detaillierte TEM-Messungen durchgeführt. Abbildung 5a zeigt ein Hellfeld-(BF)-TEM-Bild mit niedriger Auflösung eines typischen GaSb-Nanodrahts, der auf einem InAs-Stiel bei 520 °C aufgewachsen ist (wie in Abbildung 2c gezeigt). Nach dem anschließenden Wachstum des GaSb-Nanodrahts weist der dünnere InAs-Nanodraht eine grobe Morphologie auf. Dies könnte auf die Pyrolyse von InAs und das unregelmäßige radiale Wachstum von GaSb während des GaSb-Nanodraht-Wachstumsprozesses zurückgeführt werden. Abbildung 5b–e stellen die entsprechenden hochauflösenden TEM (HRTEM)-Bilder dar, die aus den in Abbildung 5a mit vier roten Rechtecken markierten Regionen aufgenommen wurden. Die HRTEM-Aufnahme und das zugehörige Fast-Fourier-Transform(FFT)-Muster in Abb. 5b zeigen, dass der axial gewachsene GaSb-Nanodraht eine reine ZB-Kristallstruktur aufweist, die völlig frei von planaren Defekten ist, was üblicherweise beim Wachstum von Antimonid-Nanodrähten beobachtet wird. Die gelegentlichen planaren Defekte (Zwillingsebenen (TPs) und Stapelfehler (SFs)), die an der oberen und frühen Wachstumsregion des GaSb-Nanodrahts auftreten (Abb. 5c, d), können jedoch durch eine leichte Schwankung der lokalen Wachstumsbedingungen während der eventuelle Abkühlungsprozess und die anfängliche Übergangsphase von InAs zum oberen GaSb. Darüber hinaus können die restlichen As-Atome auch eine Rolle bei der Bildung von planaren Defekten im Übergangsbereich spielen (wie in den EDS-Analysen unten gezeigt). Im Gegensatz dazu besteht die Kristallstruktur des InAs-Stamms, wie in Fig. 5e gezeigt, aus einem Polytyp von WZ- und ZB-Strukturen mit einer großen Anzahl planarer Defekte entlang seiner Wachstumsrichtung; aufgrund der Koexistenz von WZ- und ZB-Strukturen teilen sich die entsprechenden FFT-Spots auf und sind entlang der Wachstumsrichtung leicht verlängert (Einschub in Abb. 5e). Es wurde gezeigt, dass Strukturdefekte in Nanodrähten unerwünschte Hemmungen der Ladungsträgermobilität verursachen können [41] und somit die Transporteigenschaften im InAs/GaSb-Heterostruktursystem verringern. Kürzlich wurde berichtet, dass der Einbau von Sb die Kristallqualität von InAs-Nanodrähten effektiv verbessert [42, 43], wodurch das Potenzial der Kristallphasen-Engineering von InAs-Nanodrähten ohne Fremdkatalysatoren erheblich gesteigert wird.
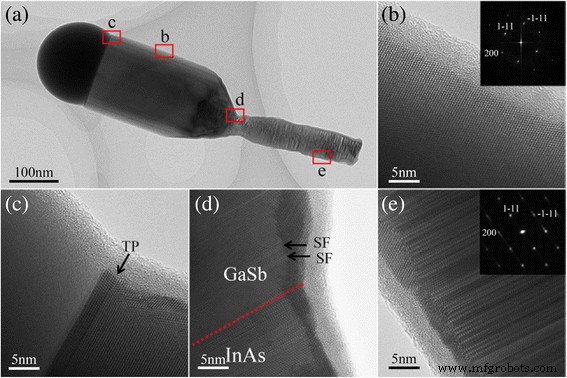
a Ein TEM-Bild mit geringer Vergrößerung eines typischen InAs/GaSb-Heterostruktur-Nanodrahts. b –e Hochauflösende TEM (HRTEM)-Bilder aus den mit roten Rechtecken markierten Regionen in (a ) bzw. Alle HRTEM-Bilder werden von der 110〉-Zonenachse aufgenommen. Die rote gestrichelte Linie in d bezeichnet die Grenzfläche zwischen dem InAs-Stiel und dem oberen GaSb-Nanodraht. Die Einsätze in b und e sind die entsprechenden Muster der schnellen Fourier-Transformation (FFT) des GaSb-Nanodrahts bzw. des InAs-Stamms
Abbildung 6a–f zeigen ein TEM-Bild eines anderen InAs/GaSb-Heterostruktur-Nanodrahts und die entsprechenden EDS-Analysen. Alle EDS-Messungen verwenden die Lα-Emissionssignale von In, As und Sb und das Kα-Emissionssignal von Ga. Der EDS-Linienscan entlang der axialen Richtung (Abb. 6b) und die Elementarkartierung der Nanodrahtzusammensetzung (Abb. 6c–f) zeigen, dass das Tröpfchen hauptsächlich Ga und eine geringe Menge In enthält, während fast kein As oder Sb beobachtet wird, was den selbstkatalysierten Wachstumsmechanismus der GaSb-Nanodrähte direkt bestätigt (Atomprozentsatz aus quantitativer EDS-Punktanalyse in Punkt 1:Ga, 96,13 %, In, 3,8 %, As, 0, Sb, 0,07 % bzw. EDS-Spektren der Punktanalysen in den beiden Spots sind in Zusatzdatei 1:Abbildung S5) gezeigt. Diese schwache In-Konzentration im Tröpfchen wird hauptsächlich der Auflösung der In-Atome im Ga-Tröpfchen während der anfänglichen Übergangsphase von InAs zu GaSb zugeschrieben. Außerdem beginnt gemäß dem EDS-Zeilenscan in Fig. 6b das Wachstum von GaSb-Nanodrähten auf den InAs-Stämmen und aus der EDS-Punktanalyse der Elementarzusammensetzungsverteilung in Punkt 2 (Ga, 48,86 %; In, 0,91 %; As 0,70%, Sb 49,53%), beträgt das stöchiometrische Verhältnis von Ga- und Sb-Atomen im gewachsenen GaSb-Segment etwa 1:1. Die relativ hohen Signale von Ga und Sb im InAs-Abschnitt stammen jedoch aus dem radialen Wachstum des GaSb um den InAs-Stamm, und der elementare Gradient für die In-, As-, Ga- und Sb-Signale in der Nähe der Grenzfläche kann hauptsächlich verursacht werden durch der Rest In und As nach TMIn und AsH3 Flussmittel werden abgeschaltet.

a Die Illustration der axialen InAs/GaSb-Heterostruktur-Nanodrähte und ein TEM-Bild mit geringer Vergrößerung eines bei 520 °C gewachsenen InAs/GaSb-Nanodrahts. b EDS-Zeilenscan entlang der roten Linie markiert in (a ). c –f EDS-Zusammensetzungskarten des Nanodrahts in (a ), die die Verteilung von Ga, Sb, In und As zeigt. Zwei Plätze in a markieren Sie die Stellen, an denen EDS-Punktanalysen durchgeführt wurden
Um die optischen Eigenschaften der gewachsenen GaSb-Nanodrähte zu analysieren, wurden Raman-Messungen durchgeführt. Abbildung 7 zeigt die Raman-Spektren eines GaSb (100)-Substrats und der auf den kurzen InAs-Stielen aufgewachsenen GaSb-Nanodrähte. Im Spektrum des massiven GaSb werden zwei Streupeaks bei ungefähr 226,5 und 235,2 cm −1 . beobachtet (rote Linie in Abb. 7) und werden den transversalen optischen (TO) bzw. longitudinalen optischen (LO) Phononenmoden von GaSb zugeschrieben. Bei GaSb-Nanodrähten wurden ebenfalls deutlich ähnliche zwei Peaks bei ungefähr 225,0 und 233,6 cm −1 . beobachtet im Raman-Spektrum (blaue Linie in Abb. 7), was auf eine hohe photonische Qualität der erhaltenen GaSb-Nanodrähte hinweist. Bei Raman-Rückstreuungsmessungen ist die TO-Phononenmode in (100)-Richtung verboten, ein kleiner Peak der TO-Phononenmode für das Bulk-GaSb-(100)-Substrat könnte auf eine leichte Substratfehlorientierung oder Unvollkommenheit zurückgeführt werden [44]. Da die Nanodrähte jedoch in vertikaler (111)-Richtung und mit sechs {110}-Seitenwänden wachsen, können bei den GaSb-Nanodrähten sowohl die TO- als auch die LO-Phononenmode im Raman-Spektrum deutlich beobachtet werden. Darüber hinaus zeigen die TO- und LO-Phononenmoden von GaSb-Nanodrähten im Vergleich zu Bulk-GaSb ein schwaches Herunterschalten. Bei Raman-Streuungsmessungen können sowohl der Quanteneinschluss als auch Defekte die Frequenzabwärtsverschiebung von Phononenpeaks induzieren [45]. Aufgrund des großen Durchmessers der gewachsenen GaSb-Nanodrähte, der fast keinen Quanteneinschlusseffekt zeigt, spekulieren wir hingegen, dass diese schwache Abwärtsverschiebung der Phononenfrequenz mit Oberflächendefekten der GaSb-Nanodrähte verbunden sein könnte. Mit den zweistufigen Flussraten von TMGa und TMSb haben wir das vertikale Wachstum von reinen ZB-GaSb-Nanodrähten auf InAs-Stämmen durch MOCVD ohne Fremdkatalysatoren realisiert. Wir erwarten, dass durch eine weitere Optimierung der Wachstumsparameter, wie der Wachstumstemperatur und verschiedenen Kombinationen der TMGa- und TMSb-Flussraten im zweistufigen Wachstumsprozess, GaSb-Nanodrähte mit einem höheren Aspektverhältnis erzielt werden könnten.

Raman-Spektren eines GaSb (100)-Substrats (rote Linie ) und die GaSb-Nanodrähte (blaue Linie ). Die grünen Linien sind Ergebnisse der Lorentzschen Anpassung mit mehreren Peaks
Schlussfolgerungen
Zusammenfassend haben wir das selbstkatalysierte Wachstum von GaSb-Nanodrähten auf InAs-Stämmen durch MOCVD demonstriert. Um das Wachstum der vertikalen InAs/GaSb-Heterostruktur-Nanodrähte zu realisieren, verwenden wir zunächst relativ niedrige TMGa- und TMSb-Flussraten, um die Ga-Tröpfchen auf den InAs-Stämmen zu erhalten. Dann werden die Flussraten von TMGa und TMSb erhöht, um die axiale Wachstumsrate zu verbessern. Aufgrund der langsameren radialen Wachstumsrate von GaSb bei höherer Wachstumstemperatur haben bei 500 °C gewachsene GaSb-Nanodrähte einen größeren Durchmesser als solche, die bei 520 °C gewachsen sind. Für das axiale Wachstum sind jedoch aufgrund des Gibbs-Thomson-Effekts und der Verringerung der Tröpfchenübersättigung mit steigender Wachstumstemperatur die bei 500 °C gewachsenen GaSb-Nanodrähte länger als die bei 520 °C gewachsenen. Detaillierte TEM-Messungen zeigen, dass die Kristallstruktur der InAs-Stämme eine Mischung aus WZ- und ZB-Strukturen ist, während die oberen GaSb-Nanodrähte eine perfekte ZB-Kristallphase aufweisen und Raman-Analysen eine hohe optische Qualität der erhaltenen GaSb-Nanodrähte zeigen. Das hier vorgestellte Wachstumsverfahren kann für das Wachstum anderer Nanodrähte auf Antimonidbasis geeignet sein. Darüber hinaus könnten die gewachsenen GaSb-Nanodrähte auf InAs-Stämmen neue Möglichkeiten für Anwendungen in Nanodraht-basierten Geräten und für das Studium der Quantenphysik eröffnen.
Abkürzungen
- CMOS:
-
Komplementärer Metalloxid-Halbleiter
- EDS:
-
Energiedispersive Spektroskopie
- FFT:
-
Schnelle Fourier-Transformation
- LO:
-
Optischer Längsschnitt
- MBE:
-
Molekularstrahlepitaxie
- MOCVD:
-
Metallorganische chemische Gasphasenabscheidung
- SEM:
-
Rasterelektronenmikroskopie
- SF:
-
Stapelfehler
- TEM:
-
Transmissionselektronenmikroskopie
- TMGa:
-
Trimethylgallium
- TMSb:
-
Trimethylantimon
- AN:
-
Transversal optisch
- TP:
-
Doppelflugzeug
- VLS:
-
Dampf-flüssig-fest
- ZB:
-
Zinkblende
Nanomaterialien
- Was ist chemische Gasphasenabscheidung?
- Materialwissenschaftler bringen Nanodrähten das Tanzen bei
- Advanced Atomic Layer Deposition Technologies für Mikro-LEDs und VCSELs
- Aufklärung der morphologischen Evolution und Ätzkinetik poröser Silizium-Nanodrähte beim metallunterstützten chemischen Ätzen
- Die antibakteriellen hierarchischen Polyamid-6-ZnO-Nanofasern, hergestellt durch Atomlagenabscheidung und hydrothermales Wachstum
- Großflächiger WS2-Film mit großen Einzeldomänen, die durch chemische Gasphasenabscheidung gewachsen sind
- Kontrollieren des Wachstums von Indiumselenid (In2Se3)-Nanodrähten mit hoher Gleichmäßigkeit durch den schnellen thermischen Glühprozess bei niedrigen Temperaturen
- Einachsige Magnetisierungsleistung von texturierten Fe-Nanodraht-Arrays, die durch eine Abscheidungstechnik mit gepulstem Potential galvanisch abgeschieden wurden
- Elektrische Eigenschaften von mittel- und langwelligen InAs/GaSb-Übergittern, die auf GaAs-Substraten durch Molekularstrahlepitaxie gewachsen sind
- Selbst gesätes MOCVD-Wachstum und dramatisch verstärkte Photolumineszenz von InGaAs/InP-Kern-Schale-Nanodrähten



