Fermi-Level-Tuning von ZnO-Filmen durch Supercycling-Atomschichtabscheidung
Zusammenfassung
Ein neuartiger superzyklischer Atomlagenabscheidungsprozess (ALD), der den thermischen ALD-Prozess mit in situ O2 . kombiniert In dieser Arbeit wird eine Plasmabehandlung vorgestellt, um dünne ZnO-Schichten mit hochgradig einstellbaren elektrischen Eigenschaften abzuscheiden. Sowohl O2 Plasmazeit und die Anzahl der thermischen ALD-Zyklen in einem Superzyklus können eingestellt werden, um eine Feinabstimmung des Filmwiderstands und der Ladungsträgerkonzentration bis zu sechs Größenordnungen ohne extrinsische Dotierung zu erreichen. Es wird angenommen, dass die Konzentration von Wasserstoffdefekten eine Hauptrolle bei der Einstellung der elektrischen Eigenschaften von ZnO-Filmen spielt. Die Ergebnisse der Kelvinsondenkraftmikroskopie zeigen offensichtlich die Verschiebung des Fermi-Niveaus in verschiedenen ZnO-Filmen und sind gut mit der Änderung der Ladungsträgerkonzentration verbunden. Diese zuverlässige und robuste Technik, über die hier berichtet wird, weist eindeutig auf die Fähigkeit hin, mit dieser Methode ZnO-Filme mit kontrollierten Eigenschaften in verschiedenen Anwendungen herzustellen.
Hintergrund
Einmal als zukünftiges Material definiert , Zinkoxid (ZnO) hat aufgrund seiner überlegenen optischen und elektrischen Eigenschaften seit über einem halben Jahrhundert das Interesse der Wissenschaftsgemeinschaft geweckt [1]. In letzter Zeit hat das schnelle Wachstum der transparenten leitfähigen Oxidindustrie ihre Anwendung als transparente Elektroden in Flachbildschirmen, Touchscreens, Beschichtungen mit niedrigem Emissionsgrad, Dünnschichtsolarzellen usw. weiter belebt [2, 3]. Darüber hinaus hat ZnO zahlreiche Anwendungen in elektronischen Geräten gefunden, einschließlich Leuchtdioden, Fotodetektoren und Leistungsgeräten [4, 5]. Diese verschiedenen Arten von Anwendungen erfordern ZnO-Filme mit verschiedenen elektrischen Parametern, und einige Anwendungen erfordern sogar mehrschichtige ZnO-Filme mit unterschiedlichen elektrischen Eigenschaften [6]. Beispielsweise wurden zahlreiche Anstrengungen unternommen, um einen transparenten resistiven Direktzugriffsspeicher (TRRAM) zur Realisierung einer vollständig integrierten transparenten Elektronik zu entwickeln [7, 8]. Als einer der vielversprechendsten Kandidaten verwendet ZnO-basierter TRRAM einen hochohmigen ZnO-Film als aktive Schaltschicht, während hochleitfähige ZnO-Filme idealerweise als transparente Elektroden fungieren sollen [8,9,10]. Die Fähigkeit, die elektrischen Eigenschaften wie den spezifischen Widerstand und die Ladungsträgerkonzentration der ZnO-Filme zu steuern, ist daher eine Schlüsselanforderung. Die Dotierung wird normalerweise verwendet, wenn eine Eigenschaftsmodifikation erforderlich ist und eine Vielzahl von Dotierstoffen verwendet wurde, um die Eigenschaften des ZnO-Films zu ändern [11,12,13]. Die Dotierung ist jedoch immer aufwendig und kann zur Sekundärphasenbildung führen [14]. Die Modulation der elektrischen Eigenschaften von undotiertem ZnO durch einen einzigen Abscheidungsprozess kann daher vorteilhaft sein.
Atomic Layer Deposition (ALD) ist zu einer beliebten Technik geworden, um qualitativ hochwertiges ZnO mit hervorragender Kontrolle der Filmdicke bis in den Nanometerbereich und Gleichmäßigkeit über ein großes Substrat zu bilden [15, 16]. Die Wachstumstemperatur von ZnO liegt normalerweise unter 200 °C, wodurch es mit einer Reihe von Substraten, einschließlich Glas und Kunststoffen, kompatibel ist. Das ALD ZnO wird normalerweise unter Verwendung von Diethylzink (DEZ) als Zn-Vorstufe und Wasserdampf (thermisch) oder Sauerstoffplasma (plasmaverstärkt) als Sauerstoffvorstufe gezüchtet. Der vorherrschende Weg, um die Eigenschaften von undotierten ZnO-Filmen im thermischen ALD-Prozess abzustimmen, besteht darin, die Wachstumstemperatur zu ändern [17, 18]. Obwohl dies die Abscheidung von hochleitfähigen Filmen ermöglicht, sind qualitativ hochwertige ZnO-Filme mit niedriger Ladungsträgerkonzentration schwierig zu erhalten. Die plasmaunterstützte ALD wird bevorzugt eingesetzt, wenn eine niedrige Trägerkonzentration von ZnO erforderlich ist [19, 20]. Wir haben kürzlich über die Möglichkeit berichtet, ZnO mit einem einzigen plasmaunterstützten ALD-Prozess abzustimmen, der die Einstellung seines spezifischen Widerstands und seiner Ladungsträgerkonzentration bis zu drei Ordnungen unter Verwendung verschiedener O2 . ermöglicht Plasmazeiten [21]. Die plasmaunterstützte ALD könnte jedoch ein nicht selbstlimitierendes Wachstum erleiden, wenn ein kurzer O2 Plasmazeit wird angewendet, um die erforderliche Trägerkonzentration zu erreichen, was zu einer schlechten Gleichmäßigkeit über einem großen Substrat führen kann. Ein abstimmbarer ALD-Prozess innerhalb des selbstbegrenzenden Fensters wäre daher wünschenswert.
Abgesehen von der Möglichkeit, die elektrischen Eigenschaften von ZnO abzustimmen, bleibt auch die Bestimmung dieser Eigenschaften eine Herausforderung. Die Hall-Effekt-Messung ist die beliebteste Methode zur Messung der elektrischen Eigenschaften von ZnO-Dünnschichten. Sie kann jedoch anfällig für Fehlinterpretationen sein und hat Schwierigkeiten, die eigentliche Ursache des Dopings eindeutig zu erkennen [1]. Die Kelvinsondenkraftmikroskopie (KPFM) ist eine zerstörungsfreie Oberflächentechnik, die umfassend zur Charakterisierung der nanoskaligen strukturellen, dynamischen und elektrischen Eigenschaften von Halbleitermaterialien und -geräten verwendet wird [22, 23]. Durch direkte Messung der Kontaktpotentialdifferenz (V CPD ), d. h. der Unterschied zwischen den Austrittsarbeiten der Spitze und der Probe, kann sie einen Einblick in die Dotierstofftypen des Materials, die Ladungsträgerkonzentrationen und den spezifischen Widerstand geben, da sie die Position des Fermi-Niveaus innerhalb der Bandlücke beeinflussen. Arbeiten, die die ZnO-Eigenschaften mit KPFM-Ergebnissen korrelieren, werden jedoch selten berichtet, und unseres Wissens gibt es keine, die auf ALD-gewachsenen ZnO-Filmen basieren [24,25,26].
In dieser Arbeit schlagen wir einen neuartigen superzyklischen ALD-Prozess zur Abstimmung der elektrischen Eigenschaften in undotiertem ZnO vor. Kombination des thermischen ALD-Prozesses mit einem in situ O2 Plasmabehandlung ermöglicht dieser Prozess eine breite und dennoch verfeinerte Einstellung des spezifischen Widerstands und der Ladungsträgerkonzentration des ZnO-Films. Noch wichtiger ist, dass die Verschiebungen des Fermi-Niveaus in den ZnO-Filmen direkt durch KPFM gemessen und zur Charakterisierung der elektrischen Eigenschaften von ZnO verwendet werden können.
Methoden
Alle dünnen ZnO-Filme wurden in einem OIPT FlexAl ALD-System unter Verwendung eines Diethylzink (DEZ)-Vorläufers hergestellt. Jeder Superzyklus des ALD-Prozesses besteht aus m Zyklen thermischer ALD-Prozesse (DEZ und H2 O) und ein O2 Plasmaschritt, wie in Abb. 1a gezeigt. Beim thermischen ALD-Verfahren wurde zunächst DEZ-Dampf in die Kammer eingeleitet und dann durch einen Argonstrom gespült, und H2 Anschließend wurde O-Dampf eingeleitet und dann mit Argon gespült. Nach m Zyklen thermischer ALD-Prozesse, ein O2 Plasmaschritt wurde als ein in-situ-Plasmabehandlungsschritt hinzugefügt. Die O2 Plasmaschritt wurde mit einem O2 . eingestellt Fluss von 60 sccm, HF-Leistung von 300 W und Druck von 15 mTorr. Beide thermischen ALD-Nummern (m ) und O2 Plasmazeit (t 3 ) wurden zur Steuerung der ZnO-Filmeigenschaften verwendet. Die spezifischen Details für einen Wachstumssuperzyklus im ALD-Prozess sind in Zusatzdatei 1:Tabelle S1 aufgeführt. Alle ZnO-Filme wurden auf dem SiO2 . abgeschieden -beschichtete Si-Substrate (1 cm × 1 cm) bei einer festen Temperatur von 190 °C, und alle Filmdicken wurden auf 40 nm projiziert.

a Illustration des Ein-Wachstums-Superzyklus des vorgeschlagenen superzyklischen ALD-Prozesses. b ZnO-Wachstumsraten als Funktion des O2 Plasmazeit für superzyklierte ALD mit festem Temperaturzyklus (m = 1) und plasmaunterstützte ALD-Prozesse; die gestrichelten Kurven sind Orientierungshilfen für das Auge. c ZnO-Wachstumsrate und lineare Anpassung als Funktion des thermischen Prozesszyklus m mit festem O2 Plasmazeiten (t 3 = 1 und 8 s)
Die Dicke und die optischen Konstanten der abgeschiedenen ZnO-Filme wurden durch Ellipsometrie (VASE, J. A. Woollam Co. M-2000) gemessen und mit einem Tauc-Lorentz (TL)-Modell versehen. Die elektrischen Eigenschaften wurden durch Hall-Messungen (Nanometrics HL5500PC) bei Raumtemperatur in einem Magnetfeld von 0,5 T gemessen. Es wurde besonders darauf geachtet, dass vor jeder einzelnen Messung ein linearer Kontakt zwischen jeder Kupfersonde und der Probe hergestellt wurde. Röntgenbeugungsmuster (XRD) wurden im streifenden Einfall (θ 1 = 1°) mit einem Rigaku Smartlab Diffraktometer mit einem 9-kW-Cu-K α Quelle. Die Daten der Röntgenphotoelektronenspektroskopie (XPS) wurden mit einem Thermo Scientific Theta Probe System mit Al-K . gewonnen α Strahlung (Photonenenergie = 1486.6 eV). Wo nötig, wurde eine Oberflächenkontamination durch die Verwendung einer Ionensputter-Kanone beseitigt. Das Zn 2p , O 1s , und C 1s Spektren gesammelt wurden. Alle Daten beziehen sich auf die C 1s Peak, dem eine Bindungsenergie von 284,6 eV zugewiesen wurde. KPFM-Messungen wurden auf Nanonics CV2000 mit einer Nanosensor ATEC Pt-Ir-beschichteten Spitze mit einer Resonanzfrequenz von 65 kHz durchgeführt. Um den Einfluss von Oberflächenverunreinigungen zu reduzieren, wurden die Messungen direkt nach der Entnahme der Proben aus der Vakuumkammer durchgeführt.
Ergebnisse und Diskussion
Der vorgeschlagene superzyklische ALD-Prozess ist in Abb. 1a dargestellt, wobei ein Superzyklus aus m . besteht Zyklen thermischer ALD-Prozesse (DEZ und H2 O) und ein O2 Plasmaschritt (O2 Plasma). Weitere Details finden Sie im Abschnitt „Methoden“. Abbildung 1b vergleicht die ZnO-Wachstumsraten in unserem superzyklischen ALD-Prozess bei m = 1 und der konventionelle plasmaunterstützte ALD-Prozess als Funktion von O2 Plasmazeit. Die Wachstumsrate im plasmaunterstützten ALD-Prozess (rot) ist empfindlich gegenüber dem O2 Plasma, da es von ca. 1,4 bis 1,7 Å/Zyklus, wobei sich die Plasmazeit von 2 auf 4 s ändert. Es ist dann auf einem Niveau von ca. 1,7 Å/Zyklus bei längeren Plasmazeiten. Die ungesättigte Wachstumsrate bei kürzerem O2 Plasmazeit wird auf den Sauerstoffmangel im Prozess zurückgeführt. Obwohl dies manchmal bevorzugt wird, um ZnO-Filme mit hoher Leitfähigkeit zu erhalten, ist es nicht selbstbegrenzend und könnte zu einer schlechten Gleichmäßigkeit über das gesamte Substrat führen. Auf der anderen Seite wurde festgestellt, dass die Wachstumsrate stabil bei ca. 1,69 Å/Superzyklus im superzyklischen ALD-Prozess (schwarz) und ist ähnlich dem des thermischen ALD-Prozesses (t 3 = 0 s) unabhängig von der angewendeten Plasmazeit. Außerdem Erhöhung des Wärmezyklus m in einem Superzyklus mit fester Plasmazeit führt zu einem linearen Anstieg der Wachstumsrate, wie in Abb. 1c gezeigt. Der angepasste Gradient wird für beide Wucherungen mit unterschiedlichem O2 . zu 1,67 berechnet Plasmazeiten, was ebenfalls nahe an der Wachstumsrate des thermischen ALD-Prozesses liegt. Dies deutet darauf hin, dass das Wachstum von ZnO in unserer superzyklierten ALD vom thermischen ALD-Prozess und dem anschließenden O2 . dominiert wird Plasmaschritt dient lediglich als Behandlung.
Alle ZnO-Filme, die nach dem Supercycling-ALD-Verfahren (m = 1) kristallisieren in der hexagonalen Wurtzit-Struktur und veranschaulichen eine ähnliche Verteilung der Peakintensitäten unabhängig von O2 Plasmazeit, wie in Abb. 2a gezeigt. Verglichen mit dem theoretischen Intensitätsverhältnis von 0,44 zwischen Peak (0 0 2) und (1 0 1) (berechnet aus JCPDS-34-1451 für eine zufällige Orientierung der Kristallite) zeigen diese Filme eine starke Vorzugsorientierung entlang der c -Achse mit dem (0 0 2) und (1 0 1) Peakintensitätsverhältnis zwischen 2 und 5, was auf eine gute kristalline Qualität der Filme hinweist. Mit steigendem O2 . wird ein leichter Anstieg des Peakverhältnisses (0 0 2) zu (1 0 1) beobachtet Plasmazeit (dargestellt in der zusätzlichen Datei 1:Abbildung S1). Dies legt einen höheren Grad an bevorzugter Orientierung nahe, wenn sie längerem Plasma ausgesetzt wird. Ein ähnliches Verhalten wurde auch berichtet [27, 28]. Es sei jedoch darauf hingewiesen, dass die Änderung des Intensitätsverhältnisses in unserer Arbeit im Vergleich zu anderen eher trivial ist. Dies deutet weiter auf die Stabilität unseres superzyklischen ALD-Prozesses zur Herstellung hochwertiger ZnO-Filme hin. Die durchschnittlichen Korngrößen wurden ebenfalls nach der Scherrer-Formel [29] abgeschätzt und betrugen ca. 11 nm, was darauf hindeutet, dass die ZnO-Korngröße durch das O2 . kaum beeinflusst wurde Plasmazeit. Ähnliche Muster werden auch auf ZnO-Filmen beobachtet, die aus verschiedenen thermischen ALD-Zyklen (m ) mit festem O2 Plasmazeit (1 s) wie in Abb. 2b gezeigt.
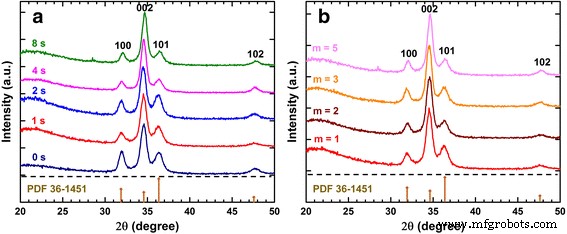
XRD-Muster von ZnO-Filmen, die durch den Supercycling-ALD-Prozess unter Verwendung von a . gewachsen sind verschiedene O2 Plasmazeiten mit festem Temperaturzyklus (m = 1) und b verschiedene thermische Zyklen mit festem O2 Plasmazeit (t 3 = 1 s)
Neben der Kristallinität wurden auch die optischen Eigenschaften der superzyklierten ALD-gezüchteten ZnO-Filme mit spektroskopischer Ellipsometrie (SE) untersucht. Optische Konstanten (n und k ) kann aus den Ellipsometrie-Ergebnissen durch ein Tauc-Lorentz-Modell extrahiert werden, das üblicherweise beim Anpassen von ZnO-Filmen verwendet wird [28, 30, 31]. Ähnlich der analogen Kristallinität sind die optischen Eigenschaften von ZnO-Filmen, die mit verschiedenen O2 . abgeschieden wurden, Plasmazeiten und thermische Zyklen bleiben ebenfalls unverändert, wie in Zusätzliche Datei 1:Abbildung S2 gezeigt. Dies steht im Einklang mit den berichteten Arbeiten, dass eine Änderung der Kristallinität immer mit einer Änderung der optischen Eigenschaften einhergeht [28, 32]. Die morphologischen Eigenschaften der ZnO-Filme werden durch AFM charakterisiert. Alle Filme erwiesen sich als ähnlich glatt mit einer durchschnittlichen Rauheit zwischen ca. 0,3 und 0,8 nm (zusätzliche Datei 1:Abbildung S3).
Die elektrischen Eigenschaften der nach dem Supercycling-ALD-Prozess gewachsenen ZnO-Filme werden mit einem Hall-Effekt-System untersucht. Alle Filme wurden als n eingestuft -Halbleiter, und der spezifische Widerstand steigt von ca. 10 −3 bis 10 3 Ω cm mit zunehmendem O2 Plasmazeit und fester thermischer Zyklus (m = 1) wie in Abb. 3a gezeigt. Damit verbunden ist die Reduzierung der Trägerkonzentration von ca. 10 21 bis 10 15 cm −3 als O2 Plasmazeit erhöht sich von 0 auf 8 s (Abb. 3b). Im Gegensatz dazu sind die Elektronenbeweglichkeiten aller ZnO-Filme ziemlich konsistent (ca. 3,0 ± 1,0 cm 2 /V s) und werden von der Plasmadauer nicht beeinflusst. Auf den detaillierten Durchführungsmechanismus wird im folgenden Abschnitt näher eingegangen. Verglichen mit dem plasmaunterstützten ALD-Prozess, über den wir zuvor berichtet haben [21], wurde die Stärke der spezifischen Widerstandsabstimmung beim superzyklischen ALD-Prozess weiter auf über fünf Größenordnungen verbessert. Darüber hinaus bietet dieser vorgeschlagene ALD-Prozess eine verfeinerte Kontrolle dieser elektrischen Eigenschaften durch Variation des thermischen Zyklus (m ) in einem Superzyklus, während das O2 . fixiert wird Plasmazeit (t 3 ). Dies ist besonders nützlich im Fall von t 3 = 1 s, bei denen eine Abstimmung durch weitere Reduzierung der Plasmazeit aufgrund der Beschränkung der ALD-Ausrüstung nicht erreichbar ist. Die offenen Punkte in Abb. 3a, b stellen die spezifischen Widerstände und Trägerkonzentrationen von ZnO-Filmen dar, die durch verschiedene thermische Zyklen (m = 2, 3, 5) wenn t 3 = 1 s (Fehlerbalken befinden sich innerhalb der Punkte). Es ist zu beobachten, dass mehr thermische Zyklen zu weniger widerstandsfähigen Filmen mit höheren Trägerkonzentrationen führen. Dies bietet zusätzlich drei spezifische Widerstände im Bereich von 10 −3 . bis 10 1 Ω cm.
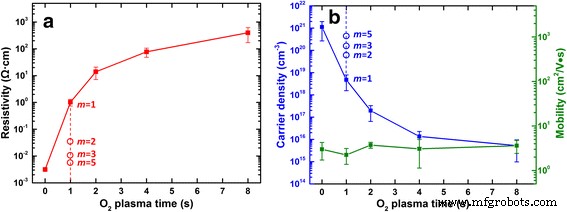
a Elektrischer spezifischer Widerstand von ZnO-Filmen, die aus verschiedenen O2 . gewachsen sind Plasmazeiten mit festem Temperaturzyklus m (durchgezogene Punkte) und verschiedene thermische Zyklen mit festem O2 Plasmazeit (offene Punkte) durch den superzyklischen ALD-Prozess. b Trägerkonzentration (blau) von ZnO-Filmen, die aus verschiedenen O2 . gewachsen sind Plasmazeiten mit festem thermischen Zyklus (durchgezogene Punkte) und verschiedene thermische Zyklen mit festem O2 Plasmazeit (offene Punkte). Mobilität (grün) von ZnO-Filmen, die aus verschiedenen O2 . gewachsen sind Plasmazeiten mit einem festen thermischen Zyklus
KPFM-Messungen wurden durchgeführt, um Einblicke in die Fermi-Niveau-Positionen der ZnO-Filme mit sich änderndem spezifischem Widerstand zu gewinnen. Es misst die Kontaktpotentialdifferenz V CPD zwischen einer leitfähigen Spitze und der Probe, die definiert ist als:
$$ {V}_{\mathrm{CPD}}=\frac{\phi_{\mathrm{Spitze}}-{\phi}_{\mathrm{Probe}}}{q} $$ (1)wo q ist die elektronische Ladung, während ϕ Tipp und ϕ Beispiel sind die Austrittsarbeit der Spitze bzw. der Probe. Wenn zwei verschiedene Materialien in elektrischen Kontakt gebracht werden, richten sich die Fermi-Niveaus durch den Elektronenstromfluss aus, was folglich eine Kontaktpotentialdifferenz zwischen der Spitze und der Probe induziert, wie in Zusatzdatei 1 gezeigt:Abbildung S4. Das detaillierte Arbeitsprinzip von KPFM ist in der zusätzlichen Datei 1 dargestellt. Die Kontaktpotentialunterschiede der ZnO-Filme, die durch den Supercycling-ALD-Prozess aus verschiedenen O2 . gewachsen sind Plasmazeiten mit festem Temperaturzyklus (m = 1) sind in Abb. 4 dargestellt. Während jedes V CPD Bild erscheint einheitlich und relativ glatt, erhebliche Unterschiede im Mittelwert V CPD Werte beobachtet werden können (dargestellt in Abb. 4f). Die Tipparbeitsfunktion ϕ Tipp bleibt bei allen Messungen konstant; der wesentliche Unterschied in V CPD ist daher die Folge der Fermi-Niveauverschiebung innerhalb verschiedener ZnO-Filme. Eine Gesamtverschiebung von ca. 0,32 eV wird zwischen einem ZnO-Film erhalten, der mit 0 und 8 s O2 . gewachsen ist Plasmazeit, die im Vergleich zur ZnO-Bandlücke signifikant ist (ca. 3,22 eV basierend auf den SE-Ergebnissen in dieser Arbeit, wie in Zusatzdatei 1:Abbildung S2c gezeigt). Für ZnO-Filme, die aus verschiedenen thermischen Zyklen (m = 2, 3, 5) bei festem O2 Plasmazeit (t 3 = 1 s), andere V CPD Werte wurden auch ermittelt, wie in Abb. 4f gezeigt. Die zweidimensionalen KPFM-Bilder dieser Filme finden Sie in der Zusatzdatei 1:Abbildung S5. Dies impliziert, dass die Änderung des Elektron-Loch-Gleichgewichts in den Filmen auftritt, was einen erheblichen Einfluss auf die ZnO-Trägerkonzentration haben könnte.
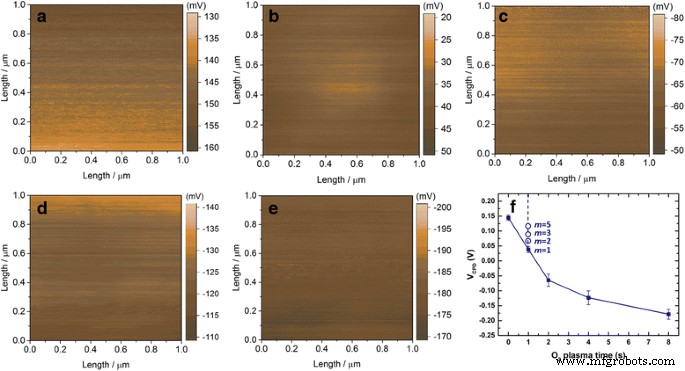
a –e Zweidimensionale Kontaktpotentialdifferenz V CPD Bilder der Oberflächenpotentialmessungen der superzyklierten ALD-gezüchteten ZnO-Filme mit O2 Plasmazeit (t 3 ) variierend von 0 bis 8 s und fester Temperaturzyklus (m = 1). f Durchschnitt V CPD Werte mit unterschiedlichem O2 Plasmazeiten (durchgezogene Punkte) und thermische Zyklen (offene Punkte)
Um den Zusammenhang zwischen Fermi-Niveau und Ladungsträgerkonzentration zu untersuchen, verwenden wir das von Maragliano et al. um die Kontaktpotentialdifferenz V . zu korrelieren CPD mit der Dotierungskonzentration im Material [26]. Unter Annahme der effektiven Donorkonzentration n D deutlich höher als die intrinsische Ladungsträgerkonzentration ist, kann sie wie folgt geschrieben werden:
$$ {n}_{\mathrm{D}}\approx {N}_{\mathrm{C}}\exp \left(\frac{q{V}_{\mathrm{C}\mathrm{PD} }-{\phi}_{\textrm{tip}}+\chi }{K_BT}\right) $$ (2)wo N C ist die effektive Zustandsdichte, χ ist die Elektronenaffinität des Halbleiters, K B ist die Boltzmann-Konstante und T ist die Temperatur. Obwohl die Werte der effektiven Zustandsdichte N C , die Spitzenarbeitsfunktion ϕ Tipp , und die Elektronenaffinität χ schwer zu erhalten sind, können die relativen Ladungsträgerkonzentrationsunterschiede verschiedener ZnO-Filme berechnet werden, da diese Werte bei allen Messungen gleich sind. Daher ist das Ladungsträgerkonzentrationsverhältnis zwischen den mit 0 s von O2 . gewachsenen Filmen Plasmazeit für einen gegebenen ZnO-Film kann wie folgt ausgedrückt werden:
$$ \frac{n_0}{n_x}=\exp \left(\frac{V_{\mathrm{CPD}0}-{V}_{\mathrm{CPD}x}}{K_BT/q}\right) $$ (3)in denen n 0 und n x sind die Trägerkonzentration des ZnO-Films, der mit 0 und x . gewachsen ist s von O2 Plasmazeit bzw. und V CPD0 und V CPDx sind die entsprechenden Kontaktpotentialdifferenzen. Die berechneten Trägerkonzentrationsverhältnisse sind in Fig. 5 als Funktion von O2 . aufgetragen Plasmazeit. Es wird berechnet, dass das Konzentrationsverhältnis mit längerem O2 . zunimmt Plasmazeit (rot). Noch wichtiger ist, dass der steigende Trend gut mit den Werten übereinstimmt, die aus den Hall-Effekt-Messergebnissen (schwarz) erhalten wurden. Ein ähnlicher Trend wurde auch für ZnO-Filme beobachtet, die aus verschiedenen thermischen Zyklen (m = 2, 3, 5) bei festem O2 Plasmazeit (t 3 = 1 s). Dies deutet offensichtlich darauf hin, dass die Verschiebung des Fermi-Niveaus des ZnO-Films direkt mit dem Niveau der Ladungsträgerkonzentration verbunden ist.
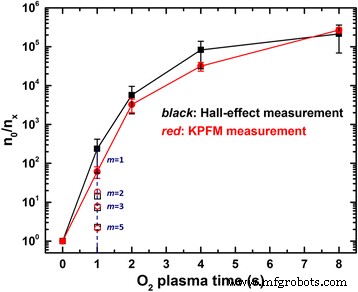
Hall-Effekt- und KPFM-Messergebnisse der Ladungsträgerkonzentrationsverhältnisse zwischen ZnO-Filmen, die mit unterschiedlichem O2 . gewachsen sind Plasmazeiten (durchgezogene Punkte) und thermische Zyklen (offene Punkte)
Röntgenphotoelektronenspektroskopie (XPS)-Messungen wurden durchgeführt, um den Leitungsmechanismus durch Untersuchung der Bindungs- und chemischen Zustände der superzyklierten ALD-gewachsenen ZnO-Filme aufzuklären. Die chemischen Zustände von O 1s sind in Abb. 6 gezeigt, wo zwei Peaks nach Gauß-Anpassungen identifiziert werden können. Der untere Energiepeak (A) liegt ca. 530.3 eV wird als O 2− . vorgeschlagen Ionen in der Wurtzit-Struktur von hexagonalem Zn 2+ Ionen [33,34,35]. Die Zuordnungen der höheren Bindungsenergiekomponente bei ca. 532,2 (B) waren in der Literatur umstritten [33,34,35,36,37,38]. Es wird jedoch häufig berichtet, dass es mit der Hydroxylgruppe (d. h. Zn-OH) [33, 37,38,39] im ZnO-Film assoziiert ist. Wir schreiben daher vorläufig das OB . zu Peak in Abb. 6 zu den Zn-OH-Bindungen. Andererseits liegt der mit Sauerstoffleerstellen assoziierte Peak bei ca. 531.2 eV [35] wird in dieser Arbeit nicht beachtet. Durch den thermischen ALD-Prozess gewachsener ZnO-Film (t 3 = 0 s) kennzeichnet ein dominantes OB Peak im XPS-Spektrum (Abb. 6a). Dies impliziert die Existenz einer großen Menge von wasserstoffbezogenen Verunreinigungen in diesem Film. Dieses hohe Maß an Defekten dient als Selbstdotierungsmechanismus und führt zu einer hohen Ladungsträgerkonzentration. Das zusätzliche O2 Plasmaschritt (t 3 ) verringert die Verunreinigungen und das OB Spitzenintensität nimmt mit längerem O2 . ab Plasmazeit (Abb. 6f). Ein ähnlicher Trend wurde auch für ZnO-Filme beobachtet, die aus unterschiedlichen thermischen Zyklen gewachsen sind, bei denen mehr thermische Zyklen zu einem Anstieg von OB . führen Spitzenintensität wie in Abb. 6f und Zusätzliche Datei 1:Abbildung S6 gezeigt.

a –e XPS-Spektren und ihre Gaußschen Anpassungen der O 1s Region der superzyklierten ALD-gezüchteten ZnO-Filme mit O2 Plasmazeit (t 3 ) variierend von 0 bis 8 s und fester Temperaturzyklus (m = 1). f Anteil des wasserstoffbezogenen OB Peak in ZnO-Filmen, die mit unterschiedlichem O2 . gewachsen sind Plasmazeiten (durchgezogene Punkte) und thermische Zyklen (offene Punkte)
Der Ursprung des intrinsischen n -Leitfähigkeit in ZnO-Filmen ist immer noch umstritten. Obwohl herkömmlicherweise diese Leitfähigkeit nativen Defekten (d. h. Sauerstoffleerstellen und Zn-Zwischengitterplätzen) zugeschrieben wird [18, 40, 41, 42, 43, 44], wurde sie durch neuere First-Principles-Rechnungen [45] in Frage gestellt. Es ist auch unwahrscheinlich, dass Sauerstoffleerstellen zu einem so hohen Konzentrationsniveau beitragen, da zahlreiche Studien darauf hindeuten, dass sie eher tiefe als flache Donatoren sind und hohe Bildungsenergien in n . aufweisen -Typ ZnO (und sind daher unähnlich zu bilden) [41,42,43,44]. Darüber hinaus sind die mit Sauerstoffleerstellen zusammenhängenden O 1s Peak wird auch in unseren XPS-Daten, die in Abb. 6 gezeigt sind, nicht beobachtet. Obwohl Zn-Interstitials flache Donatoren sind, wurde vorgeschlagen, dass sie hohe Bildungsenergien haben und schnellere Diffusoren sind und daher wahrscheinlich nicht stabil sind [41]. Die XPS-Spektren des Zn 2p 3/2 Zustand der superzyklierten ALD-gezüchteten ZnO-Filme mit verschiedenen O2 Plasmazeiten sind in Abb. 7 dargestellt. Alle Spektren sind durch einen ähnlichen Peak bei ca. 1021,5 eV, die dem Zn 2+ . zugeschrieben werden können Bindung in ZnO [6, 34, 46]. Allerdings wird die Zn-Zwischengitterkomponente bei einer etwas höheren Bindungsenergie [6, 47] nicht in allen Spektren beobachtet. Dies legt nahe, dass der Einfluss des Zn-Zwischengitters auf die Leitfähigkeit des ZnO-Films in dieser Arbeit ebenfalls ausgeschlossen werden kann.

a –e XPS-Spektren und ihre Gaußschen Anpassungen des Zn 2p 3/2 Region der superzyklierten ALD-gezüchteten ZnO-Filme mit O2 Plasmazeit (t 3 ) variierend von 0 bis 8 s und fester thermischer Zyklus (m =1)
Kürzlich wird vorgeschlagen, dass wasserstoffbedingte Verunreinigungen/Defekte eine Rolle bei der n . spielen -Typ Leitfähigkeit in ZnO [33, 48]. Der Beweis für die Existenz von Wasserstoffbrücken in ZnO wurde von Janotti et al. [48], und es wurde vorgeschlagen, dass diese Bindungen in der Lage sind, sich in hohen Konzentrationen einzubauen und sich als flache Donoren zu verhalten [49,50,51]. Tatsächlich ist Wasserstoff in unserem superzyklischen ALD-Prozess sowohl als Vorläufer als auch als H2 . vorhanden O enthalten Wasserstoff und im thermischen ALD-Schritt wird in jedem Halbzyklus eine Zn-OH-Bindung hergestellt. Dies wird auch durch die Beobachtung von Hydroxylgruppen-bezogenen O 1s . unterstützt Peak in den XPS-Spektren (gezeigt in Abb. 6). Der spezifische Widerstand und die Ladungsträgerdichte des ZnO-Films sind gegen den Anteil dieses Peaks in 8 aufgetragen. Ein hoher Anteil dieser Wasserstoffverunreinigungen induziert hohe Ladungsträgerkonzentrationen, was zu niedrigen spezifischen Widerständen führt. Die nachfolgende O2 Plasmaschritt innerhalb jedes Superzyklus reduziert die Ladungsträgerkonzentration durch effektive Entfernung der Wasserstoffbrückenbindungen. Dies geht einher mit einer Verringerung der Ladungsträgerkonzentration sowie einer Erhöhung des spezifischen Widerstands. Das gleiche Verhalten wurde auch bei ALD- und CVD-Prozessen berichtet [33, 52].
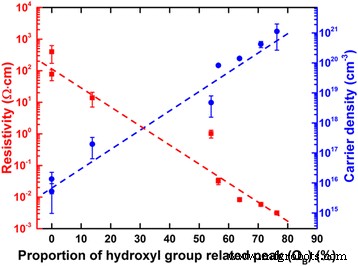
Elektrischer Widerstand und Ladungsträgerkonzentration als Funktion des Hydroxylgruppen-bezogenen OB Peakanteil (gestrichelte Linien sind Orientierungspunkte des Auges)
Schlussfolgerungen
Hier wurde über die Abscheidung undotierter ZnO-Filme mit hochgradig einstellbaren elektrischen Eigenschaften unter Verwendung eines superzyklischen ALD-Prozesses berichtet, der einen thermischen ALD-Prozess und in situ O2 . kombiniert Plasmabehandlung. Eine Anpassung des Filmwiderstands und der Ladungsträgerkonzentration um mehr als fünf Größenordnungen wurde durch die Abstimmung des O2 . erreicht Plasmazeiten. Eine feinere Abstimmung der Eigenschaften kann auch durch Variieren der Anzahl der thermischen ALD-Zyklen in einem Superzyklus realisiert werden. Es wird angenommen, dass die Abstimmung dieser elektrischen Eigenschaften mit der Änderung der Wasserstoffdefektkonzentration im Film verbunden ist. Dies verursacht direkt die Verschiebung der Fermi-Niveaus innerhalb der ZnO-Filme, wie durch die Kelvin-Sondenkraftmikroskopie gezeigt wurde. Durch die Übernahme eines einfachen elektronischen Energiemodells zeigen die aus den Fermi-Pegelverschiebungen berechneten Ladungsträgerkonzentrationen eine gute Übereinstimmung mit den Hall-Effekt-Messergebnissen. Diese zuverlässige und robuste Technik, über die hier berichtet wird, weist eindeutig auf die Fähigkeit hin, mit dieser Methode ZnO-Filme mit kontrollierten Eigenschaften in verschiedenen Anwendungen herzustellen.
Abkürzungen
- ALD:
-
Atomlagenabscheidung
- DEZ:
-
Diethylzink
- KPFM:
-
Kelvin-Sondenkraftmikroskopie
- XPS:
-
Röntgenphotoelektronenspektroskopie
- XRD:
-
Röntgenbeugung
Nanomaterialien
- Advanced Atomic Layer Deposition Technologies für Mikro-LEDs und VCSELs
- Bipolar-resistive Schalteigenschaften von HfO2/TiO2/HfO2-RRAM-Bauelementen mit dreischichtiger Struktur auf Pt- und TiN-beschichteten Substraten, die durch Atomlagenabscheidung hergestellt wurden
- Grenzflächen-, elektrische und Bandausrichtungseigenschaften von HfO2/Ge-Stapeln mit in situ gebildeter SiO2-Zwischenschicht durch plasmaunterstützte Atomlagenabscheidung
- Die antibakteriellen hierarchischen Polyamid-6-ZnO-Nanofasern, hergestellt durch Atomlagenabscheidung und hydrothermales Wachstum
- Photokatalytische Eigenschaften von Co3O4-beschichteten TiO2-Pulvern, hergestellt durch plasmaunterstützte Atomlagenabscheidung
- Zweistufige Abscheidung von Al-dotiertem ZnO auf p-GaN zur Bildung ohmscher Kontakte
- Abstimmung der Oberflächenmorphologien und -eigenschaften von ZnO-Filmen durch das Design der Grenzflächenschicht
- Optische Eigenschaften von Al-dotierten ZnO-Filmen im Infrarotbereich und ihre Absorptionsanwendungen
- Auswirkung verschiedener CH3NH3PbI3-Morphologien auf die photovoltaischen Eigenschaften von Perowskit-Solarzellen
- Vorbereitungs- und Antibiofilmeigenschaften von Zinkoxid/porösem anodischem Aluminiumoxid-Verbundfilm



