Untersuchung der Bandausrichtung für hybride 2D-MoS2/3D-β-Ga2O3-Heterojunctions mit Nitrierung
Zusammenfassung
Hybride Heteroübergänge basierend auf zweidimensionalen (2D) und konventionellen dreidimensionalen (3D) Materialien bieten einen vielversprechenden Weg zu nanoelektronischen Bauelementen mit technischen Eigenschaften. In dieser Arbeit untersuchten wir die Bandausrichtung eines gemischtdimensionalen Heteroübergangs aus transferiertem MoS2 auf β-Ga2 O3 (\( 2- \)01) mit und ohne Nitrierung. Die Leitungs- und Valenzband-Offsets für unnitriertes 2D-MoS2 /3D-β-Ga2 O3 Heteroübergang wurde mit 0,43 ± 0,1 bzw. 2,87 ± 0,1 eV bestimmt. Für den nitrierten Heteroübergang wurden die Leitungs- und Valenzband-Offsets auf 0,68 ± 0,1 bzw. 2,62 ± 0,1 eV abgeleitet. Die modifizierte Bandausrichtung könnte aus dem Dipol resultieren, der durch Ladungstransfer über die Heteroübergangsgrenzfläche gebildet wird. Der Effekt der Nitrierung auf die Bandausrichtungen zwischen Gruppe-III-Oxiden und Übergangsmetall-Dichalkogeniden wird praktikable technische Wege für das Design ihrer elektronischen und optoelektronischen Bauelemente auf Heteroübergangsbasis liefern.
Hintergrund
Beta-Galliumoxid (β-Ga2 O3 ) hat aufgrund seiner überlegenen Materialeigenschaften großes Interesse auf sich gezogen [1, 2]. Bei einer ultrabreiten Bandlücke (4,6–4,9 eV) ist das theoretische elektrische Durchschlagsfeld (E C ) wird auf etwa 8 MV/cm geschätzt [3, 4]. In Kombination mit seiner hohen relativen Dielektrizitätskonstante (ε) und Elektronenmobilität (μ) ist die Gütezahl des Baliga (\( \upvarepsilon \upmu {E}_C^3 \)) dreimal so hoch wie die von GaN oder SiC, was den Leitungsverlust reduziert deutlich [1]. Darüber hinaus bietet die Verfügbarkeit großer massiver Einkristalle, die durch Schmelzwachstums- und Epitaxietechniken synthetisiert werden, erhebliche Vorteile für industrielle Anwendungen [5, 6]. Bei weitem β-Ga2 O3 hat sich in einer Vielzahl elektronischer Anwendungen bewährt, darunter Leuchtdioden, Gassensoren, Fotodetektoren sowie Feldeffekttransistoren [7,8,9,10]. In jüngster Zeit sind hybride Heterojunctions, also die Integration von zweidimensionalen (2D) Materialien mit dreidimensionalen (3D) Materialien aufgrund der komplementären Eigenschaften ihrer Materialsysteme von besonderem Interesse [11].
Bis heute wurden verschiedene 2D-Schichtmaterialien auf Halbleitern mit großer Bandlücke gestapelt, um hybride Heteroübergänge für neuartige Anwendungen mit unterschiedlichen Funktionalitäten wie MoS2 . zu konstruieren /GaN, WSe2 /GaN, MoS2 /SiC usw. [12,13,14,15]. Strukturell ist das MoS2 Kristall besteht aus einer Mo-Atomschicht, die zwischen zwei Schwefelschichten eingebettet ist und eine zweidimensionale hexagonale Dreischicht bildet, die durch schwache Van-der-Waals-Kräfte an ihre Nachbarschichten gebunden ist [16, 17]. Im Gegensatz zu Graphen mit einer Bandlücke von null motivierte die dickeabhängige Modulation der Bandlücken die Erforschung von MoS2 in optischen und elektrischen Geräten [18, 19]. Basierend auf der Physik von MoS2 , die Zustandsdichte von mehrlagigem MoS2 ist drei Größenordnungen höher als bei einschichtigem (SL) MoS2 , was zu hohen Antriebsströmen im ballistischen Grenzbereich führt. In diesem Zusammenhang ist MoS2 . mit mehreren Schichten kann für Transistoranwendungen deutliche Vorteile bieten als SL MoS2 [18]. Somit ist die Integration von MoS2 mit β-Ga2 O3 ist von großem Interesse, um die jeweiligen Vorzüge der etablierten 2D- und 3D-Materialien zu kombinieren. Und die optischen und elektrischen Eigenschaften für Hybrid-Heteroübergänge werden von Natur aus durch die Ausrichtung der Grenzflächenenergiebänder dominiert. Folglich ist es durchaus wünschenswert, abstimmbare Bandausrichtungen zu haben, um die Leistung von Vorrichtungen auf Heteroübergangsbasis zu verbessern. In dieser Arbeit haben wir die Bandausrichtung von 2D-MoS2 . untersucht /3D-β-Ga2 O3 Heteroübergänge mit und ohne Nitridierungsbehandlung durch Röntgenphotoelektronenspektroskopie (XPS)-Charakterisierungen und Grundprinzipienrechnungen.
Methoden
Das SiO2 /Si-Substrat wurde jeweils 10 min mit Aceton und Visopropanol beschallt, gefolgt von Spülen in entionisiertem Wasser und Trocknen mit N2 . Wenigschichtiges MoS2 Filme wurden auf dem SiO2 . gezüchtet /Si-Substrat durch chemische Gasphasenabscheidung (CVD) unter Verwendung von Vorläufern von MoO3 (0,08 mg, 99%, Alfa Aesar) und S-Pulver (1 g, 99%) [20, 21]. Das MoO3 und S-Pulver wurden in zwei separate Tiegel mit einem SiO2 /Si-Substrat im Quarzrohr, wie in Abb. 1a gezeigt. Während des Wachstumsprozesses wurde das Quarzrohr für MoS2 . auf 800 °C gehalten Filmwachstum innerhalb von 5 min. Abbildung 1b zeigt das optisch mikroskopische Bild von einheitlichem MoS2 Film auf SiO2 /Si-Substrat. Nach dem Wachstum von MoS2 Film, würde es auf β-Ga2 . übertragen O3 (Tamura Corporation, Japan) Substrat über ein PMMA-unterstütztes Verfahren, [22] wie in Abb. 1c skizziert. Während des Transferprozesses wurde PMMA zuerst auf MoS2 . im gewachsenen Zustand aufgeschleudert Film als Trägerschicht, und dann wurden die Proben in KOH-Lösung eingetaucht, um das SiO2 . wegzuätzen Schicht. Anschließend die PMMA-Schicht mit MoS2 Film würde auf der Lösung schwimmen, wonach die Probe 1 Minute in entionisiertem Wasser gespült wurde, um das restliche K + . zu entfernen und weiter auf β-Ga2 . übertragen O3 Substrat. Zuletzt würde die oberste PMMA-Schicht mit Aceton entfernt. Für das nitrierte MoS2 /β-Ga2 O3 Heteroübergang wurde die Nitrierung auf dem β-Ga2 . implementiert O3 Oberfläche mit 50s N2 Plasmabehandlung bei einem Druck von 3 Pa vor dem MoS2 Transfer. Die HF-Leistung und N2 die Strömungsgeschwindigkeit betrug 100 W bzw. 80 sccm. Als Ergebnis wurden vier Proben für XPS-Messungen vorbereitet:(1) unbeschichtetes β-Ga2 O3 Substrat (Masse β-Ga2 O3 ), (2) mehrlagiges MoS2 Film auf SiO2 /Si-Substrat (wenige Schichten MoS2 ), (3) übertragenes MoS2 Film auf β-Ga2 O3 Substrat, (4) übertragenes MoS2 Film auf nitriertem β-Ga2 O3 Substrat.
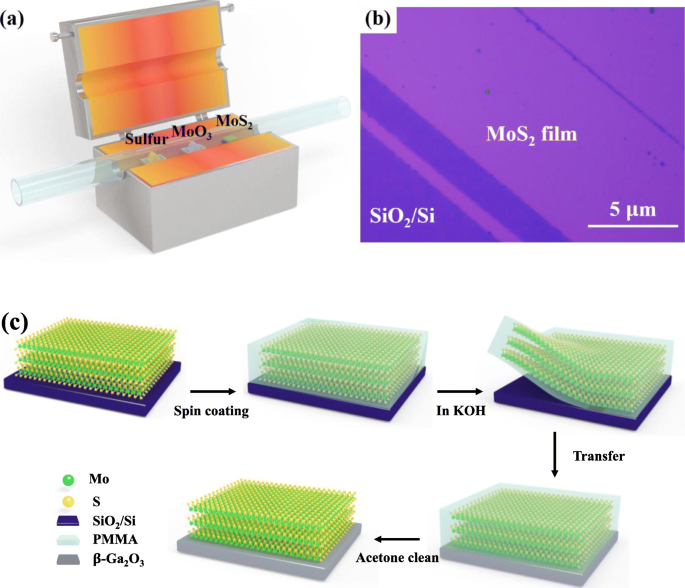
a Schematische Darstellung des Versuchsaufbaus zum CVD-Wachstum von MoS2 . b Optisches Bild für das gewachsene wenige Schichten MoS2 Film auf SiO2 /Si-Substrat. c Prozessablauf des PMMA-unterstützten Nasstransferverfahrens für das MoS2 /β-Ga2 O3 Heteroübergangsbildung
Ergebnisse und Diskussionen
Raman-Spektroskopie wurde verwendet, um die Qualität von MoS2 . mit wenigen Schichten zu untersuchen Film sowie die Überprüfung der entsprechenden Schichtnummern. Die Raman-Spektren von MoS2 Film vor und nach dem Transfer sind in Abb. 2 dargestellt, der durch RENISHAW inVia Raman-Spektroskopie charakterisiert wurde. Bei 381,91 cm −1 . konnten zwei charakteristische Raman-Moden beobachtet werden und 405,84 cm −1 , entsprechend dem Modus in der Ebene (\( {E}_{2g}^1 \)) und außerhalb der Ebene (A 1g )-Modus bzw. [23, 24]. Im Vergleich zu gewachsenem MoS2 Film gibt es fast keine Raman-Verschiebung in \( {E}_{2g}^1 \) und A 1g Modi nach dem Übertragungsprozess, ein Hinweis auf unbeschädigtes MoS2 nach dem Übertragungsprozess. Der Peak bei 412,99 cm −1 nach dem Transferprozess stammt aus dem β-Ga2 O3 Substrat, in Übereinstimmung mit früheren Berichten [25]. Die Frequenzdifferenz zwischen \( {E}_{2g}^1 \) und A 1g Der Modus wurde zu 23,93 cm −1 . abgeleitet , bezeichnet vier Schichten aus wenigen Schichten MoS2 Film [26]. Ferner ist, wie im Einschub von Fig. 2 gezeigt, die Dicke von MoS2 Der Film wurde mit einem hochauflösenden Transmissionselektronenmikroskop (HRTEM) auf ungefähr 3 nm (etwa vier Schichten) verifiziert, was in guter Übereinstimmung mit unseren Raman-Spektren ist. Aus Fig. 3a ist ersichtlich, dass ein Peak mit hoher Intensität von N 1 s von dem Nitrid β-Ga2 . nachgewiesen wurde O3 Substrat, was auf Stickstoff hindeutet. Abbildung 3b zeigt die SIMS-Profile von MoS2 /β-Ga2 O3 Heteroübergang mit Nitridierung, wobei die Signale der Hauptkomponenten, dargestellt durch Mo, N und Ga, gegen die Tiefe aufgetragen sind. Es wird beobachtet, dass sich der N-Peak beim MoS2 . befindet /β-Ga2 O3 Grenzfläche, und das N breitet sich in β-Ga2 . aus O3 Substrat könnte durch die N-Injektion in die darunterliegende Schicht während der Plasmabehandlung oder Primärstrahlbombardierungen beigetragen werden. Das höhere Ga-Profil im MoS2 Schicht als β-Ga2 O3 Substrat stammt wahrscheinlich aus der unterschiedlichen Ionenausbeute in der unterschiedlichen Materialmatrix [27]. Darüber hinaus ist der Mo-Schwanz in β-Ga2 O3 könnte dem Diffusions- oder Tiefenauflösungsproblem zugeschrieben werden, das durch den Primärstrahlbeschuss verursacht wird [28].
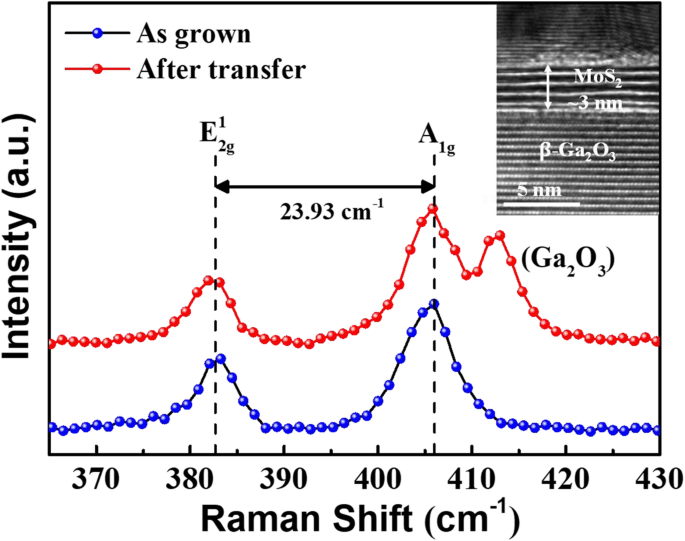
Raman-Spektren von gewachsenem MoS2 auf SiO2 /Si-Substrat und übertragenes MoS2 auf β-Ga2 O3 Substrat bzw. Der Einschub zeigt eine Querschnitts-Transmissionselektronenmikroskopie (TEM)-Aufnahme von hergestelltem MoS2 /β-Ga2 O3 Heteroübergang
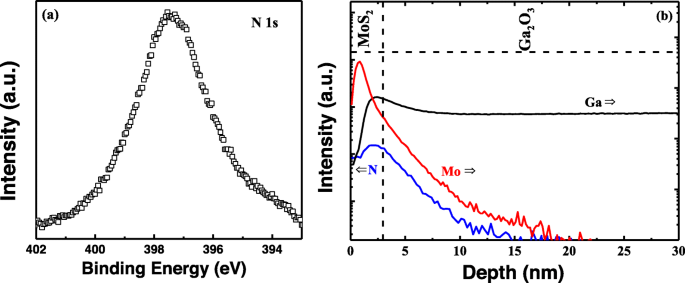
a N 1 s XPS-Spektrum von β-Ga2 O3 Substrat mit Oberflächennitrierung. b SIMS-Tiefenprofil von hergestelltem MoS2 /β-Ga2 O3 Heteroübergang
Um die Bandausrichtungen von MoS2 . zu erhalten /β-Ga2 O3 Heterojunctions wurden XPS-Messungen mit einer Stufe von 0,05 eV an einem VG ESCALAB 220i-XL-System mit einer monochromatischen Al Kα-Röntgenquelle (hν =1486,6 eV) durchgeführt. Die konstante Durchgangsenergie wurde auf 20 eV eingestellt. Zusätzlich wurde der Standard C 1 s (284,8 eV) zur Kalibrierung der Bindungsenergie (BE) verwendet [29]. Um den Valenzband-Offset (VBO) am MoS2 . auszuwerten /β-Ga2 O3 Schnittstelle, Mo 3d und Ga 3d Core Levels (CLs) wurden für MoS2 . mit wenigen Schichten verwendet und β-Ga2 O3 Proben bzw. Abbildung 4a zeigt den XPS-Schmalscan von Mo 3d und Valenzbandspektren von MoS2 . mit mehreren Schichten [30]. Die Bindungsenergiedifferenz (BED) zwischen CLs von Mo 3d5/2 und Valenzbandmaximum (VBM) für MoS2 wurde mit 228,59 ± 0,1 eV berechnet. Wie in Fig. 4b gezeigt, ist die BE von Ga 3d CL und VBM aus wenigen Schichten β-Ga2 O3 wurden zu 20,25 ± 0,05 bzw. 3,23 ± 0,05 eV abgeleitet. Die entsprechende BED wurde zu 17,02 ± 0,1 eV bestimmt, was gut mit der von Sun et al. [31]. Abbildung 4c zeigt die gemessenen XPS-Spektren von Mo 3d und Ga 3d CLs für MoS2 /β-Ga2 O3 Heteroübergänge mit/ohne Nitrierung. Es wird darauf hingewiesen, dass die Mo 3d5/2 CL verschob sich von 228,95 ± 0,05 eV für den nicht nitrierten Heteroübergang zu 229,60 ± 0,05 eV für den nitrierten Heteroübergang, während sich Ga 3d CL von 20,25 ± 0,05 auf 20,65 ± 0,05 eV verschob. Basierend auf der Methode von Kraut[32] ist der Valenzband-Offset (VBO, ∆E V ) aus mehrlagigem MoS2 /β-Ga2 O3 Heteroübergänge wurde nach der folgenden Gleichung berechnet:
$$ \Delta {E}_V=\left({E}_{Mo\ 3{d}_{5/2}}^{Mo{S}_2}-{E}_{VBM}^{Mo{ S}_2}\right)-\left({E}_{Ga\ 3d}^{Ga_2{O}_3}-{E}_{VBM}^{Ga_2{O}_3}\right)-{\ Delta E}_{CL} $$ (1)
a XPS-Spektren von Mo 3d CL und Valenzband von mehrschichtigem MoS2 . b XPS-Spektren von Ga 3d CL und Valenzband von β-Ga2 O3 Substrat. c XPS-Spektren von Mo 3d- und Ga 3d-CLs für hergestelltes MoS2 /β-Ga2 O3 Heteroübergang mit/ohne Oberflächennitrierung. d XPS-Spektren von O 1 s CL-Energieverlust von β-Ga2 O3 Substrat mit/ohne Oberflächennitrierung
wobei \( {E}_{Mo\ 3{d}_{5/2}}^{Mo{S}_2} \) und \( {E}_{VBM}^{Mo{S}_2} \ ) sind Bindungsenergien von Mo 3d5/2 CL und VBM von MoS2 , \( {E}_{Ga\ 3d}^{Ga_2{O}_3} \), und \( {E}_{VBM}^{Ga_2{O}_3} \) sind Bindungsenergien von Ga 3d CL und VBM aus β-Ga2 O3 , \( {\Delta E}_{CL}=\Big({E}_{Mo\ 3{d}_{5/2}}^{Mo{S}_2}-{E}_{Ga\ 3d}^{Ga_2{O}_3} \)) ist die Bindungsenergiedifferenz zwischen Mo 3d5/2 und Ga 3d CLs für MoS2 /β-Ga2 O3 Heterojunctions. Daher ist das ∆E V von MoS2 auf β-Ga2 O3 Substrat mit und ohne N2 Die Plasmabehandlung wurde mit 2,62 ± 0,1 bzw. 2,87 ± 0,1 eV berechnet.
Abbildung 4d zeigt die O 1 s CL-Energieverlustspektren von β-Ga2 O3 Substrate mit und ohne Nitrierung. Es ist anzumerken, dass die Bandlücke nach der Nitridierungsbehandlung mit einem Wert von 4,70 ± 0,1 eV unverändert bleibt. Somit kann der Leitungsband-Offset wie folgt extrahiert werden:
$$ {\Delta E}_C={E}_g^{Ga_2{O}_3}-{E}_g^{Mo{S}_2}-{\Delta E}_V $$ (2)wobei \( {E}_g^{Ga_2{O}_3} \) und \( {E}_g^{Mo{S}_2} \) die Bandlücken von β-Ga2 . sind O3 und mehrschichtiges MoS2 , bzw. Die Bandlücke von 1,4 ± 0,1 eV für mehrlagiges MoS2 wurde in dieser Arbeit verwendet. 34 Nach Gl. (2), das ∆E C zwischen MoS2 und β-Ga2 O3 mit und ohne Nitrierung wurden zu 0,68 ± 0,1 bzw. 0,43 ± 0,1 eV abgeleitet. Die berechneten Banddiagramme für Heteroübergänge ohne/mit Nitridierung sind in Fig. 5(a) bzw. 5(b) gezeigt.
Als nächstes wurden die elektronischen Strukturen von nitrierten und nicht nitrierten Heteroübergängen mit dem Vienna Ab-initio-Simulationspaket (VASP) basierend auf Dichtefunktionaltheorie (DFT) weiter untersucht [33,34,35]. Für die Austauschkorrelationsfunktion wurde die generalisierte Gradientenapproximation (GGA) der Perdew-Burke-Ernzerhof (PBE)-Parametrierung übernommen [36, 37]. Wir haben den DFT-D3-Dispersionskorrekturansatz verwendet, um die Langstrecken-Van-der-Waals-(vdW)-Wechselwirkungen zu beschreiben [38,39,40]. Zur Beschreibung der Kern-Valenz-Wechselwirkung mit einem kinetischen Energie-Cutoff von 650 eV für die Expansion der ebenen Welle wurde die Projector Augmented Wave (PAW) Pseudopotential-Methode verwendet. Wir verwenden ein 4 × 4 × 1 G-zentriertes k-Mesh zur strukturellen Relaxation der Elementarzelle mit dem kleinsten Abstand zwischen den k-Punkten von 0.04 Å −1 , was durch den Konvergenztest bezüglich der Anzahl von k Punkten genau genug ist. Die Konvergenzschwellen sind auf 10 –4 . eingestellt eV für Energiedifferenzen des Systems und 10 −2 eV Å −1 für Hellman-Feynman-Kraft. Um künstliche Wechselwirkungen zwischen zwei benachbarten Atomschichten zu eliminieren, wird die Dicke der Vakuumschicht auf ~ 15 eingestellt. Die Eigenwerte der Heterojunctions werden weiter durch die Hybridfunktionalrechnungen von Heyd-Scuseria-Ernzerhof (HSE06) verifiziert, die die Genauigkeit der Eigenwerte durch Reduzierung der Lokalisierungs- und Delokalisierungsfehler von PBE- und Hartree-Fock (HF)-Funktionalen verbessern [41]. Das Mischungsverhältnis beträgt 25 % für den kurzreichweitigen HF-Austausch. Der Screening-Parameter beträgt 0,2 Å −1 .

Banddiagramme von MoS2 /β-Ga2 O3 Heteroübergang a ohne und b mit Oberflächennitrierung
Das MoS2 /β-Ga2 O3 Heteroübergänge wurden wie in Fig. 6a gezeigt konstruiert. Die Methode der Universal Binding Energy Relation (UBER), die eine einfache universelle Form für die Beziehung zwischen Bindungsenergie und Atomabstand bietet, [42] wurde angewendet, um die energetisch stabile Struktur vor der elektronischen Strukturberechnung zu bestimmen. Es wurden verschiedene Abstände zwischen den Schichten berücksichtigt und die Oberflächenadhäsionsenergie W Anzeige für die Heterojunctions sind unten gezeigt,
$$ {W}_{ad}=\frac{E_{Ga_2{O}_3}+{E}_{Mo{S}_2}-{\mathrm{E}}_{Ga_2{O}_3/ Mo {S}_2}}{A} $$
Atomstruktur und Ladungsdichteverteilungen von β-Ga2 O3 -MoS2 gestapelte Heterostrukturen a ohne und b mit Stickstoff-Dotierstoffen in einer 4 × 4 × 1-Superzelle aus der Seitenansicht. Ga (O)-Atome sind rot (grau) und Mo (S)-Atome blau (orange). Bandstrukturen von MoS2 /β-Ga2 O3 Heterostrukturen c ohne und d mit Stickstoff-Dotierstoffen
wobei A die Grenzflächenfläche, \( {E}_{Ga_2{O}_3} \), \( {E}_{Mo{S}_2} \) und \( {E}_{Ga_2{O }_3/Mo{S}_2} \) sind die Gesamtenergien von β-Ga2 O3 , einschichtiges MoS2 und das MoS2 /β-Ga2 O3 Heteroübergang bzw. Sobald das W Anzeige ein Maximum erreicht, wird der optimale Zwischenschichtabstand erhalten. Nach Strukturoptimierungen wird ein Stickstoffatom im ursprünglichen MoS2 . substituiert /β-Ga2 O3 Heteroübergang, wie in Fig. 6b gezeigt. Die Stickstoffkonzentration in der DFT-Berechnung beträgt etwa 4,17%, was nahe der (3,61%) in Experimenten liegt. Die elektronischen Strukturen für nitriertes und unnitriertes MoS2 /β-Ga2 O3 Heteroübergänge wurden wie in Fig. 6c und d dargestellt berechnet. Es wurde festgestellt, dass Zustände mit mittlerer Lücke eingeführt wurden, die den Ladungstransfer über das MoS2 . verbessern können /β-Ga2 O3 Grenzfläche, und der resultierende Grenzflächendipol trug zur gemessenen Verschiebung der Bindungsenergie bei. Darüber hinaus sind die berechneten Leitungsband-Offsets ∆E C (\( \Delta {E}_C={E}_{CB}^{Mo{S}_2}-{E}_{CB}^{Ga_2{O}_3} \)) für undotiert- und dotiert- β-Ga2 O3 /MoS2 Heteroübergänge betragen 0,82 bzw. 1,0 eV, was den gleichen Trend wie bei den experimentellen Ergebnissen zeigt. Wir haben auch die Eigenwerte von \( {E}_{CB}^{Mo{S}_2} \) und \( {E}_{CB}^{Ga_2{O}_3} \) mit der HSE06-Methode berechnet um die obige Schlussfolgerung weiter zu bestätigen und festzustellen, dass das korrigierte ∆E C sind 0,87 und 1,08 eV für undotiertes und dotiertes β-Ga2 O3 /MoS2 bzw. Heterojunctions.
Schlussfolgerungen
Zusammenfassend, jeweiliges MoS2 Film wurde auf unnitriertes und Nitrid β-Ga2 . übertragen O3 zum Bau von MoS2 /β-Ga2 O3 Heterojunctions. Die Qualität des übertragenen MoS2 . wurde mit Raman-Spektroskopie untersucht Film, und SIMS-Studie wurde durchgeführt, um die elementaren Tiefenprofile des MoS2 . zu untersuchen /β-Ga2 O3 Heteroübergang mit Nitridierung. Die VBOs wurden mit 2,62 ± 0,1 eV für nitriertes MoS2 . bestimmt /β-Ga2 O3 Heteroübergang bzw. 2,87 ± 0,1 eV für unnitrierten Heteroübergang durch XPS. Die resultierenden CBOs wurden zu 0,68 ± 0,1 und 0,43 ± 0,1 eV abgeleitet, was den gleichen Trends wie bei den DFT-Rechnungen entspricht. Diese Ergebnisse zeigten, dass die Bandversätze durch einen Oberflächennitrierungsprozess modifiziert werden können. Diese Studie bietet großartige Perspektiven auf die Implementierung von entworfenen elektronischen Geräten, die auf vertikalen 2D/3D-Heterojunctions basieren.
Verfügbarkeit von Daten und Materialien
Die Datensätze, die die Schlussfolgerungen dieses Manuskripts unterstützen, sind im Manuskript enthalten.
Abkürzungen
- β-Ga2 O3 :
-
Beta-Galliumoxid
- SL:
-
Einschichtig
- MoS2 :
-
Molybdändisulfid
- XPS:
-
Röntgenphotoelektronenspektroskopie
- CBO:
-
Leitungsband-Offset
- VBO:
-
Valenzband-Offset
- Lebenslauf:
-
Chemische Gasphasenabscheidung
- PMMA:
-
Poly(methylmethacrylat)
- HRTEM:
-
Hochauflösendes Transmissionselektronenmikroskop
- SIMS:
-
Sekundärionen-Massenspektrometrie
- BE:
-
Bindungsenergie
- BETT:
-
Bindungsenergiedifferenz
- CL:
-
Kernstufe
- VBM:
-
Valenzband-Maximum
- VASP:
-
Wien-Ab-initio-Simulationspaket
- DFT:
-
Dichtefunktionaltheorie
- GGA:
-
Verallgemeinerte Gradienten-Approximation
- PBE:
-
Perdew-Burke-Ernzerhof
- PAW:
-
Projektor-verstärkte Welle
- UBER:
-
Universelle Bindungsenergiebeziehung
Nanomaterialien
- MoS2 mit kontrollierter Dicke für die elektrokatalytische Wasserstoffentwicklung
- Grenzflächen-, elektrische und Bandausrichtungseigenschaften von HfO2/Ge-Stapeln mit in situ gebildeter SiO2-Zwischenschicht durch plasmaunterstützte Atomlagenabscheidung
- Elektrogesponnene Polymer-Nanofasern, dekoriert mit Edelmetall-Nanopartikeln für die chemische Sensorik
- Hochleitfähige PEDOT:PSS transparente Lochtransportschicht mit Lösungsmittelbehandlung für Hochleistungs-Silizium/organische Hybridsolarzellen
- Temperaturabhängige Kristallisation von MoS2-Nanoflocken auf Graphen-Nanoblättern für die Elektrokatalyse
- Elektrische Eigenschaften von Verbundmaterialien mit durch ein elektrisches Feld unterstützter Ausrichtung von Nanokohlenstoff-Füllstoffen
- Monodisperse Kohlenstoff-Nanosphären mit hierarchischer poröser Struktur als Elektrodenmaterial für Superkondensatoren
- Sequentiell dampfgezüchteter Hybridperowskit für planare Heterojunction-Solarzellen
- Untersuchung einer kristallinen Silizium-Solarzelle mit schwarzer Siliziumschicht auf der Rückseite
- Polarisationskonverter mit steuerbarer Doppelbrechung basierend auf einer hybriden volldielektrischen Graphen-Metaoberfläche



