Auswirkung der in HfOx-Dünnschichten dispergierten Ag-Konzentration auf die Schwellenschaltung
Zusammenfassung
Ein Schleichpfadstrom – ein Strom, der durch eine benachbarte Speicherzelle fließt – ist ein inhärentes und unvermeidliches Problem in einem aus Memristor-Speicherzellen bestehenden Kreuzschienen-Array. Dieses ernsthafte Problem kann durch serielles Verbinden der Selektorvorrichtung mit jeder Memristorzelle gemildert werden. Unter den verschiedenen Arten von Auswahlvorrichtungskonzepten hat der diffusive Auswahlschalter aufgrund seiner hervorragenden Leistung beträchtliche Aufmerksamkeit auf sich gezogen. Dieser Selektor verfügt über eine flüchtige Schwellenschaltung (TS) unter Verwendung der Dynamik von aktiven Metallen wie Ag oder Cu, die als Elektrode oder Dotierstoff im Festelektrolyten wirken. In dieser Studie wurde ein diffusiver Selektor basierend auf Ag-dotiertem HfOx wird unter Verwendung einer Co-Sputter-Anlage hergestellt. Da die Ag-Konzentration im HfOx Schicht variiert, werden unterschiedliche elektrische Eigenschaften und dadurch TS-Eigenschaften beobachtet. Die Notwendigkeit des Galvanoformungsverfahrens (EF) für die TS-Charakteristik wird durch die richtige Ag-Konzentration im HfOx . bestimmt Schicht. Dieser Unterschied im EF-Prozess kann die Parameter der TS-Eigenschaften erheblich beeinflussen. Daher ist eine optimierte Dotierungsbedingung für einen diffusiven Selektor erforderlich, um ein ausgezeichnetes Verhalten der Selektorvorrichtung zu erreichen und einen EF-Prozess zu vermeiden, der schließlich die Leistung der Vorrichtung verschlechtern kann.
Einführung
Widerstandsschaltspeicher, auch als Memristor bekannt, wird seit Jahrzehnten als vielversprechender Kandidat für nichtflüchtige Speicher der nächsten Generation untersucht. Kürzlich wurden Memristor-Bauelemente auf künstliche Synapsen und Neuronen angewendet, die ihrem auf Ionenmigration basierenden Schaltmechanismus für gehirninspiriertes Computing ähneln [1,2,3]. Schnelle Schaltgeschwindigkeit (< 1 ns), extreme Skalierbarkeit (< 2 nm), ziemlich gute Ausdauer (bis zu 10 11 Programmier-/Löschzyklen) und dreidimensionale Stapelstruktur haben sich bisher in einzelnen memristiven Systemen bewährt [4,5,6]. Darüber hinaus können Bildverarbeitung und Mustererkennung durch den Aufbau eines großen Crossbar-Arrays (CBA) ermöglicht werden [1, 3, 7, 8].
Eine CBA-Struktur hat jedoch ein inhärentes Problem darin, dass ein Kriechpfadstrom durch benachbarte Memristor-Speicherzellen die Schreib-/Leseoperationen an der ausgewählten oder halb ausgewählten Zelle stört [9,10,11]. Um das Problem des Schleichpfadstroms und der Halbauswahl zu unterdrücken, kann eine Auswahlvorrichtung mit zwei Anschlüssen seriell mit jeder Speicherzelle verbunden werden. Es gibt viele Arten von Auswahlvorrichtungen mit nichtlinearer Strom-Spannung (I -V ) eingeführte Charakteristika, wie Schottky-Dioden, Metall-Isolator-Übergänge (MITs), Ovonische Schwellenwertschalter (OTSs), Tunnelbarrieren-Selektoren und diffusive Selektoren (auch als diffusive Memristoren bezeichnet) [9,10,11,12,13,14 ,fünfzehn]. Unter ihnen hat ein diffusiver Selektor auf der Grundlage der Diffusionsdynamik von Metallspezies (Ag oder Cu) im Inneren der Dielektrika aufgrund seiner einfachen Struktur und überlegenen Leistung, wie z. 19,20,21,22]. Der diffusive Selektor verfügt über einen flüchtigen Schwellwertschalter (TS), der auf der Bildung und dem Selbstbruch von Metallfäden basiert. Bisher wurden verschiedene diffusive Selektorsysteme und ihre dynamischen Eigenschaften beschrieben; das Verständnis des zugrunde liegenden Operationsmechanismus bleibt jedoch schwierig. Darüber hinaus ist es notwendig, die Konzentration und Verteilung der diffusiven Metallspezies festzulegen, um eine hervorragende TS-Leistung zu erzielen, da diese die elektrische Leitfähigkeit und die Übergangseigenschaften erheblich beeinflussen können.
Hier haben wir ein Pt/Ag-dotiertes HfOx . hergestellt /Pt-Stack als diffusiver Selektor, in dem Ag und HfOx wirken als diffusives Metall-Dotiermittel bzw. dielektrisches Material. Wir haben die elektrischen Eigenschaften der Bauelemente bei unterschiedlichen Dotierungskonzentrationen untersucht, um die geeigneten Bedingungen für die TS-Charakteristik in Beziehung zu setzen. Galvanoformungs-erforderliche (EF-erforderlich) und Galvanoformungs-freie (EF-frei) TS-Eigenschaften wurden durch die Dotierstoffkonzentration in den diffusiven Selektoren bestimmt. Um den Unterschied im Galvanoformungsprozess (EF) und die nachfolgenden TS-Eigenschaften zu erklären, führten wir strukturelle und chemische Analysen der diffusiven Selektorvorrichtungen durch. Unsere Studie legt den Effekt der Dotierstoffkonzentration auf die TS-Eigenschaften des diffusiven Selektors nahe und liefert eine Richtung zur Verbesserung seiner Leistung.
Methoden
Abbildung 1a zeigt ein Co-Sputter-System mit einem Ag und HfO2 Ziel. Wir stellten Geräte her, die an vier Positionen auf dem Substrat mit einem Abstand von 0,5 cm voneinander platziert wurden. Die Positionen befanden sich in der Nähe des HfO2 Ziel in der Reihenfolge von Gerät 1, 2, 3 und 4 (D1, D2, D3 und D4), wie in Abb. 1a gezeigt. Das Ag-dotierte HfOx Schaltschicht aller Bauelemente wurde auf Pt/Ti/SiO2 . abgeschieden /Si-Substrat durch Co-Sputtern mit einer Sputterleistung von 10 W für Ag und 150 W für HfO2 , bzw. Vor dem Abscheidungsprozess wurde der Basisdruck der Vakuumkammer auf ~ 5 × 10 6 . evakuiert . Die Schaltschicht wurde 5 min lang abgeschieden, ohne das Substrat bei Raumtemperatur unter einem Ar-Fluss von 20 sccm zu drehen, um das Ar-Plasma aufrechtzuerhalten. Der Prozessdruck betrug 10 mTorr. Danach wurde die obere Pt-Elektrode auf einer wie abgeschiedenen Schaltschicht unter Verwendung einer Lochmaske mit einem Durchmesser von 200 &mgr;m durch Elektronenstrahlverdampfung abgeschieden. Abbildung 1 b und c zeigen das Querschnittsbild bzw. das schematische Design des hergestellten Geräts.
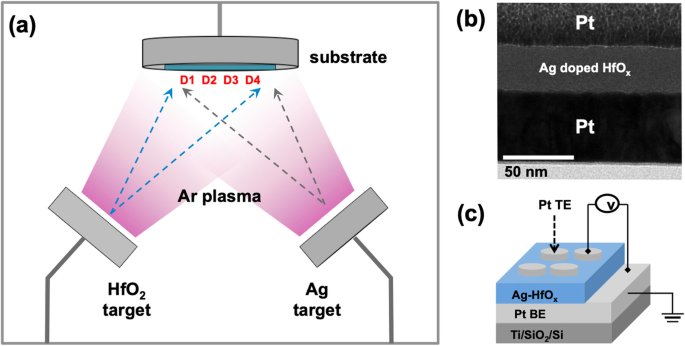
a Schematische Darstellung einer Co-Sputteranlage. b TEM-Querschnittsbild des hergestellten Geräts. c Schematische Darstellung des Gerätes mit dem elektrischen Messsystem
Die Dicke der durch Co-Sputtern abgeschiedenen Schaltschicht wurde mit einem Ellipsometer (FS-1, Film-Sense, USA) gemessen. Rutherford-Rückstreuspektrometrie (RBS; 6SDH-2, NEC, USA) und Röntgenfluoreszenzspektrometrie (XRF; ARL, Thermo Fisher Scientific, USA) wurden durchgeführt, um die atomare Zusammensetzung des Ag-dotierten HfOx Schicht. Zur Bewertung der elektrischen Eigenschaften der Vorrichtung wurde ein Halbleiterparameteranalysator (SPA; HP-4155A, Agilent, USA) bei Raumtemperatur verwendet. Alle Messungen wurden durchgeführt, indem eine Vorspannung an die obere Elektrode angelegt wurde, während die untere Elektrode geerdet war, wie in Abb. 1c gezeigt. Die Oberfläche der Vorrichtungen wurde unter Verwendung eines Feldemissions-Rasterelektronenmikroskops (FE-SEM; JSM-6700F, JEOL, Japan) und eines Rasterkraftmikroskops (AFM; XE-100, Park System, Korea) analysiert. Die Querschnittsproben der Geräte wurden mit einem fokussierten Ionenstrahl (FIB; Quanta 3D FEG, FEI, Niederlande) hergestellt und mit einem hochauflösenden Transmissionselektronenmikroskop (HR-TEM:JEM-2100F, JEOL, Japan .) beobachtet ). Die chemische Zusammensetzung wurde mit energiedispersiver Röntgenspektroskopie (EDS) analysiert.
Ergebnisse und Diskussion
Wir haben gleichzeitig vier Ag-dotierte HfOx . hergestellt Vorrichtungen für diffusive Selektoren während eines einzigen Prozesses. Während des Abscheidungsprozesses wurde das Substrat nicht gedreht, um die Wirkung der Dotierungskonzentration auf die elektrischen Eigenschaften zu bestätigen. Tabelle 1 zeigt die Dicke, das Ag:Hf-Kationenverhältnis und den quadratischen Mittelwert (RMS) der Rauheit von D1, D2, D3 bzw. D4. Die Ag-Zusammensetzung in der Schaltschicht wurde als Kationenverhältnis unter Verwendung einer aus der XRF-Analyse erhaltenen Menge an Ag und Hf ausgedrückt. Wie gezeigt hat jede Vorrichtung eine andere Dicke und Ag-Konzentration. Mit zunehmendem Abstand vom HfO2 Targets nahm die Schaltschichtdicke ab, während die Ag-Zusammensetzung in der Oxidschicht zunahm. Mit steigender Ag-Konzentration stiegen die RMS-Rauheitswerte leicht an (AFM-Bilder sind in Zusatzdatei 1:Abbildung S1) zu sehen.
Gleichstrom (DC)–Spannung (I -V ) von allen Geräten gemessene Eigenschaften sind in Abb. 2a–d dargestellt. D1 (35,3 nm, 7 % Ag) befand sich anfangs in einem stark isolierenden Zustand, und während der DC-Messungen (Abb. 1a) wurde kein Schwellenschalten beobachtet, da die Ag-Konzentration trotz der dicken Schaltschicht nicht ausreichte, um einen leitenden Faden zu erzeugen. Im Gegensatz dazu zeigte D2 (27,3 nm, 16% Ag) eine Schwellenänderung von einem hochohmigen Zustand (HRS) zu einem niederohmigen Zustand (LRS) nach dem Galvanoformprozess (EF) im makellosen Zustand, um ein funktionsfähiges Gerät herzustellen wie in Abb. 1b gezeigt. Während des EF-Prozesses stieg der Strom von einem niedrigen Niveau auf einen Compliance-Strom (I cc ) bei einer Spannung von – 4.3 V. Danach zeigte D2 bei beiden Vorspannungspolaritäten bei einer niedrigeren Betriebsspannung als der Formungsspannung kontinuierlich ein TS-Verhalten. Ähnlich zeigte D3 (24 nm, 39% Ag) ein typisches bidirektionales TS-Verhalten; Der EF-Prozess war jedoch im unberührten Zustand von D3 nicht erforderlich. Mit anderen Worten, D3 präsentiert EF-freies TS-Verhalten. Im Gegensatz dazu befand sich D4 (18,8 nm, 58 Ag%) anfangs in einem hochleitenden Zustand, wahrscheinlich aufgrund von Ag-Perkolation innerhalb des dünnen HfOx Schicht aufgrund der hohen Ag-Konzentration.

Elektrische Eigenschaften der hergestellten Geräte. a I-V Kurve von D1 (stark isolierender Zustand). b I-V Kurve von D2, die den EF-Prozess und das nachfolgende TS-Verhalten zeigt. c I-V Kurve von D3, die das TS-Verhalten ohne den EF-Prozess zeigt. d I-V Kurve von D4 (leitender Zustand)
Oberflächenmorphologie und Korngröße änderten sich mit steigender Ag-Konzentration. Wie bereits erwähnt, nahmen die RMS-Rauheitswerte mit steigender Ag-Konzentration zu, wie in Tabelle 1 gezeigt. Die Korngröße wurde auch mit einem REM bewertet (zusätzliche Datei 1:Abbildung S2). Mit zunehmender Ag-Konzentration wurde eine Zunahme der Korngröße beobachtet. Im Fall von D2 und D3, die unterschiedliche TS-Eigenschaften aufweisen, war der Unterschied in der Oberflächenrauheit und Korngröße jedoch recht gering. Dennoch gab es einen erheblichen Unterschied in ihren elektrischen Eigenschaften im Hinblick auf das EF-Verfahren und die folgenden TS-Eigenschaften. Daher haben wir die TS-Eigenschaften von D2 und D3 wie folgt weiter verglichen.
Abbildung 3 a und b zeigen das wiederholbare TS-Verhalten, das in D2 und D3 mittels DC-Messung beobachtet wurde. Zum Vergleich sind in den Figuren nur die TS-Kennlinien bei negativer Vorspannung gezeigt. Beide Geräte zeigten anfänglich mehrere pA-Stromwerte bei − 0,1 V unter der Nachweisgrenze. Das TS-Verhalten in D2 war nach dem EF-Prozess bei einer Formierspannung von ~ − 3.5 V offensichtlich, während ein Compliance-Strom (I cc ) von 5 μA wurde für das Gerät eingestellt, um einen harten Ausfall zu verhindern. Nach dem EF-Prozess zeigte das Gerät ein typisches TS-Verhalten, wie in Abb. 3a gezeigt. Wenn die angelegte Spannung die Schwellenspannung (V te ) von ~ − 1.1 V erreichte der Strom plötzlich ein I cc von 5 μA; das Gerät wechselte vom AUS-Zustand in den EIN-Zustand. Der EIN-Zustand des Geräts kehrte jedoch in den AUS-Zustand zurück, wenn die angelegte Spannung auf weniger als die Haltespannung (V halten ). Obwohl das Gerät in den AUS-Zustand zurückkehrte, wurde ein höherer AUS-Strom beobachtet als der des Geräts vor EF.
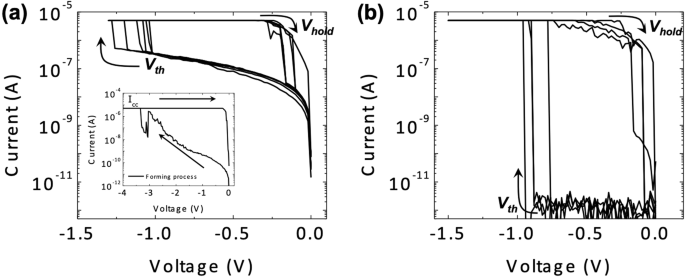
Vergleich der TS-Kennlinien in D2 und D3. a TS-Verhalten bei erhöhtem AUS-Strom nach dem EF-Prozess. Die nebenstehende Abbildung zeigt den EF-Prozess in einem abgeschiedenen Gerät. b TS-Verhalten, ohne dass der EF-Prozess einen niedrigen AUS-Strom und einen hohen NL aufrechterhält
D3 zeigte auch typische TS-Eigenschaften, wie in Abb. 3b gezeigt. Der EF-Prozess war jedoch nicht erforderlich, um das TS-Verhalten im Gerät im ursprünglichen Zustand zu induzieren. Der Strom erreichte ein I cc von 5 μA bei einem V te von ~ − 0.8 V, was der EIN-Zustand ist, und kehrte dann bei einem V . spontan in den anfänglichen AUS-Zustand zurück te kleiner als ~ − 0.2 V. Das nachfolgende D3 I -V Schleifen waren ähnlich wie beim ersten I -V Schleifen. Darüber hinaus zeigte das Gerät im Vergleich zu D2 bei einer niedrigen Betriebsspannung durchweg einen niedrigen AUS-Strom. Außerdem blieb die Stromdichte im AUS-Zustand in D3 immer noch geringer als die von D2; der Unterschied betrug ungefähr 10 5 A/cm 2 . Folglich wurde bestätigt, dass der Unterschied in der Ag-Konzentration im HfOx Schicht bestimmte die Notwendigkeit des EF-Prozesses, und im Gegenzug änderten sich die TS-Eigenschaften dramatisch.
Um einen Ein-Selektor-Eins-Widerstandsspeicher (1S1R) zu realisieren, benötigt ein Selektor einen niedrigen AUS-Strom, um den Leckstrom zu unterdrücken, und einen hohen EIN-Strom, der dem Rücksetzstrom des Widerstandsspeichers entspricht [21, 22]. Um ein solches Ich zu erfüllen -V nichtlinearen Eigenschaften haben wir die Nichtlinearität bestätigt (NL ) und Selektivität (S ) unserer Geräte und die von TS-Selektoren, von denen zuvor berichtet wurde, dass sie ihre Leistung als Selektoren bewerten [14, 18, 21, 22, 23]. Hier definieren wir NL und S unter Verwendung von Gl. (1) bzw. (2) wie folgt:
$$ NL=\frac{I_{V_{\textrm{th}}}}{I_{\frac{1}{2}{V}_{\textrm{th}}}} $$ (1) $$ S=\frac{I_{\textrm{ON}}}{I_{\textrm{OFF}}} $$ (2)NL ist definiert als das Verhältnis des Stroms bei V te und die Hälfte von V te . Im Half-Bias-Schema im Crossbar-Array ist V te wird auf die Targeting-Zelle angewendet, während die Hälfte von V te wird auf die benachbarten halbselektierten Zellen angewendet. Daher NL ist entscheidend, um eine Fehlfunktion des Crossbar-Arrays während der Programm-/Leseoperationen zu verhindern. Im Gegensatz dazu S ist das Verhältnis des Stroms im EIN-Zustand und im AUS-Zustand bei V te , die die Leistung des TS-basierten Selektors darstellt. Beide Definitionen werden häufig für den Vergleich der Leistung von Selektorgeräten verwendet. Also große NL und S Werte sind für den 1S1R-Betrieb erforderlich, um den Kriechpfadstrom effektiv zu unterdrücken.
Verschiedene Schaltparameter einschließlich NL und S in unseren Geräten und die TS-Selektoren in der Literatur sind in Tabelle 2 dargestellt. Im Fall von D2 verursacht eine Erhöhung des AUS-Stroms eine signifikante Verringerung von NL und S . Im Gegensatz dazu ist der D3 OFF-Strom ausreichend niedrig, sodass ein größer als 10 6 NL und S erworben wurden. D2 und D3 konnten jedoch nur bei einem niedrigen I . eine TS-Charakteristik aufweisen cc (< 10 μA), weil TS bei einem höheren I . zum Speicherwechsel übergegangen ist cc . Es ist bekannt, dass die meisten TS-Selektorvorrichtungen, die Ag-Filament verwenden, einem Übergang des Umschaltens des nichtflüchtigen Speichers bei einem I . unterliegen cc größer als 10–100 μA [23,24,25,26]. Wenn ich cc höher als 10–100 μA ist, wird ein robuster und stabiler Metallfaden gebildet, der im Vergleich zu dem dünnen und instabilen Faden, der bei einem niedrigeren I . gebildet wird, schwer spontan reißt cc [26, 27]. Daher können verschiedene Verfahren, wie eine Mehrschichtstruktur (Ag/TaOx /TaOy /TaOx /Ag) und Ag-Nanopunkte, die im Dielektrikum templatiert sind, wurden vorgeschlagen, um zuverlässige TS-Eigenschaften bei einem höheren I . zu erhalten cc [21, 22].
Um die Größe und Verteilung der Ag-Atome innerhalb des HfOx . zu beobachten Schicht-, HR-TEM- und EDS-Elementaranalysen wurden an D2 und D3 durchgeführt. Abbildung 4 a und b (c und d) zeigen HR-TEM-Querschnittsbilder von D2 (D3). Laut den HR-TEM-Bildern ist es wahrscheinlich, dass die Atomgröße von Ag gleichmäßig im HfOx . verteilt ist Matrix. In beiden Geräten wurden keine unterscheidbaren Ag-Partikel oder Ag-Cluster mit einer Größe von wenigen Nanometern beobachtet. Darüber hinaus ist das HfOx Die amorphe Phase wurde über ein Bild einer schnellen Fourier-Transformation (FFT) bestätigt, wie in den Einfügungen von Fig. 4 b und d gezeigt. Das Ag-Signal in den Linienprofilen weist jedoch auf das Vorhandensein von Ag im HfOx . hin Schicht. Daraus wird geschlossen, dass Ag in HfOx im atomaren Maßstab verteilt wäre. Der Schaltbereich einschließlich des Ag-Nanofilaments sollte untersucht werden; die TS-Eigenschaften sind jedoch volatil, sodass in Zukunft eine In-situ-TEM-Beobachtung versucht werden sollte.
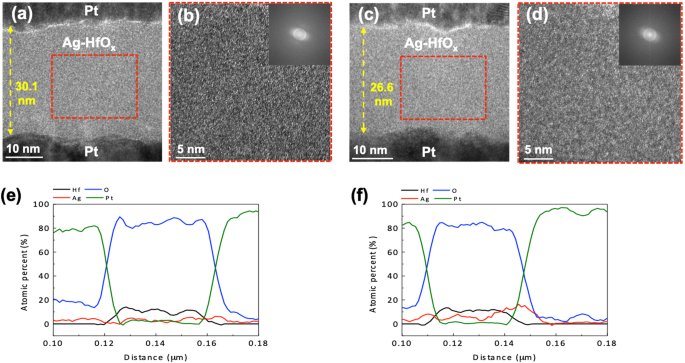
Mikrostruktur- und Zusammensetzungsanalyse. a TEM-Querschnittsbild von D2. b Vergrößertes TEM-Bild von D2. Der Einschub ist das entsprechende FFT-Bild. c TEM-Querschnittsbild von D3. d Vergrößertes TEM-Bild von D3. Der Einschub ist das entsprechende FFT-Bild. EDS-Elementarlinienprofile von e D2 und f D3
Wir schlagen den folgenden Mechanismus für TS-Verhalten in unseren Geräten vor, wie in Abb. 5 a und b gezeigt. Das so hergestellte Ag-dotierte HfOx Schaltschichten haben gleichmäßig verteilte Ag-Atome im HfOx . Es wird jedoch erwartet, dass aufgrund der geringen Ag-Konzentration in D2 ein relativ großer Abstand zwischen den Ag-Atomen besteht. Abbildung 5a zeigt den EF-Prozess von D2 im Fertigungszustand. Wenn ein elektrisches Feld an das Gerät in einem unberührten Zustand angelegt wird, werden Ag-Atome im HfOx kann zu Ag + . oxidiert werden Ionen und wandern entlang der Feldrichtung. Das oxidierte Ag + Ionen werden an der anderen Pt-Elektrode wieder zu Ag-Atomen reduziert, wo ein Ag-leitendes Filament kontinuierlich wachsen kann. Sobald das Filament zwischen den beiden Elektroden angeschlossen ist, wird das Gerät von einem AUS-Zustand in einen EIN-Zustand geschaltet. Während des EF-Prozesses in D2 konnten aufgrund des hohen elektrischen Feldes größere Ag-Cluster gebildet werden. Aus der Literatur in situ TEM-Beobachtungen wurde festgestellt, dass ein so großes elektrisches Feld ausreicht, um Ag-Nanopartikel mit mehreren Nanometern Durchmesser zu bilden [14, 15]. Nachdem das angelegte elektrische Feld entfernt wurde, diffundiert Ag im atomaren Maßstab in das HfOx Matrix, die anzeigt, dass das Gerät in den AUS-Zustand zurückversetzt wird. Größere Ag-Cluster, die nicht ausreichend ausdiffundieren können, bleiben jedoch auf der Leiterbahn. Somit führen diese restlichen Ag-Cluster zu einem größeren AUS-Strom im nachfolgenden AUS-Zustand. Im Gegensatz dazu wird im Fall von D3 im Herstellungszustand, wie in Fig. 5b gezeigt, ein Ag-Filament ohne Bildung von Ag-Clustern gebildet, da D3 unter dem niedrigen elektrischen Feld betrieben wird, was bedeutet, dass die Vorrichtung einen niedrigen AUS-Strom aufrechterhalten kann. Wenn das angelegte elektrische Feld entfernt wird, kehrt das Gerät aufgrund des spontanen Bruchs des Ag-Filaments in den AUS-Zustand zurück, der durch den Thomson-Gibbs-Effekt der Minimierung der Grenzflächenenergie zwischen einem Filament und einer Matrix erklärt werden kann [15, 18 , 28]. Folglich können bidirektionale TS-Eigenschaften durch wiederholbare Ag-Atom/-Ionen-Diffusionsdynamik erreicht werden.
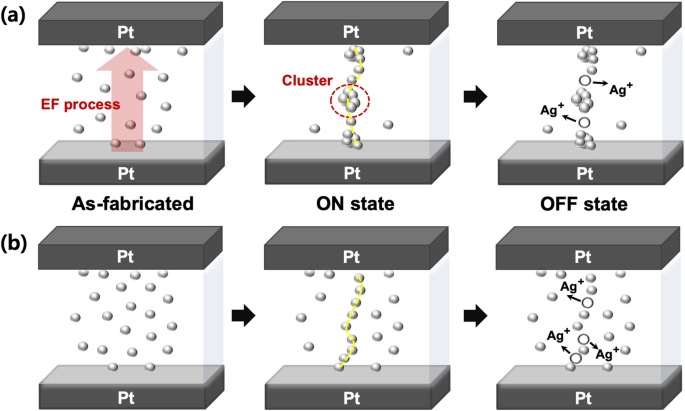
Vorgeschlagener Mechanismus von TS in einem Ag-dotierten HfOx-Gerät. Die erste Ag-Filament-Bildung/-Bruch für das TS-Verhalten in a EF-benötigt (D2) und b EF-freie (D3) Geräte
Um den Unterschied während des EF-Prozesses zu erklären, schlagen wir die folgenden Gl. (3) und (4):
$$ D={D}_0\mathit{\exp}\left(-\frac{E_{\mathrm{mo}}}{kT}\right) $$ (3)wo D ist die Diffusivität, D 0 ist der präexponentielle Faktor, E mo ist die Migrationsbarriere bei null Bias, k ist die Boltzmann-Konstante und T ist die lokale absolute Temperatur. Um das Ag-Filament innerhalb des HfOx . zu bilden Schicht müssen Ag-Ionen eine Migrationsbarriere überwinden, um sich in Richtung der negativ vorgespannten Elektrode zu bewegen. Wenn die externe Vorspannung angelegt wird, kann das elektrische Feld die Migrationsbarriere senken, E m , was zu Ionenwanderungen entlang der Feldrichtung wie folgt führt:
$$ {E}_{\mathrm{m}}={E}_{\mathrm{m}\mathrm{o}}-\frac{e\bullet {V}_{\mathrm{bias}}}{ Z_{\mathrm{box}}}\bullet \Updelta z $$ (4)mit einer Elektronenladung e , Vorspannung V Voreingenommenheit , HfOx Schichtdicke Z box , und Ag-Hopping-Distanz in der z Richtung ∆z . Tatsächlich können Ag-Ionen unter Null-Vorspannung in alle Richtungen springen. Wir haben jedoch überlegt, entlang der z . zu hüpfen Richtung im EF-Prozess, da die Vorrichtung unter dem hohen elektrischen Feld in den EIN-Zustand geschaltet werden kann, wo Ag-Ionen dominant entlang der Richtung des elektrischen Felds hüpfen. Um das E zu schätzen m , berechneten wir die Ag-Hopping-Distanz (∆z ) als 0,67 nm in D2 und 0,45 nm in D3 aus unseren experimentellen Ergebnissen der Ag-Konzentration und Filmdicke. Die Migrationsbarriere bei null Bias, E mo = 3.02 eV, wurde aus der Literatur verwendet [29]. Bei der ersten Bildung des Ag-Filaments war ein elektrisches Feld von ~ 1.6 MV/cm in D2 erforderlich und es senkte die Migrationsbarriere um 0.11 eV. Im Gegensatz dazu war für das erste Umschalten in D3 ein elektrisches Feld von ~ 0.4 MV/cm erforderlich und es senkte die Migrationsbarriere um 0.04 eV. Somit ist die Ag-Diffusion ausreichend, um den Ag-Filament in D3 trotz der geringeren Barrierereduktion aufgrund der kurzen Sprungstrecke und der hohen Ag-Konzentration im Vergleich zu denen von D2 zu bilden. Aufgrund der relativ langen Sprungstrecke in D2 war jedoch die größere Barrierereduktion für eine ausreichende Diffusion zur Bildung eines Ag-Filaments erforderlich. Sobald sich der Glühfaden gebildet hat, sollte er spontan reißen, indem die Spannung eingestellt wird; jedoch konnte das Ag-Filament nicht vollständig in seine ursprüngliche Verteilung diffundieren, und damit die Sprungstrecke ∆z verringert sich gegenüber dem von D2 im Herstellungszustand. Daher führte dieses Ergebnis zu einem verringerten elektrischen Feld (~ 0,4 MV/cm) beim nachfolgenden Schwellenschalten. Es sollte beachtet werden, dass die Filmdicke das I . erheblich beeinflusst -V Eigenschaften des Geräts. Daher haben wir den EF-Prozess in den Geräten mit ähnlicher Dicke, aber mit unterschiedlicher Ag-Konzentration bestätigt. Ebenso zeigten die Vorrichtungen einen Übergang von den EF-erforderlichen zu EF-freien Eigenschaften mit zunehmender Ag-Konzentration. Daher wurde gezeigt, dass die Ag-Konzentration den EF-Prozess wesentlich beeinflusst, indem sie das effektive interne elektrische Feld steuert. Das heißt, Modulieren der Ag-Konzentration und damit der Hüpfdistanz im HfOx Schicht ist erforderlich für EF-freie TS-Eigenschaften mit größerem NL und S Werte.
Schlussfolgerungen
Diffusive Selektorvorrichtungen basierend auf Ag-dotiertem HfOx dünne Filme wurden hergestellt und ihre TS-Eigenschaften wurden bewertet. Um den Einfluss der Ag-Konzentration auf die elektrischen Eigenschaften zu verstehen, wurden Geräte mit unterschiedlichen Ag-Konzentrationen bewertet. Das TS-Verhalten in den Geräten kann durch die Bildung/Selbstzerrung von Ag-Filamenten aus atomar dispergierten Ag-Atomen im HfOx . beschrieben werden . Es wurde bestätigt, dass die Ag-Konzentration den EF-Prozess beeinflussen könnte, um einen solchen metallischen Faden zu bilden. Das Gerät mit einer niedrigen Ag-Konzentration erforderte einen vorhergehenden EF-Prozess für das TS-Verhalten, während das EF-freie TS-Verhalten in dem Gerät mit einer höheren Ag-Konzentration nachgewiesen wurde. Darüber hinaus zeigte das EF-freie Gerät eine bessere TS-Leistung als das EF-benötigte Gerät in Bezug auf Nichtlinearität und AUS-Strom. Daher sind eine geeignete Dotierstoffkonzentration und -verteilungssteuerung erforderlich, um eine EF-freie Diffusionsselektorvorrichtung zu erhalten, um eine Leistungsverschlechterung aufgrund des EF-Prozesses zu verhindern.
Verfügbarkeit von Daten und Materialien
Alle Daten sind uneingeschränkt verfügbar.
Abkürzungen
- CBA:
-
Crossbar-Array
- EF:
-
Galvanoformung
- HRS:
-
Hochohmiger Zustand
- LRS:
-
Niederohmiger Zustand
- NL :
-
Nichtlinearität
- S :
-
Selektivität
- TS:
-
Schwellwertumschaltung
Nanomaterialien
- Herstellung von SrGe2-Dünnschichten auf Ge (100), (110) und (111) Substraten
- Untersuchung der Adhäsionskraft und des Glasübergangs dünner Polystyrolfolien durch Rasterkraftmikroskopie
- Ferroelektrischer Feldeffekt induzierter asymmetrischer ohmscher Schalteffekt in epitaktischen BaTiO3/Nb:SrTiO3-Heteroübergängen
- Impedanzanalyse dünner Schichten von organisch-anorganischen Perowskiten CH3NH3PbI3 mit Kontrolle der Mikrostruktur
- Runde Goldnanopartikel:Einfluss der Partikelgröße und -konzentration auf das Wurzelwachstum von Arabidopsis thaliana
- Auswirkung verschiedener CH3NH3PbI3-Morphologien auf die photovoltaischen Eigenschaften von Perowskit-Solarzellen
- Doppelfunktionen von V/SiOx/AlOy/p++Si-Gerät als Selektor und Speicher
- Auswirkung von CeO2−x/ZnO- und ZnO/CeO2−x-Doppelschichten-Heterostrukturen und Galvanoformungspolarität auf die Schalteigenschaften von nichtflüchtigem Speicher
- Auswirkung des postthermischen Temperns auf die optischen Eigenschaften von InP/ZnS-Quantenpunktfilmen
- Amorphe Vanadiumoxid-Dünnschichten als leistungsstabile Kathoden von Lithium- und Natrium-Ionen-Batterien



