Stapelfertigung von Breitband-metallischen planaren Mikrolinsen und ihren Anordnungen, die die Selbstmontage von Nanosphären mit konventioneller Photolithographie kombinieren
Zusammenfassung
Es wird demonstriert, dass ein neuartiges, kostengünstiges Batch-Fertigungsverfahren, das die Spin-Coating-Nanosphären-Lithographie (NSL) mit der konventionellen photolithographischen Technik kombiniert, die metallischen planaren Mikrolinsen und ihre Arrays effizient herstellt. Die entwickelten Mikrolinsen bestehen aus Subwellenlängen-Nanolöchern und können Licht im gesamten sichtbaren Spektrum effektiv fokussieren, wobei die Foki-Größen nahe der Rayleigh-Beugungsgrenze liegen. Durch Ändern des Abstands und des Durchmessers von Nanolöchern kann die Fokussierungseffizienz abgestimmt werden. Obwohl die zufälligen Defekte häufig während der Selbstorganisation von Nanokugeln auftreten, bleibt die Hauptfokussierungsleistung, z. B. Brennweite, Tiefenschärfe (DOF) und Halbwertsbreite (FWHM), fast unveränderlich. Diese Forschung bietet eine kostengünstige Möglichkeit, die integrierten nanophotonischen Bauelemente auf Wafer-Ebene zu realisieren.
Hintergrund
Mikrolinsen als eine Klasse der am weitesten verbreiteten optischen Komponenten, die darauf abzielen, Licht auf der Mikro-/Nanoskala zu manipulieren und zu fokussieren, haben wichtige Anwendungen wie Displaytechnologie [1], Laserstrahlkollimation [2], molekulare Detektion [3] und optische Informationsspeicherung [4]. Obwohl refraktive Mikrolinsen in kommerziellen Geräten mit hohem optischem Durchsatz häufig verwendet werden, leiden sie unweigerlich unter sperriger Größe, chromatischen und sphärischen Aberrationen [5]. Auf der anderen Seite weisen diffraktive Mikrolinsen weniger Aberration auf, aber ihre physikalische Größe und die komplexen dreidimensionalen (3D) Oberflächenprofile machen sie in miniaturisierten und hochskalierten Geräten weniger nützlich. Darüber hinaus erfordert ihre Herstellung eine präzise Ausrichtung während mehrerer lithografischer Prozesse, was auch ihre Verwendung in hochintegrierten mikro-/nano-optischen Geräten einschränkt [6, 7].
Aufgrund der einzigartigen Fähigkeit, Licht im Nanometerbereich zu leiten und zu manipulieren, wurden in den letzten Jahren erhebliche Anstrengungen zur Erforschung der Plasmonik unternommen [8,9,10]. Als eine wichtige Kategorie plasmonischer Geräte wurden plasmonische Linsen basierend auf dünnen nanostrukturierten Metallfilmen vorgeschlagen und entwickelt [11,12,13,14,15,16,17]. Oberflächenplasmonen (SPs) auf metallischen Filmen werden durch die Wechselwirkung von einfallendem Licht mit den Ladungsschwingungen an der Eintrittsfläche der Linse angeregt und in die Nanoaperturen gequetscht. Nach dem Durchlaufen der gesamten Metallschichten in bestimmten Wellenleitermoden gehen SPs wieder in die sich ausbreitenden Wellen über. Die von allen Nanoaperturen übertragenen Teilwellen interferieren miteinander und bilden in einem bestimmten Abstand von der Austrittsfläche der Linse einen Lichtfleck mit der maximalen Intensität, der auch als Fokussierfleck und Brennebene bezeichnet wird. Folglich sind metallische planare Mikrolinsen, die aus Nanoapertur-Arrays bestehen, potenzielle Kandidaten für konventionelle refraktive Linsen auf dielektrischer Basis, die eine Fokussierung im Subwellenlängenbereich und dennoch eine Breitbandfokussierung hervorbringen und eine vollständig optische oder optoelektronische Einzelchip-Integration ermöglichen. Alle Mikrolinsen, die aus Nanostrukturen bestehen, erfordern jedoch hochpräzise Nanofabrikationstechniken wie Elektronenstrahllithographie (EBL) und fokussiertes Ionenstrahlfräsen (FIB). Obwohl es sich um leistungsstarke Werkzeuge für das Prototyping von Mikrolinsen handelt, sind diese Prozesse teuer, zeitaufwändig und nicht für die großflächige parallele Fertigung geeignet.
Kürzlich wurde über eine Art Mikrolinse auf der Basis von Nanolöchern berichtet, die alle Wellenlängen im sichtbaren Spektrum auf einen einzigen Punkt fokussieren kann, indem ein Batch-Herstellungsverfahren der weichen Interferenzlithographie (SIL) gefolgt von einem Nanostrukturierungsverfahren verwendet wird [18]. Leider ist diese Methode für Mikrolinsen nicht ideal, da die Nanolöcher am Rand einen deutlich kleineren Durchmesser aufweisen als die mittleren, und einige sogar blockiert sind, was eine große Abweichung der Brennweite vom Design verursacht. Daher ist die Entwicklung einer vielseitigen und großflächigen Herstellungstechnik für Mikrolinsen entscheidend für deren praktische Anwendung; Dennoch bleibt die effektive Methode mit den aktuellen Top-Down- oder Bottom-Up-Ansätzen eine große Herausforderung. Darüber hinaus lohnt es sich, die zufälligen Defekte in der Fokussierleistung und den Kopplungseffekt zwischen benachbarten Mikrolinsen zu untersuchen.
Die vielversprechenden großflächigen Herstellungsverfahren wie Photolithographie, Laserinterferenzlithographie (LIL) und Nanosphärenlithographie (NSL) ermöglichen die Herstellung verschiedener Nanostrukturen. Photolithographie wird in der Mikroelektronik häufig verwendet, um integrierte Schaltkreise (ICs) herzustellen. Die Kombination von kurzwelligen Lichtquellen, darunter tiefes Ultraviolett (DUV) und extremes Ultraviolett (EUV), und Innovationen wie Immersionslithographie und Phasenverschiebungsmasken haben die Strukturgröße weit in den Nanometerbereich verschoben [19, 20]. Obwohl die traditionelle optische Lithographie auf Maskenbasis gut etabliert ist und in der IC-Industrie weit verbreitet ist, ist sie sowohl in der Einrichtung als auch im Betrieb sehr teuer. Als eine viel einfachere und kostengünstigere Maßstabsmethodik basiert LIL auf der Interferenz mehrerer kohärenter Laserstrahlen und kann eindimensionale (1D), zweidimensionale (2D) und 3D-periodische Strukturen mit Merkmalsdimensionen von bis zu 20 nm erzeugen [21] . Aber unter der Einschränkung der Technologie ist es für LIL schwierig, die Muster im Zentimetermaßstab zu erzeugen [22]. NSL ist eine typische kolloidale Selbstorganisationstechnik, die die effektive Nanofabrikation auf hochparallele, kostengünstige Weise im Wafer-Maßstab erfüllt und hexagonal dicht gepackte Nanokugeln aus hauptsächlich Polystyrol (PS) oder Siliziumdioxid als Masken oder Template für Photolithographie, Verdampfung, Abscheidung, Ätzen, Prägen etc. [23, 24]. Aufgrund der hexagonalen, dicht gepackten Anordnung der Nanokugeln führt dies zu einer ähnlichen Anordnung von Nanostrukturen. Darüber hinaus können solche Strukturen Gittereffekte aufweisen, beispielsweise die außerordentliche optische Transmission (EOT) von Nanohole-Arrays, im Allgemeinen als Ergebnis der Anregung von Oberflächenplasmonenpolaritonen (SPPs) [25]. Dies ist besonders wichtig für viele mögliche Anwendungen wie oberflächenverstärkte Raman-Streuung (SERS), verbesserte Detektion von Infrarot-(IR)-Schwingungen, Solarzellen und verbesserte Fluoreszenz [26,27,28,29].
In dieser Arbeit kombiniert unser Ansatz die Vorteile der modifizierten NSL, z. B. großflächige und kostengünstige Herstellung, mit der konventionellen photolithographischen Technik, um die gewünschten metallischen planaren Mikrolinsen herzustellen, die den „Patches“ von Odom ähneln. Die realisierten Mikrolinsen wie gezeigt können einzelne Lichtwellenlängen über das gesamte sichtbare Spektrum sowie das breitbandige weiße Licht mit minimaler Divergenz fokussieren. Darüber hinaus zeigen durch die Simulation und experimentelle Verifizierung die bei der Selbstorganisation von Nanokugeln in Nanoloch-Arrays üblicherweise auftretenden zufälligen Defekte keine dramatischen Einflüsse auf die Fokussierungsleistung von Mikrolinsen, was bedeutet, dass die Brennflecke von verschiedenen Mikrolinsen auf demselben Wafer die identische laterale Abmessungen, nahe der Rayleigh-Beugungsgrenze. Die hier vorgestellten metallischen Nanoloch-basierten Mikrolinsen und die so entwickelte NSL-Methode können die Tür zum Design und zur Herstellung eines neuen Typs von Mikrolinsen für miniaturisierte transmissive planare mikro-/nanooptische Bauelemente öffnen.
Methoden
Die Bottom-up-Selbstorganisation dielektrischer PS-Nanosphären als einfacher und kostengünstiger Weg zur Bildung von Subwellenlängen-Nanolöchern leidet oft unter schwerwiegenden Defekten, z. B. Versetzungen, Mehrschichten- und Punkt- oder Flächenleerstellen. Um diese Probleme anzugehen, führen wir experimentelle Studien der Spin-Coating-Parameter durch, einschließlich der Rotationsgeschwindigkeit, Beschleunigung, Suspensionsdosierung und der hydrophilen Modifikation von Substratoberflächen zur Qualität der gebildeten selbstorganisierten Arrays über den gesamten 4-in . Glaswafer. Obwohl die optimierten Parameter verwendet werden, um die Hauptdefekte (Leerstellen und Multilayer) zu reduzieren und die entsprechenden Nanoloch-Arrays durch Musterübertragung zu erzeugen, sind einige Versetzungen und Leerstellen immer noch unvermeidlich und werden auf die endgültigen Nanolochstrukturen verschoben.
Abbildung 1 veranschaulicht die Kombination aus einer Bottom-up-Technik (Spin-Coating-Selbstorganisation von PS-Nanosphären) und einer Top-down-Technik (Photolithographie) für die kostengünstige, parallele Herstellung von Mikrolinsen und ihren Arrays. Zunächst werden die PS-Nanosphären (von microParticles GmbH) auf Glassubstrate aufgeschleudert, wodurch eine Monolayer-Maske aus Nanosphären mit dem hexagonalen Gitter gebildet wird (Abb. 1a). Nach der Abscheidung der Nanokugeln wird deren Größe über das Sauerstoffplasma in einem Parallelplattenreaktor (Plasmareaktor, 0,75 Pa, O2 .) verändert 100 sccm, 80 W), wie in Abb. 1b gezeigt. Im nächsten Schritt wird eine 100 nm dicke Goldschicht auf die Monolayer-PS-Nanosphären gesputtert (Abb. 1c). Danach wird der Lift-off-Prozess durch die Ultraschallreinigung in Tetrahydrofuran (THF) durchgeführt und so ein großflächiges Nanoloch-Array erreicht (Abb. 1d). Dann wird der Chrom(Cr)-Film auf den ersten löchrigen Goldfilm gesputtert (Abb. 1e) und mit den gewünschten Mikrolinsen und ihren Arrays durch Photolithographie strukturiert (Abb. 1f), was die Fokussierungsleistung der letztendlich erzielten Mikrolinsen dominiert. Als nächstes wird die durch die Öffnungsbereiche freigelegte Cr-Schicht entfernt, wodurch die löchrigen Goldnanolöcher übrig bleiben, um das einfallende Licht durchzulassen (Abb. 1g). Nach dem Reinigen des restlichen Fotolacks werden die entworfenen Mikrolinsen und ihre Arrays realisiert (Abb. 1h).
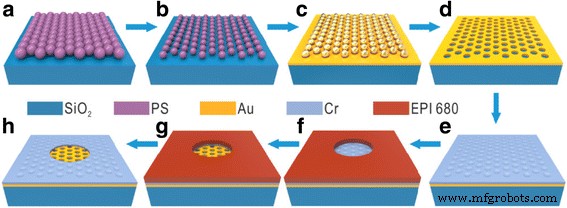
Schematische Darstellung der wichtigsten Prozessschritte zur Herstellung der Mikrolinsen und ihrer Arrays. a Spincoating von Monolayer-PS-Nanosphären. b Größenschrumpfung von PS-Nanosphären. c Au-Ablagerung. d Entfernung von PS-Nanosphären. e Cr-Abscheidung. f Übertragung von Mikrolinsenmustern auf Fotolack. g Nassätzung. h Entfernung von Fotolack
Abbildung 2 zeigt die repräsentativen Rasterelektronenmikroskop(REM)-Bilder, die verschiedene selbstorganisierte Morphologien von PS-Nanosphären mit dem Gitterabstand P . zeigen = 900 nm, d. h. der Durchmesser der verwendeten PS-Nanosphären. Die selbstorganisierten Monoschichten von PS-Nanosphären sind auf den Glassubstraten in Abb. 2a, d geordnet in einem hexagonalen Gitter gepackt. Versetzungen, die als „Risse“ dargestellt werden, sind jedoch aufgrund der elektrostatischen Abstoßung zwischen den Partikeln [30] sowie der Punktleerstellen immer noch vorhanden. Abbildung 2b, c veranschaulicht Flächenleerstellen, mehrschichtige und zufällig gepackte Defekte, die in bestimmten Regionen mit schlechter Steuerbarkeit verteilt sind, wenn die Schleuderbeschichtungsparameter nicht optimiert oder gestört sind.

REM-Bilder werden für a . angezeigt selbstorganisierte, geordnet gepackte Monolayer-PS-Nanosphären mit 900 nm Durchmesser, (b ) PS-Größenschrumpfung um O2 Plasma, das die Defekte von Leerstellen und Mehrschichten enthält, (c ) zufällig gepackte PS-Nanosphären und (d ) eine vergrößerte Ansicht einer hexagonal gepackten PS-Einheit
Abbildung 3 zeigt das Ergebnis der Beugung des sichtbaren Lichts an der Nanosphären-Maske und Digitalkamerabilder des 4-Zoll. Wafer und ein 10 mm × 10 mm-Chip mit verschiedenen Zellen von Mikrolinsen. Die einzelne Mikrolinse und ihr Array sind in Abb. 3d dargestellt, in der die darunter liegenden Nanolöcher und die abgelösten Mikrolinsen deutlich zu sehen sind. Es zeigt auch die vorhandenen zufälligen Defekte in den einzelnen Mikrolinsen.
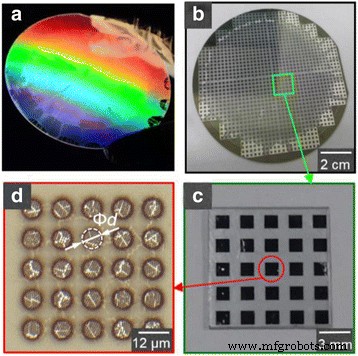
a Beugungsbild des hergestellten 4-in. Monolayer-Nanosphärenmaske auf Wafer-Ebene. Fotografien der hergestellten Mikrolinsen und ihrer Arrays auf einem Glassubstrat in (b ) die Waferebene und (c ) die Chipebene. d Optische Mikroskopaufnahme der 8-μm-Mikrolinse und ihres 5 × 5-Array-Abstands 4 μm voneinander entfernt
Um die Fokussierungsleistung der erreichten Mikrolinsen zu untersuchen, vergleichen wir die 3D-Simulationsergebnisse der Finite-Differenz-Zeitdomäne (FDTD) mit den experimentellen Tests. Unser in Abb. 4 beschriebener Versuchsaufbau, der das inverse optische Mikroskop von Nikon als Hauptbetriebsplattform verwendet, wird verwendet, um die optischen Felder abzubilden, die von der auf die Mikrolinse einfallenden ebenen Welle erzeugt werden. Ein hochwertiges Öl-Immersions-Mikroskopobjektiv (100×, NA = 1.49) bildet nach Durchlicht durch die Mikrolinse Speckle-Muster auf eine CCD-Kamera ab und wird vom Piezo-Controller E-816 (Physik Instrumente (PI)) mit Stepping . angesteuert Länge von 100 nm. Nach dem Sammeln von Hunderten von 2D-Lichtschnitten kann so das optische 3D-Feld entlang der Ausbreitungsachse der Mikrolinse konstruiert werden.

Versuchsaufbau zur Charakterisierung der optischen Fokussierleistung von Mikrolinsen und ihren Arrays. Ein 532-nm-CW-Laser wird über ein Teleskop aufgeweitet, um einen homogenen Strahl zu erhalten. Durch die Mikrolinse hindurch wird das übertragene Speckle-Muster von einem Mikroskopobjektiv gesammelt und von einem CCD gemessen
Ergebnisse und Diskussion
- ich.
Fokussierleistung von Mikrolinsen
Das 3D-Modell einer Mikrolinse mit einem Durchmesser von d mit kreisförmigen Nanolöchern, die in einem hexagonalen Gitter angeordnet sind, wird unter Verwendung des FDTD-Verfahrens hergestellt. Das kollimierte, x -polarisiertes Licht mit einer Betriebswellenlänge von 532 nm wird beleuchtet, ein gut definierter Brennfleck (Ort der maximalen Intensität) wird im x . beobachtet -z Ebene (das gleiche wie y -z Ebene, da das elektromagnetische Feld symmetrisch verteilt ist) durch das Zentrum der 4-μm-Mikrolinsen, und die Halbwertsbreite (FWHM) des Flecks in der Brennebene beträgt 1,25 μm (Abb. 5a), was nahe liegt bis zur Rayleigh-Beugungsgrenze von 0,912 μm, berechnet aus 0,61λ /NA [31]. Darüber hinaus werden die optischen Fernfeldmuster mit den Gitterabständen von 522 und 900 nm simuliert und die Betriebswellenlängen von 532 und 633 nm ausgewählt. Die simulierten Brennweiten betragen 12 und 10,4 μm für die 4-μm-Mikrolinse bei λ = 532 bzw. 633 nm, und der Wert steigt auf 46 μm für die 8-μm-Mikrolinse bei λ = 532 nm, wie in Abb. 5a, c gezeigt. Da ihre Fokussierungseffekte nicht auf die Wellenfronttechnik zurückzuführen sind, haben 4-μm-Mikrolinsen mit 522- oder 900-nm-Gitterabstand nahezu identische Brennflecken, was bestätigt, dass die Brennweite hauptsächlich von der Linsengröße und der Arbeitswellenlänge abhängt.

a Optische Feldabbildungen der 4 μm-Mikrolinse für die simulierten Fälle von a1 λ = 633 nm, P = 522 nm; a2 λ = 532 nm, P = 522 nm; a3 λ = 532 nm, P = 900 nm; und a4 das Messergebnis von λ = 532 nm, P = 900 nm. b Die axiale Lichtintensität des berechneten R-S-Integrals, FDTD-Simulation und optische Messung für die entworfene Mikrolinse von d = 4 μm. c Die Feldstärkedifferenz für das c1 simuliert und c2 gemessene Ergebnisse, wenn d = 8 μm bei λ = 532 nm, P = 900 nm. d Die axiale Intensität für die Mikrolinse von d = 8 μm. Die Intensitätsfelder entlang der y-z Ebenen sind identisch verteilt wie x-z Flugzeuge
Der Brennfleck unterliegt der klassischen Rayleigh-Beugungsgrenze, da die Fernfeldfokussierung nicht aus der Erholung des evaneszenten Feldes [32] oder Superoszillationen [33] stammt. Daher kann die Abhängigkeit der Brennweite von der Betriebswellenlänge durch eine aus dem Rayleigh-Sommerfeld (R-S)-Integral abgeleitete Beziehung ausgedrückt werden [18]. Aus Abb. 5b, d können wir sehen, dass die berechneten optischen Feldverteilungen durch das R-S-Integral für beide Fälle sehr gut mit den FDTD-Simulationsergebnissen übereinstimmen. Die Messergebnisse zeigen jedoch aufgrund der verschiedenen Fehler, die während des Herstellungsverfahrens und der optischen Messung eingeführt wurden, einen leichten Unterschied. Bemerkenswert ist, dass die Messabweichung im 4-μm-Fall im Gegensatz zur Simulation 8,3% beträgt, gegenüber 1,1% im 8-μm-Fall. Mit anderen Worten, die Mikrolinsen mit einem größeren Durchmesser sind unempfindlicher gegenüber den normalen Fehlern.
Da die Fokussierleistung für die Wellenfronttechnik irrelevant ist, hängt der optische Durchsatz des Brennflecks von der SP-verstärkten Transmission durch die Subwellenlängenaperturen ab [18]. Wenn die Ergebnisse aus Fig. 6 mit den Transmissionsspektren der verschiedenen Mikrolinsen verglichen werden, liegen die verstärkten Transmissionen und die unterdrückten Transmissionen je nach Gitterabstand bei unterschiedlichen Wellenlängen vor. Nach früheren Berichten [34] wurde entdeckt, dass die selektive spektrale Reaktion aus der kombinierten Wirkung der sich ausbreitenden Oberflächenplasmonenresonanz (PSPR), die an der Metall/Dielektrikum-Grenzfläche aufrechterhalten wird, und der lokalisierten Oberflächenplasmonenresonanz (LSPR) um die Nanolöcher herrührt. Wie in Abb. 6c zu sehen ist, weisen die Stellen der Transmissionseinbrüche, wie durch die Kreise angedeutet, eine Rotverschiebung entlang des x . auf -Koordinatenachse mit zunehmendem Gitterabstand zunimmt, so ist es mit den Transmissionsspitzen. Dies verleiht den Mikrolinsen ungewöhnliche Fähigkeiten zur Steuerung des optischen Durchsatzes bei bestimmten Wellenlängen und stellt sicher, dass Mikrolinsen einfach mit einer hocheffizienten Fokussierung konstruiert werden können. Abbildung 6a, b zeigt die Feldverteilungen einer 4-μm-Mikrolinse für den Fall von P = 400 nm bei der Dip-Wellenlänge von 581 nm bzw. der Spitzenwellenlänge von 681 nm. Abgesehen von einer durch die erhöhte Wellenlänge verursachten Verringerung der Brennweite ist die Intensität des Brennflecks für die Wellenlänge von 681 nm fast 100-mal höher als die von λ = 581 nm.

a , b Simulationsergebnisse der elektrischen Feldmuster der 4-μm-Mikrolinse bei P = 400 nm bei der Arbeitswellenlänge von λ = 581 nm (Übertragungseinbruch) bzw. 681 nm (Spitze). c Simulierte Gesamttransmissionsspektren für die Mikrolinsen entsprechend den Gitterabständen P = 400, 530 und 600 nm im Frequenzbereich von 400~800 nm und der Einschub zeigt das Modell einer 4-μm-Mikrolinse. Die Übertragungseinbrüche und -spitzen werden durch Kreise gekennzeichnet und Dreieck , bzw.
- II.
Einflüsse zufälliger Defekte
Trotz der Tatsache, dass NSL ein hochgradig paralleles Herstellungsverfahren ist, um großflächige Nanoloch-Arrays in den Mikrolinsen und ihren Arrays zu erzeugen, besteht ein wahrgenommenes Problem dieser Technik darin, dass die Defekte zufällig über die Nanolochschicht der Mikrolinsen verteilt sind. Die Defekte sind während des Selbstorganisationsprozesses von Nanokugeln nahezu unvermeidlich, von denen normalerweise angenommen wird, dass sie die Auflösung und Eindringtiefe der optischen Methoden grundlegend einschränken. Erstaunlich ist jedoch, dass Defekte eine ungewöhnliche Alternative zu herkömmlichen periodischen Strukturen bieten, um Licht zu manipulieren. Es wurde gezeigt, dass einige zufällige Defekte die Schärfe des Fokus in einem spezifischen optischen Experiment verbessern, anstatt sie zu verschlechtern [35, 36]. Daher ist der Einfluss von Defekten, die aus unserem Herstellungsprozess hervorgehen, auf die hier untersuchte Fokussierungsleistung von Mikrolinsen für praktische Anwendungen und die weitere Erforschung zufälliger photonischer Kristalle von wesentlicher Bedeutung.
Abgesehen von den oben erwähnten Leerstellen, Versetzungen und Mehrschichtdefekten, die durch den Selbstorganisationsprozess von Nanokugeln erzeugt werden, kann die Formverformung von Nanolöchern auch in den ultimativen Mikrolinsen während der PS-Schrumpfung und PS-Entfernung als Folge des unausgeglichenen O2 Plasmaätzen. Daher können diese von uns betrachteten Fehler als Form- und Positionsfehler klassifiziert werden. Um den Einfluss der Formfehler auf die Fokussierleistung von Mikrolinsen zu demonstrieren, präsentieren wir die Mikrolinsen mit unterschiedlicher Unrundheit σ in den Nanolöchern, wenn ihr gemeinsamer Füllfaktor 0,33 beträgt und die entsprechenden optischen Fokussierungsbilder in Abb. 7a dargestellt sind. Offensichtlich sind diese Fokussierungsmuster für Fälle von σ = 0.4 und σ = 0,7 sind mit Ausnahme der leichten Variation der Brennpunktintensität fast gleich. Wie in Abb. 7a zu sehen ist, zeigen die ähnlichen Brennpunktmuster in a1, a2 und a3 offensichtlicher, dass der erhöhte Verformungsgrad und die Änderung der Verformungsrichtung einen vernachlässigbaren Einfluss auf die Fokussierungseigenschaften von Mikrolinsen haben.

a Brennflecken von Mikrolinsen sind unabhängig vom Unrundheitsfehler σ von Nanolöchern. Die Fokussierungseigenschaften zeigen keine deutliche Änderung, wenn σ = 0 (abgerundete Nanolöcher) in Abb. 5 wird auf a1 σ . erhöht = 0.4, a2 σ = 0.7 mit horizontal verzerrter Richtung und a3 σ = 0.7 mit einer senkrecht verzerrten Richtung. b Einführung von räumlicher Zufälligkeit in die Positionen von Nanolöchern. Abweichungsrichtungen sind zufällig von Loch zu Loch unterschiedlich, aber die Abweichungslänge δ wird für jedes Loch konstant gehalten. Die gleichen Fokussierungsmuster werden erhalten, wenn die Abweichungslänge b1 δ = 0, b2 δ = 50 nm und b3 δ = 100 nm
Um die Einflüsse von Positionsdefekten zu untersuchen, lenken wir die Positionen von Nanolöchern in verschiedene Richtungen mit einer Länge von δ . Die Abweichungsrichtung jedes Lochs wird zufällig von Loch zu Loch verteilt und für jedes δ . konstant gehalten (siehe Abb. 7b). Mit der Zunahme von δ , weichen die Nanolöcher vom perfekt dicht gepackten Zustand ab und werden „zufälliger“. Drei ähnliche Fokussierungsmuster von Mikrolinsen bezüglich verschiedener zufälliger Positionen von Nanolöchern, δ = 0, 50 und 100 nm, erhalten. Darüber hinaus wird beobachtet, dass bei einem eher zufälligen Nanoloch-Array eine leichte Abnahme der Brennpunktintensität im Feldprofil auftritt. Es zeigt sich vor allem, dass die Form- und Lagefehler innerhalb von Mikrolinsen wenig Einfluss auf die Fokussierleistung haben und meist nur die Fokusintensität modulieren.
- III.
Fokussierleistung von Mikrolinsenarrays
Abbildung 8 zeigt das hergestellte 3 × 3-Mikrolinsen-Array mit unterschiedlichen Abständen und die experimentell gemessenen optischen Muster unter λ = 532 nm, sowie die Breitbandausleuchtung. Beachten Sie, dass die Brennflecken von Mikrolinsen mit mehr Versetzungen im Array schwächer sind als die von anderen Mikrolinsen in Abb. 8b. Dies liegt daran, dass die Versetzungsdefekte die Anzahl der Nanolöcher, die zu dem optischen Interferenzmuster beitragen, effektiv reduzieren. Darüber hinaus zeigen die Ergebnisse eine ausgezeichnete Übereinstimmung mit denen, die durch die FDTD-Simulationen erhalten wurden, dass die Defekte hauptsächlich die Brennpunktintensität beeinflussen. Darüber hinaus können die Mikrolinsen aufgrund der minimalen chromatischen Aberration das breitbandige weiße Licht (Abb. 8 (a2) und (b2)) fokussieren. Die Brennflecke unter der Weißlichtbeleuchtung haben ähnliche seitliche Abmessungen wie die unter einer einzelnen Wellenlänge, während die Breitbandbrennweite ungefähr dem Durchschnitt der Brennweiten bei den SP-verstärkten Wellenlängen entspricht. Darüber hinaus zeigt sich der Fokussierungskopplungseffekt in Mikrolinsen-Arrays, den wir in unserer vorherigen Forschung [37] analysiert hatten, in den erhaltenen Fokussierungsmustern als die Regionen C, D und E, die in Abb. 8 (b1) und (b2) markiert sind.

a Optische Mikroskopbilder für das hergestellte 3 × 3-Mikrolinsen-Array mit einem Abstand von 8 μm bei d = 8 μm und die gemessenen optischen Muster (A –A ) unter (a1) die einzelne Wellenlänge von λ = 532 nm und (a2) die Breitbandausleuchtung. Identische Brennpunkte von einzelnen Mikrolinsen werden beobachtet. b Experimentelle Ergebnisse (B –B ) für den 3 × 3-Mikrolinsen-Array-Abstand 4 μm unter (b1) die einzelne Wellenlänge von λ = 532 nm und (b2) die Breitbandausleuchtung. Der Kopplungseffekt zwischen zwei benachbarten Mikrolinsen, gekennzeichnet durch die Bereiche C , D , und E , kann beobachtet werden
Schlussfolgerungen
Zusammenfassend haben wir zum ersten Mal gezeigt, dass die NSL-Technik als hochparallele und kostengünstige Methode verwendet werden kann, um die metallischen planaren Mikrolinsen herzustellen, die über das gesamte sichtbare Spektrum funktionieren. Unterstützt durch die simulierten und experimentellen Ergebnisse können die Fokussierungseigenschaften von Mikrolinsen durch eine Kombination sowohl optischer Interferenz als auch Oberflächenplasmoneneffekten erklärt werden. Unter Berücksichtigung des Gitterabstands und des Durchmessers von Nanolöchern können die Mikrolinsen maßgeschneidert werden, um eine hohe Transmission bei bestimmten Wellenlängen bereitzustellen. Die Fokussierleistung von Mikrolinsen vom perfekten bis zum defekten Zustand wird durch das FDTD-Verfahren ausgenutzt. Sowohl die Simulationen als auch die Experimente verdeutlichen, dass die zufälligen Defekte in Nanoloch-Arrays einfach die Fokussierungseffizienz von Mikrolinsen beeinflussen und der vorhergesagte Fokussierungskopplungseffekt sowohl bei der Einzelwellenlängen- als auch bei der Breitbandbeleuchtung auftritt. Die Breitband-Fokussierfähigkeit, die miniaturisierte Größe und die vielseitige Herstellungstechnik eröffnen zusammen ein großes Potenzial für kompakte und kostengünstige rein optische oder optoelektronische Geräte wie Photovoltaik [26], Farbfilter [38] und Brechungsindex-Erfassung [39] .
Abkürzungen
- 3D:
-
Dreidimensional
- CCD:
-
Ladungsgekoppeltes Gerät
- FDTD:
-
Zeitbereich mit endlicher Differenz
- FWHM:
-
Volle Breite bei halbem Maximum
- LIL:
-
Laserinterferenzlithographie
- NA:
-
Numerische Apertur
- NSL:
-
Nanosphären-Lithographie
- PS:
-
Polystyrol
- SEM:
-
Rasterelektronenmikroskop
Nanomaterialien
- Beeindrucken Sie Freunde und Familie mit Epoxidharzprojekten
- Digitale Fertigung und IIoT – Erfolg mit einer einzigen Plattform
- Breitband-Perfekter Absorber mit Monolayer-MoS2 und hexagonalem Titannitrid-Nano-Disk-Array
- Einfache Herstellung von multihierarchischem porösem Polyanilin-Komposit als Drucksensor und Gassensor mit einstellbarer Empfindlichkeit
- Eigenschaften von elektromagnetischen Längsschwingungen in Metallen und deren Anregung an ebenen und sphärischen Oberflächen
- Herstellung von nanoskaligen Gruben mit hohem Durchsatz auf Polymerdünnschicht unter Verwendung der AFM-Spitzen-basierten dynamischen Pfluglithographie
- Herstellung, Charakterisierung und biologische Aktivität von Avermectin-Nanoabgabesystemen mit unterschiedlichen Partikelgrößen
- Umweltfreundliche und einfache Synthese von Co3O4-Nanodrähten und ihre vielversprechende Anwendung mit Graphen in Lithium-Ionen-Batterien
- Erzeugung reaktiver Sauerstoffspezies in wässrigen Lösungen, die GdVO4:Eu3+-Nanopartikel und deren Komplexe mit Methylenblau enthalten
- Transformation der modernen Fertigung durch visuelle Kommunikation und Zusammenarbeit



