Plasmaverstärkte Atomlagenabscheidung von Kobaltfilmen unter Verwendung von Co(EtCp)2 als Metallvorstufe
Zusammenfassung
Für die fortschrittliche Cu-Verbindungstechnologie wurden Co-Filme umfassend untersucht, um aufgrund ihrer besseren Benetzbarkeit für Cu als Ta als Liner- und Saatschicht-Ersatz zu dienen. In diesem Artikel werden die Co-Filme durch plasmaunterstützte Atomlagenabscheidung unter Verwendung von Co(EtCp)2 . gezüchtet als Vorstufe, und die Einflüsse von Prozessparametern auf die Eigenschaften der Co-Filme werden aufwendig untersucht. Die Ergebnisse zeigen, dass das Prozessfenster 125–225 °C mit einer Wachstumsrate von ~0,073 Å/Zyklus beträgt. Das heißt, die Verbindung der Et-Gruppe mit dem Cp-Liganden kann ein stabiles Filmwachstum bei 125 °C ermöglichen, während die entsprechende Temperatur in Bezug auf Co(Cp)2 . höher als 200 °C sein muss und Co(MeCp)2 . Die abgeschiedenen Filme enthalten neben dominantem Co und C auch N- und O-Elemente. Außerdem ist die Verlängerung des NH3 Pulszeit verbessert die Leitfähigkeit des Co-Films erheblich und ein niedriger spezifischer Widerstand von 117 μΩ cm kann mit einem NH3 . erreicht werden Pulszeit von 40 s. Der quadratische Mittelwert der Rauheit zeigt eine geringere Variation mit der Abscheidungstemperatur und behält einen niedrigen Wert von ~ 0,3 nm bei, was auf einen flachen Co-Film hinweist.
Hintergrund
In Anbetracht des herkömmlichen Cu-Verbindungsprozesses in ultragroß integrierten Hochgeschwindigkeitsschaltungen ist eine Barriereschicht wie TaN unverzichtbar, um die Diffusion von Cu-Atomen in die umgebenden Zwischenschichtdielektrika (ILD) zu verhindern [1]. Außer der Sperrschicht ist auch eine Deckschicht wie Ta erforderlich, um die Haftung zwischen der Sperrschicht und Cu zu verbessern. Außerdem ist es aufgrund der schwachen Nukleation von Cu-Atomen auf der Ta-Oberfläche schwierig, die Cu-Linie auf der Liner-Schicht durch direktes Elektroplattieren abzuscheiden. Folglich muss vor dem Galvanisieren von Cu eine Cu-Keimschicht auf die Deckschicht aufgetragen werden. Das heißt, ein Stapel von TaN/Ta/Cu-Keimschichten muss zwischen dem ILD und der Cu-Leitung eingefügt werden. Weiterhin wird dieser Stapel auf dem als Trenches und Vias strukturierten ILD beschichtet. Mit der Verkleinerung der Gerätemerkmalsgröße nimmt das für die Cu-Verbindungsleitung verfügbare Volumen stetig ab. Um einen niedrigeren Cu-Verbindungswiderstand zu erreichen, wurde eine keimfreie Barriere-/Linerschicht umfassend untersucht [2, 3, 4, 5, 6]. Beispielsweise fungiert TaN immer noch als Sperrschicht und Co ersetzt Ta als Deckschicht. Aufgrund einer besseren Benetzbarkeit von Co zu Cu als Ta kann Cu direkt auf die Co-Oberfläche galvanisiert werden. Herkömmlicherweise wird die Barriere/Liner-Schicht durch einen physikalischen Dampfabscheidungsprozess aufgewachsen. Die Abscheidung einer hochwertigen Barriere/Liner-Schicht ist jedoch eine Herausforderung, da PVD eine schlechte Stufenbedeckungsrate in Gräben und Vias mit hohem Aspektverhältnis aufweist. Stattdessen können dank der selbstbegrenzenden Wachstumseigenschaft ultradünne, kontinuierliche und gute Stufenabdeckungsfilme durch die Atomlagenabscheidungstechnik (ALD) erhalten werden [7].
In Bezug auf ALD-Co-Filme wurde eine große Anzahl von Co-Vorstufen, insbesondere auf der Basis von Cyclopentadienyl-Liganden (Cp), umfassend untersucht, wie z. B. Bis-Cyclopentadienyl-Cobalt (CoCp2 ) [8,9,10,11,12,13,14], Bis(η-methylcyclopentadienyl)cobalt [Co(MeCp)2 ] [15] und Cyclopentadienylisopropylacetamidinatocobalt [Co(CpAMD)] [16]. Der Einsatz von CoCp2 ermöglicht das Wachstum von Co-Filmen mit niedrigem spezifischen Widerstand und hoher Reinheit; das stabile Filmwachstum ist jedoch auf Temperaturen über 250 °C beschränkt. Durch die Addition einer Methylgruppe an den Cp-Liganden kann bei 200 °C ein geringeres Temperaturwachstum erreicht werden, was auf die höhere Reaktivität von NH3 . zurückgeführt wird Radikal zum MeCp-Liganden im Vergleich zum Cp-Liganden. Auf Basis des Co-Filmwachstums mit CoCp2 und Co(MeCp)2 als Vorläufer könnte das Prozessfenster zu niedrigeren Temperaturen verschoben werden, d. h. < 200 °C, wenn die Ethylgruppe an den Cp-Liganden gebunden ist.
In dieser Arbeit wurden Co-Dünnschichten durch plasmaunterstützte ALD (PE-ALD) unter Verwendung von Bis(ethylcyclopentadienyl)-Kobalt [Co(EtCp)2 . gezüchtet ] und NH3 Plasma als Vorstufe. Der Einfluss verschiedener Prozessparameter auf die Eigenschaften der Co-Filme wurde aufwendig untersucht. Als Ergebnis wurde ein Prozessfenster von 125–225 °C erfolgreich erreicht. Darüber hinaus weisen die Co-Filme einen geringeren spezifischen Widerstand auf (~ 130 μΩ cm).
Methoden
Verschiedene Co-Dünnschichten wurden durch PE-ALD auf einem 200 nm großen SiO2 . gezüchtet Film, der durch thermische Oxidation auf p-Siliziumsubstraten abgeschieden wurde. Co(EtCp)2 wurde als Metallvorläufer verwendet, der in einem Behälter bei 70 °C gelagert und mit einem N2 . in die Abscheidungskammer überführt wurde Trägergas. Das NH3 Plasma wurde von einem entfernten Plasmagenerator mit einer Leistung von 2800 W erzeugt, der als Reduktionsmittel diente. Die Durchflussmenge von N2 wurde bei 50 sccm gehalten, und der Arbeitsdruck betrug ~~1000 Pa während des Filmwachstums. Um den Einfluss der Abscheidungstemperatur auf das Filmwachstum zu untersuchen, wurde die Substrattemperatur von 100 bis 270 °C in Schritten von 25 °C variiert. Um die Prozessparameter zu optimieren, werden außerdem die Pulszeiten von Co(EtCp)2 und NH3 Plasma wurden auch jeweils gewechselt. Um den Effekt des Nachglühens auf die Leistung der Co-Schichten zu untersuchen, wurden die bei verschiedenen Temperaturen abgeschiedenen Proben außerdem im Formiergas (N2 /4%-H2 ) bei 400 °C für 30 Minuten.
Die Dicke und Dichte des Films wurden durch Röntgenreflexion abgeleitet, und die Mikrostruktur des Films wurde durch Röntgenbeugung unter streifendem Einfall (XRD) an einem Diffraktometer (Bruker D8 Discover) mit Cu Kα Strahlung. Die Oberflächenmorphologie des Films wurde mit Rasterkraftmikroskopie (AFM) (Bruker Icon) und Rasterelektronenmikroskop (REM) (Zeiss SIGAMA HD) beobachtet. Die elementare Zusammensetzung und die chemischen Bindungen des Films wurden durch Röntgen-Photoelektronenspektroskopie (XPS) (Kratos Axis Ultra DLD) analysiert. Der Schichtwiderstand des Films wurde durch eine Vierpunktsonde gemessen und der spezifische Filmwiderstand wurde basierend auf der Filmdicke und dem Schichtwiderstand berechnet
Ergebnisse und Diskussion
Optimierung der ALD-Prozessparameter
Abbildung 1a zeigt die Wachstumsrate des Co-Films als Funktion der Substrattemperatur. Es wurde festgestellt, dass die Wachstumsrate bei einer Erhöhung der Substrattemperatur auf 125 °C zunimmt und dann zwischen 125 und 225 °C eine relativ stabile Wachstumsrate von 0,073 ± 0,02 Å/Zyklus erhalten wird. Steigt die Substrattemperatur jedoch auf 250 °C oder höher, wird die Wachstumsrate erhöht. Daher kann der Temperaturbereich von 125–225 °C als geeignetes Prozessfenster angesehen werden. Im Vergleich zu Co(Cp)2 und Co(MeCp)2 , ermöglicht die Addition der Et-Gruppe an den Cp-Liganden, dass das Prozessfenster zu einer niedrigeren Abscheidungstemperatur verschoben wird, was auf eine höhere Reaktivität von EtCp-Liganden mit NH3 . hinweist Plasma. Ein solch niedriges Temperaturwachstum bei 125 °C ist vorteilhaft, um das Wärmebudget zu reduzieren. Bei Substrattemperaturen unter 125 °C ist das relativ langsamere Filmwachstum auf das Fehlen einer ausreichenden Aktivierungsenergie für die chemische Reaktion zurückzuführen [7]. Eine so hohe Wachstumsrate bei ≥ 250 °C hängt mit der thermischen Zersetzung der Metallvorstufe zusammen [17]. Um den Einfluss von Co(EtCp)2 . zu untersuchen Pulszeit von der Wachstumsrate des abgeschiedenen Films, der Pulszeit von Co(EtCp)2 erhöht sich allmählich von 1 auf 4 s mit einem Schritt von 1 s, während andere Prozessparameter festgelegt sind. Wie in Abb. 1b gezeigt, steigt die Wachstumsrate von ~ 0,06 auf ~ 0,073 Å/Zyklus mit der Zunahme von Co(EtCp)2 Pulszeit von 1 bis 2 s und behält dann einen relativ stabilen Wert bei. Dies weist darauf hin, dass die Oberflächenadsorption von Co(EtCp)2 erreicht eine Sättigung bei einer Pulszeit von 2 s. Abbildung 1b veranschaulicht auch den Einfluss von NH3 -Plasmapulszeit auf die Wachstumsrate des Films. Die Wachstumsrate steigt mit längerer NH3 -Plasmapulszeit; Wenn die Plasmapulszeit jedoch 20 s überschreitet, erreicht die Wachstumsrate einen Sättigungswert von ~ 0,12 Å/Zyklus.

Abhängigkeit der Wachstumsrate des ALD-Films von a Substrattemperatur, b Co(EtCp)2 , und NH3 Pulszeit
Charakterisierung der hinterlegten Co-Filme
Abbildung 2 zeigt die Übersichts-XPS-Spektren der bei 175 °C abgeschiedenen Filme. Die abgeschiedenen Filme bestehen aus Co-, N-, O- und C-Elementen. Es ist erwähnenswert, dass alle Proben vor der Sammlung der XPS-Spektren 6 Minuten lang in situ mit Ar-Ionenbeschuss geätzt wurden, um die Oberflächenkontamination vollständig zu entfernen. Tabelle 1 listet die elementaren Prozentsätze des bei 175 °C abgeschiedenen Films mit der Ätzzeit auf, und der C- und O-Gehalt bleibt nach 6 Minuten Ätzen konstant, was auf eine vollständige Entfernung der Oberflächenkontamination hinweist. Tabelle 2 listet das elementare Atomverhältnis der bei 100 bzw. 175 °C gewachsenen Filme auf, die aus den hochauflösenden XPS-Spektren extrahiert wurden. Wenn die Substrattemperatur von 100 auf 175 °C steigt, sinkt der relative Gehalt an C von 40 auf 32 % und der elementare Anteil an N steigt von 14 auf 18 %. Darüber hinaus zeigt der relative Prozentsatz von O einen leichten Anstieg von 5 auf 7 %. Die höheren C-Gehalte sind auf die teilweise Entfernung der EtCp-Liganden zurückzuführen [15, 16]. Da die Vorläufer kein O-Element enthalten, stammen die O-Atome in den abgeschiedenen Filmen wahrscheinlich vom Sauerstoff in der Reaktionskammer.
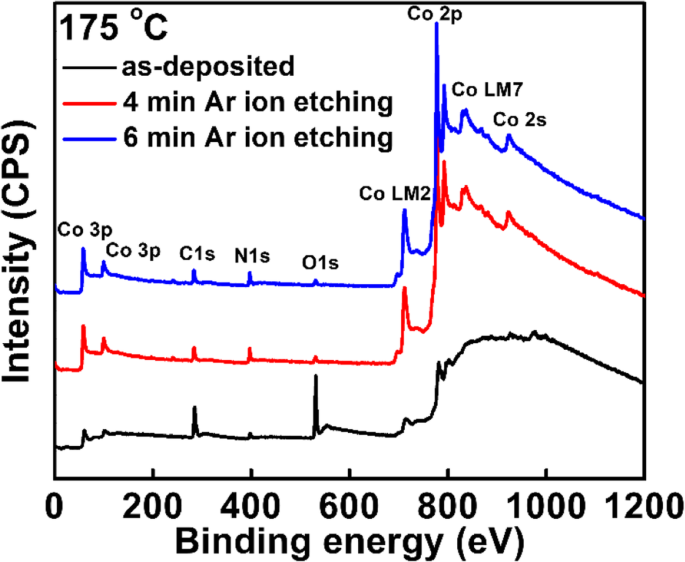
Die Übersichtsspektren der bei 100 °C abgeschiedenen Co-Filme mit unterschiedlicher Ätzzeit
Abbildung 3a zeigt hochauflösende C 1s-Spektren der bei verschiedenen Temperaturen abgeschiedenen Filme. Das C 1s-Spektrum kann gut in vier Komponenten bei 283,2, 284,7, 286,1 ± 0,1 eV und 288,9 eV unterteilt werden, die sich aus C-Co [12], CC [12, 18], CN [15, 19] und ergeben CO [12]-Bindungen. Wenn die Temperatur von 100 auf 175 °C steigt, sinkt der relative Gehalt der C-C-Bindung von 61 auf 56 %, während der von C-Co, C-N und C-O um 1 %, 2 % bzw. 2 % ansteigt. Dies zeigt, dass bei einer höheren Temperatur mehr EtCp-Liganden zersetzt wurden, was zu einer Verringerung des relativen Prozentsatzes von C im Film führte. Abbildung 3b zeigt die hochauflösenden N 1s-Spektren der bei verschiedenen Temperaturen abgeschiedenen Filme. Jedes N 1s-Spektrum kann unter Verwendung der Gauß-Lorentz-Funktion gut in zwei Komponenten getrennt werden. Der bei 397,8 eV gelegene Peak sollte der N-Co-Bindung [13] zugeordnet sein, und die bei 399,2 eV zentrierten Peaks sollten der N-C-Bindung [20, 21] entsprechen. Wenn die Substrattemperatur von 100 auf 175 °C steigt, sinkt der relative Gehalt an N-Co von 72 auf 69 %. Dies liegt daran, dass die Desorption von Stickstoff aus dem Film bei höheren Temperaturen verstärkt wird, was zur Bildung von weniger N-Co-Bindungen führt. Abbildung 3c zeigt hochauflösendes Co 2p3/2 XPS-Spektren der bei verschiedenen Temperaturen abgeschiedenen Co-Filme. In Bezug auf die Existenz der C-Co- und N-Co-Bindungen, wie in Abb. 3a, b gezeigt, ist es vernünftig, dass die Co 2p3/2 Spektrum kann in drei Komponenten unterteilt werden, die sich bei 778, 778,9 bzw. 780,86 ± 0,34 eV befinden. Der Peak bei der kleinsten Bindungsenergie sollte der Co-Co-Bindung zugeschrieben werden [12, 22]. Da außerdem die Pauling-Elektronegativität von C (2,55) kleiner ist als die von N (3.04), ist die positive Ladungsdichte von an N gebundenem Co größer als die von an C gebundenem Co. Daher sind die Peaks bei 778,9 und 780,86 ± 0,34 eV sollte sich aus den Co-C- bzw. Co-N-Bindungen ergeben. Wenn die Abscheidungstemperatur von 100 auf 175 °C erhöht wird, sinkt der relative Gehalt an Co-N-Bindung von 48 auf 32 %, was mit der Entwicklung der N-Co-Bindung in Abb. 3b übereinstimmt.

Hochauflösend a Co 2p3/2 , b C 1s und c N 1s XPS-Spektren der bei 100 °C bzw. 175 °C abgeschiedenen Filme
Die Kristalleigenschaften der Co-Filme werden durch TEM charakterisiert, wie in Fig. 4 gezeigt. Die bei 100 bzw. 250 °C abgeschiedenen Co-Filme werden beide kristallisiert. Abbildung 5 zeigt die AFM-Bilder der bei verschiedenen Temperaturen gewachsenen Co-Filme. Wenn die Abscheidungstemperatur von 100 auf 250 °C ansteigt, zeigt der Effektivwert der Rauheit (RMS) eine geringere Schwankung und behält einen niedrigen Wert von ~ 0,3 nm bei, was auf einen flachen Co-Film hinweist.
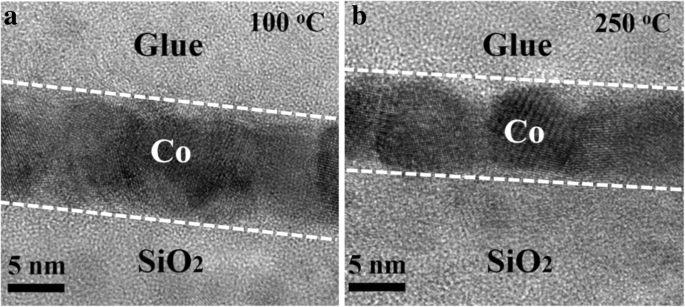
Die Querschnitts-TEM-Bilder der Co-Filme (1200 Zyklen), die bei a . abgeschieden wurden 100 °C und b jeweils 250 °C
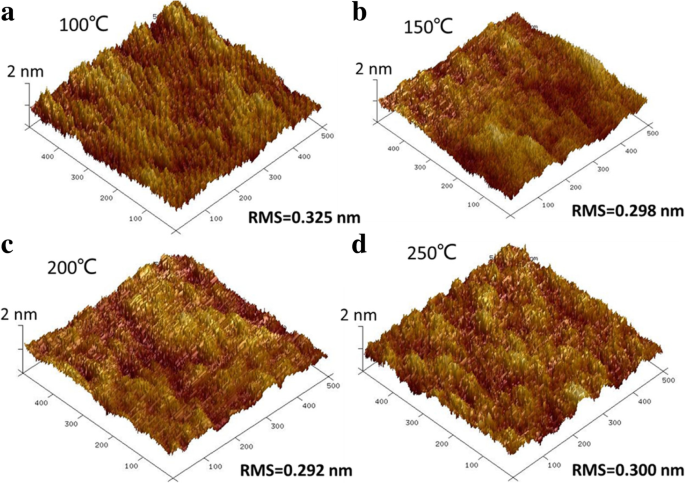
AFM-Bilder der Co-Filme (1200 Zyklen), die mit Co(EtCp)2 abgeschieden wurden Pulszeit von 2 s und NH3 Plasmapulszeit von 10 s bei verschiedenen Temperaturen:a 100 °C; b 150 °C; c 200 °C; d 250 °C
Abbildung 6a, b zeigt die Abhängigkeit des spezifischen Widerstands der Co-Filme von der Substrattemperatur und NH3 Pulszeit. Der spezifische Filmwiderstand verringert sich deutlich von 652 auf 130 Ω cm und bleibt dann konstant, wenn die Abscheidungstemperatur von 100 auf 275 °C erhöht wird. Die Ergebnisse sollten dem Anstieg des relativen Gehalts an metallischem Co im Film zugeschrieben werden. Als NH3 Pulszeit steigt von 10 auf 40 s, der spezifische Widerstand der Co-Filme sinkt von 158 auf 117 μΩ cm (siehe Abb. 6b). Abbildung 7 zeigt den Co 2p3/2 XPS-Spektren der mit verschiedenen NH3 . abgeschiedenen Co-Filme Plasmazeiten. Als NH3 Die Plasmazeit wird von 10 auf 40 s verlängert, der relative Anteil der Co-Co-Bindungen steigt von 31 auf 34% und der relative Gehalt der Co-C-Bindungen sinkt von 40 auf 31%. Darüber hinaus sinkt der Kohlenstoffgehalt um 22 %, wenn das NH3 Die Plasmapulszeit erhöht sich von 10 auf 40 s. Dies weist auf die allmählich zunehmende Entfernung der EtCp-Liganden hin, was zur Abnahme des spezifischen Widerstands des Co-Films beiträgt.

Der spezifische Widerstand des Co-Films als Funktion der Wachstumstemperatur (a ) und NH3 Pulszeit (b ) bzw.
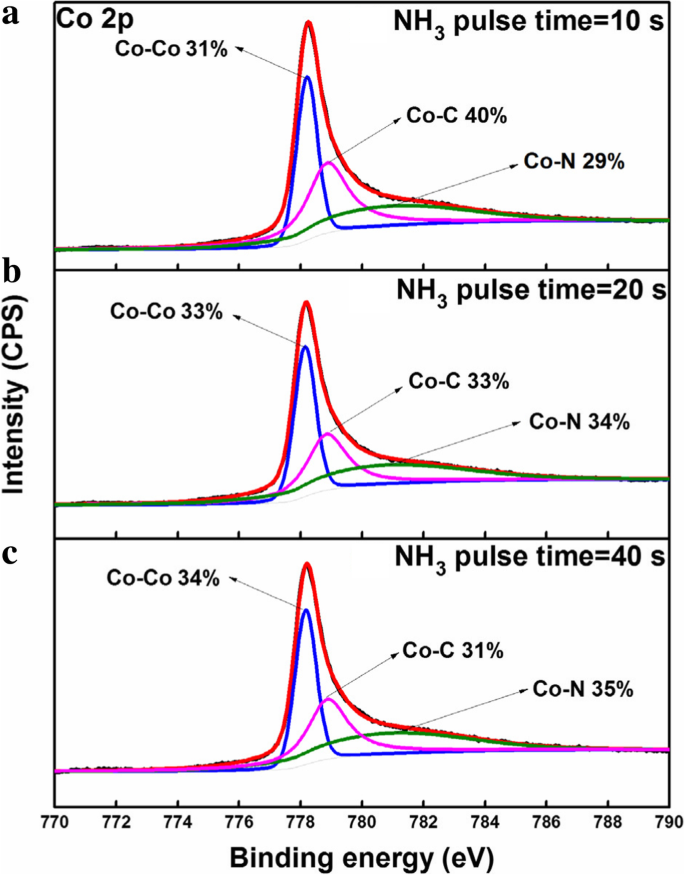
Die XPS-Spektren der Co-Filme mit verschiedenen NH3 Plasmazeiten:a 10 s; b 20 s; c 40 s
Tabelle 3 zeigt den Leistungsvergleich der Co-Filme, die mit verschiedenen Vorstufen gezüchtet wurden. Im Vergleich zu CoCp2 und Co(MeCp)2 , Co(EtCp)2 ermöglicht die Atomlagenabscheidung von Co-Filmen bei einer niedrigeren Temperatur. Darüber hinaus unter Verwendung der Metallvorstufe von Co(EtCp)2 führt zu einer geringeren Wachstumsrate. Theoretisch ist der ALD-Prozess das Wachstum von Monoschicht für Monoschicht. Tatsächlich beeinflussen sowohl der sterische Hinderungseffekt als auch die Oberflächenadsorption von Vorläufern das Filmwachstum. Im Hinblick auf den sterischen Hinderungseffekt bedeutet dies, dass die Liganden der chemisorbierten Metallvorläuferspezies eine Teiloberfläche abschirmen und verhindern können, dass andere Metallvorläuferspezies vollständig auf der Substratoberfläche adsorbiert werden. Da Co(EtCp)2 hat einen größeren Liganden im Vergleich zu CoCp2 und Co(MeCp)2 , wird angenommen, dass während des ALD-Prozesses ein signifikanter sterischer Hinderungseffekt auftritt. Dies kann zum Wachstum einer Submonoschicht führen, was zu einer geringeren Wachstumsrate führt. Da andererseits für zukünftige praktische Anwendungen eine Co-Linerschicht auf einer TaN-Barriereschicht abgeschieden werden sollte, wurden 1200 Zyklen von Co-Filmen auf dem ALD-TaN-Film bei 125 °C gezüchtet. Abbildung 8 zeigt das Querschnitts-TEM-Bild des auf der TaN-Oberfläche abgeschiedenen Co-Films. Es wird beobachtet, dass der Co-Film kontinuierlich und gleichförmig ist, was ein überlegenes Wachstumsverhalten zeigt. Ferner hat sich herausgestellt, dass die Dicke (ungefähr 10 nm) des auf dem ALD-TaN-Film abgeschiedenen Co-Films der auf dem SiO2 . aufgewachsenen ähnlich ist Oberfläche.
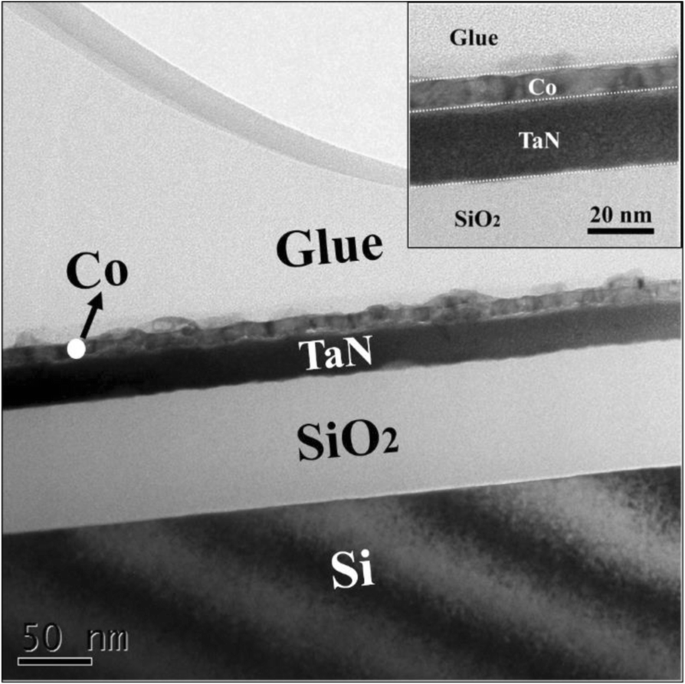
Das Querschnitts-TEM-Bild des Co-Films (1200 Zyklen), der bei 125 °C auf der ALD-TaN-Oberfläche abgeschieden wurde, und der Einschub ist ein vergrößertes Bild
Schlussfolgerungen
Das Wachstum des Co-Dünnfilms wird durch PE-ALD unter Verwendung der Vorläufer von Co(EtCp)2 . übertragen , und der Einfluss von Prozessparametern auf die Eigenschaften der Co-Filme wurden untersucht. Das Hinzufügen der Et-Gruppe zum Cp-Liganden ermöglicht, dass das Prozessfenster auf eine niedrigere Abscheidungstemperatur von 125 °C verschoben wird. Darüber hinaus bestehen die Co-Filme aus Co- und C-Elementen zusammen mit einigen N- und O-Elementen. Mit steigender Abscheidungstemperatur werden die EtCp-Liganden ausreichend entfernt und der relative elementare Anteil von C verringert. Infolgedessen verringert sich der spezifische Widerstand der abgeschiedenen Co-Filme von 652 auf 130 μΩ cm und bleibt dann ein stabiler Wert, wenn die Substrattemperatur von 100 auf 275 °C erhöht wird. Bei einer Abscheidungstemperatur von 125 °C nimmt der spezifische Widerstand mit der Verlängerung von NH3 . allmählich ab Pulszeit und ein niedriger spezifischer Widerstand von 117 μΩ cm können erreicht werden, wenn ein NH3 Es wird eine Pulszeit von 40 s verwendet. Der quadratische Mittelwert der Rauheit zeigt eine geringere Variation mit der Abscheidungstemperatur und behält einen niedrigen Wert von ~ 0,3 nm bei, was auf einen flachen Co-Film hinweist.
Abkürzungen
- AFM:
-
Rasterkraftmikroskopie
- ALD:
-
Atomlagenabscheidung
- Co(CpAMD):
-
Cyclopentadienylisopropylacetamidinatokobalt
- Co(EtCp)2 :
-
Bis(ethylcyclopentadienyl)cobalt
- Co(MeCp)2 :
-
Bis(η-methylcyclopentadienyl)cobalt
- CoCp2 :
-
Bis-cyclopentadienyl-cobalt
- Cp:
-
Cyclopentadienyl
- ILD:
-
Zwischenschichtdielektrikum
- PE:
-
Plasmaverstärkt
- RMS:
-
Quadratischer Mittelwert
- SEM:
-
Rasterelektronenmikroskop
- XPS:
-
Röntgenphotoelektronenspektroskopie
- XRD:
-
Röntgenbeugung
Nanomaterialien
- Advanced Atomic Layer Deposition Technologies für Mikro-LEDs und VCSELs
- Bipolar-resistive Schalteigenschaften von HfO2/TiO2/HfO2-RRAM-Bauelementen mit dreischichtiger Struktur auf Pt- und TiN-beschichteten Substraten, die durch Atomlagenabscheidung hergestellt wurden
- Grenzflächen-, elektrische und Bandausrichtungseigenschaften von HfO2/Ge-Stapeln mit in situ gebildeter SiO2-Zwischenschicht durch plasmaunterstützte Atomlagenabscheidung
- Untersuchungen zur Sorption von Schwermetallionen unter Verwendung von Nanokompositen aus eisenmodifizierter Pflanzenkohle
- Die antibakteriellen hierarchischen Polyamid-6-ZnO-Nanofasern, hergestellt durch Atomlagenabscheidung und hydrothermales Wachstum
- Photokatalytische Eigenschaften von Co3O4-beschichteten TiO2-Pulvern, hergestellt durch plasmaunterstützte Atomlagenabscheidung
- Zweistufige Abscheidung von Al-dotiertem ZnO auf p-GaN zur Bildung ohmscher Kontakte
- Fermi-Level-Tuning von ZnO-Filmen durch Supercycling-Atomschichtabscheidung
- Messung der Schichtdicke mit einem Mikroskop
- Vorteile der Verwendung von Legierungen



