Eine vergleichende Studie über die ferroelektrischen Eigenschaften von Hf0,5Zr0,5O2-Dünnschichten mit abgeschiedenen Atomschichten unter Verwendung von Tetrakis(ethylmethylamino)- und Tetrakis(dimethylamino)-Vorstufen
Zusammenfassung
Die chemischen, physikalischen und elektrischen Eigenschaften der abgeschiedenen Atomschicht Hf0,5 Zr0,5 O2 Dünnschichten unter Verwendung von Tetrakis(ethylmethylamino) (TEMA)- und Tetrakis(dimethylamino) (TDMA)-Vorläufern werden verglichen. Der Ligand der metallorganischen Vorstufen beeinflusst stark die Rest-C-Konzentration, die Korngröße und die resultierenden ferroelektrischen Eigenschaften. Einzahlung von Hf0,5 Zr0,5 O2 Filme mit den TDMA-Vorläufern führen zu einer geringeren C-Konzentration und einer etwas größeren Korngröße. Diese Ergebnisse sind vorteilhaft, um einen stärker ferroelektrischen Phasen-dominanten Film wachsen zu lassen, was seinen Aufweckeffekt abschwächt. Aus dem Aufwecktest des TDMA-Hf0.5 Zr0,5 O2 Film mit einem zyklischen Feld von 2,8 MV/cm wurde der nachteilige Aufwacheffekt bis zu 10 5 . gut unterdrückt Zyklen, mit einem relativ hohen doppelten remanenten Polarisationswert von ~40 μC/cm 2 . Der Film zeigte auch ein zuverlässiges Umschalten bis zu 10 9 Zyklen mit dem 2,5 MV/cm-Zyklusfeld ohne den Aufwacheffekt, aber mit dem typischen Ermüdungsverhalten.
Einführung
Abgelagerte Atomschicht Hf1-x Zrx O2 (HZO, x ~ 0.5) Dünnfilme sind der führende Konkurrent als ultradünne ferroelektrische (FE) Schicht auf dem Gebiet von Halbleiterbauelementen für Speicher- und Logikanwendungen. Dies liegt daran, dass der FE-HZO-Film mit Fluorit-Struktur sogar unter 10 nm verkleinert und auf dreidimensionalen Nanostrukturen unter Verwendung von ausgereiften Atomlagenabscheidungstechniken (ALD) homogen abgeschieden werden kann. Darüber hinaus ist es mit der konventionellen TiN-Elektrode [1, 2] kompatibel, die mit den konventionellen Ferroelektrika mit Perowskit-Struktur kaum zu erreichen ist. Trotz der signifikanten Verbesserung der HZO-Filmverarbeitung und der Vorrichtungsherstellung unter Verwendung der ALD-basierten Dünnfilme in den letzten Jahren gibt es mehrere ungelöste Mängel. Insbesondere die Zuverlässigkeit der Fluorit-Struktur-Ferroelektrika ist ungewiss. Derzeit gelten der Aufwacheffekt und die begrenzte Anzahl an Ausdauer als die schwerwiegendsten Probleme [3]. Im Allgemeinen sind die Polarisations-elektrischen Feld-(P-E)-Kurven im unberührten Zustand eingeengt, was darauf hindeutet, dass das Koerzitivfeld (Ec ) ist räumlich nicht einheitlich, und mehrere FE-Domänen sind gepinnt [4]. Nach einem elektrischen Feldwechsel mit einer Feldstärke höher als Ec , können symmetrischere und quadratischere P-E-Kurven erreicht werden, ein Phänomen, das als Wake-up-Effekt bekannt ist. In einigen Fällen dauert ein solcher Aktivierungsprozess 10 4 –10 5 Zyklen, das ist ein typischer Ausdauerzyklus von ca. Flash-Speicher, wodurch die Geräte- und Systembedienung kompliziert wird [5]. Die begrenzte Anzahl an Ausdauer ist ein weiterer kritischer Punkt, wenn es als Arbeitsgedächtnis verwendet werden soll (Ausdauer> 10 15 Wird benötigt). Bei einer Metall-Ferroelektrisch-Metall-Kondensatorstruktur beträgt die maximale gemeldete Lebensdauer weniger als 10 11 [6], und für Metall-Ferroelektrik-Halbleiter-Gate-Stack in ferroelektrischen Feldeffekttransistoren ist die Lebensdauer auf 10 5 . begrenzt mal [3, 7].
In der Literatur werden verschiedene Ursprünge des Wake-up-Effekts vorgeschlagen. Die vorgeschlagenen Mechanismen sind das Fixieren von Domänengrenzen durch Defekte wie Verunreinigungen, Sauerstoffleerstellen und das Vorhandensein der nichtferroelektrischen Phase (kubische oder tetragonale Phase) an den Grenzflächen neben den Elektroden oder Halbleiterkanälen im unberührten Zustand [5, 8 ,9,10]. Es wird erwartet, dass die Konzentration der Pinning-Stelle während des wiederholten Polarisationswechsels abnimmt. Außerdem wandelt das zyklische elektrische Feld die tetragonalen oder kubischen Grenzflächenphasen in die orthorhombische FE-Phase um [5]. Diese Studie konzentrierte sich hauptsächlich auf die Verbesserung der elektrischen Leistung des HZO-Films oder die Eliminierung des Aufweckeffekts durch die Verwendung alternativer Hf- und Zr-Vorläufer während des ALD-Prozesses, was zu einer geringeren Verunreinigungskonzentration, insbesondere Kohlenstoffverunreinigung, führen kann.
Bei ALD-Prozessen mit metallorganischen Vorstufen ist es fast unvermeidlich, Restverunreinigungen wie C, N und H in den gewachsenen Film zu induzieren, die höchstwahrscheinlich von den organischen Liganden stammen. Kimet al. [11, 12] zeigten, dass durch Änderung der Abscheidungstemperatur von HfO2 und HZO-Film konnten der Polymorphismus und die resultierenden elektrischen Eigenschaften kontrolliert werden. Aus der Auger-Elektronenspektroskopie (AES) ergab sich, dass die C-Konzentration im ALD HZO-Dünnfilm mit abnehmender Abscheidungstemperatur zunahm, was möglicherweise auf die unvollständigen Ligandenaustauschreaktionen zurückzuführen ist [11, 12]. Auch der seitliche Korndurchmesser nahm mit steigender C-Konzentration ab. Die Bildung der instabilen oder metastabilen Phasen (tetragonal, orthorhombisch und kubisch) anstelle der stabilen monoklinen Phase in solchen Filmen mit Fluoritstruktur ist eng mit dem Korngrößeneffekt verbunden [13,14,15,16]. Daher ist die Kontrolle der Störstellenkonzentration entscheidend, um die gewünschte Phase (FE orthorhombisch) zu erreichen und die elektrische Zuverlässigkeit des Films zu verbessern.
Für die ALD von FE-HZO-Dünnschichten sind die am häufigsten verwendeten metallorganischen Hf- und Zr-Vorstufen Tetrakis[ethylmethylamino]hafnium (TEMAH) und Tetrakis[ethylmethylamino]zirconium (TEMAZ) [11, 12, 17]. Diese Vorstufen wurden für die metallorganische chemische Gasphasenabscheidung mit dem Ziel einer leichten Ligandenzersetzung über den elektrischen Ladungstransfer zwischen den Methyl- und Ethylgruppen entwickelt [18,19,20]. Diese Art der thermisch induzierten Ligandenzersetzung und die anschließende Entfernung der (Fragmente von) organischen Liganden beeinträchtigen jedoch die einfache ALD-Reaktion, die zum Einbau der Verunreinigungen (C, H und N) in den Film führt [11, 17, 18, 19,20].
Im Gegensatz dazu haben die Tetrakis[dimethylamino]hafnium (TDMAH)- und Tetrakis[dimethylamino]zirconium (TDMAZ)-Vorstufen, die auch zur Abscheidung der FE-HZO-Filme verwendet wurden [21,22,23,24], nur Methylgruppen in ihren Liganden. Daher kann eine solche nachteilige Wirkung nicht schwerwiegend sein, obwohl die vollständige Unterdrückung der thermischen Zersetzung nicht garantiert werden kann.
Diese Studie führte eine vergleichende Analyse zwischen den HZO-Filmen durch, die durch die ALD-Prozesse mit zwei verschiedenen Metallvorläufern gezüchtet wurden; TEMAH/TEMAZ und TDMAH/TDMAZ. Letzteres Verfahren führte zu einer geringeren C-Konzentration im Film, was die elektrische Leistung des HZO-Films deutlich verbesserte. Unter den optimierten Schaltzyklusbedingungen wurde fast kein Aufweckeffekt erzielt, während die schaltbare Polarisation bei ~ 40 μC/cm 2 . blieb .
Methoden/Experimental
Vorbereitung der Hf0.5 Zr0,5 O2 Dünne Filme
Diese Arbeit untersuchte den Einfluss von Arten von metallorganischen Vorläufern auf die Struktur und die elektrische Leistung des atomarschichtabgeschiedenen Hf0,5 Zr0,5 O2 dünne Filme. Die HZO-Dünnschichten wurden unter Verwendung eines thermischen ALD-Reaktors mit einem Durchmesser von 4 Zoll mit TDMAH (oder TEMAH), TDMAZ (oder TEMAZ) und Ozon (190 g/m 3 .) abgeschieden Konzentration) als Hf-Vorstufe, Zr-Vorstufe bzw. Sauerstoffquelle. Der optimierte ALD-Prozess mit TEMAH/TEMAZ-Vorstufen war wie in den vorherigen Studien der Autoren [5, 9, 11,12,13,14,15,16]. Die HZO-Dünnfilme mit TDMAH/TDMAZ-Vorläufern wurden durch thermisches ALD bei einer Substrattemperatur von 260°C hergestellt. Für den elektrischen Test wurde ein Hf:Zr-Verhältnis von 50:50 gewählt, da berichtet wurde, dass die Zusammensetzung die größte remanente Polarisation (Pr ) Wert in früheren Studien [17, 25, 26]. Die HZO-Dünnschichten mit den TDMAH/TDMAZ-Vorläufern wurden mit einem ALD-Zyklusverhältnis von 1:1 von Hf- und Zr-Vorläufern auf TiN/Ti/SiO2 . abgeschieden /Si-Substrat. Ein ALD-Zyklus bestand aus Quellenzufuhr (2 s) - Quellenspülung (20 s) - Ozonzufuhr (3 s) - Ozonspülung (10 s). Die Wachstumsrate des HZO-Films betrug 0,13 nm pro Zyklus und die 10 nm dicken HZO-Dünnfilme wurden für die Experimente mit TDMAH/TDMAZ-Vorläufern hergestellt. Die optimalen Bedingungen können je nach Volumen der ALD-Kammer variieren. Tabelle 1 zeigt den Vergleich der physikalischen Eigenschaften der TEMA- und TDMA-Quellen. Die Filme aus TiN (50 nm) und Ti (5 nm) wurden durch Sputtern mit einer Sputterleistung von 5 kW auf den thermisch oxidierten p-Typ-Si-Substraten unter Verwendung eines kommerziellen Sputterwerkzeugs (Endura, Applied Materials) abgeschieden. Die abgeschiedenen HZO-Filme sind im abgeschiedenen Zustand nur teilweise kristallin oder amorph, daher wurde das anschließende Tempern zur Kristallisation unter Verwendung eines schnellen thermischen Prozesses (RTP) bei 450°C in N2 . durchgeführt Atmosphäre.
Charakterisierung der chemisch-physikalischen Eigenschaften des Hf0,5 Zr0,5 O2 Dünne Filme
Die kristallinen Strukturen der abgeschiedenen Filme wurden mit einem Röntgendiffraktometer (XRD, X’pert pro, Panalytical) innerhalb einer streifenden Einfallsgeometrie mit einem Einfallswinkel von 0,5° analysiert. Die Mikrostrukturen der Proben wurden mit einem Rasterelektronenmikroskop (SEM, S-4800, Hitachi) analysiert und die Korngrößenverteilung wurde mit einer Gwyddion-Software [29] durch eine Wasserscheidenmethode analysiert. Die chemische Zusammensetzung des abgeschiedenen HZO-Films wurde unter Verwendung von Röntgenfluoreszenz (XRF, Quant'X, Thermo SCIENTIFIC) analysiert, und die tiefgreifenden Variationen der chemischen Zusammensetzungen, einschließlich Verunreinigungen wie C, wurden unter Verwendung einer Zeitanalyse analysiert. Flugauger-Elektronenspektroskopie (AES, PHI-700, ULVAC-PHI).
Charakterisierung der elektrischen Eigenschaften des Hf0,5 Zr0,5 O2 Dünne Filme
Um die elektrischen Eigenschaften der HZO-Filme zu analysieren, wurden die oberen TiN-Elektroden durch einen Sputterprozess mit einer Leistung von 100 W unter dem 92,6%-Ar/7,4%-N2 . reaktiv abgeschieden Atmosphäre. Die oberen TiN-Elektroden wurden unter Verwendung einer Lochmaske mit kreisförmigen Löchern mit einem Durchmesser von 300 µm strukturiert. Die P-E-Kennlinien wurden mit einem ferroelektrischen Tester (TF Analyzer 2000, Aixacct Systems) bei einer Messfrequenz von 1 kHz analysiert. Der Dauertest wurde mit rechteckigen bipolaren Pulsen mit Höhen und Breiten von 2,8 ~ 3,8 MV/cm bzw. 10 µs durchgeführt, die von einem Pulsgenerator (81110A, Agilent) und einem ferroelektrischen Tester (TF Analyzer 2000, Aixacct Systems) erzeugt wurden. Die Kapazität-Spannungs-(C-V)-Eigenschaften wurden mit einem Impedanzanalysator (4194A, Hewlett-Packard) unter sinusförmigen Wechselstromimpulsen mit einer Frequenz von 10 kHz und einer Höhe von 50 mV in Kombination mit einer DC-Vorspannung gemessen. Die Dielektrizitätskonstanten von HZO-Filmen wurden aus der gemessenen Kapazität sowie der durch optische Mikroskopie gemessenen Elektrodenfläche und der mit spektroskopischer Ellipsometrie gemessenen Dicke (ESM-300, J. A. Woollam) berechnet. Die Charakteristiken der Stromdichte und des elektrischen Felds (J-E) wurden unter Verwendung eines Halbleiterparameteranalysators (4155B, Hewlett-Packard) unter DC-Vorspannung mit einer Verzögerungszeit von 1 s analysiert
Ergebnisse und Diskussion
Abbildung 1a zeigt die Röntgenbeugungsmuster (GIXRD) von 10 nm dickem Hf0.5 . unter streifendem Einfall Zr0,5 O2 dünne Filme abgeschieden unter Verwendung von TDMAH/TDMAZ (TDMA-HZO, schwarze Kurve) und TEMAH/TEMAZ (TEMA-HZO, rote Kurve) mit einem Einfallswinkel von 0,5°. Im unteren Teil sind die Referenzmuster aus der Literatur für die monoklinen, tetragonalen und orthorhombischen Phasen angehängt. Aus beiden GIXRD-Mustern der TDMA- und TEMA-HZO-Filme waren die Intensitäten der Beugungspeaks aus der monoklinen Phase vernachlässigbar und es konnte kein bemerkenswerter Unterschied in den Peakformen und -intensitäten identifiziert werden. Somit wurden keine signifikanten Unterschiede in der kristallographischen Struktur zwischen TDMA und TEMA HZO experimentell von GIXRD bestätigt.

(a) GIXRD-Muster von HZO-Dünnfilmen, die mit TDMAH/TDMAZ (schwarze Kurve) und TEMAH/TEMAZ (rote Kurve) abgeschieden wurden, die Referenzmuster aus der Literatur für die monoklinen, tetragonalen und orthorhombischen Phasen sind in den unteren Feldern angebracht. (b) Das planare REM-Bild von TDMA HZO-Filmen und (c) die Korngrößenverteilung von TEMA (rot; wiedergegeben aus Lit. [15]), TDMA (schwarz) HZO. (d) Das Tiefenprofil der TDMA-HZO-Dünnschichten, das mit der Flugzeit-Auger-Elektronenspektroskopie analysiert wurde, und (e) der vergrößerte Bereich niedriger Konzentration des HZO-Filmteils. Durchschnittliche C-Konzentration von TDMA (schwarze Strichpunktlinie), TEMA (rote Strichlinie; wiedergegeben aus Lit. [12]), HZO ist dargestellt
Die Mikrostruktur, einschließlich der seitlichen Korngröße, ist ein weiterer kritischer Faktor, der die FE-Eigenschaften von HZO-Dünnschichten stark beeinflussen kann [13,14,15,16, 30]. Daher wurden die Mikrostrukturen der TDMA- und TEMA-HZO-Filme unter Verwendung von Rasterelektronenmikroskopie (REM) analysiert. Abbildung 1b zeigt das planare REM-Bild von TDMA-HZO-Filmen. Verschiedene frühere Studien berichteten, dass die mittels thermischer ALD abgeschiedenen HZO-Dünnfilme eine säulenförmige Kornstruktur aufwiesen, was darauf hindeutet, dass die vertikale Korngröße so groß ist wie die Filmdicke [1, 5, 11, 31]. Die mit der oben genannten Software [29] analysierte Verteilung der seitlichen Korngröße wurde mit der Gauß-Funktion angepasst. Die Korngrößenverteilung von TEMA HZO (rote Kurve) wurde einer früheren Studie entnommen [15] und mit der von TDMA HZO (schwarze Kurve) in Abb. 1c aufgetragen. Wie in Abb. 1c gezeigt, war der durchschnittliche seitliche Korndurchmesser des TDMA HZO (8,5 nm) größer als der des TEMA HZO (7,1 nm). Dies könnte der Hauptgrund für die verbesserte FE-Leistung des TDMA HZO sein. Nach früheren Berichten wird die Bildung der metastabilen Phasen, wie orthorhombischen und tetragonalen Phasen, durch die kinetischen Ursprünge getrieben, und die tetragonalen und orthorhombischen Phasen werden im Bereich kleiner Korngrößen bevorzugt [13, 16]. Viel größere Körner bevorzugen monokline Phasen, kleinere Korngrößen bevorzugen die tetragonale Phase und die etwas größere Korngröße bevorzugt die orthorhombische Phase. Die nahezu Überlappung der Peakpositionen der beiden Phasen (tetragonale und orthorhombische Phasen) in den Beugungsmustern erlaubte keine eindeutige Identifizierung der Hauptphase in den beiden Filmen. Das SEM und die begleitende Korngrößenanalyse zeigten jedoch, dass der TDMA HZO-Film im Vergleich zum TEMA HZO-Film einen höheren Anteil der orthorhombischen Phase aufweisen könnte.
Die unterschiedlichen Korngrößen könnten auf die unterschiedliche Höhe der C-Fremdstoffkonzentration in den beiden Filmen zurückzuführen sein. Die Konzentrationen an Verunreinigungen könnten die Mikrostruktur und die resultierenden ferroelektrischen Eigenschaften von HZO-Dünnschichten stark beeinflussen [11, 12, 32]. Daher wurde die chemische Zusammensetzung der TDMA- und TEMA-HZO-Dünnfilme mithilfe von Flugzeit-AES analysiert und die resultierenden Tiefenkonzentrationen verschiedener Atome wie Hf, Zr, O, C, Ti und N in TDMA HZO Film wurden als Funktion der Sputterzeit in Abb. 1d aufgetragen. Abbildung 1e zeigt den vergrößerten Bereich niedriger Konzentration von Abbildung 1d (roter gestrichelter Kasten) im HZO-Filmteil. Die durchschnittliche C-Konzentration im TDMA-HZO-Film (schwarzes Quadrat) betrug ~2,4 %, was ~~38% niedriger ist als die (~~3,9%) des TEMA-HZO-Films (rotes Dreieck) [12], von dem AES-Daten in der berichtet wurden vorherige Studie der Autoren [12]. Alle anderen Konzentrationen, einschließlich N, zeigten keine nennenswerten Unterschiede.
Cho et al. schlugen vor, dass die während des ALD-Prozesses gebildeten restlichen C-Verunreinigungen das Kornwachstum verlangsamten und zu einer kleinen Korngröße der schließlich abgeschiedenen Filme führten [32]. Ein ähnlicher Trend wurde für ferroelektrisches Hf0,5 . beobachtet Zr0,5 O2 dünne Filme und reines HfO2 Filme von Kim et al. als die Abscheidungstemperatur von 280 auf 200°C sank [11, 12]. Junget al. verwendeten Computersimulationen, um zu zeigen, dass die Differenz der freien Energie zwischen der tetragonalen und der monoklinen Phase mit steigender C-Konzentration in HfO2 . abnimmt , was darauf hindeutet, dass die Einbeziehung von C-Verunreinigungen die Stabilität der metastabilen tetragonalen Phase erhöht [33]. Künneth et al. untersuchte auch die Wirkung der C-Konzentration auf die Werte der freien Energie von HfO2 . Sie berichteten jedoch, dass die Erhöhung der C-Konzentration nicht zu einer Verringerung der freien Energiedifferenz zwischen der orthorhombischen und der monoklinen Phase führte [34]. In der Arbeit von Kuenneth et al. wurden die C-Substitutionsdefekte betrachtet, obwohl die C-Verunreinigungen im Allgemeinen als interstitielle Defekte in HfO2 . bekannt sind [33, 35]. Daher zeigten die theoretischen Berechnungen nicht eindeutig, dass die C-Verunreinigungen den Unterschied der freien Energie zwischen der tetragonalen und der orthorhombischen Phase verringern könnten. Experimente haben jedoch bestätigt, dass die Zunahme der C-Verunreinigungen den Anteil der tetragonalen Phase in den dünnen ALD-HZO-Filmen erhöhen könnte [11, 12, 33].
Die niedrigere C-Fremdstoffkonzentration im TDMA-HZO-Film könnte der unterschiedlichen thermischen Zersetzungsnatur der TDMA- und TEMA-Liganden zugeschrieben werden. Die äußersten Kohlenstoffatome in den TEMA-Liganden neigen zur thermischen Dissoziation und verbleiben während des ALD-Prozesses auf der Filmoberfläche [11, 12], was beim TDMA-Liganden möglicherweise nicht der Fall ist.
Als nächster Schritt wird der Einfluss der C-Konzentration und der resultierenden Mikrostruktur auf die ferroelektrischen Eigenschaften diskutiert. Abbildung 2a und b zeigen die P-E-Kurven von MFM-Kondensatoren mit den TDMA HZO- bzw. TEMA HZO-Filmen, gemessen in einem unberührten Zustand und einem um 10 2 . geschalteten Ermüdungszustand , 10 3 , 10 4 , und 10 5 mal unter Verwendung der 3,8 MV/cm-hohen und 10 μs breiten bipolaren Rechteckimpulse. Aus den P-E-Kurven in Abb. 2a und b (unberührter Zustand) ist die P-E-Kurve des TEMA HZO-Kondensators (schwarze Kurve, Abb. 2b) im makellosen Zustand im Vergleich zum TDMA HZO-Kondensator (schwarz Kurve, Abb. 2a). Abbildung 2b zeigt deutlich die Buckel in der unberührten P-E-Kurve des TEMA HZO-Kondensators, was bei der unberührten P-E-Kurve des TDMA HZO-Kondensators nicht der Fall ist. Die Höcker in der P-E-Kurve entstehen durch die Aufspaltung von Schaltstromspitzen, die im Allgemeinen aus der räumlichen Inhomogenität im inneren elektrischen Feld und/oder Koerzitivfeld resultieren. Abbildung 2c zeigt die Veränderungen in 2Pr Werte von TDMA- und TEMA-HZO-Kondensatoren als Funktion von Ermüdungsimpulsen. Die 2Pr Werte nach 10 5 Zeiten elektrischer Impulse im Vergleich zum unberührten 2Pr Werte von TDMA- und TEMA HZO-Kondensatoren betragen ~ 80 bzw. ~ 69%. Dies deutet darauf hin, dass der TEMA HZO-Film ein höheres Aufwachverhalten als der TDMA HZO-Film aufweist.

Die Polarisations-elektrischen Feld-(P-E)-Kurven von (a ) die TDMA HZO und (b ) TEMA HZO (reproduziert aus Ref. [5]) Kondensatoren, gemessen im unberührten Zustand und im Ermüdungszustand, gepulst mit 10 2 , 10 3 , 10 4 , und 10 5 mal bei 3,8 MV/cm-hohen und 10 µs breiten bipolaren Rechteckimpulsen. (c) Die Änderungen in 2Pr Werte von TDMA (schwarz) und TEMA (rot) HZO-Kondensatoren als Funktion von Ermüdungspulsen. Die Dielektrizitätskonstante-elektrischen Feldkurven von (d ) die TDMA HZO und (e ) TEMA HZO (Wiedergabe aus Lit. [5]) Kondensatoren mit den oberen und unteren TiN-Elektroden, gemessen im unberührten Zustand und im Ermüdungszustand. (f) Die Änderungen der Dielektrizitätskonstantenwerte mit zunehmender Anzahl von Ermüdungspulsen für TDMA (schwarz) und TEMA (rot) HZO-Kondensatoren
Abbildung 2d und e zeigen die Dielektrizitätskonstante-elektrisches Feld (εr - E) Kurven der TDMA HZO- und TEMA HZO-Kondensatoren, gemessen in einem unberührten Zustand und im Ermüdungszustand um 10 2 . geschaltet , 10 3 , 10 4 , und 10 5 mal unter Verwendung der 3,8 MV/cm-hohen und 10 μs breiten bipolaren Rechteckimpulse. Die εr Werte von TDMA HZO-Kondensatoren sind bei allen Testbedingungen deutlich niedriger als die von TEMA HZO-Kondensatoren. Abbildung 2f zeigt die Veränderungen in εr Werte mit zunehmender Anzahl von Ermüdungsschaltzyklen für TDMA- und TEMA-HZO-Kondensatoren. Die εr Werte wurden durch Mittelung von εr . berechnet Werte gemessen bei den höchsten und niedrigsten elektrischen Feldern in Abb. 2d und e. Aus den GIXRD-Mustern in Abb. 1a waren die monoklinen Phasenanteile in beiden Filmen vernachlässigbar. Somit ist der Unterschied in εr Wert könnte durch die relativen Anteile der tetragonalen und orthorhombischen Phasen oder der Defektkonzentration bestimmt werden, von der erwartet wird, dass sie die durchschnittliche Dielektrizitätskonstante mit lokalen Gitterverzerrungen verringert. Die εr Wert der tetragonalen Phase (35–40) war höher als der der orthorhombischen Phase (25–30). Somit ist das hohe εr Der Wert des TEMA HZO-Kondensators weist darauf hin, dass er im Vergleich zu den TDMA-HZO-Kondensatoren einen höheren tetragonalen Phasenanteil aufweist. Mit zunehmender Anzahl von Ermüdungspulsen steigt der εr Wert sowohl der TEMA HZO- als auch der TDMA HZO-Kondensatoren sinkt, wie in Abb. 2f gezeigt. Das Ausmaß der Abnahme von εr Wert während 10 5 mal Polarisationsumschaltung für TDMA HZO-Kondensator (26,8 bis 25,3) war um ~ 42% kleiner als die für TEMA-HZO-Kondensator (32,2 bis 29,6). Dies stimmt mit dem in Abb. 2c gezeigten Aufwachverhalten überein.
Der Unterschied im tetragonalen Phasenanteil und die daraus resultierenden unterschiedlichen εr Wert von TDMA- und TEMA-HZO-Dünnfilmen konnte aus dem Unterschied in der C-Konzentration verstanden werden. Laut Kim et al. [12] verringert die Erhöhung der C-Konzentration die freie Energie der tetragonalen Phase im Vergleich zu der der orthorhombischen Phase (die tetragonale Phase ist im Vergleich zur orthorhombischen Phase noch günstiger). Als Ergebnis wird mit steigender C-Konzentration erwartet, dass der Anteil der tetragonalen Phase zunimmt. Da die C-Konzentration des TDMA HZO-Films niedriger ist als die des TEMA HZO-Films, wird erwartet, dass der Anteil der tetragonalen Phase im TDMA HZO-Film niedriger ist als der des TEMA HZO-Films. Der in Abb. 1c gezeigte Unterschied in der Korngröße unterstützt auch den gleichen Trend bei den relativen kristallinen Phasenanteilen. Gemäß Materlik et al. [30], die freie Oberflächenenergie der tetragonalen Phase (2.5 J/m 2 ) ist niedriger (2,9 J/m 2 .) ) der orthorhombischen Phase, obwohl diese freien Oberflächenenergien geschätzt wurden, um die experimentellen Beobachtungen in HZO-Dünnfilmen mit verschiedenen Dicken und Zr-Konzentrationen zu erklären. Batraet al. [36] berechneten die freie Oberflächenenergie der verschiedenen kristallinen Phasen mit verschiedenen Orientierungen und zeigten, dass die freie Oberflächenenergie der tetragonalen Phase niedriger ist als die der orthorhombischen und monoklinen Phase. Es wird allgemein akzeptiert, dass die Hochwinkel-Korngrenzenenergie ungefähr 1/3 der freien Oberflächenenergie beträgt [37]. Somit ist die Korngrenzenenergie der tetragonalen Phase im Vergleich zu den orthorhombischen und monoklinen Phasen am niedrigsten, was sie zur stabilsten Phase bei der kleinsten Korngröße macht. Diese stimmen mit der Idee überein, dass die kleinere Korngröße des TEMA HZO dazu neigt, einen höheren Anteil der nicht-ferroelektrischen tetragonalen Phase zu enthalten, verglichen mit dem TDMA HZO-Film, der eine größere durchschnittliche Korngröße aufwies. Daher unterstützen die experimentell beobachtete C-Konzentration und Korngröße durchweg die unterschiedliche Kristallstruktur und die resultierenden elektrischen Eigenschaften der TDMA- und TEMA-HZO-Dünnschichten.
Um den Mechanismus hinter dem Aufweckeffekt aufzuklären, kann die Pulsumschaltmessung, die die Grenzflächenkapazität (Ci ) aus der nicht-ferroelektrischen Schicht in der Nähe von Elektroden, wurde an TDMA HZO- und TEMA HZO-Kondensatoren durchgeführt [5]. Abbildung 3a und b zeigen die Veränderungen in Ci , Übergangswiderstand (Rc ) und Ec Werte mit zunehmender Anzahl von Ermüdungsimpulsen für die TDMA HZO- bzw. TEMA HZO-Kondensatoren. Die detaillierte Messmethode und die Ergebnisse sind in den Online-Hintergrundinformationen enthalten. Die Daten für den TEMA HZO-Kondensator wurden der vorherigen Arbeit von Kim et al. [5] entnommen, in der der Ci Wert steigt mit zunehmender Anzahl von elektrischen Feldzyklen [5]. Im unberührten Zustand ist das Ci (37,6 μF/cm 2 ) Wert des TDMA-Kondensators ist höher als dieser (21,1 μF/cm 2 .) ) des TEMA HZO-Kondensators um ~~75%, was darauf hindeutet, dass die Dicke der nicht-ferroelektrischen Grenzschicht in TDMA HZO viel geringer ist als die in TEMA HZO-Film. Andererseits ist der Unterschied in Ec Wert im tadellosen Zustand von TDMA- und TEMA HZO-Kondensatoren beträgt nur 13%, was darauf hindeutet, dass der Hauptgrund für den Unterschied in den unberührten P-E-Eigenschaften von TDMA- und TEMA HZO-Kondensatoren die unterschiedliche Dicke der nicht-ferroelektrischen Grenzflächenschichten ist. Da Rc Wert stark vom Kontaktwiderstand für den elektrischen Testaufbau beeinflusst wird, kann er im Vergleich zu den anderen beiden Faktoren eine geringere Bedeutung haben. Daher konnten die unterschiedlichen P-E-Eigenschaften im unberührten Zustand von TDMA- und TEMA-HZO-Kondensatoren basierend auf dem vorherigen Aufwachmodell von Kim et al. [5]. Nach früheren Studien ist die Sauerstoffleerstellenkonzentration in der Nähe der TiN-Elektroden höher als die des Filmvolumenbereichs im unberührten Zustand. Nach Hoffmann et al. [38] erhöht die Erhöhung der Sauerstoffleerstellenkonzentration die Stabilität der tetragonalen Phase im Vergleich zur orthorhombischen Phase. Während des wiederholten Polarisationswechsels im Dauertest schien sich die tetragonale Grenzflächenphase in die orthorhombische FE-Phase durch Ausdiffundieren der Sauerstoffleerstellen in den Volumenbereich des Films umzuwandeln. Das angelegte Feld induzierte auch einen Phasenübergang der Grenzflächen-Nicht-FE-Phase in die FE-Phase. Da die Dicke der Grenzflächenschicht des TDMA-HZO-Kondensators im ursprünglichen Zustand geringer ist als die der TEMA-HZO-Kondensatoren, könnte der Aufweckeffekt während des Feldzyklus abgeschwächt werden.
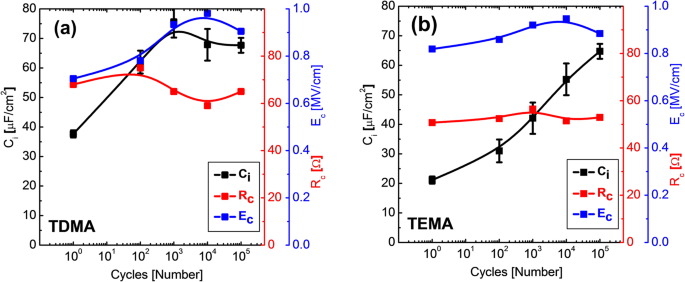
Die Änderungen von (a ) TDMA HZO und (b ) TEMA HZO (wiedergegeben aus Ref. [5]) in der Grenzflächenkapazität (Ci ), Übergangswiderstand (Rc ) und Koerzitivfeld (Ec ) Werte mit zunehmender Anzahl von Ermüdungspulsen
Auch die Amplitude des Ermüdungspulses ist ein weiterer entscheidender Faktor, der das Aufwachphänomen der Fluorit-Struktur-Ferroelektrika stark beeinflussen kann [6, 8]. Daher wurde der Aufweckeffekt des TDMA-HZO-Kondensators unter Verwendung von Ermüdungspulsen mit verschiedenen Amplituden von 2,8, 3,1, 3,5 und 3,8 MV/cm untersucht. Abbildung 4a, b und c zeigen die P-E-Kurven, die während des Aufwachtests mit Ermüdungspulshöhen von 2,8, 3,1 bzw. 3,5 MV/cm gemessen wurden. Die Änderungen in 2Pr während des Aufwachtests sind in Abb. 4d zusammengefasst. Ähnlich dem in Abb. 2a gezeigten Aufwachtestergebnis wurde die P-E-Messung bei einem elektrischen Messfeld von 3,8 MV/cm nach einer bestimmten Anzahl von Aufwachzyklen mit der gegebenen Feldamplitude durchgeführt. Die Änderungen der P-E-Hysterese nehmen mit abnehmender Amplitude der Ermüdungsimpulse ab, wie in Abb. 4a–c gezeigt. Abbildung 4d zeigt eine Zusammenfassung der Änderungen in 2Pr Wert während des Dauertests mit 2,8, 3,1, 3,5 und 3,8 MV/cm Amplituden-Ermüdungspulsen. Wie in Abb. 4d zu sehen ist, ist die Größe von 2Pr Erhöhung nach 10 5 Die Zeiten der Feldzyklen betrugen 0,41, 5,18, 9,93 und 9,94 μC/cm 2 für die verschiedenen Ermüdungsfeldamplituden, die ~ 1, ~ 13, ~ 26 bzw. ~ 24% Änderungen entsprechen. Dieses Ergebnis impliziert, dass der Aufwacheffekt vernachlässigbar ist, wenn ein Ermüdungspuls mit einer Amplitude von 2,8 MV/cm angelegt wurde, wobei ein angemessen hoher 2Pr Wert (~ 40 μC/cm 2 ) konnte noch erreicht werden.
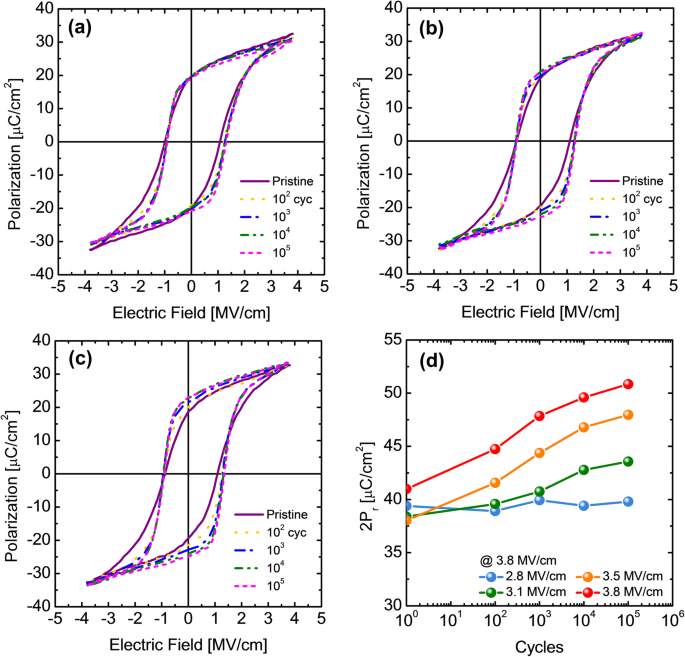
Die Polarisations-elektrischen Feld-(P-E)-Kurven, die während des Aufwachtests mit der Ermüdungspulshöhe von (a ) 2.8, (b ) 3.1 und (c ) 3,5 MV/cm. (d) Die Änderungen in 2Pr Wert im Dauertest mit 2,8, 3,1, 3,5 und 3,8 MV/cm-hohen Ermüdungspulsen
Der Wake-up-Effekt hängt stark mit der Drift von Sauerstoffleerstellen und dem daraus resultierenden Phasenübergang von der tetragonalen Phase in die orthorhombische Phase, hauptsächlich in der Grenzschicht, zusammen [9, 10]. Die Drift der Sauerstoffleerstellen sollte stark von der Amplitude der Ermüdungsimpulse beeinflusst werden, und eine entsprechend niedrigere Ermüdungstestfeldamplitude (in diesem Fall 2,8 MV/cm) kann einen solchen nachteiligen Effekt weitgehend abmildern. Obwohl das erreichbare Maximum 2Pr Wert wurde von ~ 51 μC/cm 2 . gesenkt (bei 3,8 MV/cm) bis ~ 40 μC/cm 2 (bei 2,8 MV/cm), ~ 40 μC/cm 2 ist für ferroelektrische Speichervorrichtungen immer noch ein angemessen hoher Wert. Im Fall des TEMA HZO-Films könnte eine ähnliche Strategie angewendet werden, um das Aufwachproblem zu mildern, aber der anfänglich niedrige 2Pr Wert (~ 30 μC/cm 2 ) könnte das potenzielle Problem für eine solche Methode sein.
Der Einfluss der C-Konzentration wurde durch den Dauertest bis 10 9 . weiter geklärt Zyklen, wie in Abb. 5a und b gezeigt, die die Variationen von Pr . zeigten unter Feldamplitude von 2,5 und 3,0 MV/cm für die TEMA- bzw. TDMA-HZO-Filme. In beiden Fällen ist der Pr Werte wurden durch die P-E-Schleifen mit dem maximalen elektrischen Feld der identischen Stärke wie das zyklische Feld geschätzt, also der geschätzte Pr Werte sind im Allgemeinen kleiner als die Werte in Abb. 4, wo die P-E-Tests mit 3,8 MV/cm durchgeführt wurden. Als das maximale Feld (3,8 MV/cm) für den P-E-Test in Abb. 4 für die Dauertests verwendet wurde, wurden die Filme früh abgebaut, was die Dauertests bis zu den maximalen Zyklenzahlen verbot. Die beiden Filme zeigten konsistente Trends in der Entwicklung des Pr vs. Zyklusverhalten:TEMA HZO-Film erhöhte den Pr . weiter Werte, wohingegen der Trend im Fall der TDMA HZO-Folie deutlich niedriger war. The TEMA HZO film showed unsteady Pr changes before break down at ~ 10 7 and ~ 10 9 cycles using 3.0 and 2.5 MV/cm field cycling, respectively. In contrast, the TDMA HZO film showed no indication of breakdown up to ~ 10 7 and ~ 10 9 cycles at 3.0 MV/cm and 2.5 MV/cm field cycling, and sudden breakdown was observed. The Pr value decreased slightly after ~ 10 7 under the cycling field strength of 2.5 MV/cm, which corresponds to the genuine fatigue behavior. Similar decay in the Pr performance with the switching cycles has been extensively reported for conventional perovskite ferroelectrics, which usually ascribed to the domain wall pinning by the increasing defect density [40, 41]. In the previous studies on the HZO-based ferroelectric thin films, such genuine fatigue behaviors have hardly been observed due to the involvement of significant wake-up and early breakdown, which was also the case in Fig. 5a. The data shown in Fig. 5b reveals that the HZO film may also suffer from the fatigue effect, known in the perovskite ferroelectric film, under the condition that the wake-up and early breakdown are appropriately addressed.
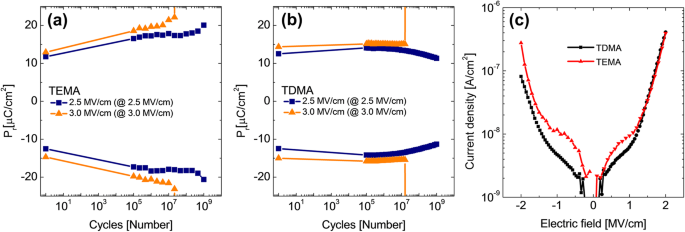
The results of endurance test of (a ) TEMA HZO (reproduced from Ref. 39) and (b ) TDMA HZO with the electric field cycling and pulse field amplitude of 2.5 and 3.0 MV/cm. The frequency of the rectangular double pulse for the endurance test was fixed at 100 kHz. (c) The current density–electric field curves of TDMA HZO (black) and TEMA HZO (red; reproduced from Ref. [39])
Figure 5c shows the comparison in the leakage current density performance of the two types of films. Due to the lower C concentration, TDMA HZO film had a lower leakage current than that of the TEMA HZO film at field strength <~ 1.5 MV/cm, where the trap-assisted tunneling may dominate. As a result of the leakage current improvement in TDMA HZO, the film did not show the breakdown up to 10 9 cycles, with relatively low field strength of 2.5 MV/cm.
However, in the higher field strength region, the difference becomes diminished, which may indicate that the high-field leakage current is more dominated by the interface Schottky barrier property, and such barrier property was less sensitive to the C concentration. Further research will be performed to more precisely identify the leakage current mechanism in subsequent work. The similar leakage currents in the high field region coincide with the no significant difference in the number of switching cycles before the breakdown at 3.0 MV/cm, shown in Fig. 5a and b.
Schlussfolgerung
In conclusion, this work examined the influence of types of metal-organic precursors on the structure and electrical performances of the atomic layer-deposited Hf0.5 Zr0,5 O2 dünne Filme. The adopted Hf and Zr precursors have either TEMA or TDMA ligands, where the former is more prone to the thermal decomposition compared to the latter. The ALD process using the precursors with TDMA ligands resulted in a lower C impurity concentration (~2.4 atomic % vs. ~3.9 atomic %) in the HZO film, which induced a slightly larger grain size (~8.5 nm vs. ~7.1 nm). As the slightly larger grain size prefers to have the ferroelectric orthorhombic phase rather than the non-ferroelectric tetragonal phase, the TDMA HZO film outperformed the TEMA HZO film, especially for the wake-up performance. When the wake-up field cycle was 2.8 MV/cm, the TDMA HZO film showed almost no wake-up effect, while a high 2Pr value of ~40 μC/cm 2 could be achieved. This is significant merit over the severely waking-up property of the TEMA HZO film. The TDMA HZO film also contained a lower portion of the interfacial non-ferroelectric phase with the TiN electrodes, compared with the TEMA HZO film. Due to the lower C concentration, the TDMA HZO film showed a lower leakage current in the low field region (<~1.5 MV/cm), but the high-field leakage current behaviors were similar. As a result, the number of switching cycles before breakdown was similar when the cycling field was as high as 3.0 MV/cm (~10 7 cycles), but it could be extended over 10 9 cycles when the cycling field was lower (2.5 MV/cm) for the case of the TDMA HZO film. The TDMA HZO film revealed that the typical fatigue behavior, i.e., decreasing Pr value with the increasing switching cycles, could be observed after ~ 10 7 cycles at 2.5 MV/cm, which might be ascribed to the domain wall pinning by the accumulated defects, as for the conventional perovskite ferroelectric films.
Verfügbarkeit von Daten und Materialien
The datasets supporting the conclusions of this article are included within the article and its Additional file 1.
Abkürzungen
- TEMA:
-
Tetrakis(ethylmethylamino)
- TDMA:
-
Tetrakis(dimethylamino)
- TEMAH:
-
Tetrakis[ethylmethylamino]hafnium
- TEMAZ:
-
Tetrakis[ethylmethylamino]zirconium
- TDMAH:
-
Tetrakis[dimethylamino]hafnium
- TEMAZ:
-
Tetrakis[dimethylamino]zirconium
- TDMA HZO:
-
Hf0.5 Zr0,5 O2 thin films deposited using TDMAH/TDMAZ
- TEMA HZO:
-
Hf0.5 Zr0,5 O2 thin films deposited using TEMAH/TEMAZ
- ALD:
-
Atomlagenabscheidung
- AES:
-
Auger-Elektronenspektroskopie
- RTP:
-
Rapid thermal process
- XRD:
-
Röntgendiffraktometer
- GIXRD:
-
Grazing incidence X-ray diffraction
- SEM:
-
Rasterelektronenmikroskopie
- HZO:
-
Hf1-x Zrx O2 , x~0.5
- FE:
-
Ferroelectric
- Pr :
-
Remanent polarization
- Ec :
-
Coercive field
- P–E:
-
Polarization–electric field
- C–V:
-
Capacitance–voltage
- J–E:
-
Current density–electric field
- Ci :
-
Interfacial capacitance
- Rc :
-
Contact resistance
Nanomaterialien
- Enthüllung der atomaren und elektronischen Struktur von gestapelten Kohlenstoff-Nanofasern
- Die antibakteriellen hierarchischen Polyamid-6-ZnO-Nanofasern, hergestellt durch Atomlagenabscheidung und hydrothermales Wachstum
- First-Principles-Studie zur Stabilität und dem STM-Image von Borophen
- Abstimmung der Oberflächenmorphologien und -eigenschaften von ZnO-Filmen durch das Design der Grenzflächenschicht
- Herstellung von SrGe2-Dünnschichten auf Ge (100), (110) und (111) Substraten
- Untersuchung der Adhäsionskraft und des Glasübergangs dünner Polystyrolfolien durch Rasterkraftmikroskopie
- Eine Studie zu Kohlenstoffnanofasern und Aktivkohle als symmetrischer Superkondensator in wässrigem Elektrolyt:Eine Vergleichsstudie
- Vorbereitung und thermoelektrische Eigenschaften von ITO/PtRh:PtRh-Dünnschicht-Thermoelementen
- TEM- und STEM-Studien zu den Querschnittsmorphologien von Dual-/Tri-Layer-Breitband-SiO2-Antireflexfolien
- Vergleichende Studie der elektrochemischen, biomedizinischen und thermischen Eigenschaften natürlicher und synthetischer Nanomaterialien



